TGV(Through Glass Via)和TSV(Through Silicon Via)是两种用于实现不同层面之间电气连接的技术。
TGV技术通过在玻璃基板上制作垂直贯通的微小通孔,并在通孔中填充导电材料,实现电气连接。TGV以高品质硼硅玻璃、石英玻璃为基材,通过一系列工艺步骤如种子层溅射、电镀填充、化学机械平坦化等实现3D互联。这种技术具有优良的高频电学特性,机械稳定性强,且制作成本相对较低。TGV在光通信、射频、微波、微机电系统、微流体器件和三维集成领域有广泛的应用前景。
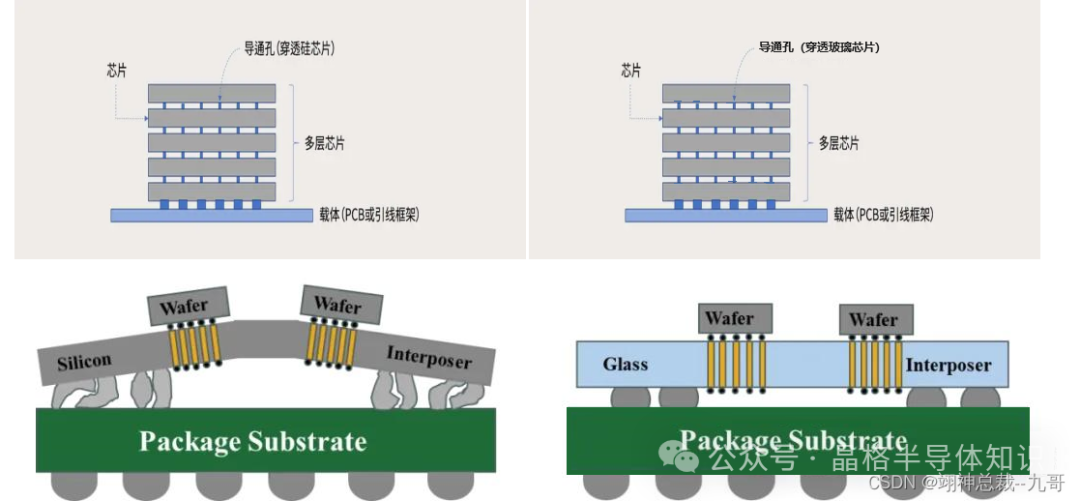
TSV技术则是在硅晶圆上制作垂直贯通的微小通孔,并在通孔中填充导电材料,实现芯片内部不同层面之间的电气连接。这种技术能够显著提高芯片内部的互连密度,降低信号传输延迟,提高系统的整体性能。TSV技术广泛应用于存储器、处理器、图像传感器等高性能芯片中,如用于堆叠式DRAM的制作,实现更高的存储容量和更快的数据传输速度。
TGV的主要工艺步骤包括:
1. 基板准备:选择合适的玻璃基板,基板需要具备良好的尺寸稳定性、热膨胀系数匹配性和电学性能。
2. 孔洞制作:通过激光加工、化学腐蚀或机械加工等方法,在玻璃基板上制作微小孔洞,用于连接芯片和外部电路。
3. 金属填充:在孔洞中填充金属材料,通常使用铜、银或金等导电性能良好的材料。
4. 磨平与抛光:通过研磨和抛光等工艺,将填充金属与基板表面磨平,确保信号传输的可靠性和封装的平整度。
5. 电镀:在填充金属的表面进行电镀,增加导电性能和保护层。
6. 后处理:进行封装后的检测和测试,确保TGV封装的质量和可靠性,并进行封装外观的检查和包装工艺的处理。
晶格半导体-提供高纯度单晶硅、多晶硅材料,并可定制加工各种类型硅部件、硅筒、硅电极、硅环、硅锭、硅管、硅毛坯材料。17826693981
而TSV的主要工艺步骤则包括:
1. 硅基底准备:通常以覆盖有二氧化硅(SiO₂)层的硅基底开始,这层SiO₂可以通过热氧化或等离子体增强化学气相沉积(PECVD)方法形成。
2. 光刻:在SiO₂层上涂布光刻胶,然后通过曝光和显影步骤进行图案化,以定义硅蚀刻的区域。
3. 硅蚀刻:使用光刻图案作为掩模,在硅基底中蚀刻出通孔。
4. 去除光刻胶:蚀刻完成后,去除光刻胶,为接下来的层沉积步骤做准备。
5. 沉积绝缘层和阻挡层:在孔壁上沉积一层二氧化硅作为绝缘层,防止电子窜扰;然后沉积一层导电的阻挡层,以便后续的铜镀层能更好地附着,并防止电子迁移。
6. 铜电镀:在绝缘层和阻挡层上进行铜镀层,填充TSV孔洞。
7. 退火:电镀完成后,进行退火工序,释放应力。
玻璃,尤其是用于电路板的玻璃基材,因其高硬度、高温稳定性、低热膨胀系数和优异的绝缘性能而表现出色。这些特性使得玻璃基材电路板能够在高温环境下稳定工作,并具备较好的机械强度和稳定性。在信号完整性方面,玻璃基材的低介电常数和低损耗角正切意味着信号在电路板上传输时损耗较小,从而提供了更好的信号完整性和较低的信号衰减。
硅,作为半导体材料,在微电子行业中占据核心地位。硅基芯片和器件的制造对于现代电子设备至关重要。在信号完整性方面,硅材料的高纯度、稳定性和可控性是关键因素。通过精确的工艺控制和设计,硅基芯片能够实现高速、低噪声和低失真的信号传输,确保信号的完整性和准确性。
TSV和TGV 工艺成本
TSV(Through Silicon Via,硅通孔)和TGV(一种玻璃基巨量互通技术)是两种不同的封装技术,它们各自具有独特的成本结构和特点。
TSV技术的成本结构中,通孔蚀刻占比最高,达到44%,其次是通孔填充和减薄,分别为25%和24%。TSV为HBM核心工艺,成本占比接近30%,在HBM的3D封装中成本占比最高。此外,TSV形成和显露的成本占比也相对较高,超过了前/后道工艺的成本占比。
相较之下,TGV技术是对TSV的升级,其制作成本相较于硅基转接板只有1/8。这主要得益于TGV技术无需制作绝缘层,降低了工艺复杂度和加工成本。此外,玻璃材料的优良电学、热学和力学性能也使其在应用中具有显著优势。TGV技术作为应用于晶圆级封装领域的新兴纵向互连技术,有望实现芯片之间距离最短、间距最小的互联。
-
芯片
+关注
关注
463文章
54632浏览量
470940 -
工艺
+关注
关注
4文章
725浏览量
30430 -
玻璃基板
+关注
关注
1文章
106浏览量
11109 -
TSV
+关注
关注
4文章
139浏览量
82828
原文标题:什么是TGV和TSV技术
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
TSV技术的关键工艺和应用领域

TSV工艺流程与电学特性研究

玻璃基板时代,TGV技术引领基板封装
TGV2566-SM MMIC VCO
TSV关键工艺设备及特点
TSV的工艺流程和关键技术综述
先进封装之TSV及TGV技术初探(二)
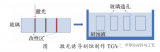
开启高性能芯片新纪元:TSV与TGV技术解析

玻璃通孔(TGV)技术深度解析
TSV以及博世工艺介绍

TSV和TGV产品在切割上的不同难点




 TGV和TSV技术的主要工艺步骤
TGV和TSV技术的主要工艺步骤



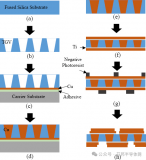




评论