来源:新材料纵横
导读:
自集成电路诞生以来,摩尔定律一直是其发展的核心驱动力。根据摩尔定律,集成电路单位面积上的晶体管数量每18到24个月翻一番,性能也随之提升。然而,随着晶体管尺寸的不断缩小,制造工艺的复杂度和成本急剧上升,摩尔定律的延续面临巨大挑战。例如,从22纳米工艺制程开始,每一代技术的设计成本增加均超过50%,3纳米工艺的总设计成本更是高达15亿美元。此外,晶体管成本缩放规律在28纳米制程后已经停滞。
在传统二维芯片设计中,芯片的工作区和引线普遍采用平面布局,这种设计限制了芯片之间的高频信号传输,因为互连线过长导致信号延迟大。为突破这一瓶颈,20世纪80年代,随着超微加工技术的发展,三维封装(3D封装)技术应运而生。3D封装通过在单一芯片上构建多层电路,利用绝缘层隔离各层电路,并通过穿孔实现层间互连,从而在不增加芯片平面空间的前提下,显著提升集成度,缩短信号传输路径。
三维封装技术
近年来,3D封装技术取得了重大突破。英特尔在2022年的IEEE国际电子器件会议上展示了其3D封装技术的新进展,该技术可将互连密度再提升10倍。英特尔的Foveros技术是一种3D堆叠芯片技术,能够以垂直方式堆叠计算模块,优化成本和能效。此外,英特尔还通过混合键合技术将互连间距微缩到3微米,实现了与单片式系统级芯片相似的互连密度。
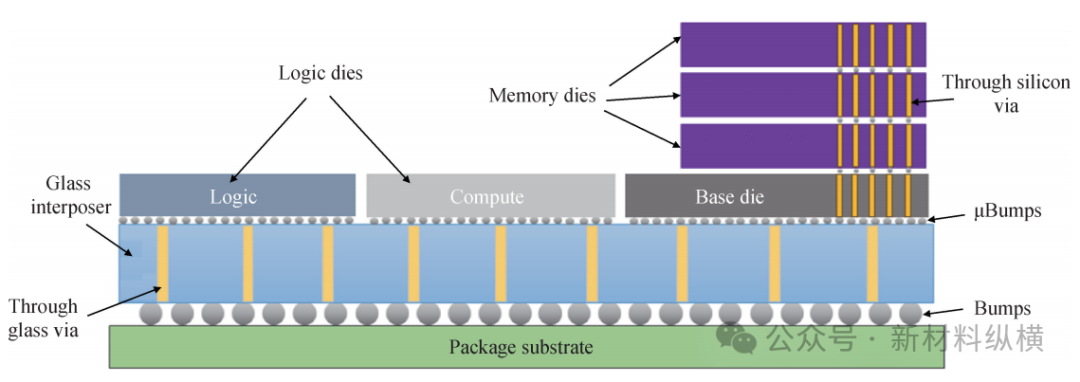
芯片3D封装结构示意图
玻璃基板
玻璃因具有热膨胀系数低、电气绝缘性能好等优势,被芯片设计开发者引入芯片封装领域作为封装基板使用。玻璃基板为芯片提供了稳定的支撑平台,可确保封装过程中芯片不会因基板变形或不平坦而受损。
目前,芯片封装的基板材料主要包括有机基板、陶瓷基板和玻璃基板三种:
(1)有机基板:具有质量轻、可实现复杂电路设计、工艺流程简单、生产成本低等优点,但高温热稳定性差,易受高温影响而变形。
(2)陶瓷基板:介电性能稳定,机械性能好,能满足集成电路的需求,但制造成本较高,且不适用于对轻量化有需求的应用场景。
(3)玻璃基板:具备优异的热稳定性,能在高温环境下保持物理形态不变,同时具有优异的电气绝缘性能,能有效减少信号损耗和串扰,适合高频应用环境。玻璃基板还具备高机械强度和高平整度,能够实现高密度互连和精确的层间对准。
三种芯片封装基板材料的性能参数
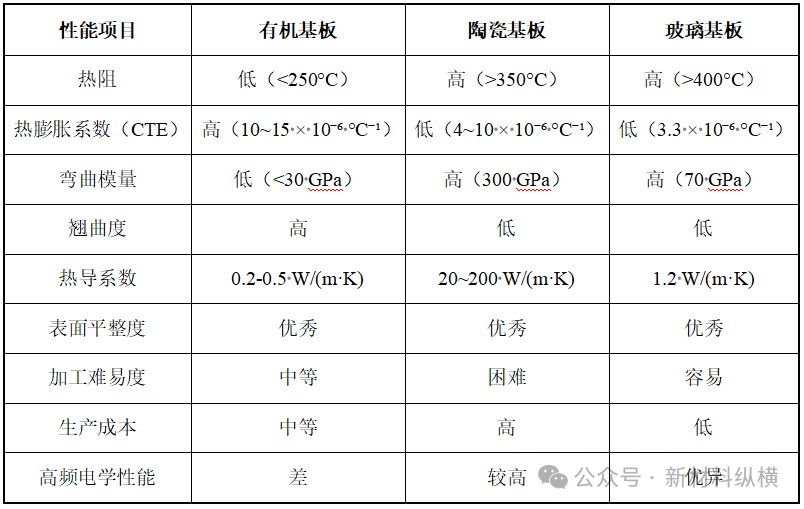
随着芯片3D封装技术的发展,硅通孔(rhrough silicon via, TSV)技术和玻璃通孔(through glass via,TGV)技术相继得到应用。早期的芯片3D封装是通过TSV技术实现的,TSV具有互连密度、电阻相对小和信号延迟低、工艺技术成熟及机械强度较好等优点,但成本高、散热管理难及加工过程中可能产生应力等问题限制了其广泛的应用。TGV因具有电绝缘性能好、高频衰减小、成本低、热膨胀系数与硅匹配等优势,现在已成功应用于射频封装、微机电系统(micro-electro-mechanical system, MEMS)封装领域,将在芯片3D封装中占据重要地位。
TSV技术和TGV技术的优缺点

玻璃基板在芯片封装中的应用
1玻璃中介层
玻璃中介层是玻璃基板一种常见应用形式,作为电气互连层,被广泛应用于高性能集成电路封装。玻璃中介层通过TGV技术实现高密度的电气连接,被认为是有机中介层和硅中介层的有力替代品。
Zhong等将金刚石直接集成到芯片背面,并与玻璃基板进行异质集成,构建了一个高效的散热系统。该研究采用纳米层Cu/Au重结晶的低温连接技术,将金刚石与硅芯片键合,并将此结构封装到玻璃基板上。玻璃基板作为中介层,其低热膨胀系数与硅芯片的良好匹配有效减少了热循环过程中产生的热应力,同时玻璃基板优异的电气绝缘性能还可有效降低信号损耗和电气干扰。
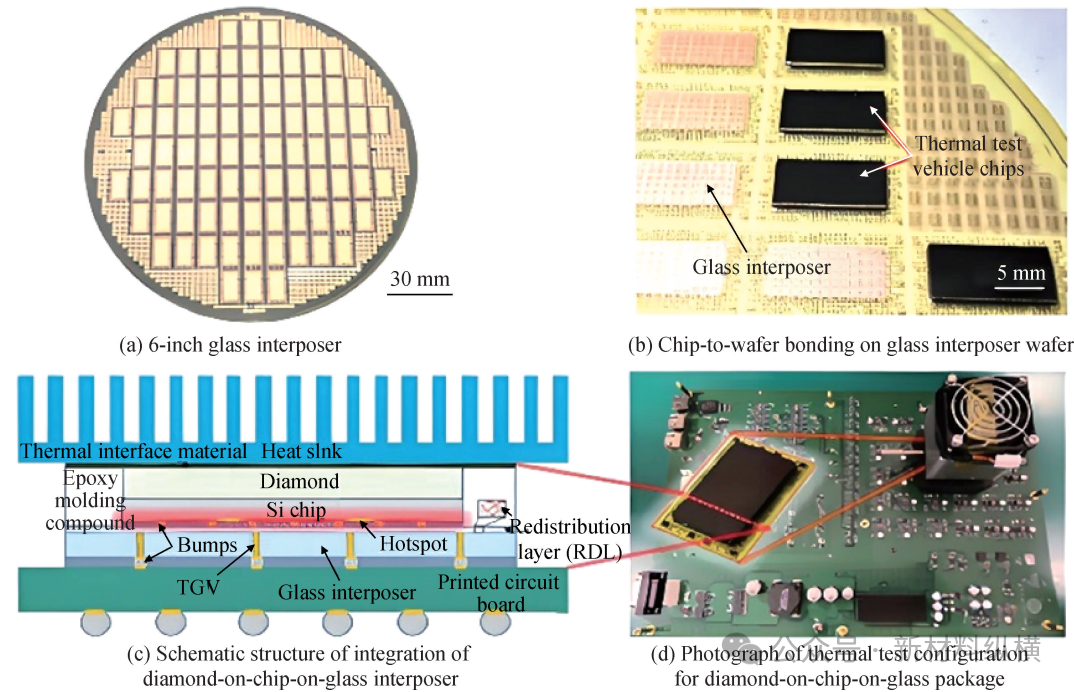
金刚石-芯片-玻璃中介层封装集成和热测试
资料来源:ZHONG Y, BAO S C, HE Y M, et al. Heterogeneous integration of diamond-on-chip-on-glass interposer for efficient thermal management[J]. IEEE Electron Device Letters, 2024, 45(3): 448-451.
2扇出型封装
扇出型封装是一种先进的半导体封装技术,通过在芯片周围重新布线,提高封装的输入/输出引脚数量密度和电性能。玻璃基板在扇出晶圆级封装和扇出面板级封装中表现出色,其低热膨胀系数、高机械强度和优异的电性能使其成为理想选择。
Liu等提出了一种基于玻璃基板嵌入技术的扇出天线封装结构,通过在单面或双面玻璃基板上嵌入再布线层技术来增加设计灵活性和改善天线辐射性能,最终得到了两种优化的天线设计,一种是具有7.6 GHz带宽和4.7 dB增益的向上辐射天线;另一种是具有5.3 GHz带宽和5.2 dB增益的向下辐射天线。玻璃基板在该创新封装中发挥了关键作用,适用于5 毫米波和其他高频通信应用。
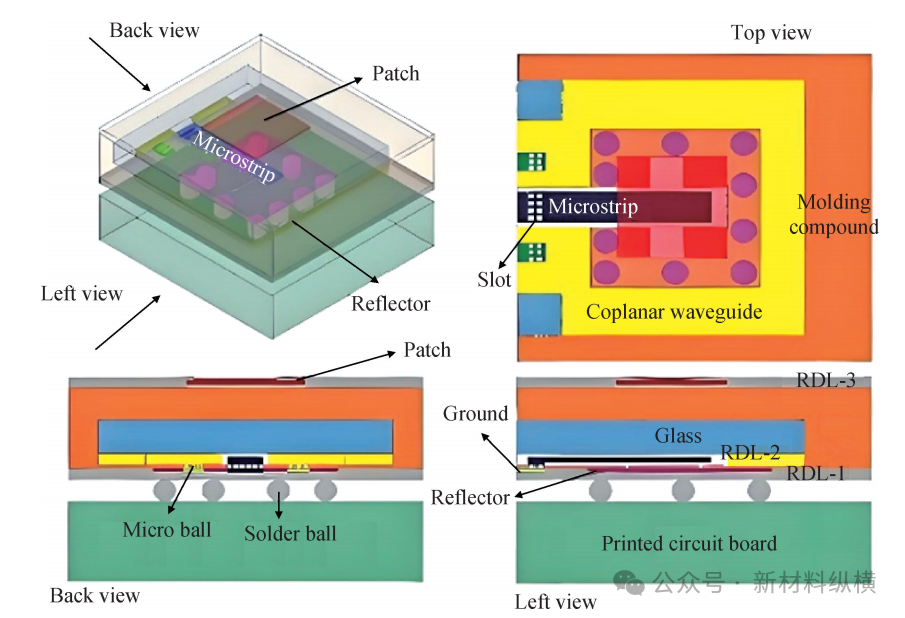
玻璃嵌入式扇出天线封装结构
资料来源: LIU C H, LU R K, CHUNG H, et al. Glass-embedded fan-out antenna-in-packaging for 5G millimeter wave applications[J]. International Journal of Integrated Engineering, 2022, 14(6): 019.
3微机电系统封装
微机电系统封装是确保器件性能和可靠性的关键技术。玻璃基板在微机电系统封装中不仅提供机械保护和电气绝缘,由于其低热膨胀系数,还在热管理方面表现出显著优势。
Szyszk等介绍了一种基于MEMS技术的微型四极质谱仪,下图展示了微型四极质谱仪的模块布局,其中关键部件采用单晶硅制造,并通过硼硅酸盐玻璃进行封装和电气绝缘。该装置通过3D打印外壳确保机械稳定性、元件对齐和电气绝缘。这项研究展示了玻璃基板作为电绝缘和结构支撑材料在MEMS器件中的应用,成功实现了小型化、便携性与合理性能的结合,适用于现场实时分析。
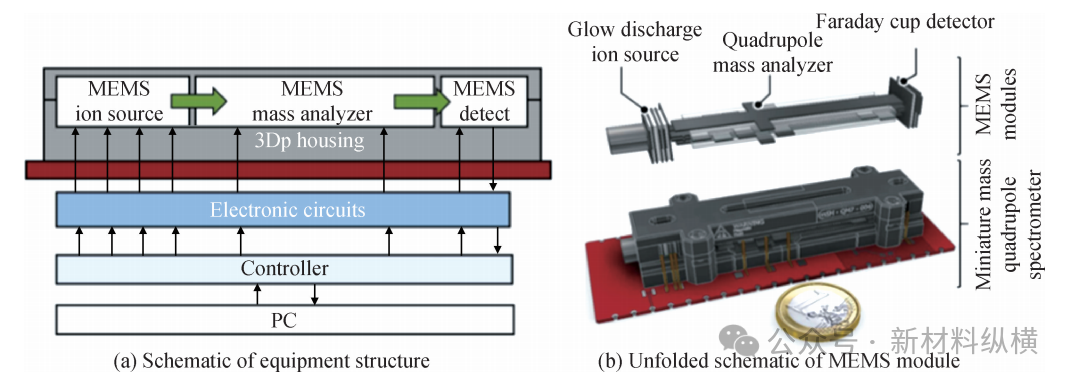
微型四极质谱仪
资料来源: SZYSZKA P, JENDRYKA J, SOBKÓW J, et al. MEMS quadrupole mass spectrometer[J]. Sensors and Actuators B: Chemical, 2024, 411: 135712.
玻璃基板成分体系及理化性能要求
1玻璃基板的成分体系
芯片封装用玻璃基板的成分体系主要包括以下三种主要类型:
1、硼硅酸盐玻璃体系
硼硅酸盐玻璃基板通常包含约80%的二氧化硅(SiO₂)和12%~13%的氧化硼(B₂O₃)。这种玻璃体系具有以下特点:
(1)耐热性好:能够在高温环境下保持稳定。
(2)热膨胀系数低:与硅芯片的热膨胀系数相匹配,减少了因热膨胀差异导致的应力和变形。
(3)化学稳定性高:在多种化学环境中表现出良好的耐腐蚀性。
2、铝硅酸盐玻璃体系
铝硅酸盐玻璃基板主要由二氧化硅(SiO₂)和氧化铝(Al₂O₃)组成,同时还包含少量的碱金属氧化物(R₂O)和碱土金属氧化物(RO)。其主要特性包括:
(1)优异的光学性能:适用于需要高透明度的应用场景。
(2)高硬度和低表面张力:能够抵抗划伤和磨损,适合高机械强度需求的封装。
(3)较低的热膨胀系数:有助于在热循环过程中保持尺寸稳定。
3、无碱铝硼硅玻璃体系
无碱铝硼硅玻璃基板不含或仅含有极少量的碱金属氧化物(通常质量分数不超过0.1%)。其主要优势包括:
(1)优异的电绝缘性能:能够有效防止电信号的干扰和泄漏,特别适合高频电子器件的封装。
(2)良好的化学稳定性:在酸、碱和有机溶剂中表现出色,能够长期保持稳定的物理和化学性能。
(3)高机械强度和低热膨胀系数:适用于需要高可靠性和尺寸稳定性的微机电系统(MEMS)器件,如加速度计、陀螺仪和压力传感器。
2玻璃基板的主要理化性能要求
玻璃基板在芯片封装中的应用对其理化性能提出了严格的要求。这些性能直接影响玻璃基板的加工和使用,进而决定了封装电子器件的整体综合性能。
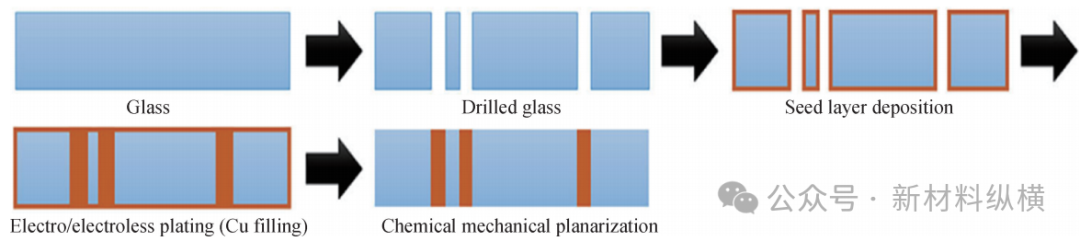
TGV制作工艺过程
玻璃基板理化性能要求

1、介电性能
介电常数:玻璃基板的介电常数应尽可能低,以减少信号延迟和寄生电容,提升高频信号传输的完整性和效率。高频应用中,低介电常数的玻璃基板更具优势。
介电损耗:介电损耗正切(tan δ)是衡量材料在电场中能量损失的指标。低介电损耗意味着信号传输过程中能量损失少,信号强度和质量更高。
2、热性能
热膨胀系数:玻璃基板的热膨胀系数应与其他封装材料(如硅芯片)相匹配,以减少热循环过程中产生的应力和变形。低热膨胀系数有助于保持封装结构的尺寸稳定性和可靠性。
热导率:玻璃基板应具有较高的热导率,以有效散热,防止芯片在工作过程中因过热而损坏。
3、化学性能
耐腐蚀性:玻璃基板应具有良好的耐化学腐蚀性能,特别是在氢氟酸等常用蚀刻剂中的稳定性。这有助于确保玻璃基板在加工和使用过程中的化学稳定性。
化学稳定性:玻璃基板在酸、碱和有机溶剂中应保持稳定的化学性能,以防止材料性能退化。
4、机械性能
密度:玻璃基板的密度应较低,以减轻封装器件的重量,同时保持足够的机械强度。
弹性模量:较高的弹性模量能够确保玻璃基板在封装过程中保持稳定,减少变形和失效风险。
硬度和耐磨性:高维氏硬度有助于提升玻璃基板的抗划伤性和耐磨性,延长使用寿命。
断裂韧性:较高的断裂韧性能够防止玻璃基板在受力时出现裂纹,确保封装的完整性和稳定性。
5、光学性能
透光率:玻璃基板应具有高透光率,以确保光信号的有效传输,特别是在光学与电子器件的封装中。
6、蚀刻性能
蚀刻速率:在玻璃通孔(TGV)加工中,适当的蚀刻速率能够确保获得高深宽比、高垂直度的通孔,同时光滑的孔壁能够降低电阻和电容效应,提升信号传输的稳定性和速度。
发展趋势
(1)优化介电性能
随着高频信号传输速率不断提高,进一步降低介电常数和介电损耗的需求愈发迫切。应考虑通过调控玻璃的微观结构来增强介电性能,从而提高玻璃基板在高频应用中的表现。
(2)提升机械性能
在频繁的热循环和高温环境下,玻璃基板需要具备更高的机械强度和抗裂性能,以确保长期使用的稳定性。如何通过材料改性或开发新的复合材料体系来增强玻璃基板的韧性和强度,仍是一个重要的技术瓶颈。
(3)改善加工工艺
尽管玻璃通孔(TGV)技术近年来备受关注,但其加工精度和表面质量仍需进一步提升。同时,现有制造工艺的高成本限制了其大规模应用的可行性。因此,优化TGV技术以提高精度并降低成本,已成为当前的关键研究方向。
-
集成电路
+关注
关注
5469文章
12740浏览量
376233 -
玻璃基板
+关注
关注
1文章
106浏览量
11108 -
芯片封装
+关注
关注
14文章
626浏览量
32435 -
三维封装
+关注
关注
0文章
5浏览量
7455
原文标题:玻璃基板在芯片封装中的应用和性能要求
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
玻璃基板时代,TGV技术引领基板封装
玻璃基板对于下一代多芯片封装至关重要
康宁计划扩大半导体玻璃基板市占 拟推出芯片封装用玻璃芯
苹果抢跑!自研AI服务器芯片选定玻璃基板,先进封装迎来终极方案?




 玻璃基板在芯片封装中的应用
玻璃基板在芯片封装中的应用

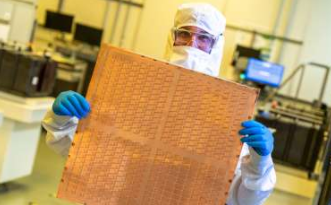
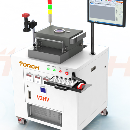
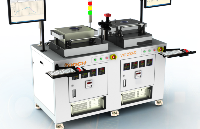

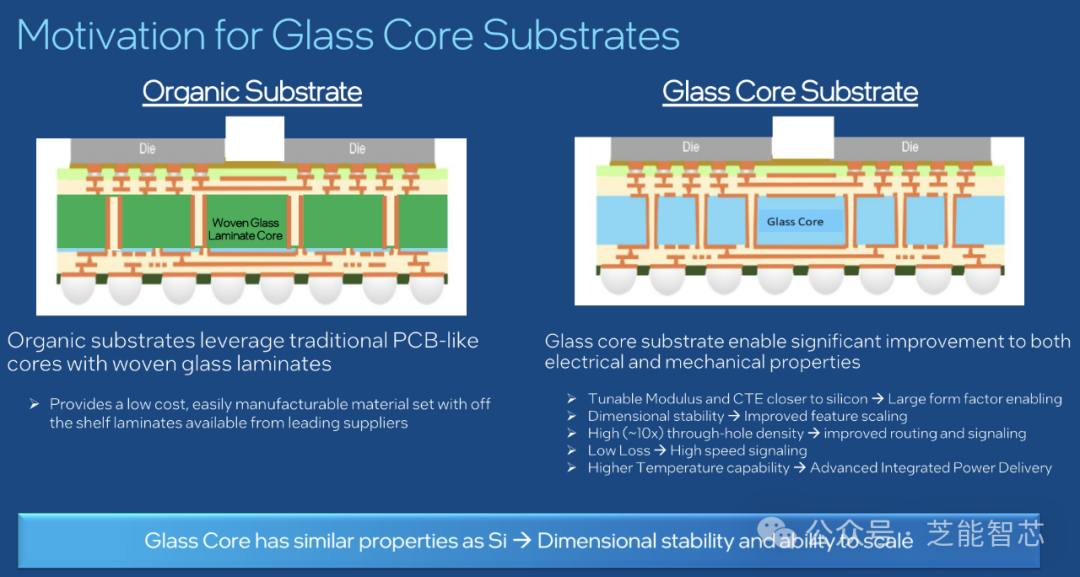







评论