氧化镓(Ga2O3 )是性能优异的超宽禁带半导体材料,不仅临界击穿场强大、饱和速度高,而且具有极高的 巴利加优值和约翰逊优值,在功率和射频器件领域具有重要的应用前景。本文聚焦于 Ga2O3射频器件,首先介绍了 Ga2O3在射频器件领域的优势和面临的挑战,然后综述了近年来 Ga2O3射频器件在体掺杂沟道、AlGaO/Ga2O3调制 掺杂异质结以及与高导热衬底异质集成方面取得的进展,并对研究结果进行了讨论,最后展望了未来 Ga2O3射频器 件的发展前景。
0 引言
超宽禁带半导体的禁带宽度大于4eV,其临界击穿场强远高于SiC和GaN,被认为是研制下一代超高耐压电力电子器件和超大功率射频器件的先进电子材料。常见的超宽禁带半导体有金刚石、氧化镓(Ga2O3)、氮化铝(AlN)、氮化硼(BN)等,然而,金刚石、AlN等绝大多数超宽禁带半导体的杂质激活能较高、掺杂难度大,限制了其在功率和射频器件领域的发展。Ga2O3是目前唯一可以容易实现高效率n型掺杂的超宽禁带半导体材料,虽然起步较晚,但随着大尺寸单晶衬底制备和n型外延掺杂技术的日益成熟,近年来在功率器件领域的发展十分迅速,其中功率器件的击穿电压已超过10kV,功率优值(P⁃FOM)最高达13.2GW/cm2,超越了GaN和SiC的理论极限,发展速度超过金刚石、AlN等其他超宽禁带半导体,有望率先实现工程化应用。
在射频器件领域,与GaN器件相比,由于Ga2O3在禁带宽度和击穿场强上的优势,Ga2O3射频器件不仅可在更高场强和更高电压下工作,大幅度提升输出功率密度,还可以实现在高温、强辐照等极端环境下的应用。由于其饱和速度较高,Ga2O3射频器件有望与GaN器件一样获得较高的截止频率。Ga2O3的约翰逊优值(JFOM)约为GaN的2.6倍,表明Ga2O3在射频器件领域也具有较大的应用潜力。美国空军研究实验室、美国纽约州立大学布法罗分校(以下简称布法罗大学)等机构已相继布局开展氧化镓射频器件的研究。根据前期研究进展,整理出Ga2O3射频器件发展技术路线如图1所示。2017年,美国空军研究实验室首次报道了Ga2O3器件的射频性能,然而,由于体掺杂Ga2O3沟道较厚,限制了栅长的进一步缩小,此外Ga2O3还存在迁移率低、热导率低等问题,制约了其在射频器件领域的发展。为了抑制器件的短沟道效应和提高电子迁移率,2019年和2021年美国俄亥俄州立大学和布法罗大学分别报道了δ掺杂和基于AlGaO/Ga2O3异质结调制掺杂结构的Ga2O3射频器件,频率性能得到显著提升。2023年和2024年南京大学和上海微系统与信息技术研究所分别报道了SiC和金刚石与Ga2O3射频器件的异质集成,器件的饱和电流密度、频率及功率性能均得到显著提升。本文围绕以上技术发展路线,主要介绍了氧化镓射频器件的国内外发展现状,并对存在的问题和发展趋势进行了分析。
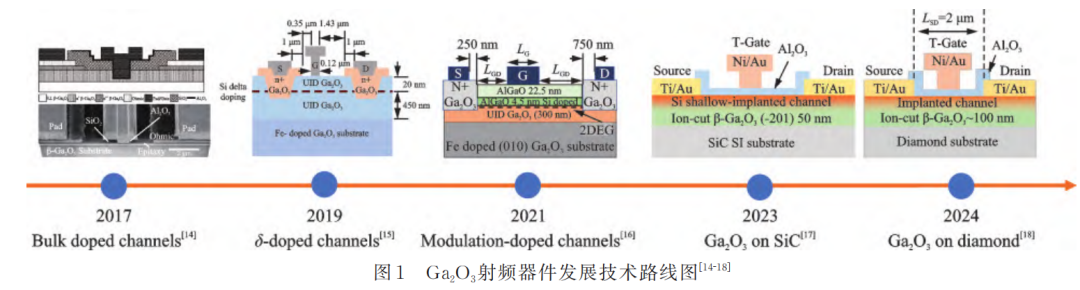
1 Ga2O3在射频器件领域的优势及面临的挑战
表 1 列出了几种常见半导体材料的物理参数, 其中 Eg 为禁带宽度,Ebr 为击穿场强,μ 为电子迁移 率,vsat 为饱和速度,λ 为热导率,ε 为相对介电常数。 可以看到 Ga2O3的 禁 带 宽 度 为 4.8 eV,临 界 击穿 场 强 高 达 8 MV/cm,是 4H⁃SiC 材 料 的 3.2 倍 ,表 明 Ga2O3在 大 功 率 器 件 领 域 更 具 有 优 势,不 仅 可 以 提 升电力电子器件的耐压,还可以提升射频器件的工 作电压,从而有望实现更大的功率。饱和速度是用 来衡量器件理论频率性能的重要指标,饱和速度越 大,载 流 子 在 沟 道 中 的 渡 越 时 间 越 短,器 件 的 截 止 频 率 越 高。Ga2O3的电子饱和速度 为 2×107cm/s, 与 SiC 相 当,是 GaN 的 80%,表明 Ga2O3 理 论 上 也 具 备 高 频 应 用 潜 力。BFOM 是衡量功率 器 件 导 通 电 阻 和 击 穿 电 压 综 合 性 能 的 参 数,正 比 于 迁 移 率, 同 时 正 比 于 击 穿 场 强 的 立 方,故 击 穿 场 强 对 器 件 BFOM 的 贡 献 要 远 高 于 迁 移 率 ,因 此 虽 然 Ga2O3 的 迁 移 率 远 低 于 SiC 和 GaN,但 却 获 得 了 更 高 的 BFOM 值 ,达 到 了 SiC 的 10 倍 。 JFOM 与 材 料 的 击 穿 场 强 和 载 流 子 的 饱 和 速 度 的 乘 积 有 关,综 合 考 虑 了 射 频 器 件 的 频 率 和 功 率 特 性,是 衡 量 射 频 器 件 综 合 性 能 最 重 要 的 指 标。 Ga2O3 的 JFOM 值 为 2844,分 别 是 SiC 和 GaN 的 10 倍 和 2.6 倍, 表 明 Ga2O3 在 射 频 器 件 领 域 也 具 有 潜 在 的 应 用 价 值。
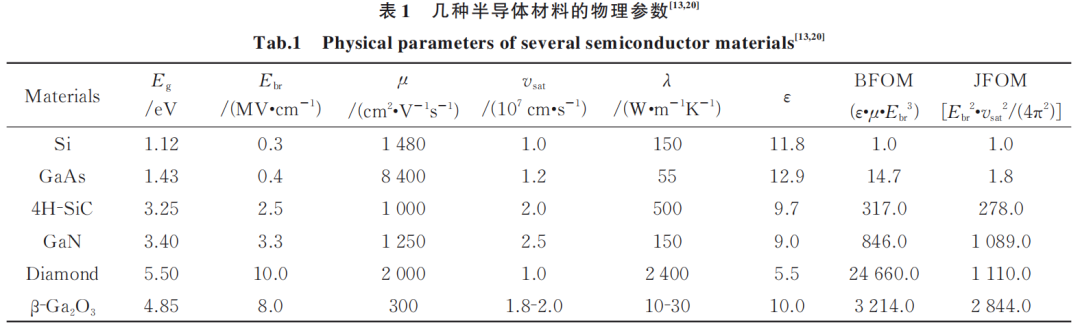
早在 2017 年,美国海军研究实验室(NRL)就对 Ga2O3器件的应用前景进行了研究和分析。他们 认 为 ,由 于 Ga2O3 的 饱 和 电 子 速 度 较 大 ,理 论 上 Ga2O3 射 频 器 件 也 可 以 获 得 较 高 的 截 止 频 率。 然 而,由 于 其 热 导 率 极 低,器 件 将 面 临 严 重 的 自 热 效 应,限 制 了 其 在 高 频、高 功 率 下 的 应 用。他 们 绘 制 了 几 种 半 导 体 材 料 应 用 领 域 的 功 率-频 率 图,如 图 2 所示,Ga2O3器件的工作频率范围与 SiC 器件 相当,但功率有望提升一个数量级,从 1 kW 提升至 10 kW。
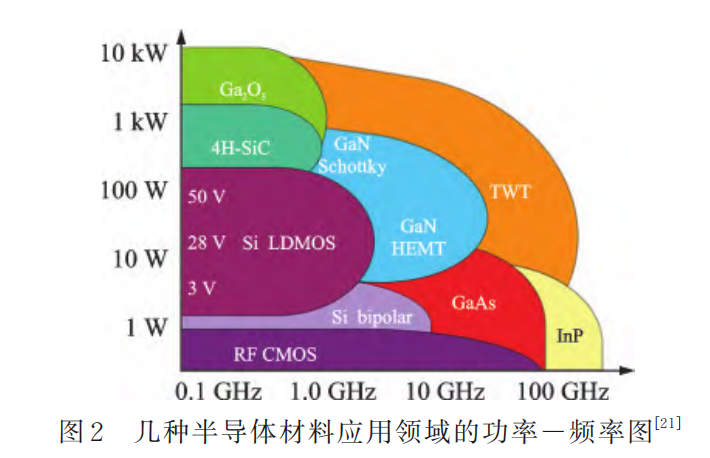
然而,由于短沟道效应、迁移率低、热导率低等 因 素 的 制 约,目 前 Ga2O3 射 频 器 件 的 电 流 密 度、频 率、功 率 密 度 等 性 能 指 标 仍 然 处 于 较 低 的 水 平,发 展面临着高难度的挑战。
首 先,与 电 力 电 子 器 件 相 比,射 频 器 件 的 栅 长 更 短,对 沟 道 厚 度 和 掺 杂 浓 度 的 精 准 调 控 要 求 更 高。GaAs、GaN 射频器件的成功离不开其高迁移率 的 二 维 电 子 气(Two ⁃ dimensional electron gas, 2DEG)沟道,由于载流子的输运被限制在超薄的 量 子 阱 中,器 件 的 短 沟 道 效 应 得 到 有 效 抑 制。而 Ga2O3难以获得如此高性能的 2DEG 沟道,美国布法 罗 大 学 虽 然 通 过 AlGaO/Ga2O3 调 制 掺 杂 技 术 获 得 了 2DEG 沟道,有效抑制了器件的短沟道效应,将器 件的截止频率提升至 30 GHz,但由于 2DEG 的浓度 和 迁 移 率 较 低,器 件 的 电 流 密 度 仅 为 74 mA/mm, 限 制 了 其 在 射 频 器 件 上 的 应 用。目 前 更 多 的 是 采 用 外 延 掺 杂 的 沟 道 ,沟 道 层 厚 度 普 遍 在 50~ 200 nm,缩 短 栅 长 容 易 产 生 短 沟 道 效 应,从 而 降 低 栅对沟道载流子的调控能力和器件的频率特性。
其次,Ga2O3的电子迁移率低,不管是传统体掺 杂还是调制掺杂,迁移率普遍低于200cm2/(V⋅s), 较 AlGaN/GaN 异质结的 2DEG 迁移率低了一个数 量 级。低 迁 移 率 导 致 器 件 难 以 在 低 电 场 下 获 得 较 高的电子饱和速度,从而限制了器件的跨导和频率 性 能 。 此 外 ,低 迁 移 率 还 会 增 大 沟 道 方 阻 ,目 前 Ga2O3 的 沟 道 方 阻 普 遍 大 于 5 kΩ/sq,是 AlGaN/ GaN 异质结的 10 倍以上,给射频器件引入了较高的 栅源和栅漏串联电阻,从而降低了器件的电流密度和频率特性。
再 次,射 频 器 件 不 仅 特 征 尺 寸 小,而 且 功 率 密 度高,如果散热不好会导致器件在工作时结温急剧 上 升,饱 和 电 流 和 功 率 发 生 退 化,因 此 对 器 件 散 热 能力有着极高的要求。然而,Ga2O3的热导率极低, 仅为 10~30 W/(m·K),远低于 SiC 和 GaN。随着功 率密度的提升,散热已成为 GaN 射频器件需要进一 步解决的问题,对于热导率更低的 Ga2O3射频器件, 其 面 临 的 散 热 问 题 将 更 为 严 峻,严 重 制 约 了 Ga2O3 在射频器件领域的发展。
2 基于体掺杂沟道的Ga2O3射频器件
早期对 Ga2O3射频器件的研究主要基于传统体 掺 杂 Ga2O3外 延 材 料,即 在 半 绝 缘 衬 底 上 同 质 外 延 体 掺 杂 的 Ga2O3沟 道 层,或 者 通 过 离 子 注 入 技 术 在 非故意掺杂 Ga2O3外延层中形成掺杂沟道。体掺杂 的 沟 道 厚 度 普 遍 在 50 nm 以 上 ,当 栅 长 缩 短 至200 nm 以 下 时,器 件 将 面 临 严 重 的 短 沟 道 效 应,制 约频率性能的提升。2017 年,美国空军研究实验室 (ARFL)首次报道了 Ga2O3器件的射频性能。采 用 金 属 有 机 气 相 外 延(Metal ⁃ organic vapor phase epitaxy,MOVPE)技术在(100)晶向半绝缘 Ga2O3衬 底上生长了一层 180 nm 厚的 Ga2O3沟道层,Si 掺杂 浓度为 1×1018cm-3。由于沟道较厚,采用挖槽技术 将栅下沟道减薄至 90 nm 左右,并制备了 SiO2介质 辅助的 T 型栅,栅长 0.7 µm,器件结构和性能如图 3 所 示。栅 下 挖 槽 技 术 有 效 提 升 了 器 件 栅 长 与 有 源 层沟道厚度的比值,峰值跨导达到 21 mS/mm,在栅 压 VGS=-8 V 时表现出良好的关断特性,开关比达 到 106 ,表明短沟道效应得到了有效抑制。然而,栅 下 挖 槽 增 大 了 沟 道 电 阻,器 件 饱 和 电 流 密 度 仅 为 150 mA/mm。器 件 的 截 止 频 率 fT 和 最 大 振 荡 频 率 fmax分别为 3.3 GHz 和 12.9 GHz,其中 fT较低可能与 介 质 辅 助 T 型 栅 引 入 了 较 高 的 寄 生 电 容 有 关。对 该 器 件 在 800 MHz 频 率 下 进 行 了 连 续 波 功 率 输 出 特 性 测 试,在 漏 极 偏 置 VDS=25 V 下 的 功 率 密 度 为 230 mW/mm。栅下挖槽技术有效提升了器件的栅 控 能 力,但 也 降 低 了 饱 和 电 流 密 度。此 外,刻 蚀 过 程 中 可 能 产 生 刻 蚀 损 伤,引 入 较 高 密 度 的 界 面 态, 从而影响器件的射频性能。

2020 年 ,AFRL 直 接 在 65 nm 薄 沟 道 的 Ga2O3 外延材料上研制了 0.5 µm 栅长的射频器件,如图4所示 ,饱 和 电 流 密 度 和 跨 导 分 别 提 升 至 300 mA/mm 和 40 mS/mm,fT 达 到 了 4.2 GHz。在 1 GHz 频率下对器件进行了功率输出性能测试,脉 冲 模 式 下 输 出 功 率 密 度 达 715 mW/mm,然 而 在 连 续波下仅为 213 mW/mm,表明 Ga2O3射频器件即使 在低频和低功率密度下也存在严重的自热效应,严 重 制 约 了 器 件 的 功 率 性 能。同 时 也 研 究 了 器 件 的 脉冲 I⁃V 特性,当漏极静态偏置电压为 0 V 时,器件 的 饱 和 电 流 密 度 达 到 了 300 mA/mm 以 上,栅 极 静 态偏置电压对电流的影响不大,但当漏极静态偏置 电压增大至 20 V 时,器件出现了严重的电流崩塌,导 通电阻急剧上升,饱和电流密度下降至 200 mA/mm, 表明漏极应力导致了器件的电流崩塌,这也是器件 输出功率密度低于预期的主要原因之一。
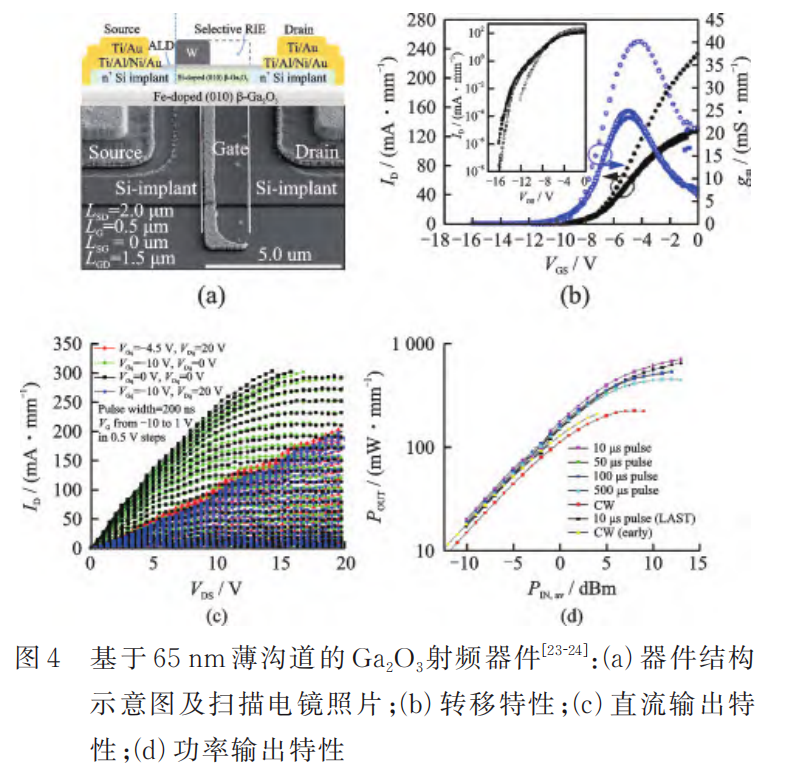
同年,日 本 国 立 信 息 通 信 技 术 研 究 所(NICT) 通过 Si 离子注入技术在非故意掺杂(Unintentional⁃ ly doped,UID)Ga2O3外延材料上形成了 70 nm 厚的 薄 层 沟 道,Si 掺 杂 浓 度 约 为 4.8×1018cm-3,并 采 用 T 型栅技术制备了栅长 50 nm 至 1 μm 的 Ga2O3射频 器件,器件结构和性能如图 5 所示。200 nm 栅长 器件的饱和电流密度 250 mA/mm,由于沟道较厚,阈 值 电 压 达 到 了 -24 V,fT 和 fmax 分 别 为 9 GHz 和 27 GHz。对 不 同 栅 长 器 件 的 频 率 特 性 进 行 了 对 比 和分析,当栅长(L G)大于 200 nm 时,频率性能随着 栅长的缩短而增大并达到饱和,进一步缩短栅长至 200 nm 以 下 时 ,频 率 性 能 反 而 出 现 了 下 降 ,表 明 200 nm 以下栅长的器件面临着严重的短沟道效应, 限制了器件频率性能的提升。因此,沟道厚度决定 了 Ga2O3射 频 器 件 的 最 小 栅 长,要 获 得 高 的 频 率 特 性,沟道厚度需要随栅长的缩短而等比例减薄。
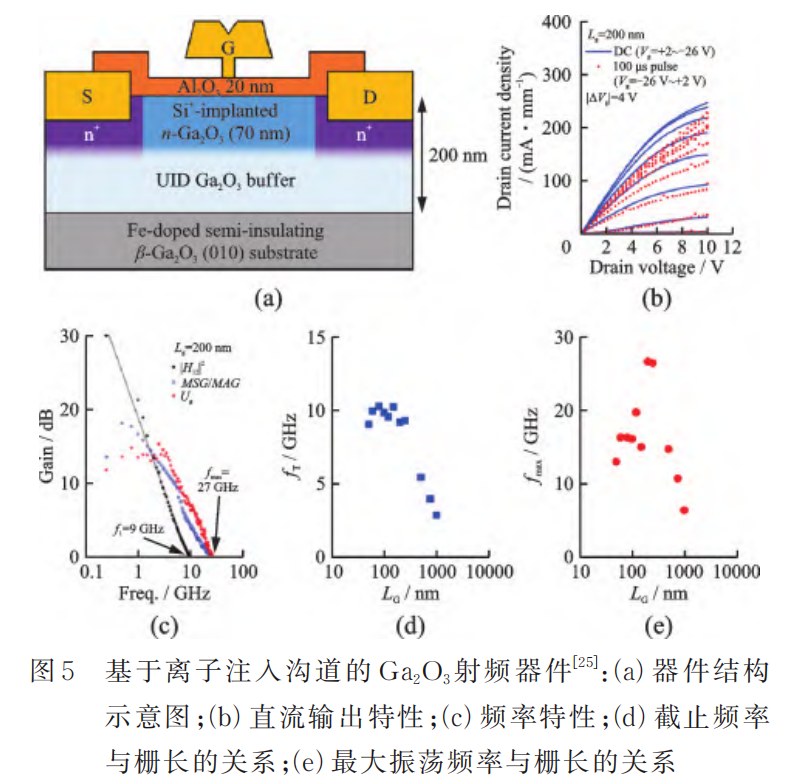
2023 年,美国布法罗大学也报道了 60 nm 薄沟 道 的 Ga2O3 射 频 器 件 ,沟 道 掺 杂 浓 度 为 9.2× 1017cm-3,器 件 采 用 了 20 nm 厚 的 SiO2 栅 介 质 和 175 nm 栅长的 SiN 介质辅助 T 型栅,器件结构和性 能如图 6 所示。该器件电流密度 285 mA/mm,阈 值电压仅为-4 V,未出现明显的短沟道效应,跨导 52 mS/mm,击穿电压高达 192 V,对应的击穿场强 达到 5.4 MV/cm,fT和 fmax分别为 11 GHz 和 48 GHz, 表 现 出 优 异 的 直 流 和 频 率 特 性。由 于 采 用 介 电 常 数相对较高的 SiN 介质对 T 型栅进行了保护,增大 了器件的栅源和栅漏寄生电容,导致器件的 fT较低。 由 于 其 单 指 栅 宽 仅 为 20 μm,大 幅 度 降 低 了 器 件 的 栅阻,从而获得了较高的 fmax。

近年来,国内也逐步开展了氧化镓射频器件的研究。2020 年,河北半导体研究所也报道了基于 体 掺 杂 沟 道 的 Ga2O3 射 频 器 件 ,其 材 料 结 构 包 含 (010)晶向半绝缘 Ga2O3衬底、500 nm UID Ga2O3缓 冲层以及 200 nm 厚的沟道层。由于外延较厚,为 了提升器件的栅控能力和降低器件的关态漏电,开 发 了 栅 下 氧 气 退 火 技 术,有 效 抑 制 Ga2O3缓 冲 层 中 的背景载流子浓度,提升了器件的关断特性和频率 性 能 。 1 µm 栅 长 的 Ga2O3 器 件 的 饱 和 电 流 密 度 200 mA/mm,fT和 fmax分别达到 1.8 GHz 和 4.2 GHz。 在 1 GHz 频率下进行了功率输出性能测试,脉冲和 连 续 波 下 的 输 出 功 率 密 度 分 别 为 0.43 W/mm 和 0.4 W/mm。
2022 年,针对体掺杂沟道器件栅长缩短后栅控 能 力 减 弱、短 沟 道 效 应 严 重 等 问 题,南 京 电 子 器 件 研 究 所 联 合 南 京 大 学 将 三 维 栅 工 艺 用 于 射 频 器 件 中,通过三维栅来提升栅电极对沟道载流子的调控 能 力,从 而 提 高 器 件 的 跨 导 和 频 率 特 性,如 图 7 所示。与平面型器件相比,三维栅射频器件的 fT从 4.5 GHz 提 升 至 5.4 GHz,fmax 从 7.2 GHz 提 升 至 11.4 GHz,提 升 幅 度 分 别 达 到 了 20% 和 58%,表 明 三 维 栅 结 构 可 以 通 过 提 升 器 件 的 跨 导 和 抑 制 器 件 的短沟道效应来提升射频器件的频率特性。然而, 三维栅会引入较高的寄生电容,影响器件的频率特 性,因此该三维栅器件的频率特性依然低于薄沟道 器件。
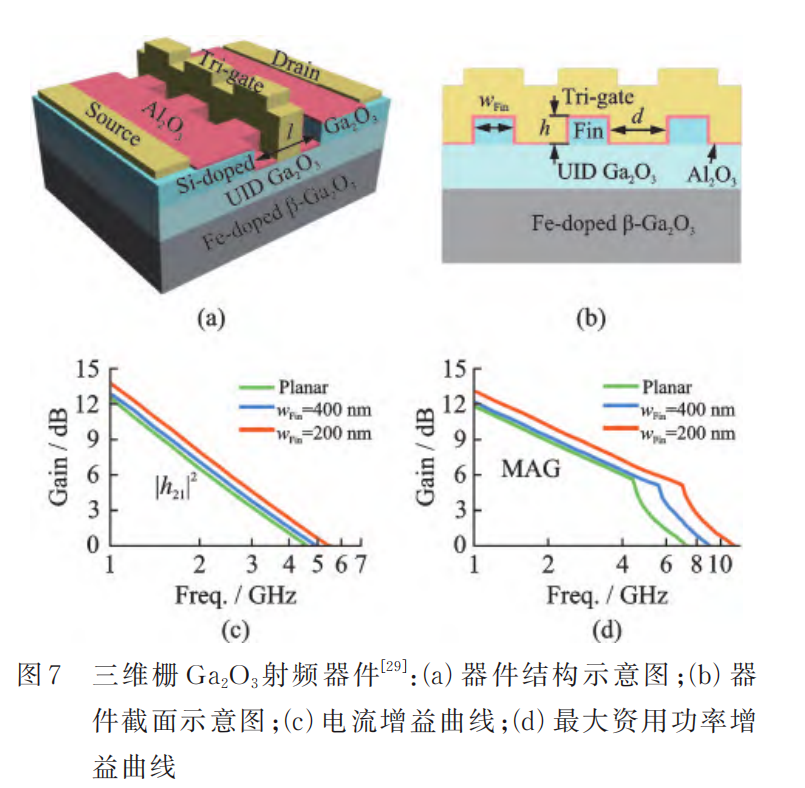
为了进一步降低沟道厚度,抑制器件的短沟道 效应,南京电子器件研究所又联合南京大学等单位 开 展 了 Ga2O3上 超 浅 离 子 注 入 沟 道 技 术 的 研 究。 通过低能量的 Si 离子注入,在 Ga2O3上实现了超薄 的 导 电 沟 道,通 过 C⁃V 提 取 得 到 沟 道 电 子 分 布 与 2DEG 类似,电子面密度高达 3.2×1013cm-2,主要分 布在距 Ga2O3表面 10 nm 范围内。基于该沟道研制 的 Ga2O3射频器件结构和性能如图 8 所示,得益于其 超薄的沟道,即使栅长缩短至 0.15 μm,器件也未出 现 明 显 的 短 沟 道 效 应 。 该 器 件 电 流 密 度 165 mA/mm,fT 和 fmax 分 别 为 29 GHz 和 35 GHz,击 穿 电 压 高 达 193 V,考 虑 到 栅 漏 间 距 仅 为 0.93 μm, 栅漏击穿场强达到了 2.07 MV/cm,展现出 Ga2O3射 频器件高耐压的优势。

通过以上研究结果可以看出,如何随着栅长的 缩 短 来 等 比 例 减 薄 Ga2O3 沟 道 厚 度 是 抑 制 体 掺 杂 Ga2O3射频器件短沟道效应和提升器件频率特性的 关 键 。 目 前 ,通 过 外 延 掺 杂 形 成 的 沟 道 普 遍 在 50 nm 以上,而通过低能离子注入技术可以在 Ga2O3 表面形成 10 nm 厚的沟道,为 Ga2O3射频器件的沟道 设计提供了一个新的思路。此外,在功率性能研究 中 也 发 现,基 于 同 质 衬 底 的 Ga2O3射 频 器 件 面 临 着 严 重 的 自 热 效 应 ,严 重 制 约 了 器 件 的 功 率 输 出 性能。
3 基于二维电子气沟道的Ga2O3射频器件
GaAs、GaN 射频器件的成功离不开其高迁移率 2DEG 沟 道,2DEG 不 仅 迁 移 率 高,而 且 厚 度 极 薄, 可以有效抑制器件的短沟道效应。为发展 Ga2O3射 频 器 件,国 外 开 展 了 Ga2O3上 2DEG 沟 道 制 备 技 术 的研究。研究发现,通过在 AlGaO 势垒层中进行 δ 调制掺杂(如图 9 所示),可在 AlGaO/Ga2O3异质结 界面实现 2DEG 沟道。由于杂质离化后产生的电子 进 入 了 异 质 结 量 子 阱 中,降 低 了 离 化 杂 质 散 射,因 此可以获得比传统体掺杂更高的迁移率。2018 年, 美 国 俄 亥 俄 州 立 大 学 首 次 报 道 了 AlGaO/Ga2O3 调 制 掺 杂 结 构 材 料,室 温 下 2DEG 面 密 度 2.25× 1012cm-2,迁 移 率 180 cm2/(V·s),在 50 K 低 温 下 迁 移率大幅度提升至 2 790 cm2/(V·s),表明声子散射 是制约 Ga2O3室温迁移率的主要因素。由于电子浓 度 较 低,器 件 表 现 出 增 强 型 特 性,饱 和 电 流 密 度 也 仅为 46 mA/mm,0.7 μm 栅长器件的 fT和 fmax分别为 3.1 GHz 和 13.1 GHz。
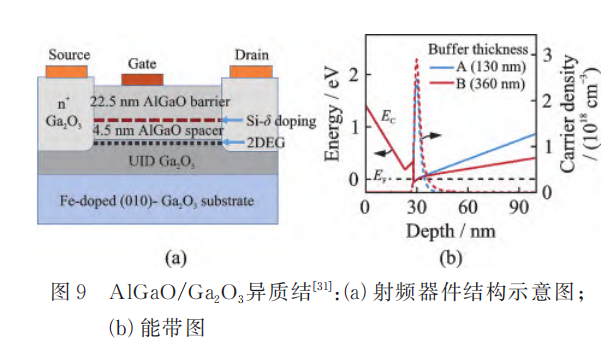
2021 年 ,美 国 布 法 罗 大 学 也 报 道 了 AlGaO/ Ga2O3调制掺杂结构的射频器件,如图 10 所示,该 器件同样表现出了增强型,160 nm 栅长的射频器件 虽 然 饱 和 电 流 密 度 仅 为 74 mA/mm,但 跨 导 高 达 64 mS/mm,fT和 fmax分别高达 30 GHz 和 37 GHz,表 明栅极对 2DEG 的调控能力要远高于体掺杂沟道, 有效抑制了短栅长器件的短沟道效应,器件的频率 性能得到了大幅度提升。该结果充分展现出 Ga2O3 调制掺杂结构材料在研制射频器件方面的优势,未 来 有 望 用于 更 高 频 率 的 射 频 器 件 中。另 外 需 要 指出的是,调制掺杂结构材料可以直接在 AlGaO 势垒 层上制备肖特基栅电极,可以避免在生长栅介质时 引 入 新 的 界 面 态,这 对 射 频 器 件 也 至 关 重 要,因 此 肖特基栅也是该器件结构的一大优势。然而,目前 调 制 掺 杂 结 构 材 料 面 临 的 最 大 问 题 是 电 子 浓 度 和 迁移率均低于预期,严重限制了器件的直流和射频性能。
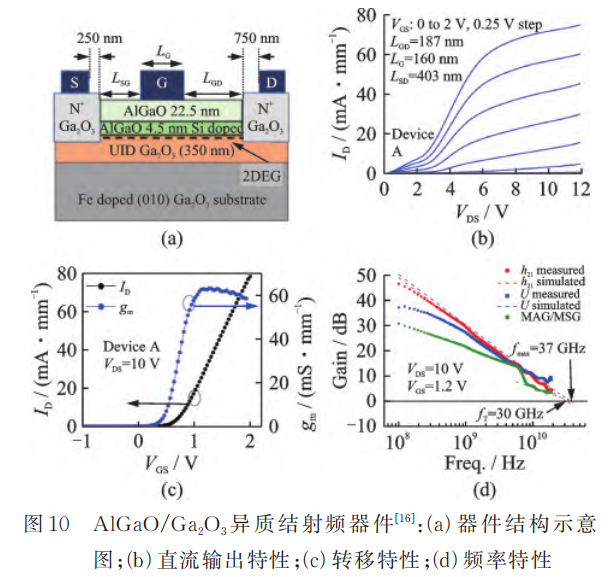
2019 年,美国俄亥俄州立大学采用分子束外延 (Molecular beam epitaxy,MBE)技术在 Fe 掺杂半绝 缘 Ga2O3 衬 底 上 生 长 了 δ 掺 杂 的 外 延 层,并 研 制 了 120 nm 栅长的射频器件,如图 11 所示。通过 C⁃V 提取了沟道电子浓度,其分布类似于异质结 2DEG, 面密度高达 9.9×1012cm-2,远高于 AlGaO/Ga2O3异 质 结,饱 和 电 流 密 度 也 因 此 提 升 至 260 mA/mm,fT 和 fmax 分 别 达 到 27 GHz 和 16 GHz。其 中 fT 与 异 质 结射频器件接近,但 fmax却出现了大幅度下降,这可 能与其制备的 T 型栅截面积小、栅阻大有关。
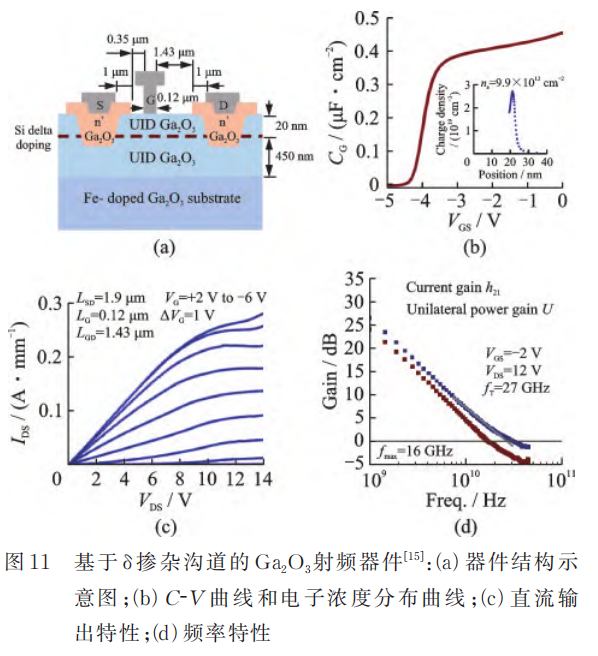
通过采用 AlGaO/Ga2O3异质结调制掺杂或者 δ 掺杂技术均可实现 2DEG 沟道,与体掺杂沟道相比 具有更高的电子迁移率和更薄的沟道厚度,是研制 Ga2O3射频器件的理想方法。异质结调制掺杂材料 的电子面密度目前还比较低,导致器件的饱和电流 密度较小;而 δ 掺杂的沟道由于电子面密度更高,器件的饱和电流密度得到了显著提升。然而,由于受 到声子散射的制约,Ga2O3中形成的 2DEG 在室温下 的迁移率依然低于 200 cm2/(V·s),较传统体掺杂沟 道未展现出明显优势,制约了器件的频率特性。
4Ga2O3射频器件的异质集成技术
射 频 器 件 特 征 尺 寸 小、功 率 密 度 高,热 效 应 要 远 超 电 力 电 子 器 件。而Ga2O3的 热 导 率 极 低,仅 为SiC的2%~6%,Ga2O3射频器件将面临严重的自热 效应。采用高导热的衬底与Ga2O3异质集成是解决Ga2O3射 频 器 件 散 热 问 题 的 有 效 方 法,同 时 利 用 异 质 结 的 能 带 结 构 可 以 将 电 子 束 缚 在Ga2O3薄 膜 中, 从而抑制器件的短沟道效应。2019年,上海微系统 与 信 息 技 术 研 究 所 首 次 通 过 离 子 刀 技 术 实 现50.8 mm(2英 寸)(-201)晶 向Ga2O3薄 膜 与SiC衬 底的异质集成,如图12所示,表面粗糙度RMS小 于0.5 nm,X射线衍射(X⁃ray diffraction,XRD)摇摆 曲线半高宽为130 arcsec,表明异质集成后的Ga2O3薄膜的晶体质量较高,可以用于射频器件研制。
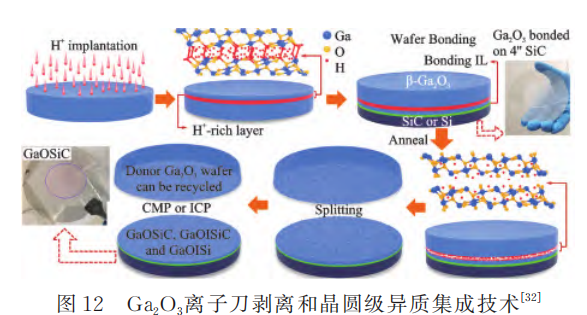
2023年,南 京 大 学 联 合 南 京 电 子 器 件 研 究 所、 上海微系统与信息技术研究所等单位,首次报道了 高导热SiC衬底与Ga2O3射频器件的异质集成,并 通过低能离子注入技术实现了超薄导电沟道,有效 抑制了Ga2O3射频器件的短沟道效应,结果如图13所示。研制的0.1 μm栅长的Ga2O3射频器件饱和电 流密度高达661 mA/mm,远高于Ga2O3同质衬底器 件。得益于高导热的SiC衬底和超薄导电沟道,器 件未出现明显的自热效应和短沟道效应,峰值跨导 高 达57 mS/mm。器 件 的fT和fmax分 别 高 达47 GHz和51 GHz,较Ga2O3衬底的射频器件得到了显著提 升。然 而,与 同 质 衬 底 器 件 相 比,该 器 件 的 击 穿 电 压从193 V大幅度下降至90 V,在2 GHz下的连续 波 输 出 功 率 密 度 为296 mW/mm,未 展 现 出 明 显 优 势,这 可 能 与 异 质 集 成 界 面 或Ga2O3薄 膜 内 部 存 在 较多的缺陷态有关,是未来异质集成技术需要重点 解决的关键问题之一。 同年,西安电子科技大学也报道了SiC衬底上 的Ga2O3射频器件,器件结构和性能如图14所示。 通 过 氢 离 子 注 入 和 剥 离 技 术 将Sn掺 杂 浓 度 为3× 1018cm-3的Ga2O3薄膜转移至SiC衬底上,并通过化 学 机 械 抛 光(Chemical mechanical polishing,CMP) 结 合BCl3干 法 刻 蚀 的 方 法 将Ga2O3薄 膜 的 厚 度 从500 nm左右减薄至100~110 nm。为了提升器件的 栅控能力和抑制短沟道效应,又进一步对栅下刻蚀 了45 nm。研 制 的180 nm栅 长 的 射 频 器 件 饱 和 电 流 密 度 高 达1.1 A/mm,fT和fmax分 别 达 到27.6 GHz和57 GHz。对器件进行了功率性能测试,2 GHz下 连 续 波 输 出 功 率 密 度 高 达2.3 W/mm,功 率 密 度 随 着工作频率的上升而下降,8 GHz下的输出功率密 度 降低 至0.7 W/mm。该 结 果 表 明 采 用 高 导 热 的SiC衬 底 与Ga2O3异 质 集 成 可 以 很 好 地 解 决Ga2O3射频器件的散热难题,器件的饱和电流密度和输出 功率密度均得到了极大提升。
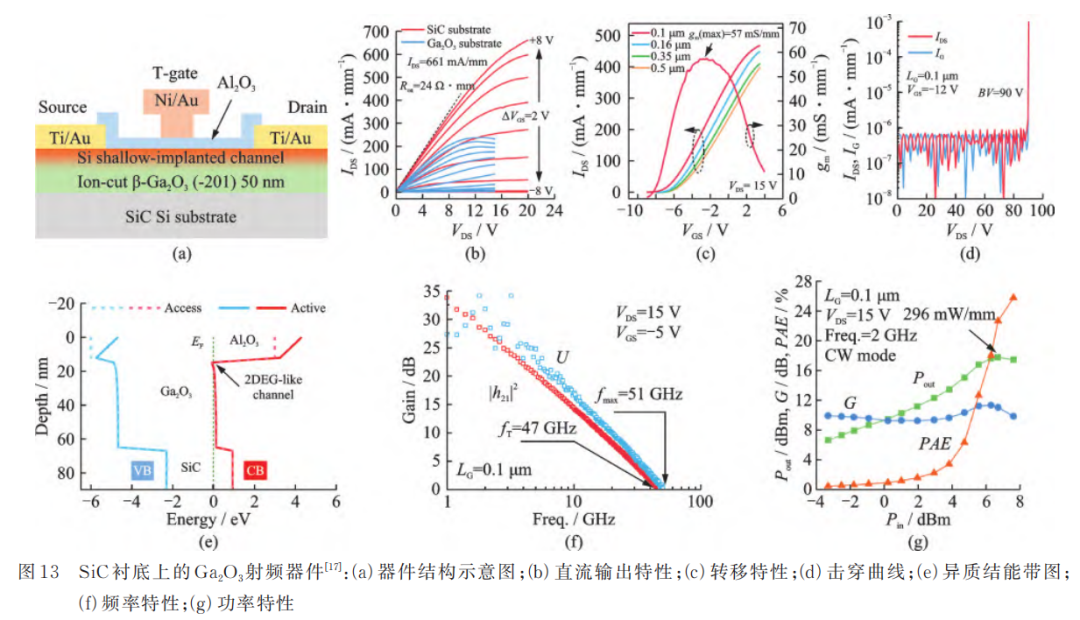
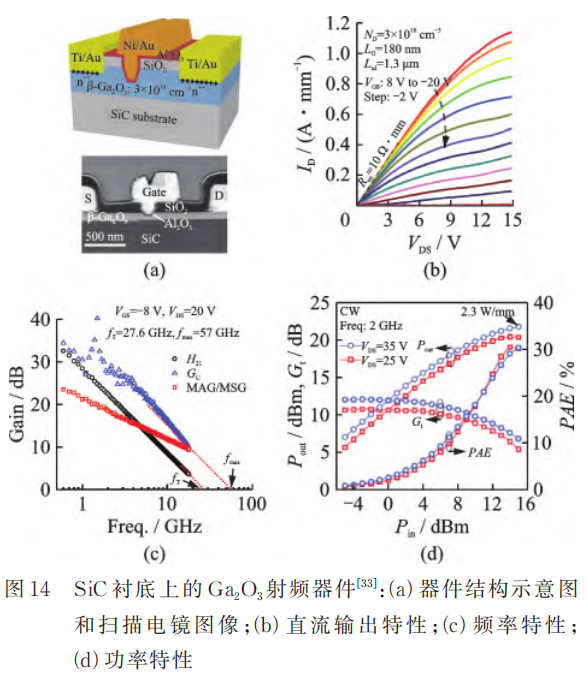
金 刚 石 不 仅 与Ga2O3同 为 超 宽 禁 带 半 导 体,而 且 其 热 导 率 高 达2 200 W/(m·K),是SiC的4倍 以 上,如果与Ga2O3器件集成,有助于进一步提升其耐 压和散热能力。2024年,上海微系统与信息技术研 究所联合南京电子器件研究所在第70届国际电子 器 件 会 议(IEDM)上 首 次 展 示 了Ga2O3薄 膜 与 高 导 热金刚石衬底的晶圆级异质集成技术,极大地提升 了Ga2O3射频器件的性能,研究结果如图15所示。0.1 μm栅 长 的 器 件 的 电 流 密 度 达 到810 mA/mm, 在 未 剥 离 寄 生 参 数 的 情 况 下,fT和fmax分 别 达 到 了34 GHz和61 GHz。由 于 金 刚 石 衬 底 的 高 热 导 率, 与Ga2O3同质衬底器件相比,热阻从62.4 K·mm/W下降至5.52 K·mm/W,结温下降了约250℃,有效解 决了Ga2O3器件散热能力差这一瓶颈问题,为Ga2O3器 件 的 热 管 理 提 供 了 晶 圆 级 解 决 方 案 ,对 推 动Ga2O3射频器件的发展具有重要的意义。
以上研究表明,与SiC、金刚石等高导热衬底异 质集成,可以有效提升Ga2O3射频器件的散热能力, 从而提高器件的饱和电流密度和功率性能。然而, 基于离子刀的异质集成技术在Ga2O3薄膜和键合界 面 处 引 入 了 陷 阱,不 仅 降 低 了Ga2O3射 频 器 件 的 击 穿 电 压,还 加 剧 了 器 件 的 电 流 崩 塌,制 约 器 件 功 率 性 能 提 升。未 来,通 过 优 化 异 质 集 成 工 艺,或 者 在 高 导 热 衬 底 上 异 质 外 延Ga2O3沟 道 有 望 解 决 以 上 问题。
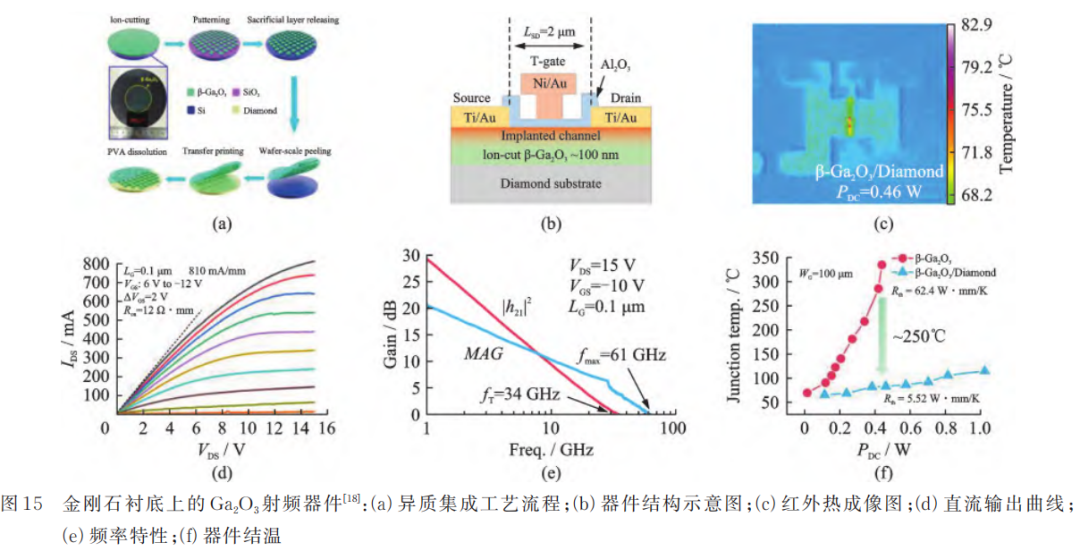
5 结束语
Ga2O3不仅禁带宽度大、击穿场强高,而且具有较高的饱和速度和约翰逊优值,在射频器件领域具有 潜 在 的 应 用 价 值。得 益 于Ga2O3超 宽 禁 带 的 优势,Ga2O3射频器件的平均击穿场强达5.4 MV/cm,超越GaN、SiC的理论极限,展现出Ga2O3在高耐压射频器件方面的巨大优势。然而,由于受到短沟道效应、迁移率低和热导率低等因素的制约,Ga2O3射频器件的发展面临着诸多挑战。近年来,国内外研究 机 构 已 对Ga2O3射 频 器 件 开 展 了 广 泛 研 究,通 过异质结、超浅离子注入等沟道技术有效抑制了器件的短沟道效应,通过与SiC、金刚石等高导热衬底异质 集 成,初 步 解 决 了Ga2O3射 频 器 件 面 临 的 散 热 难题,器件的电流密度达到了1 A/mm以上,接近GaN射 频 器 件 的 水 平。然 而,由 于 声 子 散 射 的 制 约,即使采用AlGaO/Ga2O3异质结调制掺杂结构,室温迁移率仍然低于200 cm2/(V·s),导致器件的频率特性远低于GaN射频器件,制约了Ga2O3射频器件在高频 领 域 的 发 展。因 此,鉴 于Ga2O3低 迁 移 率 和 低 热导 率 的 物 理 特 性,未 来Ga2O3主 要 聚 焦 于 低 频 率 下的射频器件,并且需要通过异质集成或异质外延等技 术 来 提 高 器 件 的 散 热 能 力。随 着 材 料 和 器 件 工艺 的 发 展,Ga2O3有 望 在 更 高 功 率 的 射 频 器 件 上 取得突破。
来源:固体电子学研究与进展
作者:郁鑫鑫 1,2;沈 睿 1,2,3;谯 兵 1,2;李忠辉 1,2,3;叶建东 4;孔月婵 2,3;陈堂胜 2,3
(1中国电科碳基电子重点实验室,南京,210016) (2南京电子器件研究所,南京,210016)
(3固态微波器件与电路全国重点实验室,南京,210016) (4南京大学 电子科学与工程学院,南京,210023)
-
半导体
+关注
关注
336文章
29985浏览量
258304 -
GaN
+关注
关注
21文章
2331浏览量
79244 -
射频器件
+关注
关注
7文章
132浏览量
26094 -
氧化镓
+关注
关注
5文章
88浏览量
10840
原文标题:氧化镓射频器件研究进展
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录





 氧化镓射频器件研究进展
氧化镓射频器件研究进展

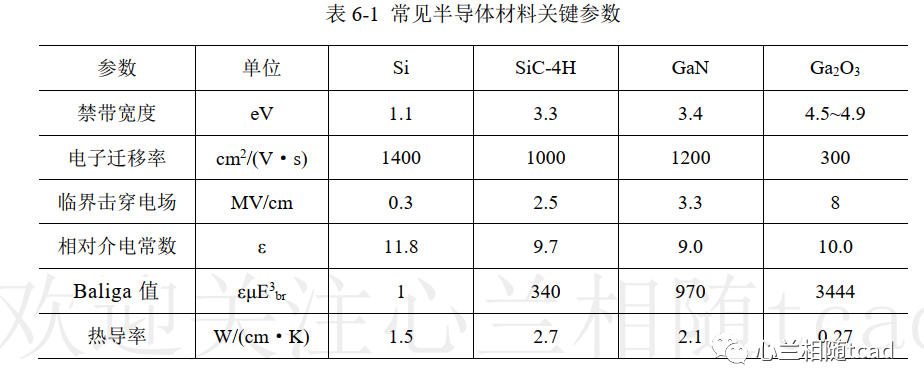











评论