文章来源:芯学知
原文作者:芯启未来
本文介绍了干法刻蚀的速率、选择比和均匀性三个评价参数。
在MEMS制造工艺中,干法刻蚀是通过等离子体、离子束等气态物质对薄膜材料或衬底进行刻蚀的工艺,其评价参数直接影响器件的结构精度和性能。那么干法刻蚀有哪些评价参数呢?
刻蚀速率
刻蚀速率是单位时间内材料被刻蚀的厚度,通常以nm/min或μm/min表示,为什么刻蚀速率是最重要的一个刻蚀指标,是因为它决定工艺效率,速率过低会延长生产周期,同时需与其他材料的刻蚀速率匹配(如掩膜层),以控制刻蚀深度。一般干法刻蚀硅衬底的速率为5~6μm/min,也就是刻蚀300μm硅槽大约需要50min,但是刻蚀速率除了与刻蚀机器设定参数和材料本身有关,还与刻蚀面积相关,因此干法刻蚀一定需要有足够的验证参数才能做到好的刻蚀形貌。
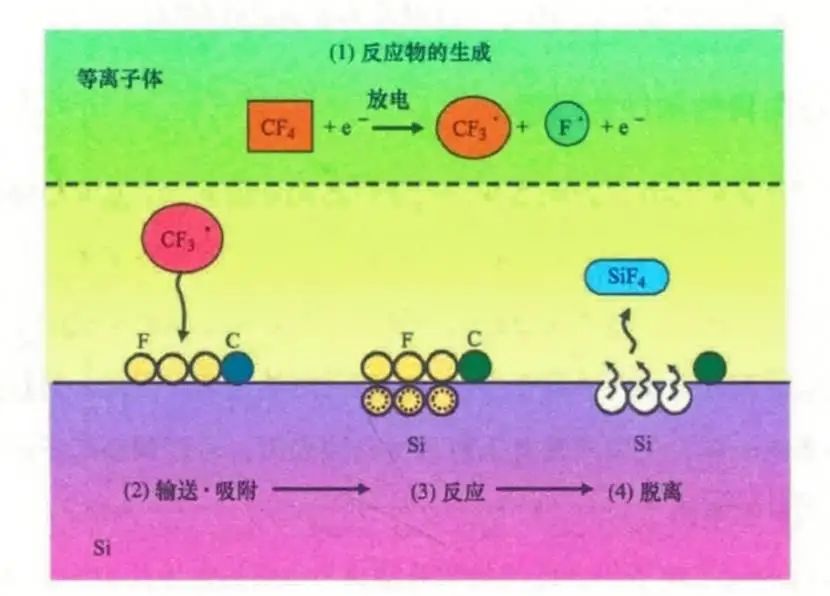
干法刻蚀过程示意图
刻蚀选择比
刻蚀选择比有两种,待刻膜与衬底的刻蚀速率比称为衬底选择比,待刻膜与掩膜的刻蚀速率比称为掩膜选择比。理想情况需要选择一种刻蚀气体,对衬底选择比低,而对掩膜选择比高,但是实际情况很难完全满足,因此需要综合衬底和待刻膜的材料性质,选择合适的刻蚀气体和掩膜。

英寸晶圆SiO2刻蚀速率面内分别
刻蚀均匀性
晶圆表面不同位置刻蚀速率的一致性,通常用偏差百分比表示。刻蚀均匀性分为片内均匀性和片间均匀性,片内均匀性是指同一晶圆上不同位置的刻蚀速率一致性,片间均匀性是指不同晶圆之间的刻蚀速率一致性。片内均匀性差会导致器件尺寸偏差,影响MEMS结构的对称性,6英寸晶圆片内均匀性通常需控制在±5%以内。片间均匀性会造成器件批次间一致性差,器件批次间精度浮动。
-
mems
+关注
关注
129文章
4534浏览量
199682 -
制造工艺
+关注
关注
2文章
216浏览量
21317 -
刻蚀
+关注
关注
2文章
225浏览量
13830
原文标题:干法刻蚀的评价参数有哪些?
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
释放MEMS机械结构的干法刻蚀技术
【转帖】干法刻蚀的优点和过程
释放MEMS机械结构的干法刻蚀技术
两种基本的刻蚀工艺:干法刻蚀和湿法腐蚀
GaN材料干法刻蚀工艺在器件工艺中有着广泛的应用

干法刻蚀之铝刻蚀的介绍,它的原理是怎样的

干法刻蚀工艺介绍
干法刻蚀和清洗(Dry Etch and Cleaning)
干法刻蚀工艺的不同参数
晶圆表面温度对干法刻蚀的影响

干法刻蚀侧壁弯曲的原因及解决方法




 干法刻蚀的评价参数详解
干法刻蚀的评价参数详解







评论