目前在全球半导体产业领域,有业界人士认为2.5D先进封装技术的芯片产品成本,未来可望随着相关产品量产而愈来愈低,但这样的假设可能忽略技术本身及制造商营运管理面的诸多问题与困境,可能并非如此容易预测新兴封装技术产品的未来价格走势。
2016-03-24 08:23:56 3645
3645 level package),2.5D封装(interposer,RDL等),3D封装(TSV)等先进封装技术。
2022-07-13 16:50:15 1339
1339 主要的技术路径。2.5D/3D封装正在加速3D互连密度的技术突破,TSV及TGV的技术作为2.5D/3D封装的核心技术,越来越受到重视。
2023-05-23 12:29:11 2878
2878 
Info封装与CoWoS封装是目前2.5D封装的典型代表,同属于TSMC开发的2.5D封装,那么如何区分 Info封装与CoWoS封装呢?主要从以下方面进行阐述。
2023-06-20 11:50:20 1098
1098 
最近,在先进封装领域又出现了一个新的名词“3.5D封装”,以前听惯了2.5D和3D封装,3.5D封装又有什么新的特点呢?还是仅仅是一个吸引关注度的噱头?
2024-01-23 16:13:29 496
496 
为适应异构集成技术的应用背景,封装天线的实现技术也应有所变化,利用封装工艺的优点以实现更佳的性能。
2024-02-29 11:11:30 157
157 
Eyes具备先进且经济实惠的2.5D视觉,可为所有领先机器人手臂增加深度感知和零件识别功能,提供无缝集成、单图校准、直观编程,同时避免了现有视觉系统的复杂性。
2020-04-18 12:03:53 2399
2399 “I-Cube4”全称为“Interposer-Cube4”,作为一个三星的2.5D封装技术品牌,它是使用硅中介层,将多个芯片排列封装在一个芯片里的新一代封装技术。
2021-05-06 10:26:18 1069
1069 `Altera & 华为5G竞赛已经全面开始报名了,即日起至6月11日截止。三大算法:1SCMA 稀疏码多址接入2F-OFDM 基础波形3Polar Code高性能纠错码技术此次
2015-05-15 14:55:56
那个大哥,大姐有altera Cyclone v系列的封装库,或是知道怎么从altera官网下载,求助啊!谢谢!知道如何自己画也行,这么多引脚的器件我真的不知该咋画了?
2016-08-18 19:04:14
华为内部资料:FPGA设计高级技巧(altera篇)以及代码书写规范FPGA是用altera多还是赛灵思的多呢altera的uniphy求altera cyclone V的原理图跟封装库在工程中使
2018-09-12 03:05:56
华为EMC资料-94页-2.5M相关课程:http://t.elecfans.com/topic/45.html
2016-01-01 19:07:15
、科技前沿的石墨烯散热技术、3D建模、AI影像识别、双卡4G……这些让人眼花缭乱的创新,合力支撑起了华为攀登新高峰的基石。今后再加上5G研发、AI应用、IoT项目等不断深入,不禁让人想到:华为,稳了
2018-10-19 16:45:11
就是在2.5 / 3D EM求解器中开始优化会话,让我的电脑在周末出汗。这似乎不可行。我已经看到一些使用Momentum描述优化的Web内容,但那是几个版本之前。据我所知(现在),我无法以参数化方式将过
2018-09-26 15:17:48
` 本帖最后由 lzr858585 于 2016-11-4 15:51 编辑
重点关注:华为Mate9及其“保时捷”限量版,量版6G+256G,售价破万RMB。2.5D面板、金属一体机身、背部
2016-11-04 15:35:01
什么是异构多处理呢?为什么需要异构多处理系统
2021-02-26 06:59:37
核心,同时可通过高速接口搭载多个功能型芯粒,基于全国产基板材料以及2.5D封装,做到算力可拓展,可用于AI推理、隐私计算、工业智能等不同场景,目前已与多家AI下游场景合作伙伴进行测试。启明930为北极
2023-02-21 13:58:08
【作者】:荀小苗;罗进文;【来源】:《电信快报》2010年02期【摘要】:MIH(介质独立切换)是实现下一代异构网络融合的关键技术。文章分析了基于MIH的WLAN-UMTS(无线局域网-通用无线通信
2010-04-24 09:10:39
随着集成电路设计师将更复杂的功能嵌入更狭小的空间,异构集成包括器件的3D堆叠已成为混合与连接各种功能技术的一种更为实用且经济的方式。作为异构集成平台之一,高密度扇出型晶圆级封装技术正获得越来越多
2020-07-07 11:04:42
超短距离(USR)接口在2.5D封装技术上的重要性日益提高,已导致各种电气定义和电路实现。台积电最近介绍了其IP开发团队采用的方法,该方法用于并行总线,时钟转发的USR接口,以优化功率/性...
2022-02-16 06:53:43
车载移动异构无线网络架构及关键技术是什么?
2021-06-07 06:29:57
Altera FPGA芯片的封装尺寸选择指南
2009-03-28 14:48:06 351
351 对于测量精度高的零件,中图仪器2.5d自动影像测量仪相当于一台小的三座标测量仪,即为复合式影像测量仪,全行程采用立柱式、龙门桥式的稳定结构,单轴的超高测量精度可达(1.8+L/200)um,在需要
2022-08-02 15:43:00
中图仪器CH系列2.5d影像仪品牌6.5X电动变倍高分辨率镜头和大视野镜头组合测量,表面光、透射光、同轴光分段编程控制,铸就强大的毛边、弱边抓取功能,清晰呈现工件真实边缘,实现准确测量。仪器测量手段
2022-11-04 11:43:57
Novator系列2.5d全自动影像仪将传统影像测量与激光测量扫描技术相结合,充分发挥了光学电动变倍镜头的高精度优势,多种测量新特性、新功能的创新支持,可实现2.5D和3D复合测量。还支持频闪照明
2023-03-06 09:29:01
Novator系列2.5D影像测量仪是一种全自动影像测量仪。它将传统影像测量与激光测量扫描技术相结合,充分发挥了光学电动变倍镜头的高精度优势,支持点激光轮廓扫描测量、线激光3D扫描成像,可进行高度
2023-06-07 11:19:54
基于中间件技术的异构机器人系统设计及实现:基于C++CORBA中间件的技术规范和具体应用,对异构机器人系统的集成技术进行了研究.以ACE?TAO作为开发平台,
2010-03-18 16:23:48 17
17 一位华为的资深科学家表示,华为和Altera将推出集成了FPGA和有众多I/O接口的内存的2.5D硅基封装芯片,旨在突破通信设备中的内存带宽的极限。这项技术虽然面临巨大的挑战,但该技术
2012-11-16 11:03:22 1837
1837 目前大部分中高端机型都采用了2.5D屏幕玻璃,“温润晶莹”且“柔美舒适”,厂商爱这么描述2.5D玻璃,那你对它又了解多少呢?
2017-01-23 09:47:25 6318
6318 Altera系列芯片封装
2017-02-28 16:46:42 0
0 MacRumors网站从早前日经英文站点Nikkei Asian News有关iPhone 8曲面屏幕的传闻推断,iPhone 8采用的2.5D曲面屏幕,弧度远比Galaxy S7 edge那些3D
2017-03-17 09:42:54 556
556 朋友们大家好,24号下午,华为在“华为P10/P10 Plus人像摄影大师发布盛典”上除了带来P10系列国行版本,还发布了传闻已久的华为Nova青春版手机,外观设计上,华为Nova青春版手机采用双面2.5D玻璃加金属中框的机身设计,蓝色和粉色的机身背部采用流光水波纹的设计。
2017-03-24 23:33:51 2646
2646 今天要和大家聊的是来自魅族的魅蓝X,目前售价为1499元,主要卖点有双面2.5D玻璃机身、P20处理器。从上市到现在,魅蓝X的存在感不高,此前在2000元以下,也只有荣耀8在颜值上与它有得一拼,不过现在荣耀8青春版、小米5C甚至华为NOVA青春版都加入了进来。
2017-03-26 11:36:14 2286
2286 玻璃,当时的业界普遍的认为这款手机的外观ID设计上大胆创新,甚至称之为华为最美的手机,荣耀8的设计亮点在于放弃了荣耀7上的三段式机身,改用双面2.5D玻璃+金属中框设计,这款手机在灭屏的时候,颜值真的很棒。
2017-06-27 17:23:12 2750
2750 加利福尼亚,圣克拉拉(2017年8月9日)——格芯今日宣布推出2.5D封装解决方案,展示了其针对高性能14纳米FinFET FX-14™ASIC集成电路设计系统的功能。
2017-08-14 17:46:54 789
789 对于数据密集型应用,大量能量和延时消耗在计算和存储单元之间的数据传输上,造成冯诺依曼瓶颈。在采用2.5D封装集成的系统中,这一问题依然存在。为此,提出一种新型的硬件加速方案。引入存储型计算到2.5D
2018-02-26 11:47:46 1
1 对于目前的高端市场,市场上最流行的2.5D和3D集成技术为3D堆叠存储TSV,以及异构堆叠TSV中介层。Chip-on-Wafer-on-Substrate(CoWos)技术已经广泛用于高性能计算
2019-02-15 10:42:19 6191
6191 
华为手环B5采用1.13英寸AMOLED屏幕,2.5D弧面玻璃设计,支持全彩屏触控,显示区域可达到上一代的2.4倍,可显示约40个汉字。屏幕腕带采用分离式设计,主体取下即是蓝牙耳机,随取随用。并有
2019-07-10 16:40:10 1437
1437 为了打破高性能系统中的带宽瓶颈,Altera公布了该公司声称的业界首个异构系统级封装(SiP)器件将SK Hynix的堆叠高带宽存储器(HBM2)与高性能Stratix 10 FPGA和SoC集成在一起。
2019-08-08 17:17:13 3073
3073 华为手环4搭载了一块0.96英寸臻彩全触控彩屏,2.5D弧面工艺,塑造出了浑然一体的雅致外观;曜石黑、樱语粉、赤茶橘三款配色各有特点,彰显你的不同气质;表盘也有了丰富的选择,无论是你喜爱的二次元还是极简风,总有一款适合你。
2019-10-21 14:20:26 2148
2148 协作机器人夹爪制造商OnRobot推出最新2.5D视觉系统Eyes,适用于各家先进机器手臂,提供外加的深度感知和零件辨识功能。
2020-05-31 10:14:43 974
974 半导体业界,几家公司正在竞相开发基于各种下一代互连技术的新型2.5D和3D封装。
2020-06-16 14:25:05 7443
7443 代工厂、设备供应商、研发机构等都在研发一种称之为铜混合键合(Hybrid bonding)工艺,这项技术正在推动下一代2.5D和3D封装技术。
2020-10-10 15:24:32 6116
6116 
再就是2.5D/3D先进封装集成,新兴的2.5D和3D技术有望扩展到倒装(FC)芯片和晶圆级封装(WLP)工艺中。通过使用内插器(interposers)和硅通孔(TSV)技术,可以将多个芯片进行垂直堆叠。据报道,与传统包装相比,使用3D技术可以实现40~50倍的尺寸和重量减少。
2020-10-10 16:09:18 3741
3741 除了先进制程之外,先进封装也成为延续摩尔定律的关键技术,像是2.5D、3D 和Chiplets 等技术在近年来成为半导体产业的热门议题。究竟,先进封装是如何在延续摩尔定律上扮演关键角色?而2.5D、3D 和Chiplets 等封装技术又有何特点?
2020-10-12 09:34:00 2163
2163 技术发展方向 半导体产品在由二维向三维发展,从技术发展方向半导体产品出现了系统级封装(SiP)等新的封装方式,从技术实现方法出现了倒装(FlipChip),凸块(Bumping),晶圆级封装(Waferlevelpackage),2.5D封装(interposer,RDL等),3D封装(TSV)等先进封装技术。
2020-10-12 11:34:36 15949
15949 
近日,华为将出售手机业务的传闻不胫而走,有爆料称华为手机将出售给大市国资委牵头成立的企业,谈判已接近尾声,近日即将公布。
2021-01-25 16:25:25 1494
1494 人工智能(AI)、车联网、5G 等应用相继兴起,且皆须使用到高速运算、高速传输、低延迟、低耗能的先进功能芯片;然而,随着运算需求呈倍数成长,究竟要如何延续摩尔定律,成为半导体产业的一大挑战。
2021-03-18 16:51:37 20123
20123 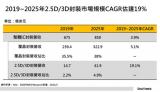
异构集成基础:基于工业的2.5D/3D寻径和协同设计方法
2021-07-05 10:13:36 12
12 今天,三星推出了全新2.5D封装解决方案H-Cube(Hybrid Substrate Cube,混合基板封装),专用于需要高性能和大面积封装技术的高性能计算(HPC)、人工智能(AI)、数据中心和网络产品等领域。
2021-11-12 15:52:17 2344
2344 农历新年后开工第一天,上海微电子装备集团(以下简称“上海微电子”)正式举行“中国首台2.5D/3D先进封装光刻机发运仪式”,由上海微电子生产的中国首台2.5D/3D先进封装光刻机正式交付客户。不过,具体客户未知。
2022-02-08 12:47:41 16595
16595 电子行业正在经历半导体封装技术的再兴。越来越多的创新性的3D封装方法已经发展,是电子工厂能够去最大化他们的产品功能。通过整合多个芯片到一个封装模组中,产品板可以明显的比它们的前辈更小,并且更短的内部
2022-04-29 17:17:43 7
7 开始呈现疲软的状态,先进
制成工艺也无法带来成本上的缩减。如何超越摩尔定律(More than Moore’s
law),让行业继续高速发展,成为业界苦苦寻思的问题。而目前来看,2.5D/3D
先进封装技术将会是行业一个重要的突破口,是超越摩尔定律的必经之路
2022-04-29 17:20:01 8
8 (Signal Integrity, SI)、电源完整性 (Power
Integrity, PI) 及可靠性优化。总结了目前 2.5D/3D 芯片仿真进展与挑战,介绍了基于芯片模型的
Ansys 芯片-封装-系统 (CPS) 多物理场协同仿真方法,阐述了如何模拟芯片在真实工况下达到优化
芯片信
2022-05-06 15:20:42 8
8 在阅读文章之前,大家可以思考下 2.5D 设计属于哪种界定?
2022-06-06 10:17:22 1109
1109 为了更有效辨别 2D 与 2.5D 之间的区别,图扑软件选用 2D 空调装配生产线与 2.5D 化工厂安全流程作比较。通过自主研发的 HT 产品,采用 B/S 架构快速搭建零代码拖拽式 Web 组态可视化场景,以真实的场景化、图形化、动态化的效果,反映二者运行状态、工艺流程、动态效果之间的不同。
2022-06-07 10:10:45 764
764 3D晶圆级封装,包括CIS发射器、MEMS封装、标准器件封装。是指在不改变封装体尺寸的前提下,在同一个封装体内于垂直方向叠放两个以上芯片的封装技术,它起源于快闪存储器(NOR/NAND)及SDRAM的叠层封装。
2022-07-25 15:35:41 1618
1618 异质整合需要通过先进封装提升系统性能,以2.5D/3D IC封装为例,可提供用于存储器与小芯片集成的高密度互连,例如提供Sub-micron的线宽与线距,或五层的互连,是良好的Interposer(中介层)。
2022-08-24 09:35:53 3279
3279 西门子数字化工业软件近日推出 Tessent™ Multi-die 软件解决方案,旨在帮助客户加快和简化基于 2.5D 和 3D 架构的下一代集成电路 (IC) 关键可测试性设计 (DFT) 。
2022-10-17 17:13:38 839
839 
2.5D封装是传统2D IC封装技术的进展,可实现更精细的线路与空间利用。在2.5D封装中,裸晶堆栈或并排放置在具有硅通孔(TSV)的中介层(interposer)顶部。其底座,即中介层,可提供芯片之间的连接性。
2022-10-26 09:34:04 627
627 2.5D封装是传统2D IC封装技术的进展,可实现更精细的线路与空间利用。在2.5D封装中,裸晶堆栈或并排放置在具有硅通孔(TSV)的中介层(interposer)顶部。其底座,即中介层,可提供芯片之间的连接性。
2022-11-14 10:14:53 942
942 2.5D封装是传统2D IC封装技术的进展,可实现更精细的线路与空间利用。在2.5D封装中,裸晶堆栈或并排放置在具有硅通孔(TSV)的中介层(interposer)顶部。其底座,即中介层,可提供芯片之间的连接性。
2022-11-15 09:35:36 1598
1598 先进的2.5D异质整合结构芯片封装技术来扮演这个角色。但是为什么需要采用2.5D封装技术,以目前来说,2.5D封装是一种高阶的IC芯片封装技术,可实现各种IC芯片的高速整合。
2022-12-05 16:25:39 595
595 
台积电InFO_PoP(package on package)技术实现商用已有10多年,包括iPhone AP的生产也已有多年。其2.5D IC CoWoS封装技术得到包括Nvidia、AMD
2022-12-20 15:48:23 424
424 2.5D封装技术可以将两种或更多类型的芯片放入单个封装,同时让信号横向传送,这样可以提升封装的尺寸和性能。
2023-01-30 15:38:28 694
694 随着超高密度多芯片模组(Multiple Chip Module,MCM)乃至系统级封装(SiP)产品在5G、AI、高性能运算、汽车自动驾驶等领域的普及,2.5D 和 3D 晶圆级封装技术备受设计人员青睐。
2023-02-24 09:38:08 748
748 虽然Chiplet异构集成技术的标准化刚刚开始,但其已在诸多领域体现出独特的优势,应用范围从高端的高性能CPU、FPGA、网络芯片到低端的蓝牙、物联网及可穿戴设备芯片。
2023-03-15 17:02:00 8662
8662 SiP是一个非常宽泛的概念,广义上看,它囊括了几乎所有多芯片封装技术,但就最先进SiP封装技术而言,主要包括 2.5D/3D Fan-out(扇出)、Embedded、2.5D/3D Integration,以及异构Chiplet封装技术。
2023-03-20 09:51:54 1037
1037 
创建真正的 3D 设计被证明比 2.5D 复杂和困难得多,需要在技术和工具方面进行重大创新。
2023-04-03 10:32:41 2446
2446 就收入而言,倒装芯片BGA、倒装芯片CSP和2.5D/3D是主要的封装平台,其中2.5D/3D技术的增长率最高。2.5D/3D 市场预计将从 2022 年的 92 亿美元增长到 2028 年的 258 亿美元,实现 19% 的复合年增长率。
2023-04-24 10:09:52 770
770 
高性能计算芯片发展需要基于异质异构集成的高性能封装。同时,Die-to-Die 2.5D/3D封装是逻辑、模拟射频、功率、光、传感器等小芯片形成异质集成的重要途径。同时,SIP技术发展至今已经形成了更高密度,更高带宽的连接,从国际学术上来看,高密度SIP技术也是异质异构集成的重要路径。
2023-04-25 10:44:32 718
718 一是将芯片封装架构由平面拓展至2.5D 或3D,可实现更小更紧凑的芯片系统;二是可以融合不同的半导体材料、工艺、器件的优点,实现更复杂的功能和更优异的性能;
2023-04-27 10:52:02 1838
1838 
电子发烧友网站提供《用焊接在一起的PCB重建2.5D凸轮.zip》资料免费下载
2023-06-08 11:05:24 0
0 据2022年2月7日消息,上海微电子装备(集团)股份有限公司(SMEE)举行首台2.5D/3D先进封装光刻机发运仪式,向客户正式交付先进封装光刻机。需要指出的是,上海微电子此次交付的是用于IC
2022-02-11 09:37:04 10435
10435 
Info封装与CoWoS封装是目前2.5D封装的典型代表,同属于TSMC开发的2.5D封装,那么如何区分 Info封装与CoWoS封装呢?主要从以下方面进行阐述。
2023-06-20 11:51:35 3243
3243 
nvidia的a100、h100和其他ai gpu目前使用控制台来制造晶片和2.5包的前端工程。nvidia ai gpu使用的hbm芯片由sk海力士独家提供。但是tsmc没有能力处理2.5d包装所需的所有工作。
2023-07-20 10:45:23 538
538 热点新闻 1、三星计划为英伟达AI GPU提供HBM3和2.5D封装服务 据报道,英伟达正在努力实现数据中心AI GPU中使用的HBM3和2.5D封装的采购多元化。消息人士称,这家美国芯片巨头正在
2023-07-20 17:00:02 404
404 
日本的半导体公司rafidus成立于2022年8月,目前正集中开发利用2.5d和3d包装将多个不同芯片组合起来的异构体集成技术。Rapidus当天通过网站表示:“计划与西方企业合作,开发新一代3d lsi(大规模集成电路),并利用领先技术,批量生产2纳米及以下工程的芯片。”
2023-07-21 10:32:31 633
633 2.5D封装和3D IC封装都是新兴的半导体封装技术,它们都可以实现芯片间的高速、高密度互连,从而提高系统的性能和集成度。
2023-08-01 10:07:36 2616
2616 
level package),2.5D封装(interposer,RDL等),3D封装(TSV)等先进封装技术。
2023-08-05 09:54:29 398
398 
(Waferlevelpackage),2.5D封装(interposer,RDL等),3D封装(TSV)等先进封装技术。免责声明:本文转自网络,版权归原作者所有,如涉及作品版权问题,
2023-08-14 09:59:24 457
457 
本文通过测试、仿真分析了影响2.5D CoWoS翘曲、应力、可靠性的因素:real/dummyHBM、interposer 厚度、C4 bump高度。对2.5D package的设计非常有指导意义。
2023-09-07 12:22:40 785
785 
Chiplet技术背景下,可将大型单片芯片划分为多个相同或者不同小芯片,这些小芯片可以使用相同或者不同工艺节点制造,再通过跨芯片互联及封装技术进行封装级别集成,降低成本的同时获得更高的集成度。
2023-09-25 12:52:28 988
988 
先进封装技术以SiP、WLP、2.5D/3D为三大发展重点。先进封装核心技术包括Bumping凸点、RDL重布线、硅中介层和TSV通孔等,依托这些技术的组合各厂商发展出了满足多样化需求的封装解决方案,SiP系统级封装、WLP晶圆级封装、2.5D/3D封装为三大发展重点。
2023-09-28 15:29:37 1614
1614 
不同的连接技术把它们拼装在一起,以实现更高效和更高性能的芯片设计。本文将会详尽、详实、细致地介绍Chiplet主流的封装技术。 1. 面向异构集成的2.5D/3D技术 2.5D/3D技术是Chiplet主流封装技术中最为流行和成熟的一种,通过把不同的芯片堆叠在一起,可以将它
2023-09-28 16:41:00 1348
1348 半导体产品在由二维向三维发展,从技术发展方向半导体产品出现了系统级封装(SiP)等新的封装方式,从技术实现方法出现了倒装(FlipChip),凸块(Bumping),晶圆级封装(Waferlevelpackage),2.5D封装(interposer,RDL等),3D封装(TSV)等先进封装技术。
2023-10-31 09:16:29 836
836 
中介层(Interposer)制造服务以连接小芯片(Chiplets),并与一流的晶圆代工厂和测试封装供货商紧密合作,确保产能、良率、质量、可靠性和生产进度,从而实现多源小芯片的无缝整合,进而保证项目的成功。 智原不仅专注于技术,更为每位客户量身打造2.5D/3D先进封装服务。作为一个中立的服务厂商,智原在包
2023-11-20 18:35:42 193
193 异构集成时代半导体封装技术的价值
2023-11-28 16:14:14 223
223 
TSV是2.5D和3D集成电路封装技术中的关键实现技术。半导体行业一直在使用HBM技术将DRAM封装在3DIC中。
2023-11-27 11:40:20 212
212 
据悉,三星很有可能将这些装置作为2.5d包使用在nvidia ai gpu和hbm3芯片上。根据Shinkawa的订单结构分析,如果英伟达的订单增加,三星的设备订单也会增加。
2023-12-07 15:37:16 272
272 半导体芯片封装的重要性、传统和先进技术以及该领域的未来趋势。
2024-01-02 11:09:17 394
394 
2.5D 和 3D 半导体封装技术对于电子设备性能至关重要。这两种解决方案都不同程度地增强了性能、减小了尺寸并提高了能效。2.5D 封装有利于组合各种组件并减少占地面积。它适合高性能计算和人工智能加速器中的应用。3D 封装提供无与伦比的集成度、高效散热并缩短互连长度,使其成为高性能应用的理想选择。
2024-01-07 09:42:10 466
466 
level package),2.5D封装(interposer,RDL等),3D封装(TSV)等先进封装技术。 审核编辑 黄宇
2024-02-21 10:34:20 180
180 
随着集成电路技术的飞速发展,封装技术作为连接芯片与外部世界的重要桥梁,也在不断地创新与演进。2.5D封装和3D封装作为近年来的热门技术,为电子系统的小型化、高性能化和低功耗化提供了有力支持。本文将详细介绍2.5D封装和3D封装技术,并对它们进行对比分析。
2024-02-01 10:16:55 508
508 
自去年以来,随着英伟达AI芯片需求的迅猛增长,作为其制造及封装合作伙伴的台积电(TSMC)在先进封装技术方面面临了前所未有的产能压力。为了应对这一挑战,台积电正积极扩大其2.5D封装产能,以确保能够满足持续增长的产能需求。
2024-02-06 16:47:14 2948
2948 2.5/3D-IC封装是一种用于半导体封装的先进芯片堆叠技术,它能够把逻辑、存储、模拟、射频和微机电系统 (MEMS)集成到一起
2024-03-06 11:46:05 394
394 
 电子发烧友App
电子发烧友App



















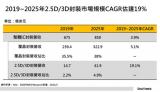
































评论