来源:西门子
·Tessent 可测试性设计 (DFT) 技术进一步促进 3D IC 成为主流应用
·创新解决方案可简化复杂多芯片设计的 DFT 周期
西门子数字化工业软件近日推出 Tessent™ Multi-die 软件解决方案,旨在帮助客户加快和简化基于 2.5D 和 3D 架构的下一代集成电路 (IC) 关键可测试性设计 (DFT) 。
随着市场对于更小巧、更节能、更高性能的 IC 需求不断提升, IC 设计业也面临着严苛挑战。下一代组件更倾向于采用 2.5D 和 3D 架构,以垂直 (3D IC) 或并排 (2.5D) 的方式连接多个芯片,使其作为单一组件工作。然而,这样的方式对 IC 测试提出巨大挑战,大部分传统的测试方法都基于常规的 2D 工艺。
为了应对这些挑战,西门子推出 Tessent Multi-die —— 一款全面的 DFT 自动化解决方案,可处理与 2.5D 和 3D IC 设计有关的复杂DFT 任务。该解决方案可与西门子的 Tessent™ TestKompress™ Streaming Scan Network 软件和 Tessent™ IJTAG 软件配合使用,优化每个模块的 DFT 测试资源,无需担忧对设计其余部分造成影响,从而简化了 2.5D 和 3D IC 的 DFT 工作。现在, IC 设计团队只需使用 Tessent Multi-die 软件,就可以快速开发符合 IEEE 1838 标准的 2.5D 和3D IC 架构硬件。
西门子数字化工业软件副总裁兼 Tessent 业务部门总经理 Ankur Gupta 表示:“在 2.5D 和 3D 组件中采用高密度封装芯片设计的需求日益增多, IC 设计公司也面临着快速增加的 IC 测试复杂难题。借助于西门子的 Tessent Multi-die 解决方案,我们的客户能够为其未来设计做好充分准备,同时减少测试工作量,降低当前制造测试成本。”
除了支持 2.5D 和 3D IC 设计的全面测试之外,Tessent Multi-die 解决方案还可生成芯片间(die-to-die) 测试向量,并使用边界扫描描述语言 (BSDL) 实现封装级别测试。此外, Tessent Multi-die 可利用西门子 Tessent TestKompress Streaming Scan Network 软件的分组数据传输功能,支持灵活并行端口 (FPP) 技术的集成。于 2020 年推出的 Tessent TestKompress Streaming Scan Network 软件可将内核级 DFT 要求与芯片级测试交付资源分离,使用真实、有效且自下而上式的流程来实现 DFT ,从而简化 DFT 的规划和实施,同时将测试时间缩短 4 倍。
Pedestal Research 总裁兼研究总监 Laurie Balch 表示:“随着时间推移,传统的 2D IC 设计方法逐渐显露出局限性,越来越多的设计团队开始利用 2.5D 和 3D IC 架构,以满足其在功耗、性能以及尺寸等方面的要求。在新设计中部署这些高级架构的首要步骤就是制定 DFT 策略,来应对复杂架构带来的种种挑战,避免增加成本或延误产品上市时间。通过持续开发 DFT 技术,满足多维设计的需求, EDA 厂商将进一步促进 2.5D 和 3D 架构在全球范围的应用。”
西门子数字化工业软件通过Siemens Xcelerator 数字商业平台的软件、硬件和服务,帮助各规模企业实现数字化转型。西门子的工业软件和全面的数字孪生可助力企业优化设计、工程与制造流程,将创新想法变为可持续的产品,从芯片到系统,从产品到制造,跨越各个行业,创造数字价值。。
西门子数字化工业集团(DI)是自动化和数字化领域的创新典范。数字化工业集团与合作伙伴和客户一起,推动过程与离散行业的数字化转型。通过数字化企业业务组合,数字化工业集团为各类规模的企业提供可以集成在整个价值链的端到端产品、解决方案和服务,并实现数字化。针对各行业的不同需求,数字化工业集团不断优化其独特的业务组合,帮助客户提升生产力和灵活性。数字化工业集团持续创新,将前沿科技不断融入产品系列。西门子数字化工业集团总部在德国纽伦堡,在全球拥有大约7.6万名员工。
关于西门子在中国:
西门子股份公司(总部位于柏林和慕尼黑)是一家专注于工业、基础设施、交通和医疗领域的科技公司。从更高效节能的工厂、更具韧性的供应链、更智能的楼宇和电网,到更清洁、更舒适的交通以及先进的医疗系统,西门子致力于让科技有为,为客户创造价值。通过融合现实与数字世界,西门子赋能客户推动产业和市场变革,帮助数十亿计的人们,共创每一天。西门子持有上市公司西门子医疗的多数股权,西门子医疗是全球重要的医疗科技供应商,塑造着医疗产业的未来。此外,西门子持有西门子能源的少数股权,西门子能源是全球输电和发电领域的重要企业。西门子自1872年进入中国,150年来始终以创新的技术、杰出的解决方案和产品坚持不懈地对中国的发展提供全面支持。2021财年(2020年10月1日至2021年9月30日),西门子在中国的总营收达到82亿欧元,拥有超过3万名员工。西门子已经发展成为中国社会和经济的一部分,并竭诚与中国携手合作,共同致力于实现可持续发展。
审核编辑:汤梓红
-
IC
+关注
关注
36文章
6487浏览量
186478 -
西门子
+关注
关注
98文章
3376浏览量
120757 -
DFT
+关注
关注
2文章
237浏览量
24118
发布评论请先 登录
英业达借助西门子软件全面提升可制造性设计效率及生产质量
西门子Innovator3D IC异构集成平台解决方案

2D、2.5D与3D封装技术的区别与应用解析

西门子V90伺服,为3D打印企业降本增效“加足马力”
西门子推出Tessent IJTAG Pro
强强合作 西门子与日月光合作开发 VIPack 先进封装平台工作流程

西门子EDA与北京开源芯片研究院达成战略合作

iTOF技术,多样化的3D视觉应用
华大九天推出芯粒(Chiplet)与2.5D/3D先进封装版图设计解决方案Empyrean Storm

西门子EDA产品组合新增两大解决方案
适用于先进3D IC封装完整的裸片到系统热管理解决方案

多芯粒2.5D/3D集成技术研究现状




 西门子Tessent Multi-die解决方案实现2.5D/3D IC可测性设计自动化
西门子Tessent Multi-die解决方案实现2.5D/3D IC可测性设计自动化


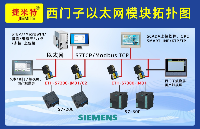



评论