
最近,在先进封装领域又出现了一个新的名词“3.5D封装”,以前听惯了2.5D和3D封装,3.5D封装又有什么新的特点呢?还是仅仅是一个吸引关注度的噱头?
今天我们就详细解读一下。
首先,我们要了解以下几个名词的确切含义,2.5D,3D,Hybrid Bonding,HBM。
2.5D
在先进封装领域,2.5D是特指采用了中介层(interposer)的集成方式,中介层目前多采用硅材料,利用其成熟的工艺和高密度互连的特性。 虽然理论上讲,中介层中可以有TSV也可以没有TSV,但在进行高密度互联时,TSV几乎是不可缺少的,中介层中的TSV通常被称为2.5D TSV。 2.5D封装的整体结构如下图所示。
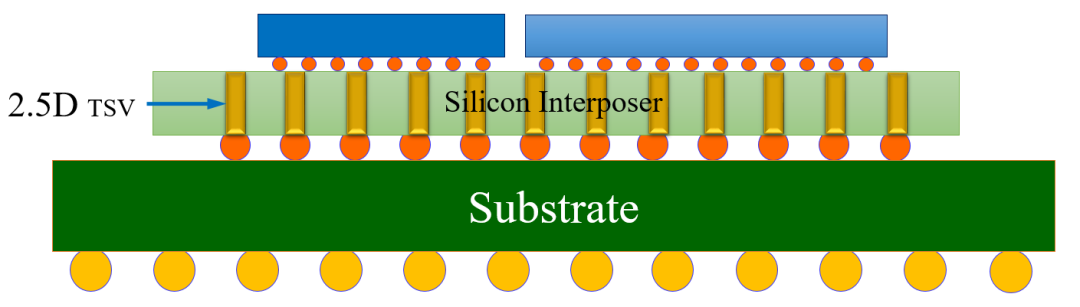
3D
和2.5D是通过中介层进行高密度互连不同,3D是指芯片通过TSV直接进行高密度互连。 大家知道,芯片面积不大,上面又密布着密度极高的电路,在芯片上进行打孔自然不是容易的事情,通常只有Foundry厂可以做得到,这也是为什么到了先进封装时代,风头最盛的玩家成了TSMC, Intel, Samsung这些工艺领先的芯片厂商。因为最先进的工艺掌握在他们手里,在这一点上,传统的OSAT还是望尘莫及的。 在芯片上直接生成的TSV则被称为3D TSV,3D封装的整体结构如下图所示。
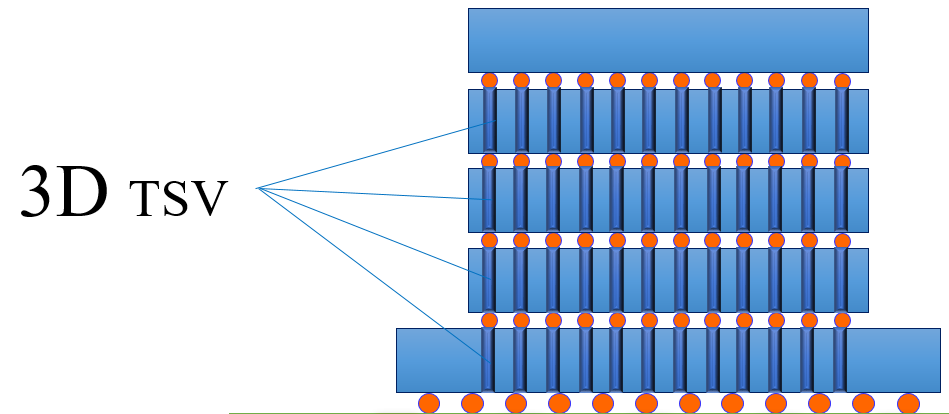
Hybrid Bonding
Hybrid Bonding混合键合技术,是一种在相互堆叠的芯片之间获得更密集互连的方法,并可实现更小的外形尺寸。 下图是传统凸点和混合键合技术的结构比较,传统凸点间距是 50 微米,每平方毫米有大约 400 个连接。混合键和Hybrid Bonding大约 10 微米的间距,可达到每平方毫米 10,000 个连接。
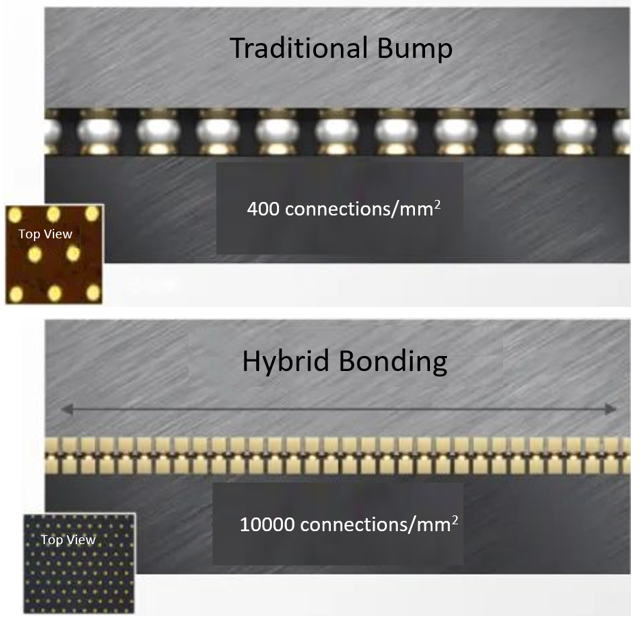
采用Hybrid Bonding技术可以在芯片之间实现更多的互连,并带来更低的电容,降低每个通道的功率。 下图是传统凸点技术和混合键合技术的加工流程比较,混合键合技术需要新的制造、操作、清洁和测试方法。
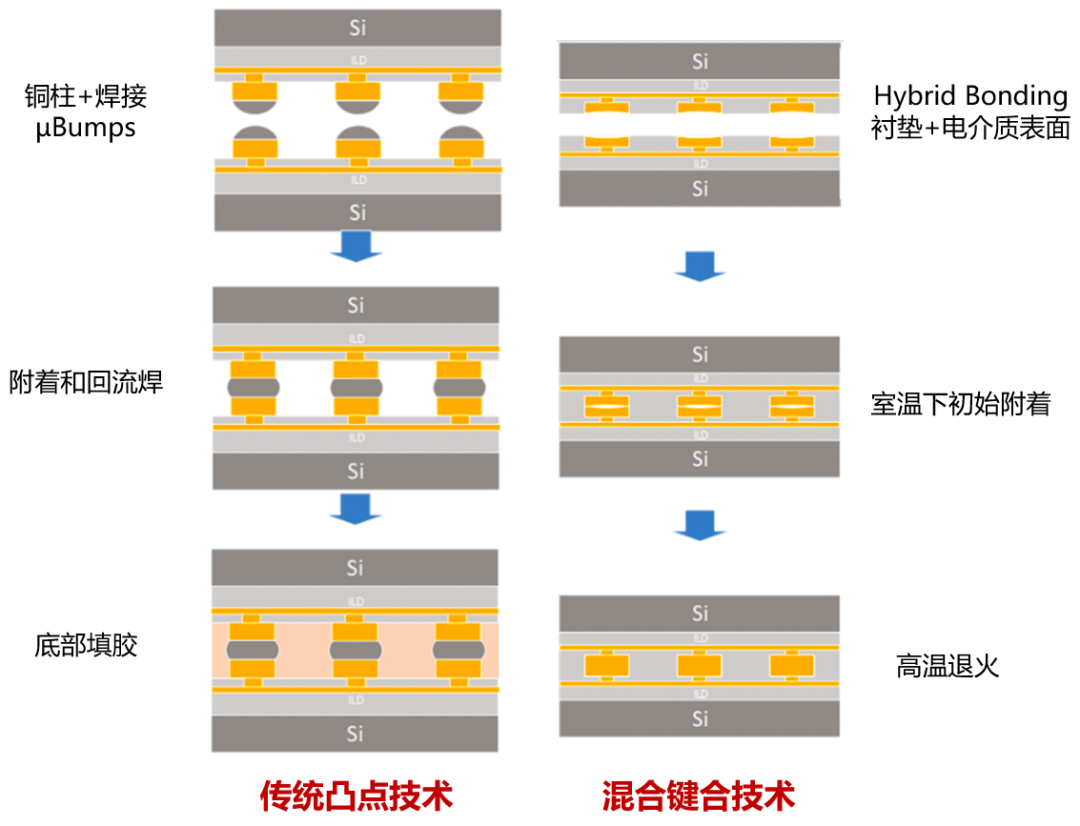
从图中我们可以看出,传统凸点焊接技术两个芯片中间是带焊料的铜柱,将它们附着在一起进行回流焊,然后进行底部填充胶。 混合键合技术与传统的凸点焊接技术不同,混合键合技术没有突出的凸点,特别制造的电介质表面非常光滑,实际上还会有一个略微的凹陷。在室温将两个芯片附着在一起,再升高温度并对它们进行退火,铜这时会膨胀,并牢固地键合在一起,从而形成电气连接。 混合键合技术可以将间距缩小到10 微米以下,可扩展的间距小于1微米,可获得更高的载流能力,更紧密的铜互联密度,并获得比底部填充胶更好的热性能。
HBM
随着人工智能技术的发展和需求,HBM现在越来越火热。 HBM(High-Bandwidth Memory )高带宽内存,主要针对高端显卡GPU市场。HBM使用了3D TSV和2.5D TSV技术,通过3D TSV把多块内存芯片堆叠在一起,并使用2.5D TSV技术把堆叠内存芯片和GPU在Interposer上实现互连。下图所示为HBM技术示意图。
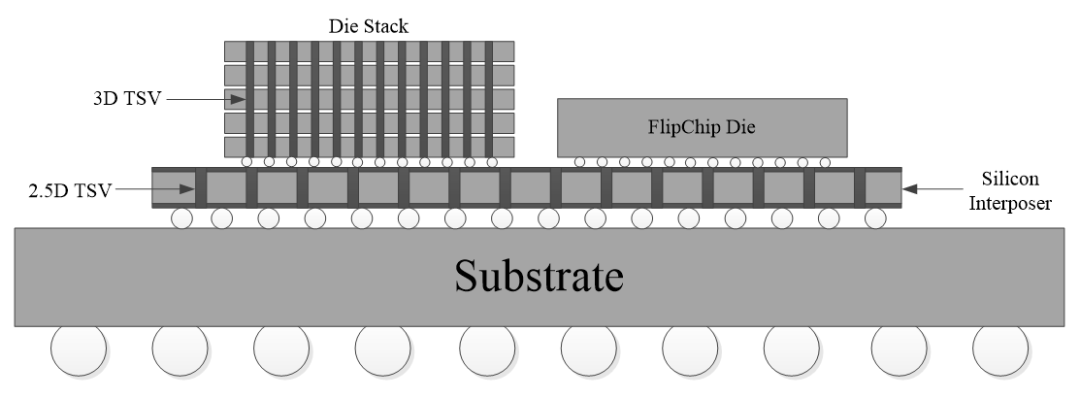
HBM既使用了3D封装技术和2.5D封装技术,应该归属于哪一类呢?有人认为HBM属于3D封装技术,也有人认为属于2.5D封装技术,其实都不确切。 通过和HMC的比较,就能得出正确的结论。 HMC(Hybrid Memory Cube)混合存储立方体,和HBM结构非常相似,HMC通过3D TSV集成技术把内存控制器(Memory Controller)集成到DRAM堆叠封装里。下图所示为HMC技术示意图。
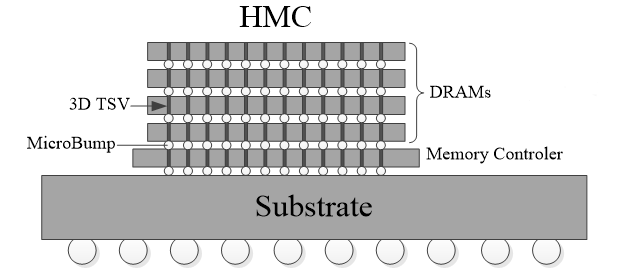
对比HBM和HMC,我们可以看出,两者很相似,都是将DRAM芯片堆叠并通过3D TSV互连,并且其下方都有逻辑控制芯片。 两者的不同在于:HBM通过Interposer和GPU互连,而HMC则是直接安装在Substrate上,中间缺少了Interposer和2.5D TSV。 在《基于SiP技术的微系统》一书中,我总结了12种当今最主流的先进封装技术。下表是对这些主流先进封装技术横向比较。

可以看出,现有的先进封装技术中,HBM是唯一一种具备3D+2.5D的先进封装技术。 如果HMC被称为3D封装,那么比其多了Interposer和2.5D TSV的HBM应该被称为什么呢? 一种新的封装命名需要呼之欲出了! 按照以往的命名规则,2D封装加上Interposer后就变成了2.5D,那么3D封装加上Interposer自然就变成了3.5D,既合情合理,又符合了通用的命名法则。
3.5D
什么是3.5D,最简单的理解就是3D+2.5D,不过,既然有了全新的名称,必然要带有新的技术加持,这个新技术是什么呢? 就是我们前文讲述的混合键和技术Hybrid Bonding。 混合键合技术应用于3D TSV的直接互连,省却了Bump,其界面互连间距可小于10um甚至1um,其互连密度则可达到每平方毫米10000~1000000个点。
这是传统的凸点互连远远无法达到的,因此,在高密度的3D互连中,凸点最终会消失,如下图所示,这一点也是我在以前的文章中阐述过的。
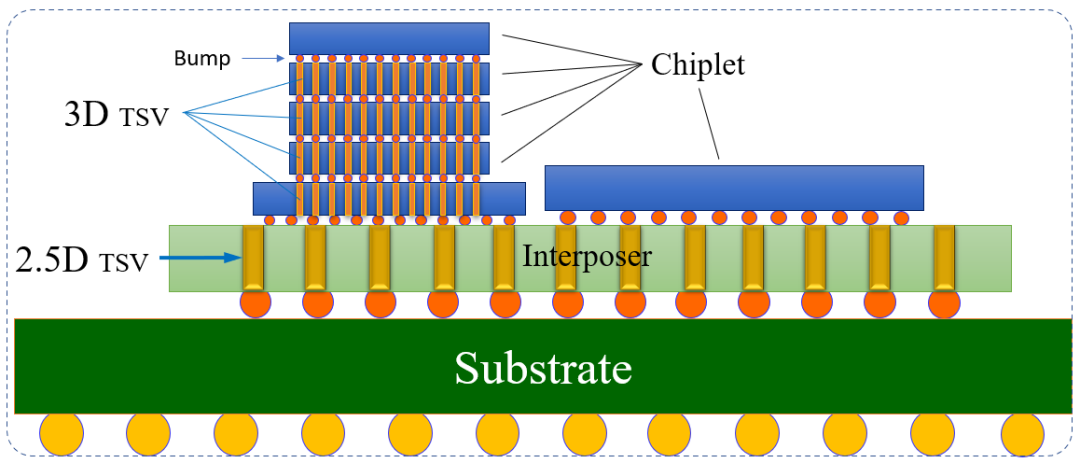

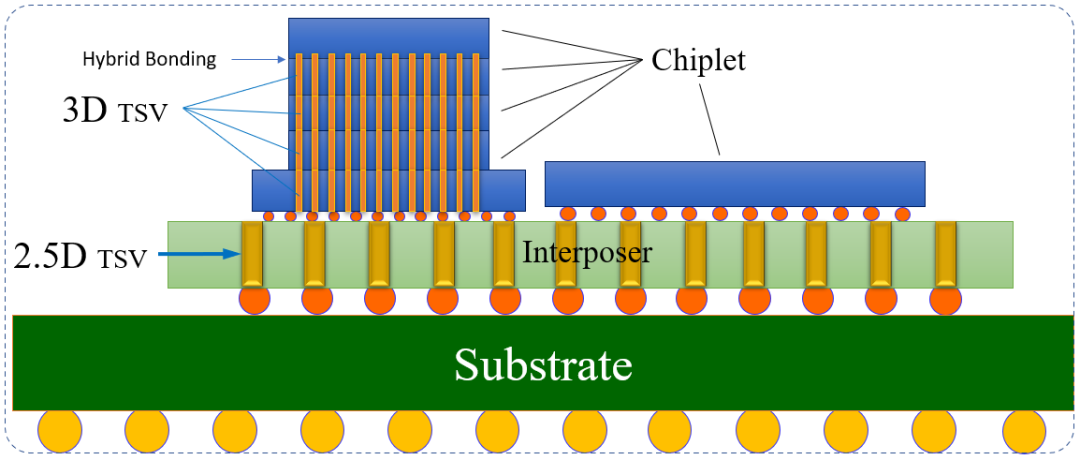
目前来说,3.5D就是3D+2.5D,再加上Hybrid Bonding技术的加持。
封装技术分类
由于3.5D的提法已逐渐被业界所普遍接受,我因此也更新一下电子集成技术的分类法,将3.5D放到了列表中。 这样,电子集成技术就分为:2D,2D+,2.5D,3D,3.5D,4D六种,如下图所示:
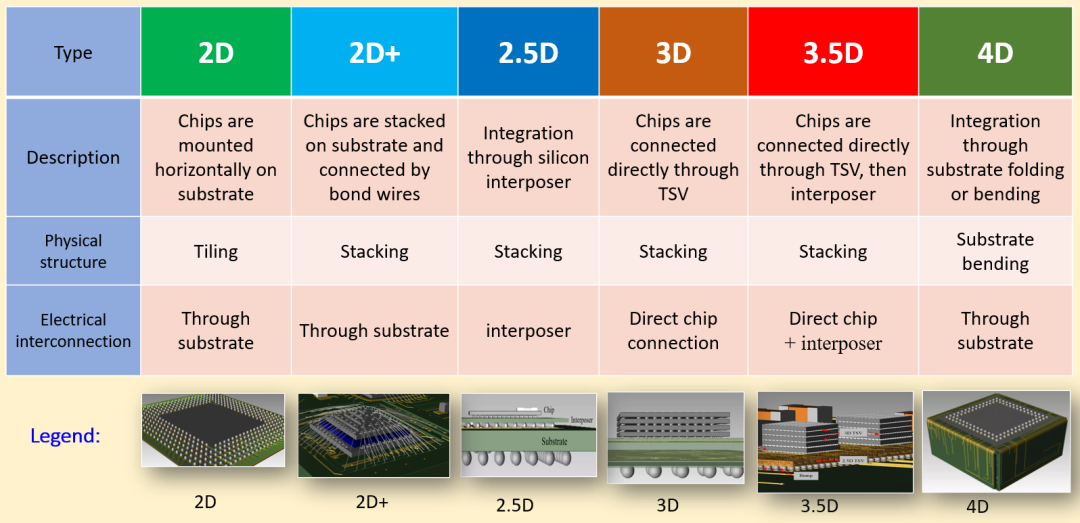
在更新的分类方法中,我并未强调Hybrid Bonding混合键合技术,因此,3.5D最简单的理解就是3D+2.5D。
在高密度先进封装的3D互连中,凸点必将消失,混合键合Hybrid Bonding是必然的趋势,因此也就无需特意强调了。
在12种当今最主流的先进封装技术中,只有HBM满足3D+2.5D结构,因此,HBM可以说是第一种真正的3.5D封装技术。
审核编辑:汤梓红
-
芯片
+关注
关注
462文章
53537浏览量
459149 -
半导体
+关注
关注
336文章
29986浏览量
258293 -
3D封装
+关注
关注
9文章
147浏览量
28198 -
先进封装
+关注
关注
2文章
519浏览量
972
原文标题:什么是3.5D封装?
文章出处:【微信号:射频美学,微信公众号:射频美学】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
HRP晶圆级先进封装替代传统封装技术研究(HRP晶圆级先进封装芯片)

怎样衡量一个芯片封装技术是否先进?
12种当今最主流的先进封装技术

巨头们先进封装技术的详细解读
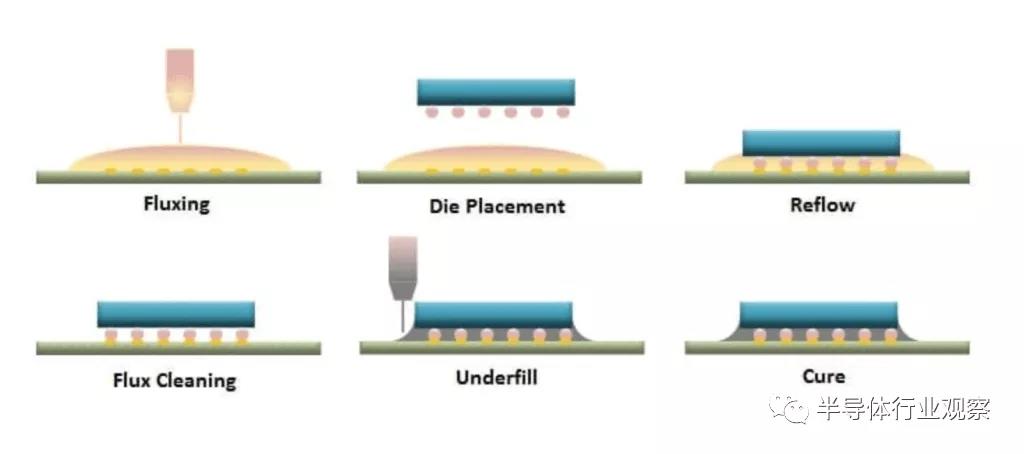
先进封装技术的发展与机遇
什么是先进封装?先进封装技术包括哪些技术






 详细解读先进封装技术
详细解读先进封装技术


















评论