在阅读文章之前,大家可以思考下 2.5D 设计属于哪种界定?
2.5D 是通过二维的元素来呈现出三维的效果。其实在国外并没有 2.5D 这样的称呼,标准说法是 Isometric 风格,翻译过来就是等距设计,在中国称之为 2.5D。
2.5D 的学术名是轴测插画或轴测插图,轴测插图的意思顾名思义,是一种单面投影图,在一个投影面上能同时反映出物体三个坐标面的形状,并接近于人们的视觉习惯,形象、逼真,富有立体感。
也就是说用二维的制作方式画出物体的三个面,富有立体感。但轴测插画需要找透视面,对设计师的空间想象能力要求很高,在制作的时候的难度和时间成本因图形的复杂程度而定有些会高于三维的工作量。
图扑软件将 2.5D 图形技术与数据可视化相结合,可帮助解决智慧工业、智慧园区、智慧机房、智慧能源等各领域应用开发成本高、周期长、体验差的问题。
应用图扑软件(Hightopo)自主研发的 HT 产品上的 Web 组态,结合 2.5D 轻量化设计形式,对智慧园区、智慧机房、智慧 SMT 生产线、智慧汽车生产线领域进行多业务运作流程透明化监控。图扑丰富的图形组件和界面设计,将枯燥繁琐的数据进行图形化、场景化,更加直观的将各图表数据形成鲜明比对。
智慧园区
园区作为城市在区域范围内的缩影,聚集着产业、人力、创新、功能等各类资源要素。
图扑软件基于新一代信息通信技术,在园区管控界面中集成建筑、能效、停车场、施工、能源,横向打通各子业务系统,实现园区控制、感知、监测、分析一体化。
运用数据驱动形式让新型组态得以使用 2.5D 等多形式实现多样化展示,实现与现实场景中相符的空间分布效果。可设置昼夜两种场景随意切换,整体设计以写实风格为主基调。
针对当下园区实行的“源网荷储”一体化运营形式,本案例以数据为核心生产要素,将接入测点后监测到发、用、储电类的实时数据,予以流程可视化动画效果以及图表数据载入融合形式直观呈现。整合园区内设施设备、碳排放、机房运行的位置分布、运作状态、环境态势,实施集中动态监测和部署,可点选查看同一数据指标下的多种分布特征,形成对园区资源空间的实时共享、平衡管理、联动控制。
基于类型、区域、质量等多维度,对园区内的能耗负荷、施工进度、机房动环、车位统计、水质等各类事件的运行状态,构建阈值告警触发机制,让系统主动识别安全风险,排除安全隐患。
可通过对接测点数据实现 Web 化跨平台多端访问,支持跨平台浏览,任何移动终端均可轻松打开浏览器访问管理界面,利用多种控制设备对显示内容集中远程管控,这是 C 端平台所不具备的优势。
数据中心
数据中心可视化管理手段是将多种管理系统的繁杂信息,集合汇总在虚拟环境中,选用符合人类视觉的方式全面展现数据中心整体架构。满足运维人员端到端的 IT 可视性,清晰快速掌握各类设备所处位置和资产信息,精准的审视数据中心全局景象。
图扑软件通过搭载智能传感器,对接区域内所需监控的动力、资产、容量、动环、门禁等信息,尽可能帮助决策者观察到各类对象。在全新的 2.5D 组态界面中,通过图扑软件 HT 强大的引擎技术,实现组态图元流畅的动态效果开发。以列表方式在界面中展示所需任意资产对象数据并动态刷新,如:机房电力负荷、UPS、设备型号、CPU 负载、温湿度等情况。
配备管线可视化,帮助运维人员有效梳理数据中心密集的电气管道与网络线路,轻松地把控数据中心链路走向及管线分布,提高排查与修复管线故障的解决效率。
针对现有运维体系和服务模式进行重新整合,将多类海量复杂的系统信息汇聚于此,提高资源利用率,缩短故障响应时间,为用户打造规范化、精细化、智能化的业务运作流程。
SMT 生产线
SMT 车间作为高度自动化的车间,可借助智能设备、FIRD、网络等先进技术,搭配图扑可视化技术,让传统的信息制造业实现数据统一管理运维,赋能行业向智能化、绿色化发展。
图扑软件运用轻量化建模形式搭建了 2.5D SMT 工艺流程监控管理可视化解决方案,针对各产线基础信息进行快速建档,整体组态系统中的各条产线可通过后端传输接口,使用图表组件反馈实时监控到的运行数据。2.5D 组态界面能更立体得看到整个工艺的流程的分布及各子流程的工艺走向。
针对厂区运营要求,可基于用户数据建设其运行成果,按需搭建多维度数据面板内容,如:OEE(设备综合效率)、时间利用率、性能利用率、产量完成度、直通率、不良率等。
设有预警告警分析功能,如遇设备数据超过临界值,将在界面中及时提醒用户关注设备。用户可通过界面下发指令,实现远程控制设备模式启停的目的,从而提高工作效率,减少运行成本。
图扑软件可视化通过 B/S 架构与模型轻量相结合,在一定程度上减轻了用户对于采购高性能硬件费用的压力。
汽车生产线
汽车制造业属于典型的离散制造,相较于普通生产线,汽车生产过程更加复杂繁琐。
图扑软件 2.5D 汽车生产线可视化解决方案,将冲压-焊接-涂装-总装等生产工艺流程运用各类卡通的二维组态和三维组态效果,还原动画场景并整合至大屏中。使汽车生产全过程在线、透明、可视、可控、可追溯。
搭载多类传感器,采集焊接车间内部设备的生产数据,运用图扑软件 HT 可视化组件,构建产线可视化看板,让用户对班组工作、员工效率及工艺环节过程中产线利用率、冲压工艺、停线/甩车时间等情况一目了然。
基于图扑软件的 HT 引擎技术,以物联网为基础,以大数据为中心,以各生产线为载体,以冲压、焊接、涂装、总装为核心冶炼工序的协同为目标,研用大数据处理技术,机器学习、机器视觉及自动控制等技术为手段,实现全局性成本最优、能效最低的智能协同制造。
图扑软件精准、简洁、直观的量化管理形式,协助用户全面快速洞察复杂数据背后的时空特征与变化规律,一改以往割裂分散笼统的治理手段。
图扑软件(Hightopo)也支持采用 3D 轻量化建模形式搭建监测场景,结合专业分析预测模型,对园区、机房、SMT、汽车生产线场景予以精炼呈现,实现对需求场景多角度、多元化的参数分析。推进全流程在线化工作,释放大量重复性工作,赋能员工高效协同,提升整体的组织效率。同时具备轻量、高效、易用和跨平台等特性,真正做到了 2D 和 3D 无缝融合,设计师和程序员统一工具协同开发模式,达到产品开发的高速迭代,快速将想法变成 2D、2.5D 和 3D 的最终界面成果。
图扑软件可视化支持编辑器的自定义风格、布局和菜单工具条等内容。可将 2D 和 3D 场景在编辑器上互相嵌套叠加、旋转和缩放,高度组件化无缝融合,承载十万以上级别的 2D、3D 及 UI 的表格树通用组件图元量,满足海量物联网设备和数据场景需求。
图扑软件不仅在传统的组态应用中游刃有余,更在新兴的三维组态行业应用中展露手脚,所呈现的组态页面,满足了当前阶段多样化的展示手段,已在众多领域上积累许多行业系统实施的解决方案,打造出丰富的 2D 组态和 3D 组态。方便用户快速上手使用,帮助制造流程快速升级转型,生产、管理能力得到进一步的提升,实现更多精美的工业监控可视化系统。
同传统组态软件 InTouch/IFix/WinCC 相比,图扑软件基于 Web 的平台更适合 C/S 向 B/S 转型的大趋势,支持快捷的数据绑定方式和多元素丰富的可视化组件,可用于快速创建和部署。已成为国内数据可视化图形组态、电信网络拓扑、工业自动化(HMI/SCADA/MMI)领域的领导性品牌。
-
数据中心
+关注
关注
18文章
5773浏览量
75208 -
组态
+关注
关注
0文章
197浏览量
15881 -
2.5D
+关注
关注
0文章
13浏览量
14024 -
智慧园区
+关注
关注
5文章
512浏览量
9761
发布评论请先 登录
深入解析L5973D:2.5A降压开关稳压器的卓越性能与应用
台积电如何为 HPC 与 AI 时代的 2.5D/3D 先进封装重塑热管理

先进封装成破局,博通率先落地3.5D,6000mm²超大集成

西门子Innovator3D IC异构集成平台解决方案

2D、2.5D与3D封装技术的区别与应用解析

浅谈2D封装,2.5D封装,3D封装各有什么区别?
Socionext推出3D芯片堆叠与5.5D封装技术

拯救工业组态 HMI 人机界面

3D封装的优势、结构类型与特点

华大九天推出芯粒(Chiplet)与2.5D/3D先进封装版图设计解决方案Empyrean Storm

后摩尔时代破局者:物元半导体领航中国3D集成制造产业

多芯粒2.5D/3D集成技术研究现状




 浅谈2.5D组态的应用案例
浅谈2.5D组态的应用案例



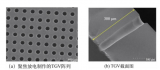



评论