影响。硅技术中RCA湿化学处理的特性基于SC-1和QDR的处理时间、温度、浓度和兆频超声波功率。提出了一种通过增加湿法清洗化学过程的变量来改进晶片表面制备的方法。 介绍 对SC-1和QDR的加工时间、温度、浓度和兆频超声波功率的影响进行了广泛的研究.这些研究表明,对颗粒
2021-12-27 10:38:32 1486
1486 
引言 Cu作为深度亚微米的多电级器件材料,由于其电阻低、电迁移电阻高和电容降低,与铝相比的时间延迟。本文从理论和实验上研究了柠檬酸基铜化学机械平坦化后二氧化硅颗粒对铜膜的粘附力以及添加剂对颗粒粘附
2021-12-29 11:00:01 2031
2031 
RCA标准清洁,在去除硅表面污染方面非常有效。RCA清洁包括两个顺序步骤:标准清洁1(SC-1)和标准清洁2(SC-2)。SC-1溶液由氢氧化铵、过氧化氢和水的混合物组成,是迄今为止发现的最有
2022-03-29 14:56:21 3119
3119 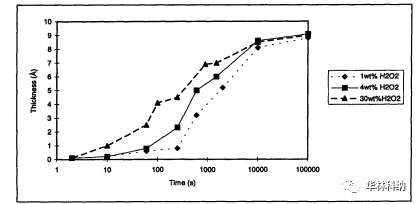
的DIO3处理在8000的厚蜡层上显示出低去除率。脱蜡器与DIO3漂洗相结合,以减少蜡去除时间并完全去除蜡残留物。用DIO3漂洗代替去离子漂洗导致表面接触角小于5°,这表明不需要进一步的清洗步骤。通过将SC-1清洗步骤与DIO3漂洗过程相结合,进一步提
2022-04-27 16:55:52 2760
2760 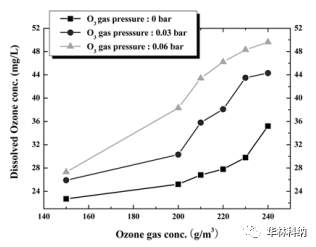
摘要 溶液中晶片表面的颗粒沉积。然而,粒子沉积和清除机制液体。在高离子中观察到最大的粒子沉积:本文将讨论粒子沉积的机理酸性溶液的浓度,并随着溶液pH值的增加而降低,在使用折痕。还研究了各种溶液中
2022-06-01 14:57:57 7869
7869 
在未来几代器件中,光刻胶(PR)和残留物的去除变得非常关键。在前端制程(FEOL)离子注入后(源极/漏极、扩展、haIos、深阱),使用PR封闭部分电路导致PR实质上硬化且难以去除。在后段制程
2022-07-04 17:04:08 11456
11456 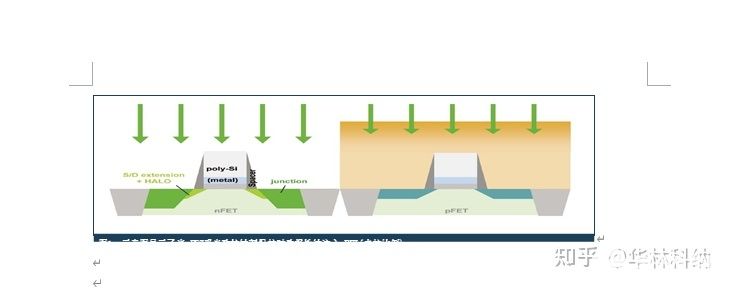
该38粒LED节能灯电路使用220V电源供电,220V交流电经C1降压电容降压后经全桥整流再通过C2滤波后经限流电阻R3给串联的 38颗LED提供恒流电源.图中R1是保护电阻,R2是电容C1的卸放电阻,R3是限
2012-03-28 11:06:34 11129
11129 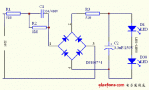
38粒LED节能灯电路使用220V电源供电,220V交流电经C1降压电容降压后经全桥整流再通过C2滤波后经限流电阻R3给串联的38颗LED提供恒流电源,下图中R1是保护电阻,R2是电容C1的卸放电阻,R3是限流电阻防止电压升高和温度升高LED的电流增大C2是滤波电容。
2021-04-23 07:21:03
原理的基础上,对后驱动环境下的退化机理作深入研究。以退化加速因子为主要分析指标,针对每一种退化机理(除引线键合熔化)推导出其加速因子模型,并以两种常见的双极型CMOS电路为对象进行退化加速评估,得出
2010-04-22 11:29:19
AL-CU互连导线侧壁孔洞形成机理及改进方法侧壁孔洞缺陷是当前Al?Cu 金属互连导线工艺中的主要缺陷之一。此种缺陷会导致电迁移,从而降低器件的可靠性。缺陷的产生是由于在干法等离子光刻胶去除工艺
2009-10-06 09:50:58
失效模式及机理进行研究和讨论,并简略介绍其他失效模式。 1 芯片碎裂引起的失效 由于IC卡使用薄/超薄芯片,芯片碎裂是导致其失效的主要原因,约占失效总数的一半以上,主要表现为IC卡数据写入错、乱码、全
2018-11-05 15:57:30
图像处理的形态学是处理二值图,下面程序首先对图像进行二值化处理,然后使用形态学函数的IMAQ RemoveParticle进行图像去除部分颗粒,端子Number of Erosion可以控制移除
2015-08-12 21:00:09
描述TIDA-00378 TI 参考设计提供模拟前端解决方案来测量 PM2.5 和 PM10 颗粒物。此设计检测由空气中的悬浮颗粒散射的光。此设计中通过软件算法示例将模拟输出转换为颗粒大小和浓度测量
2018-11-05 16:35:13
有时候,SH(SPM)后,会引入较多颗粒,一般在后面的FSI清洗中可以去除95%,但有的时候SH去胶后引入的颗粒,用FSI清洗无法去除,不知为何?有哪位同仁知道的请指点。
2011-04-14 10:44:26
有时候,SH(SPM)后,会引入较多颗粒,一般在后面的FSI清洗中可以去除95%,但有的时候SH去胶后引入的颗粒,用FSI清洗无法去除,不知为何?有哪位同仁知道的请指点。
2011-04-14 14:37:09
也相对紧密,运动气流不能将其解体,炭的燃烧可充分利用。 检测生物质颗粒燃料需要哪些设备? 1、万分之一分析天平一台。用于称重 2、鼓风干燥箱一台。用于检测粒燃料热值的水分。 3、粉碎机:一台
2019-09-07 09:15:40
申请理由:希望通过该产品的学习提高自身的知识储备,并将其应用于该项目及以后的工作中。项目描述:油液磨粒在线监测系统,利用电涡流传感器检测金属粒子,金属离子在油液中的浓度越高颗粒越大,检测信号幅值越大。该项目志在应用于汽车行业,实时将信号传回车主的手机,提醒车主该更换机油了。
2015-07-17 18:47:00
气态污染物,最后一项颗粒物更是加重雾霾天气污染的罪魁祸首,而颗粒物的英文缩写为PM,PM2.5颗粒物是指空气动力学直径小于2.5微米的细小颗粒,又被称为可入肺颗粒物或是细颗粒物。PM2.5颗粒物可以
2014-04-18 08:33:22
二进制输出。最好能给我仿真结果本人穷学生一个 ,报酬不是很高,支付宝只有150RMB,谢谢各位论坛大神了使用Verilog语言设计颗粒物体灌装系统完整的控制逻辑,灌装颗粒数100粒以下(含100粒),程序
2015-05-25 23:00:55
室内颗粒物的来源、健康效应及分布运动研究进展摘要:室内的颗粒物质与室内空气1~(indoor air quality,IAQ)有着密切关系。颗粒物质可能给人体健康或者其他设备和物品带来危害。该文回顾
2010-03-18 22:22:30
最近小弟遇到一项头疼的项目,需要测出某一粒径颗粒的浓度,精度要求挺高的,希望这方面有些想法的前辈能够支援一下,在下不胜感激
2012-08-05 16:03:20
柴油机预混合燃烧机理的研究柴油机预混合压缩燃烧是控制其排放的有效措施,因而引起国内外研究的重视。本论文结合CA498柴油机设计了基于文丘里管方式的增压发动机EGR系统和模拟EGR系统,在此基础上在
2009-04-16 14:43:24
。对煤中的水分(煤中原有的水和氢燃烧生成的水)的气化热进行校正后求得煤的低位发热量。DCLRY-4颗粒专用量热仪/热值仪技术特点:1.采用最新恒温式技术,芯片程序,采用面向对象的程序设计,模块化管理芯片
2018-07-29 09:37:16
描述TIDA-00378 提供用于测量 PM2.5 和 PM10 颗粒物的模拟前端。该参考设计可检测由空气中的悬浮颗粒散射的光。提供的示例软件算法可将设计的模拟输出转换为颗粒大小和浓度测量结果。随
2022-09-20 06:19:40
合成射流激励器的频率和电压特性(附图3)。完成合成射流激励器标定后,使用高速相机和双脉冲激光器进行粒子图像测速(PIV)实验获得流场数据,以研究合成射流高效掺混机理。
实验结果:合成射流激励器在
2024-03-08 17:47:25
利用射频共溅射方法制备了一系列不同金属含量x的Fex(SiO2)(1−x)金属−绝缘体颗粒膜,系统地研究了薄膜的霍尔效应及其产生机理。在室温和1.3 T的磁场下,当体积分数为0.52
2008-12-03 13:10:25 9
9 粗粒土颗粒渗透系数计算模型的研究摘要: 渗透系数是渗流分析中最基本的也是非常重要的计算参数, 研究粗粒土颗粒渗流系数计算模型为工程设计提供相对准确可
2010-04-28 11:48:23 15
15
SC-1型超声波加湿器电路图
2009-02-28 00:21:03 3585
3585 
短沟道MOSFET散粒噪声测试方法研究
近年来随着介观物理和纳米电子学对散粒噪声研究的不断深入,人们发现散粒噪声可以很好的表征纳米器件内部电子传输特性。由
2010-01-26 16:45:13 1084
1084 
脑电信号伪迹去除的研究进展脑电信号伪迹去除的研究进展
2016-01-15 16:15:39 0
0 高压IGBT关断状态失效的机理研究,IGBT原理,PT,NPT,Planar IGBT, Trench IGBT
2016-05-16 18:04:33 0
0 免疫机理的图像去噪方法研究_刘欢
2017-01-03 15:24:45 0
0 随着我国经济化进程的急速推进,近年以北京等地为首的我国大部分城市中,雾霾成为环境治理的重中之重。雾霾即PM2.5颗粒的主要来源为白然和人为。白然界的火山爆发、沙尘暴以及森林火灾等自然灾害均产生大量
2017-12-21 09:47:24 4
4 据报道,三星第二代10nm级别的1y-nm 8Gb DDR4颗粒已经正式投产了,8Gb DDR4颗粒采取了先进的专用电路设计技术,比初代10nm级别(1x-nm)的高30%,并且高频内存要以3600MHz起步。
2017-12-21 11:42:51 3481
3481 为解决气液固三相磨粒流抛光加T巾气泡破裂对SiC颗粒运动的可控性研究等问题,研究了气液固三相流巾近壁面微纳米气泡破裂对周围流场和颗粒的影响,采用Fluent软件巾多相流体体积模型与可实现k-s湍流
2018-02-28 14:11:35 0
0 针对液动压悬浮抛光固一液两相流中固相磨粒与工件表面撞击的过程中,对磨粒以不同的速度和不同的角度撞击工件表面后残余应力沿工件深度方向的分布规律进行了研究,利用ABAQUS软件建立了单颗磨粒撞击工件表面
2018-03-01 10:29:27 0
0 针对机械构件主系的封闭空间巾填充微小颗粒,进行振动抑制问题,对填充颗粒的尺寸、数量以及材料特性因素对振动抑制效果的影响开展了研究。通过采用离散单元法( discrete element method
2018-03-10 09:56:20 1
1 想到PM2.5。PM2.5颗粒物质雾霾的重要组成部分,对人体的健康具有较大威胁。这种颗粒物的直径小于或等于2.5微米,也称之为可吸入颗粒物。这种物质进入到人体系统以后可以进入到人体的血液参与全身的循环
2018-07-26 15:55:56 2712
2712 厚德载“雾”,自强不“吸”的日子又要来了。空气中的PM2.5颗粒更是健康杀手。PM2.5颗粒是空气动力学当量直径≤2.5um的颗粒,属于可入肺颗粒物。体积稍大的PM10由于颗粒更大,因此只能进入到人体的呼吸道。
2019-03-03 11:18:12 8513
8513 新概念Cart SC-1是一款概念车,融合了索尼研发的人工智能(AI)和机器人技术。
2019-03-31 10:07:43 4737
4737 新房装修之后所产生的甲醛非常多,对人体的危害也非常巨大,面对新房装修所产生的甲醛我们应该怎么办?怎样去除新家装修甲醛异味呢?如何去除室内甲醛,有些朋友通过网络搜到活性炭吸附,是颇为流行的一个清除室内
2019-07-22 22:11:42 891
891 过程以及被风扬起的尘土。可吸入颗粒物的形成主要有两个途径: 其一,各种工业过程(燃煤、冶金、化工、内燃机等)直接排放的超细颗粒物; 其二,大气中二次形成的超细颗粒物与气溶胶等。 那么空气中可吸入PM10颗粒物测定方法是哪些呢?
2021-02-20 16:22:46 5172
5172 。因此,现在很多城市都会测定环境中pm10颗粒物 可吸入颗粒物是空气污染中的重要污染源之一,通常来自在未铺沥青、水泥的路面上行使的机动车、材料的破碎碾磨处理过程以及被风扬起的尘土。可吸入颗粒物的形成主要有两个途径:其一,
2020-04-23 10:21:33 2358
2358 。那么如何快速粉碎单粒种子呢?小编推荐使用单粒种子粉碎器,这款仪器可以粉碎多种谷物的单粒种子,仪器粉碎快速,每三秒就可以粉碎一粒种子。 单粒种子粉碎器主要由进料机构、切刀机构和清洁机构组成。当机器进入运行状态后
2021-02-03 13:50:58 766
766 PM2.5颗粒是指空气动力学直径小于2.5微米的细颗粒,也称为入肺颗粒或细颗粒。PM2.5颗粒可直接进入支气管,甚至到达肺泡。而且这些颗粒会长时间附着在支气管和肺部,无法从自身代谢中排出。致病菌
2021-11-30 15:17:43 1688
1688 它们已经成为当今晶片清洁应用的主要工具之一。 本文重点研究了纳米颗粒刷洗涤器清洗过程中的颗粒去除机理并研究了从氮化物基质中去除平均尺寸为34nm的透明二氧化硅颗粒的方法。在洗涤器清洗后,检查晶片上颗粒径向表面浓度
2022-01-18 15:55:30 984
984 
的DIO3处理在8000的厚蜡层上显示出低去除率。脱蜡器与DIO3漂洗相结合,以减少蜡去除时间并完全去除蜡残留物。用DIO3漂洗代替去离子漂洗导致表面接触角小于5°,这表明不需要进一步的清洗步骤。通过将SC-1清洗步骤与DIO3漂洗过程相结合,进一步提
2022-01-26 16:02:02 905
905 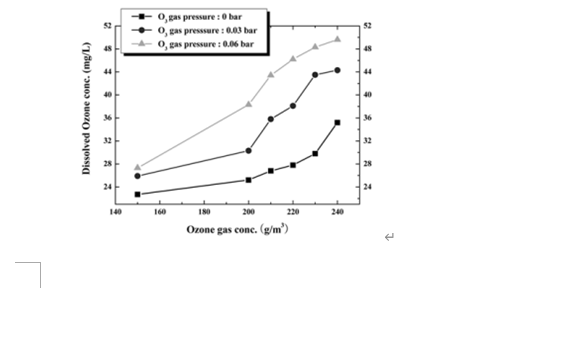
研究了在半导体制造过程中使用的酸和碱溶液从硅片表面去除粒子。 结果表明,碱性溶液的颗粒去除效率优于酸性溶液。 在碱性溶液中,颗粒去除的机理已被证实如下:溶液腐蚀晶圆表面以剥离颗粒,然后颗粒被电排斥到晶圆表面。 实验结果表明,需要0.25 nm /min以上的刻蚀速率才能使吸附在晶圆表面的颗粒脱落。
2022-02-17 16:24:27 3169
3169 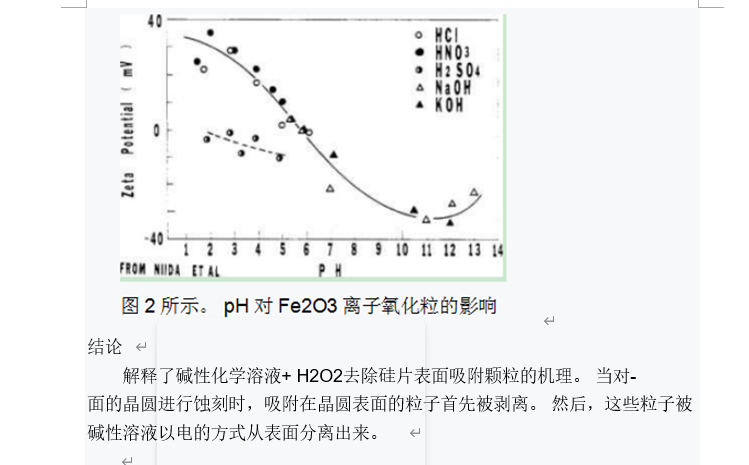
SC-l和piranha(H2SO4/H2O2)清洁剂已经使用多年来去除颗粒和有机污染物。尽管SC-1清洁剂(通常与施加的兆频超声波功率一起使用)被认为对颗粒去除非常有效,但去除机制仍不清楚。对于去
2022-02-23 13:26:32 3251
3251 
本文首次提出了由标准SC1/SC2腐蚀周期引起的Si (100)表面改性的证据。SC1/SC2蚀刻(也称为RCA清洗)通过NH3:H2O2:H2O混合物使硅片氧化,在稀释的HF中去除氧化物,通过
2022-02-23 14:15:22 10467
10467 
摘要 随着 ULSI 设备越来越小型化,对产量产生不利影响的颗粒直径一直在缩小。最近,直径为 0.1 或更小的超细颗粒变得很重要。预计这种类型的超细颗粒难以去除。本研究建立了一种评估超细颗粒去除效率
2022-03-03 14:17:36 830
830 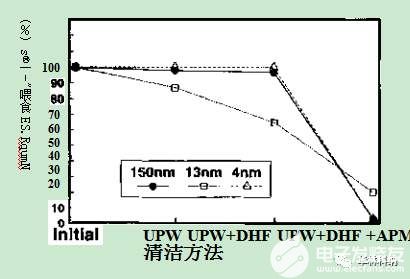
本文介绍了用兆频超声波能量从有机溶剂中的硅片上去除颗粒的实验。纳米粒子首先通过可控污染工艺沉积在硅晶片上。对于新沉积和老化的颗粒,研究了作为兆频超声波功率的函数的颗粒去除效率。通过改变处理条件和漂洗
2022-03-07 15:26:56 1335
1335 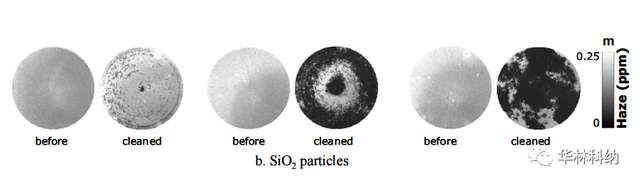
本文对晶片采用HF溶液洗净的晶片氢氟酸处理后的护发素及干燥方法,使用异丙基去除上述晶片表面残存的HF的步骤,关于晶片氢氟酸处理后的护发素和干燥方法,其特点是在对上述晶片施加82-84℃温度的同时通过
2022-03-23 17:06:05 2304
2304 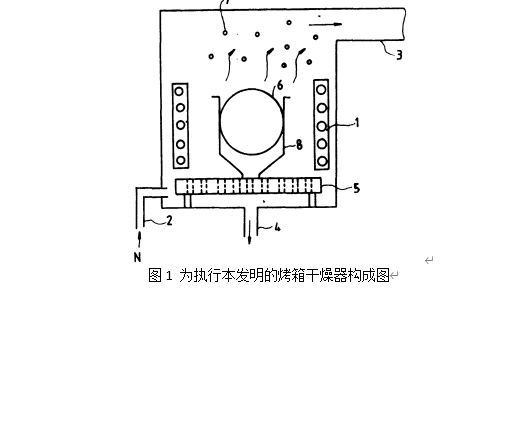
本研究在实际单位工艺中容易误染,用传统的湿式清洁方法去除的Cu和Fe等金属杂质,为了提高效率,只进行了HF湿式清洗,考察了对表面粗糙度的影响,为了知道上面提出的清洗的效果,测量了金属杂质的去除量
2022-03-24 17:10:27 2794
2794 
RCA标准清洁,在去除硅表面污染方面非常有效。RCA清洁包括两个顺序步骤:标准清洁1(SC-1)和标准清洁2(SC-2)。SC-1溶液由氢氧化铵、过氧化氢和水的混合物组成,是迄今为止发现的最有
2022-03-25 17:01:25 5482
5482 
介绍 RCA标准清洁,在去除硅表面污染方面非常有效。RCA清洁包括两个顺序步骤:标准清洁1(SC-1)和标准清洁2(SC-2)。SC-1溶液由氢氧化铵、过氧化氢和水的混合物组成,是迄今为止发现的最有
2022-03-25 17:02:50 4271
4271 
对于亚微米或深亚微米 ULSI 的制造,完全抑制在硅晶片表面产生的颗粒和污染非常重要。清洁需求的传统概念是使用化学成分(APM、氨和过氧化氢混合物)发挥主要作用。不幸的是,SC-1 (APM) 对表
2022-03-30 14:29:42 816
816 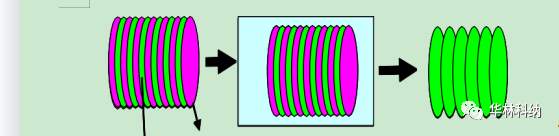
为了成功地清除来自晶片表面的颗粒污染,有必要了解颗粒与接触的基底之间的附着力和变形,变形亚微米颗粒的粘附和去除机理在以往的许多研究中尚未得到阐明。亚微米聚苯乙烯乳胶颗粒(0.1-0.5mm)沉积
2022-04-06 16:53:50 1787
1787 
过程的内在能力和局限性。已经确定了三种颗粒去除过程——能够去除所有颗粒尺寸和类型的通用过程,甚至来自图案晶片,具有相同理论能力但实际上受到粒子可及性的限制,最后是无法去除所有颗粒尺寸的清洗。 通过计算施加给细颗粒的
2022-04-08 17:22:53 1958
1958 
能力和局限性。已经确定了三种颗粒去除过程——能够去除所有颗粒尺寸和类型的通用过程,甚至来自图案晶片,具有相同理论能力但实际上受到粒子可及性的限制,最后是无法去除所有颗粒尺寸的清洗。
2022-04-11 16:48:42 1429
1429 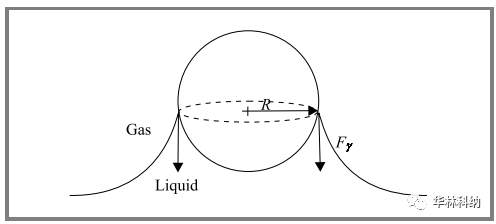
目的的盐酸-过氧化氢溶液组成的SC―2洗涤相结合的洗涤技术。SC-1洗涤的机理说明如下。首先,用过氧化氢氧化硅晶片的表面,用作为碱的氨蚀刻氧化硅,并通过剥离去除各种颗粒。另一方面,在SC-2清洗中,许多
2022-04-21 12:26:57 2394
2394 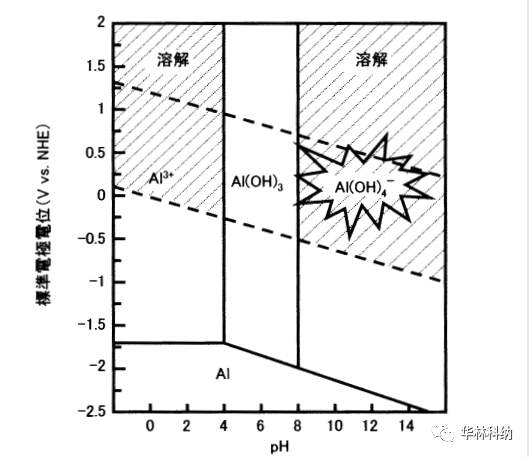
左右对蜡有较多的去除率。 将脱蜡器与dio3结合,以减少脱蜡时间和SC-1步骤,DIO3冲洗后的蜡厚度小于50A,而去离子水冲洗后的膜厚度大于200A。用DIO3冲洗代替DI冲洗后,接触角较低,表面完全亲水。用DIO3处理过的表面的光学图像显示了更薄的蜡层,这表明不需要进一步
2022-05-05 16:38:33 1440
1440 
化学机械平面化后的叶片清洗,特别是刷子擦洗,是半导体器件制造的一个关键步骤,尚未得到充分了解。临界粒子雷诺数方法用于评估在刷擦洗过程中去除晶圆表面的粘附颗粒,或者是否必须发生刷-粒子接触。考虑了直径
2022-05-07 15:48:38 2539
2539 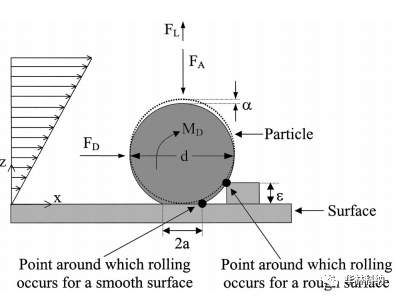
的DIO3处理在8000的厚蜡层上显示出低去除率。脱蜡器与DIO3漂洗相结合,以减少蜡去除时间并完全去除蜡残留物。用DIO3漂洗代替去离子漂洗导致表面接触角小于5°,这表明不需要进一步的清洗步骤。通过将SC-1清洗步骤与DIO3漂洗过程相结合,进一步提
2022-05-07 15:49:26 1611
1611 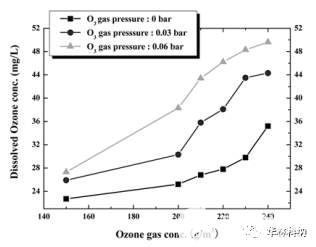
本文介绍了我们华林科纳在稀释SC1过程中使用兆声波来增强颗粒去除,在SC1清洗过程中,两种化学成分之间存在协同和补偿作用,H2O2氧化硅并形成化学氧化物,这种氧化物的形成受到氧化性物质扩散的限制
2022-05-18 17:12:59 1455
1455 
; 1000个氮化物颗粒”。然而,它没有规定用于Si,N4颗粒的沉积技术。用于在硅测试晶片上沉积Si,N的两种常用方法是气溶胶沉积技术或湿浸沉积技术。迄今为止,文献中还没有报道过这两种Si3*4沉积方法之间
2022-05-25 17:11:38 2023
2023 
./oschina_soft/piranha.zip
2022-06-21 10:29:17 1
1 实验内容:设计一套精准的磁场操控平台,并制备两种不同类型磁性颗粒;研究了均匀型磁性颗粒在磁场下的成链的机理,给出成链模型,通过实验研究了不同因素对成链的影响。探索了一种新的流场显示方法,利用磁性纳米
2022-06-21 15:14:25 2207
2207 
用半导体制造中的清洗过程中使用的酸和碱溶液研究了硅片表面的颗粒去除。
2022-07-05 17:20:17 2988
2988 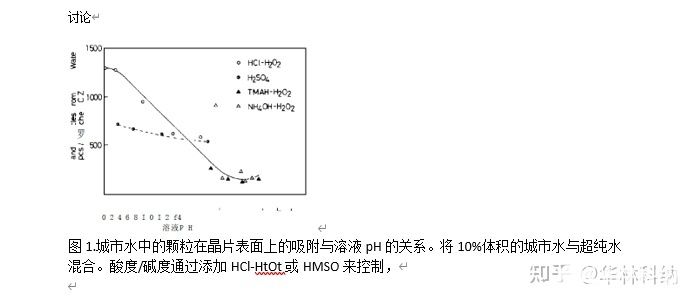
溶液中颗粒和晶片表面之间发生的基本相互作用是范德华力(分子相互作用)和静电力(双电层的相互作用)。近年来,与符合上述两种作用的溶液中的晶片表面上的颗粒粘附机制相关的研究蓬勃发展,并为阐明颗粒粘附机制做了大量工作。
2022-07-13 17:18:44 2382
2382 
电子发烧友网站提供《用于空气质量监测的PM2.5和PM10颗粒传感器模拟前端参考设计.zip》资料免费下载
2022-09-06 11:24:45 1
1 的常识。 在我们生活的环境下,空气中每时每刻都漂浮着大量的颗粒物质,它们被称为空气中的总悬浮颗粒(TSP),TSP就是空气污染物的主要成分。在TSP中,通常把直径在10微米以下的颗粒物称为PM10,又称为可吸入颗粒物或飘尘。可吸入颗
2022-09-16 14:06:34 5911
5911 
迪赛康DDR4/DDR5 Interposr测试板专门为内存颗粒测试设计,阻抗一致性优异,极低延迟,最高速率支持6.4Gbps,可以用于78pin和96pin/102pin封装的DDR4和DDR5颗粒测试。
2022-10-10 09:33:48 8531
8531 实验内容:设计一套精准的磁场操控平台,并制备两种不同类型磁性颗粒;研究了均匀型磁性颗粒在磁场下的成链的机理,给出成链模型,通过实验研究了不同因素对成链的影响。探索了一种新的流场显示方法,利用磁性纳米
2022-11-02 16:17:10 910
910 
情况。一般而言,“空气质量”旨在衡量城市污染,因此可跟踪颗粒物(2.5 微米或更小和 10 微米或更小)、一氧化碳、臭氧、氮氧化物和二氧化硫。对于野火烟雾污染,我们对颗粒物感兴趣,主要是 2.5 微米或更小的颗粒尺寸。颗粒浓度
2022-12-23 10:49:16 0
0 DRAM整体需求仍因库存压力影响着拉货动能,淡季以及砍单效应持续发酵,连带影响市场价格下跌走势更为显著,虽然DDR5颗粒稍有出现需求,但价格上仍无法满足客人目标,业界普遍认为,库存水位尚未调降前,皆无法有任何起色。
2023-02-17 10:53:45 569
569 摘 要:随着低碳经济的快速推进,人造石墨技术得到飞速的发展。国内外学者对人造石墨的包覆、石墨化、电化学及储锂机理进行了大量的研究,取得了丰硕的成果,但对粒度大小对电化学及储锂特性的影响研究较少。针对
2023-04-23 14:31:00 5024
5024 
清洗硅片(Wafer Clean)
清洗硅片的目的是去除污染物去除颗粒、减少针孔和其它缺陷,提高光刻胶黏附性
基本步骤:化学清洗——漂洗——烘干。
2023-04-25 11:09:40 6455
6455 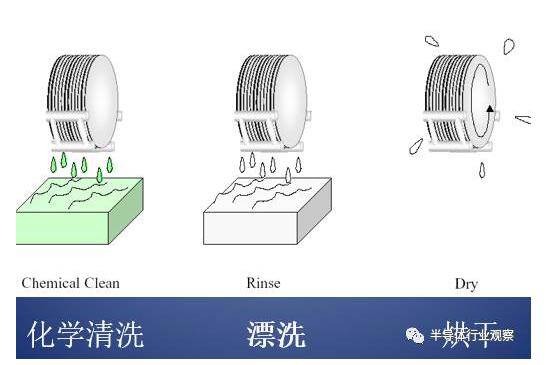
集成设备制造的缩小图案要求湿化学加工的表面清洁度和表面光滑度,特别是对于常见的清洁技术RCA清洁(SC-1和SC-2)。本文讨论了表面制备参数的特性和影响。
2023-05-06 14:25:04 1432
1432 
实验名称: 功率放大器在磁性微纳米颗粒微流体操控研究中的应用 实验内容: 设计一套精准的磁场操控平台,并制备两种不同类型磁性颗粒;研究了均匀型磁性颗粒在磁场下的成链的机理,给出成链模型,通过实验研究
2023-05-08 11:35:01 887
887 
,本文将简单讲述该磨料的工作机理。刀片组成部分示意图切削过程分三个阶段刀片起划切作用的是切削刃,切削刃上有无数个磨粒,正是这些磨粒对工件进行切削。01滑擦阶段切削
2021-11-15 18:32:07 1524
1524 
pm2.5颗粒物检测仪用哪种品牌好
2021-11-25 16:04:54 1544
1544 
实验名称:功率放大器在磁性微纳米颗粒微流体操控研究中的应用实验内容:设计一套精准的磁场操控平台,并制备两种不同类型磁性颗粒;研究了均匀型磁性颗粒在磁场下的成链的机理,给出成链模型,通过实验研究了
2022-12-12 09:40:29 1090
1090 
芯粒(chiplet)市场是整个芯粒领域最值得关注的话题之一。毫无疑问,技术问题会及时得到解决,例如芯粒裸片到裸片接口、创建良好的芯粒库格式,或是改善已知良好裸片的测试。但芯粒商业模式将何去何从,依然迷雾重重。理想的模式是:准备好一个IntelCPU芯粒、一个NVIDIAGPU芯粒、一
2023-10-21 08:13:40 1289
1289 
本文简单介去除晶圆表面颗粒的原因及方法。
在12寸(300毫米)晶圆厂中,清洗是一个至关重要的工序。晶圆厂会购买大量的高纯度湿化学品如硫酸,盐酸,双氧水,氨水,氢氟酸等用于清洗。
2024-11-11 09:40:02 2294
2294 法) RCA清洗是晶圆清洗的经典工艺,分为两个核心步骤(SC-1和SC-2),通过化学溶液去除有机物、金属污染物和颗粒124: SC-1(APM溶液) 化学配比:氢氧化铵(NH₄OH,28%)、过氧化氢(H₂O₂,30%)与去离子水(H₂O)的比例为1:1:5。 温度与时
2025-04-22 09:01:40 1289
1289 半导体清洗SC1是一种基于氨水(NH₄OH)、过氧化氢(H₂O₂)和去离子水(H₂O)的化学清洗工艺,主要用于去除硅片表面的有机物、颗粒污染物及部分金属杂质。以下是其技术原理、配方配比、工艺特点
2025-04-28 17:22:33 4240
4240 污染物。 方法:湿法化学清洗(如SC-1溶液)或超声波清洗。 硅片抛光后清洗 目的:清除抛光液残留(如氧化层、纳米颗粒),避免影响后续光刻精度。 方法:DHF(氢氟酸)腐蚀+去离子水冲洗。 2. 光刻工序 光刻胶涂覆前清洗 目的:去除硅
2025-07-14 14:10:02 1016
1016 小尺寸晶圆(2-6英寸):允许颗粒尺寸通常≥1μm,数量控制在<1000颗/cm²(具体取决于工艺节点)。部分应用(如功率器件)可接受更低标准,但需避免肉眼可见污
2025-07-22 16:54:43 1541
1541 
氧化层)选择对应的清洗方式。例如,RCA法中的SC-1溶液擅长去除颗粒和有机残留,而稀HF则用于精确蚀刻二氧化硅层。对于顽固碳沉积物,可能需要采用高温Piranha
2025-08-25 16:43:38 449
449 
标准清洗液SC-1是半导体制造中常用的湿法清洗试剂,其核心成分包括以下三种化学物质:氨水(NH₄OH):作为碱性溶液提供氢氧根离子(OH⁻),使清洗液呈弱碱性环境。它能够轻微腐蚀硅片表面的氧化层,并
2025-08-26 13:34:36 1157
1157 
按比例混合而成,常见配比为1:1:5至1:2:7(体积比)。核心作用:作为碱性溶液,主要用于去除颗粒、有机污染物及部分金属杂质。其机理在于双氧水的强氧化性分解有机
2025-09-11 11:19:13 1330
1330 
SC-1和SC-2可以一起使用,但需遵循特定的顺序和工艺条件。以下是其协同应用的具体说明:分步实施的逻辑基础SC-1的核心作用:由氨水(NH₄OH)、过氧化氢(H₂O₂)和水组成,主要去除硅片表面
2025-10-13 10:57:04 609
609 
制造良率与电学性能。本文将深入解析这两种溶液的作用机理与应用要点。以下是关于SC-1和SC-2两种清洗液能去除的杂质的详细说明:SC-1(碱性清洗液)颗粒污染物去
2025-10-13 11:03:55 1024
1024 
、湿法化学清洗RCA标准清洗(硅片常用)SC-1(碱性清洗):NH₄OH+H₂O₂+H₂O混合液,用于去除有机污染物和颗粒。DHF(稀释氢氟酸):HF:H₂O=1:
2025-12-10 13:45:30 323
323 
晶圆去胶后的清洗与干燥工艺是半导体制造中保障良率和可靠性的核心环节,需结合化学、物理及先进材料技术实现纳米级洁净度。以下是当前主流的工艺流程:一、清洗工艺多阶段化学清洗SC-1溶液(NH₄OH+H
2025-12-23 10:22:11 135
135 
UV三防漆固化后附着力强,难以直接去除,需根据基材类型、漆层面积及操作环境选择科学方法。常见去除方式主要有化学法、加热法与微研磨技术,操作时应以安全为首要原则,并尽量避免损伤基材与周边元器件。电子三
2025-12-27 15:17:19 165
165 



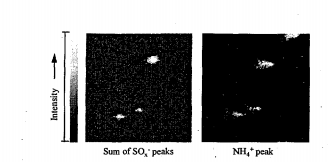
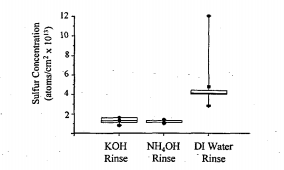
 电子发烧友App
电子发烧友App











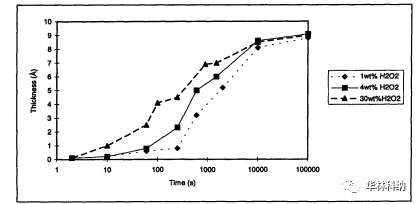
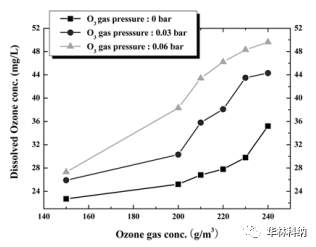

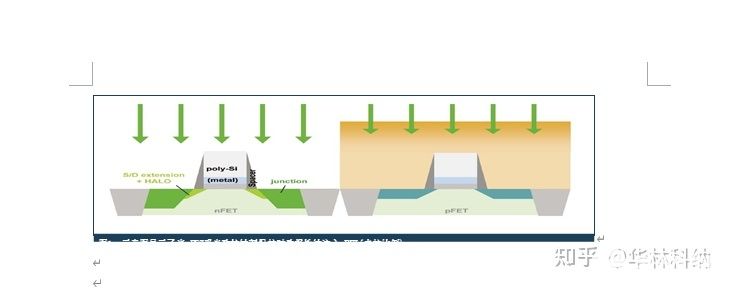
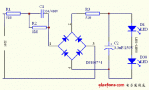




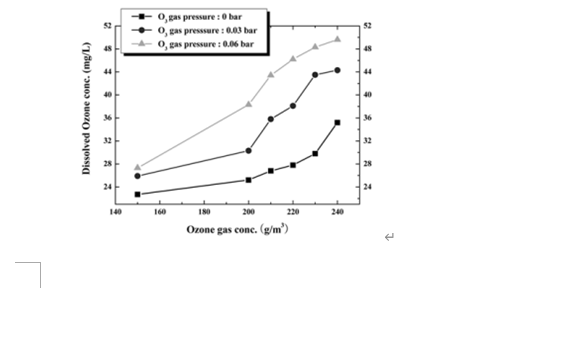
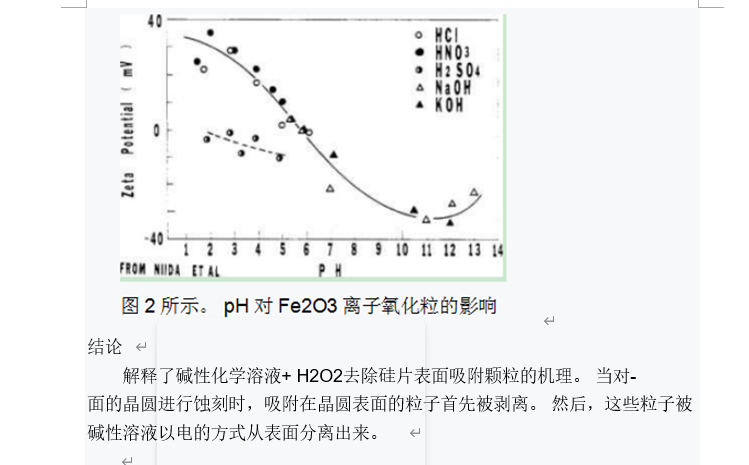


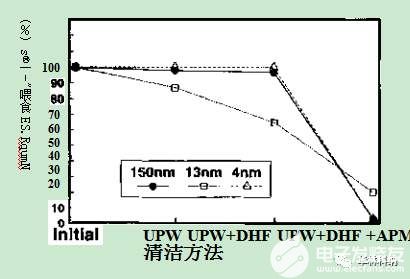
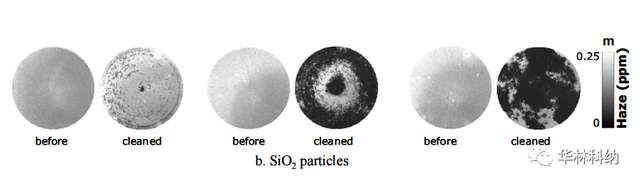
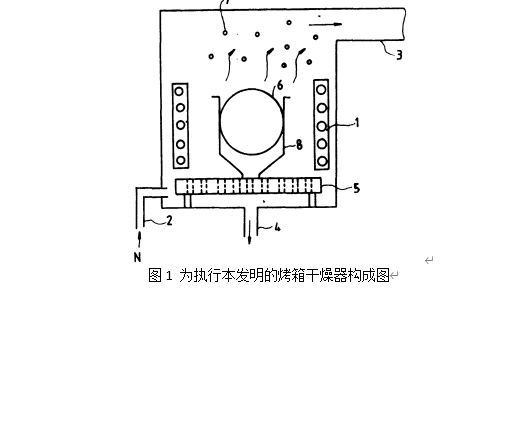



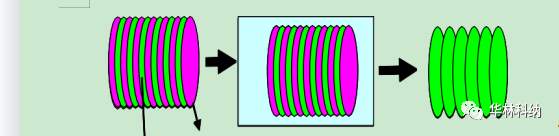


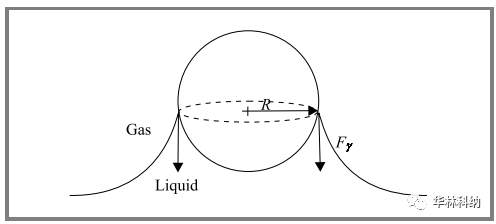
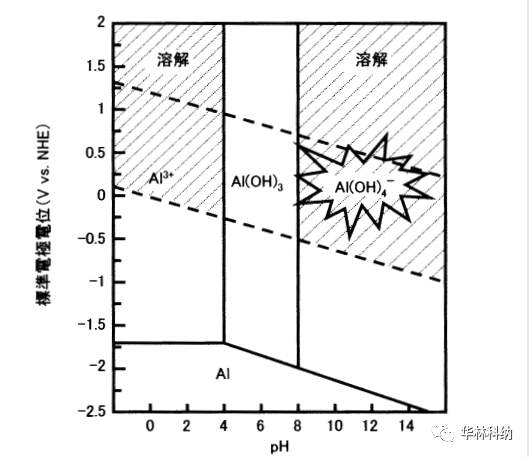

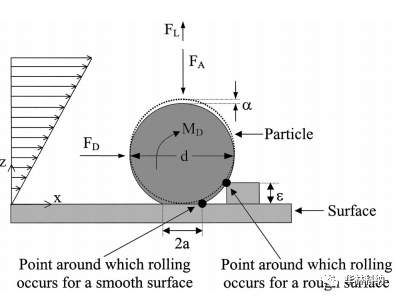
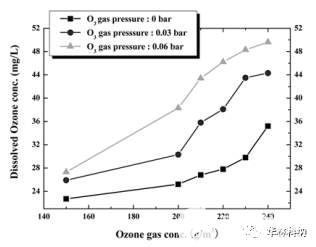



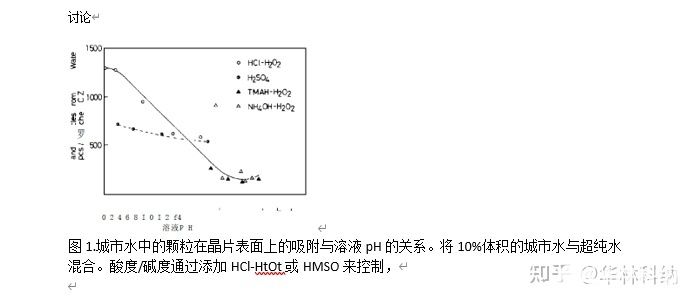



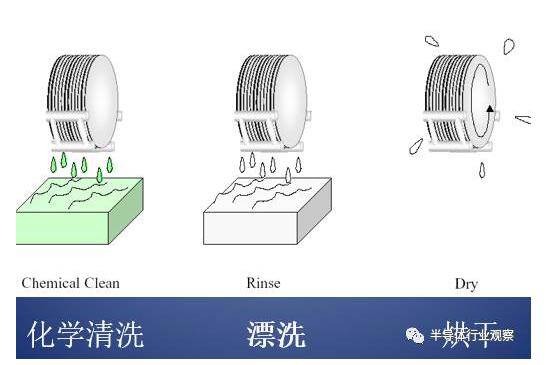

















评论