引言
SC-l和piranha(H2SO4/H2O2)清洁剂已经使用多年来去除颗粒和有机污染物。尽管SC-1清洁剂(通常与施加的兆频超声波功率一起使用)被认为对颗粒去除非常有效,但去除机制仍不清楚。对于去,除重有机污染物,piranha清洗是一个有效的过程;然而,piranha后残留物顽强地粘附在晶片表面,导致颗粒生长现象。已经进行了一系列实验来帮助理解这些过程与硅的相互作用。
实验
为了评估piranha清洗后晶片上残留的硫量,将150毫米n型裸硅和热氧化晶片在95 °C下通过5:1或10:1(氢、硫、氢、氧)piranha处理10分钟。对冲洗过程进行各种修改后,飞行时间二次离子质谱(TOF- SIMS)和全反射X射线荧光光谱法(TXRF)用于测量残留硫。清洗和干燥晶片后,还测量了作为时间函数的光点缺陷。当piranha被处理后晶片已经显示出颗粒生长现象。这些分析技术的数据用于评估各种冲洗技术的功效。
结果和讨论
在对SC-1化学物质的研究中,当稀释时,清洁效率与测量的开路电位或雾度增量之间没有明显的相关性。使用了SC-1化学物质。图1显示了基于去除硅钠颗粒的钳去除效率。 这些实验是在已知影响硅蚀刻的条件下进行的(n型和p型Si<100>, 有而疫有照明)。图2显示了相同的雾度增量数。
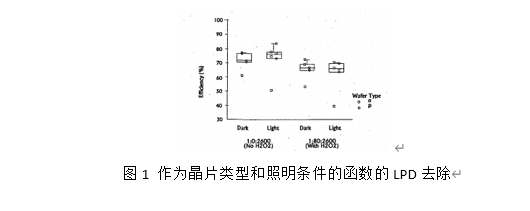
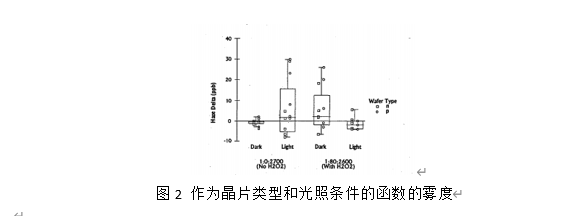
雾度值可能与表面粗糙度有关,这是由基础介质中优先的硅{100}蚀刻引起的。可以看出,有助于增加雾度以及蚀刻的条件与 颗粒移动效率的增加无关(见图1)。当在亲水晶片上使用不含H202的足够稀释的氨水溶液时,硅的碱性侵蚀和粗糙化最小,但是仍然有效去除颗粒获得。当疏水性裸硅片通过稀氨水溶液处理时,雾度明显增加。看来SC-1预清洗步骤产生的薄化学氧化物足以抑制在非常稀的氨水中对硅表面的碱性蚀刻。
这些数据表明硅的蚀刻不是有效清洁的必要条件。为了理解兆声在粒子去除中的物理机制,需要清洁浴中声压场的预测模型。使用射线追踪方法,计算的一维压力场与测量值进行比较,如图3所示。为了获得无反射的庄力測量值,实验传感器以脉冲模式工作,脉沛持续时间约为50微秒。该建模方法与测量值吻合良好,可用于预测各种槽几何形状中的压力场,并 最终可用于优化未来工具中的清洗槽几何形状。
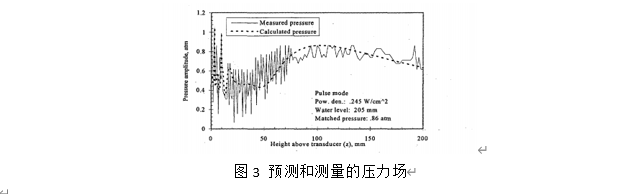
过氧化硫酸(piranha)冲洗:
经过piranha清洗后,清洗后残留在晶圆上的硫污染物会顽强地附着在硅表面。当晶片暴露在洁净室空气中时,这种残留的硫会随着时间的推移产生颗粒污染。
图4所示的piranha清洗过的晶片的TOF-SIMS负离子和正离子图像图表明,颗粒由SOx”和 NH4组成。已经发现,向piranha后冲洗浴中加入少量氢氧化铉(例如,足以达到 pH = 10)可有效降低硫的表面浓度,以及减轻piranha引起的颗粒生长。通过全反射x射线荧光(TXRF)测量的硫浓度显示在图5中,用于基本漂洗和去离子水中漂洗。
总结
表面敏感技术被用来研究SC-1对硅片的化学效应。颗粒去除效率不一定取决于表面改性现象,如蚀刻或钝化。为了研究兆频超声波清洗的物理效应,正在开发计算和实验模型。这种模型将允许浴缸制造商根据第一原则计算清洁性能。
按照piranha清洗和冲洗顺序,硅晶片表面会残留硫。当晶片储存在洁净室环境中时,这种残留物会形成颗粒物质。TOF-SIMS被用来确定这些颗粒是硫酸—铉。在piranha之后使用碱性漂洗剂(例如,pH = 10)可有效降低残留硫浓度 ,从而抑制随时间变化的颗粒形成。
审核编辑:汤梓红
-
数据
+关注
关注
8文章
7349浏览量
95025 -
晶片
+关注
关注
1文章
413浏览量
33004 -
测量
+关注
关注
10文章
5725浏览量
116981
发布评论请先 登录
氧化铝造粒粉
UV三防漆固化后怎么去除?

晶圆去胶后清洗干燥一般用什么工艺

衬底清洗全攻略:从湿法到干法,解锁半导体制造的“洁净密码”

湿法清洗机原理:化学溶解与物理作用的协同清洁机制

sc-1和sc-2可以一起用吗

标准清洗液sc1成分是什么




 SC-1颗粒去除和piranha后漂洗的机理研究
SC-1颗粒去除和piranha后漂洗的机理研究








评论