引言
在未来几代器件中,光刻胶(PR)和残留物的去除变得非常关键。在前端制程(FEOL)离子注入后(源极/漏极、扩展、haIos、深阱),使用PR封闭部分电路导致PR实质上硬化且难以去除。在后段制程(BEOL)蚀刻中,在不去除低k材料的情况下去除抗蚀剂和残留物的选择性是非常具有挑战性的。概述了现状、问题和一些新的方法。
介绍
光致抗蚀剂用于保护晶片的某些区域免受干蚀刻化学物质、离子注入等的影响。工艺完成后,需要选择性地去除光致抗蚀剂并清洁表面,以确保表面没有残留物和颗粒。原则上,使用湿化学物质如热SPM、有机溶剂或通过使用干等离子体的“灰化”去除抗蚀剂是可能的。然而,在干法蚀刻或注入处理过程中,抗蚀剂会发生化学改性,这种改性会显著降低剥离速率。如果更具侵略性-例如,使用高度氧化的化学物质,这可能导致晶片上其他材料的不希望的侵蚀。虽然这些考虑几十年来,对于单元工艺开发非常重要,对于45纳米技术节点和更高技术节点的某些iTRS路线图要求变得越来越严格,以至于工业实验室正在考虑对cMOS集成流程的几个模块进行根本性的范式转变。同时,新的替代集成方案,包括使用应变硅、金属硬掩模和金属栅电极,导致不同的要求。这使得对这一主题的研究更加复杂。
在下文中,我们华林科纳总结了现状、问题和新方法,重点关注FEOL中的源漏注入模块和BEOL的低k干法刻蚀模块。
FEOL:植入后抗蚀剂剥离
源极-漏极注入模块场效应晶体管的源极/漏极(S/D)结是通过将掺杂剂离子注入硅衬底而形成的。这种注入通常涉及离子as、P、B或BF2的面密度约为。1012到几个1015cm。离子能量的范围从非常浅的S/D扩展的几100eV到深注入的几十keV。为了确保在同一芯片/晶片上制造的各种器件,特别是nFETs和pFETs,每个器件只接受适当的注入,需要进行选择性注入。这是通过用图案化的光致抗蚀剂进行掩蔽来实现的,如图1示意性所示。因此,S/D区域中复杂的掺杂剂几何形状是通过光致抗蚀剂应用和图案化、离子注入、抗蚀剂剥离和表面清洁的循环产生的。
注入抗蚀剂的离子导致近表面区域的化学改性。抗蚀剂聚合物的化学键被来自撞击离子的能量破坏,这会导致聚合物主链断裂。
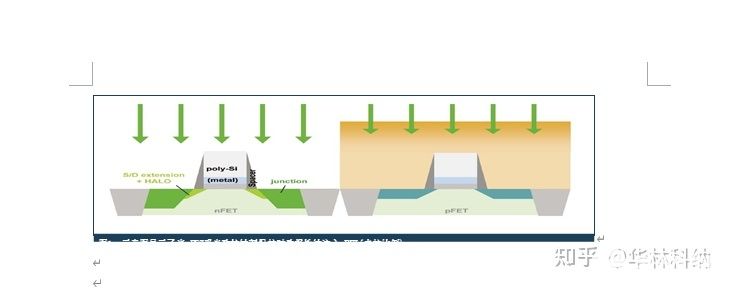
结论
开发下一代光刻胶剥离剂和残留物去除剂并不容易。它来自于大量的辛勤工作和致力于创造一种满足90纳米节点或以下技术需求的化学。
我们最新的化学技术可有效去除low-电介质上的大块光刻胶、灰渣和抗反射涂层。它还是100%水溶性的,是一种更加环保的解决方案。
-
蚀刻
+关注
关注
10文章
431浏览量
16696 -
晶片
+关注
关注
1文章
413浏览量
33024 -
光刻胶
+关注
关注
10文章
358浏览量
31906
发布评论请先 登录
使用超临界二氧化碳剥离碳化光刻胶的实验
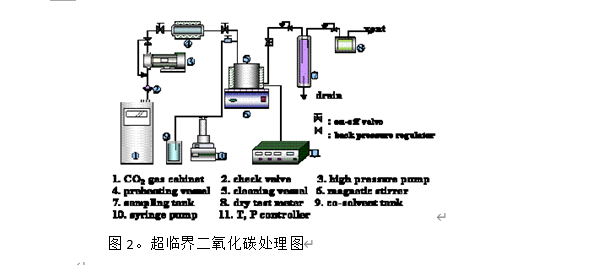
多晶硅蚀刻残留物的的形成机理
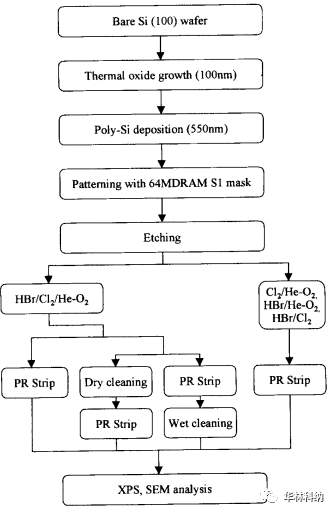
Futurrex高端光刻胶
光刻胶残留要怎么解决?
光刻胶在集成电路制造中的应用
《炬丰科技-半导体工艺》光刻前 GaAs 表面处理以改善湿化学蚀刻过程中的光刻胶附着力和改善湿蚀刻轮廓
Mattson利用欧洲的IMEC为低k/铜工艺开发光刻胶去除技术
使用湿化学物质去除光刻胶和残留物
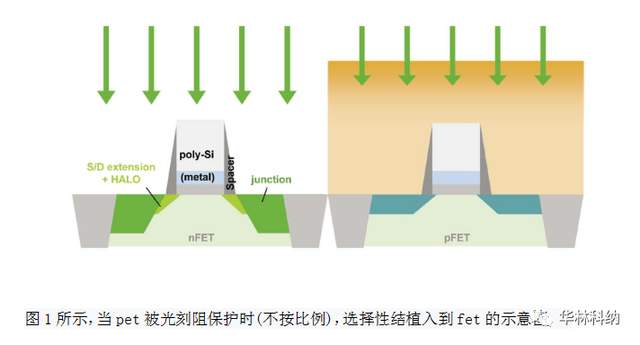



 蚀刻后残留物和光刻胶的去除方法
蚀刻后残留物和光刻胶的去除方法

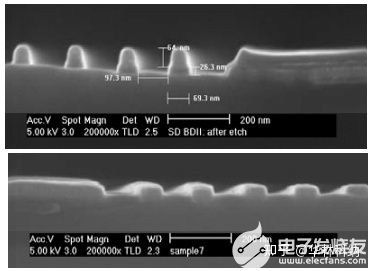
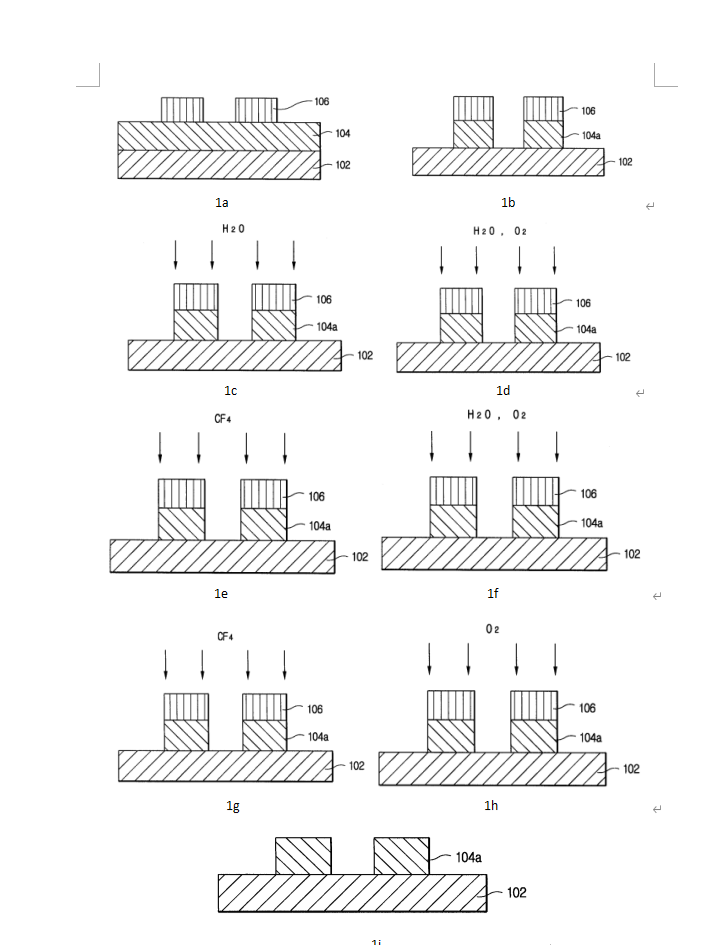
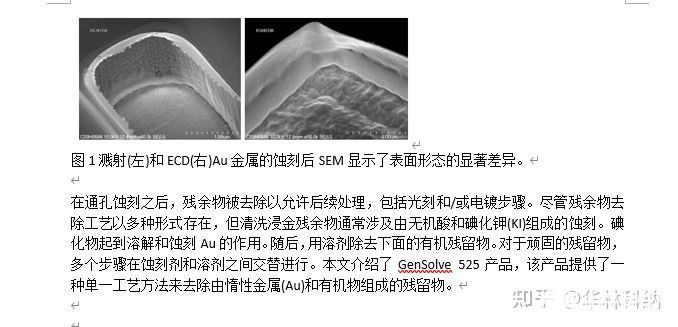





评论