摘要
研究了在半导体制造过程中使用的酸和碱溶液从硅片表面去除粒子。结果表明,碱性溶液的颗粒去除效率优于酸性溶液。在碱性溶液中,颗粒去除的机理已被证实如下:溶液腐蚀晶圆表面以剥离颗粒,然后颗粒被电排斥到晶圆表面。实验结果表明,需要0.25 nm /min以上的刻蚀速率才能使吸附在晶圆表面的颗粒脱落。
介绍
由于半导体器件正在追求更高水平的集成度和更高分辨率的模式,ET清洁技术对于重新移动硅片表面的污染物仍然至关重要。在1970年提出的RCA清洗工艺作为一种湿式清洗技术在世界各地仍在使用,以去除晶圆表面的污染物。虽然RCA净化过程中,NH4OH-H2O2-H2O溶液对颗粒的去除效果非常好,但其颗粒去除机理尚不完全清楚。
实验
采用五英寸CZ(1,0,0)晶片进行粒子吸附实验。天然氧化物首先在0.5%的HF溶液中从晶圆表面去除。然后将晶片浸泡在含有颗粒的各种溶液中10分钟,然后冲洗和干燥。天然氧化物在晶圆表面形成后,再在0.5%的HF溶液中移动,然后清洗和干燥。
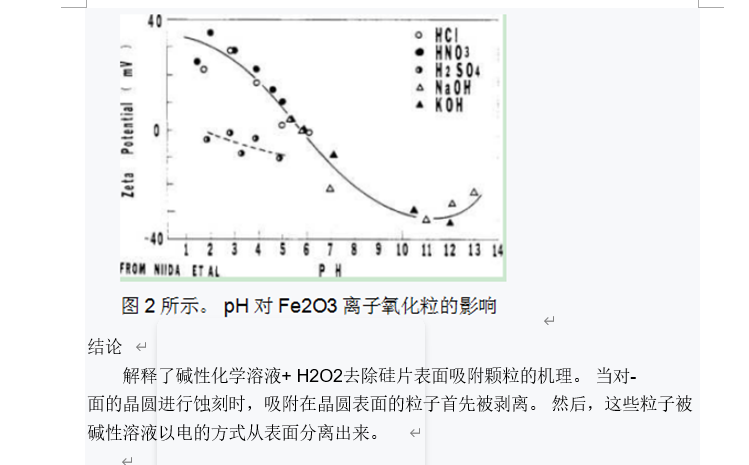
审核编辑:汤梓红
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
半导体
+关注
关注
339文章
31236浏览量
266493 -
晶圆
+关注
关注
53文章
5449浏览量
132754 -
制造
+关注
关注
2文章
562浏览量
24857
发布评论请先 登录
相关推荐
热点推荐
衬底清洗全攻略:从湿法到干法,解锁半导体制造的“洁净密码”
衬底清洗是半导体制造、LED外延生长等工艺中的关键步骤,其目的是去除衬底表面的污染物(如颗粒、有机物、金属离子、氧化层等),确保后续薄膜沉积

湿法清洗过程中如何防止污染物再沉积
在湿法清洗过程中,防止污染物再沉积是确保清洗效果和产品质量的关键。以下是系统化的防控策略及具体实施方法:一、流体动力学优化设计1.层流场构建技术采用低湍流度的层流喷淋系统(雷诺数Re9),同时向溶液

半导体哪些工序需要清洗
半导体制造过程中,清洗工序贯穿多个关键步骤,以确保芯片表面的洁净度、良率和性能。以下是需要清洗的主要工序及其目的: 1. 硅片准备阶段
超声波清洗机如何在清洗过程中减少废液和对环境的影响?
超声波清洗机如何在清洗过程中减少废液和对环境的影响随着环保意识的增强,清洗过程中的废液处理和环境保护变得越来越重要。超声波清洗机作为一种高效的清洗

wafer清洗和湿法腐蚀区别一览
步骤,以下是两者的核心区别: 1. 核心目的不同 Wafer清洗:主要目的是去除晶圆表面的污染物,包括颗粒、有机物、金属杂质等,确保晶圆表面



 湿法清洗过程中硅片表面颗粒的去除
湿法清洗过程中硅片表面颗粒的去除






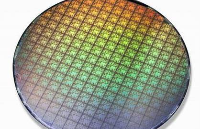





评论