本文对晶片采用HF溶液洗净的晶片氢氟酸处理后的护发素及干燥方法,使用异丙基去除上述晶片表面残存的HF的步骤,关于晶片氢氟酸处理后的护发素和干燥方法,其特点是在对上述晶片施加82-84℃温度的同时通过吹氮气去除晶片表面IPA的步骤,通过使用IPA护发素代替纯护发素,不仅可以去除杂质,而且在经过氢氟酸处理后暴露在晶片表面的疏水区域也可以充分涂布IPA。通过采用本发明的烤箱干燥方式,可以抑制干燥时局部干燥时间差所产生的水迹,比传统的IPA气相干燥方式简单,具有突破性地降低成本的效果。
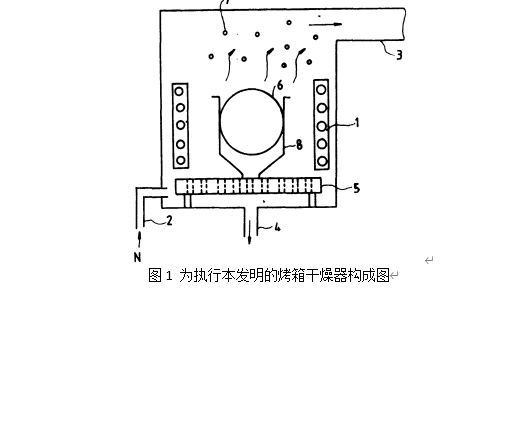
审核编辑:符乾江
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
工业
+关注
关注
3文章
2432浏览量
49339 -
电镀
+关注
关注
16文章
478浏览量
25893
发布评论请先 登录
相关推荐
热点推荐
如何选择适合12英寸大硅片抛光后清洗的化学品
针对12英寸大硅片抛光后的清洗,化学品选择需兼顾污染物类型、硅片表面特性、工艺兼容性、环保安全等多重因素,核心目标是实现高洁净度、低表面损伤,并适配后续工艺需求。以下从核心维度拆解选择逻辑,结合行业

晶圆去胶后清洗干燥一般用什么工艺
晶圆去胶后的清洗与干燥工艺是半导体制造中保障良率和可靠性的核心环节,需结合化学、物理及先进材料技术实现纳米级洁净度。以下是当前主流的工艺流程:一、清洗工艺多阶段化学清洗SC-1溶液(NH₄OH+H

晶圆清洗后保存技术指南:干燥、包装与环境控制要点
晶圆清洗后的保存需严格遵循环境控制、包装防护及管理规范,以确保晶圆表面洁净度与性能稳定性。结合行业实践与技术要求,具体建议如下:一、干燥处理与环境控制高效干燥工艺旋转甩干(SRD):通

晶圆清洗后如何判断是否完全干燥
判断晶圆清洗后是否完全干燥需要综合运用多种物理检测方法和工艺监控手段,以下是具体的实施策略与技术要点:1.目视检查与光学显微分析表面反光特性观察:在高强度冷光源斜射条件下,完全干燥的晶

硅片酸洗过程的化学原理是什么
硅片酸洗过程的化学原理主要基于酸与硅片表面杂质之间的化学反应,通过特定的酸性溶液溶解或络合去除污染物。以下是其核心机制及典型反应:氢氟酸(HF)对氧化层的腐蚀作用反应机理:HF是唯一能高效蚀刻

硅片酸洗单元如何保证清洗效果
硅片酸洗单元保证清洗效果的核心在于精准控制化学反应过程、优化物理作用机制以及实施严格的污染防控。以下是具体实现路径:一、化学反应的精确调控1.配方动态适配性根据硅片表面污染物类型(如金属杂质、天然

判定高电阻率硅的导电类型:基于氢氟酸HF处理结合扩展电阻SRP分析的高效无损方法
一个挑战。传统方法如表面光电压(SPV)法受限于表面条件和低载流子浓度。本文提出了一种结合氢氟酸(HF)处理与扩展电阻分布分析(SRP)的新方法,通过借助Xfil

晶圆清洗后的干燥方式介绍
晶圆清洗后的干燥是半导体制造过程中至关重要的环节,其核心目标是在不引入二次污染、不损伤表面的前提下实现快速且均匀的脱水。以下是几种主流的干燥技术及其原理、特点和应用场景的详细介绍:1.旋转甩干
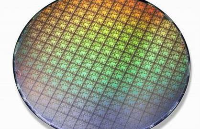
湿法腐蚀工艺处理硅片的原理介绍
湿法腐蚀工艺处理硅片的核心原理是基于化学溶液与硅材料之间的可控反应,通过选择性溶解实现微纳结构的精密加工。以下是该过程的技术要点解析:化学反应机制离子交换驱动溶解:以氢氟酸(HF)为例,其电离产生
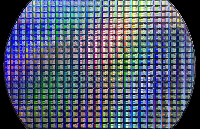
晶圆清洗后的干燥方式
晶圆清洗后的干燥是半导体制造中的关键步骤,其核心目标是在不损伤材料的前提下实现快速、均匀且无污染的脱水过程。以下是主要干燥方式及其技术特点:1.旋转甩干(SpinDrying)原理:将清洗后

半导体哪些工序需要清洗
污染物。 方法:湿法化学清洗(如SC-1溶液)或超声波清洗。 硅片抛光后清洗 目的:清除抛光液残留(如氧化层、纳米颗粒),避免影响后续光刻精度。 方法:DHF(



 硅片氢氟酸处理后的漂洗干燥方法
硅片氢氟酸处理后的漂洗干燥方法







评论