引言
用半导体制造中的清洗过程中使用的酸和碱溶液研究了硅片表面的颗粒去除。
在本文报道的研究中,我们华林科纳基于颗粒吸附在晶片表面的机理,研究了去除吸附在水表面的颗粒的机理。在颗粒去除实验中,用湿法清洗工艺中使用的酸性和碱性溶液清洗了人工污染的单晶提拉法和FZ法晶片。已经证明,就颗粒去除效率而言,碱性溶液优于酸性溶液。据认为,由于碱性溶液中大多数颗粒的ζ电位为负,颗粒被晶片表面电排斥。
除了从胶体化学的角度进行研究之外,我们认为检查由碱性溶液引起的晶片表面腐蚀也是很重要的。为此,研究了腐蚀速率和微粒去除效率之间的关系。使用直拉和FZ晶片。此外,用聚苯乙烯乳胶球代表有机物,研究了在NH,OH-H2O,-H2O溶液中的氧化过程,以找出氧化程度与颗粒物去除率之间的关系。结果,它已经被显示应该将NH4 H-HOOK-H2O溶液中的NH,OH含量降低到常规水平的1 /20,以优化颗粒去除效率。本文的剩余部分将描述实验性pro-的细节cess和结果。
英寸CZ ( 1,0,0)晶片用于粒子吸附实验。自然氧化物首先在0。5 Y HF溶液。然后将晶片浸入各种接种有颗粒的溶液中10分钟,然后冲洗并干燥。在晶片表面形成自然氧化物后,在0.5的氢氟酸溶液中再次去除,然后清洗并干燥。
五英寸锆石(1。0.0)和四英寸FZ ( 1,0,0)晶片用于清洗实验以研究颗粒去除。使用以下污染源对晶片进行人工污染:对于典型的液相颗粒,在城市水中自然成浆的颗粒,对于典型的气相颗粒,在洁净室外部的环境大气中自然成浆的颗粒,直径为0.3 pm和1.0 qm的二氧化硅球作为典型的无机颗粒,直径为0.506 pm的聚苯乙烯乳胶球作为典型的有机颗粒。通过浸入含有上述颗粒之一的高酸性溶液中,晶片被污染。其他晶片由于暴露在洁净室外部的环境空气中而被污染。通过这些程序。将表面上具有总共5000-10000个缺陷的晶片准备用于清洗实验,这些缺陷被分类为雾度(< 0.5 μm)或颗粒(> 0.5 μm)。
这些晶片在以下化学药品中清洗:
a)NH,OH-H,-HCO溶液:29 7 NH4OH。在80℃时,HCO = x:1:5;
b)TMAH(氢氧化四甲铵)-H;80℃时,O2- H2O溶液:2.38升或209‹tmah:30 9 hjo:HCO = x:y:z;
c)HzSO4-H,Ot溶液:97 $ r h2so 4:30 HCO,=和NH OH-HCO,或TMAH-HCO;
120℃左右为4:1;
d)盐酸、氧气、H2O溶液:369盐酸:30 9 H2O:H2O
= 1 : 1 : 6,温度为80—90摄氏度;
e)HF-H2 * H2溶液[12],[13]: 50 HF : 30 7‹
h;25°C时Oz: H,O = 1:33:66;
I) HCO-HCO解:30到H2 HCO = 1:0摄氏度
在硫酸-氢氟酸溶液中,将晶片浸入5分钟。在所有其他溶液中,晶片被浸没10分钟。化学清洗后,用超纯水冲洗晶片十分钟。为了避免晶片干燥过程中的颗粒污染,在化学清洗过程中形成的天然氧化物在0.5到HF的溶液中被去除。重新后移动天然氧化物,再次用超纯水冲洗晶片10分钟。清洁效果通过颗粒去除效率来评估。通过计算清洗前后的颗粒数比率来评估颗粒去除效率。
使用Aeronca WlS-100晶片检测系统评估所有晶片上的颗粒数。WIS- 100将检测尺寸分为颗粒(> 0.5 qm)和雾度I < 0.5 pm)。实验前,WIS- 100用相对标准晶片校准。在实验之前,每瓶水的初始粒子数少于50。
上述实验程序是在湿站人工进行的。至于清洗槽的材料,HF清洗和超纯水冲洗使用PFA清洗槽,而其他化学清洗使用石英清洗槽。PFA载体用于将晶片浸入浴槽中,并将它们从一个浴槽运送到另一个浴槽。这些测试中使用的化学品都是ULSI级和低粒子浓度。
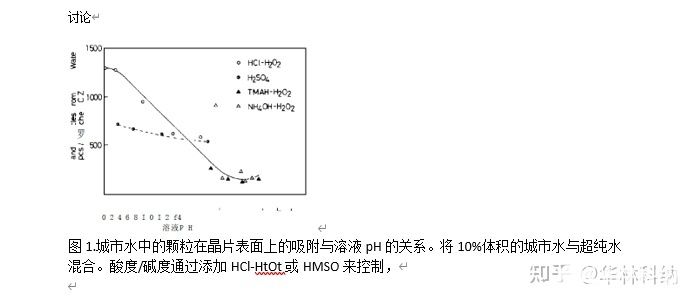
图1显示了溶液pH值和吸附在水表面的颗粒数量之间的关系。将10至10体积的自来水加入到每种测试溶液中提翁。在酸性溶液中,用HCl和H2O 2或h2so 4调节溶液pH,用NH4OH和H2O 2或TMAH和H2O调节溶液pH;在碱性溶液中。在低pH值溶液中观察到最大的颗粒吸附,吸附的颗粒数量随着溶液pH值的增加而减少。图2还显示了众所周知的pH值对Fe,O3颗粒ζ电势的影响。可以看出图1两条曲线几乎完全吻合。据报道,晶片表面上吸附的SiOz球或聚苯乙烯乳胶球的数量随着溶液pH值的增加而减少,如所示图1.通常,在碱性溶液中,大多数颗粒的ζ电位被认为是负的。特别是,根据胶体化学[14]中的下列方程,金属氧化物颗粒的ζ电势在酸性溶液中为正,在碱性溶液中为负
低pH值:M-OH+H "+OH
-- M-OH;+ OH高pH值:M — OH + H" + OH
m-OH * H "+OH
-- M-O+HCO+H
此外,据报道,亲水性(覆盖有氧化膜)和疏水性(裸硅表面)晶片在水中都表现出负表面电荷。将这些观察结果与图1所示的结果联系起来,据信在碱性溶液中,晶片表面和颗粒的ζ电势都显示出负电荷。结果,晶片表面和颗粒被认为在碱性溶液中是电排斥的。这表明碱性溶液是有益的用于从晶片表面去除颗粒。B.晶片清洗高压碱性溶液RCA清洗方法[2]是一种主要的湿法硅晶片清洗方法,它采用nh4h-H2 2”H2O溶液作为碱性溶液。氨水-二H2O溶液通常采用1 : 1 : 5的混合比(氨水:HCO:氢)。图3显示了NH4 H-Hz z-H溶液中各种NH4OH含量与溶液pH值之间的关系。如图3所示,1∶1∶5溶液的pH值为
9. 然而,图1和2所示的结果表明NH4OH-H2O ‖- H中的NH4OH含量;o如果溶液专门用于去除颗粒,则可以减少。
审核编辑:汤梓红
-
半导体
+关注
关注
339文章
31560浏览量
267990 -
晶片
+关注
关注
1文章
413浏览量
33045 -
硅片
+关注
关注
13文章
422浏览量
35861
发布评论请先 登录
衬底清洗全攻略:从湿法到干法,解锁半导体制造的“洁净密码”

标准清洗液sc1成分是什么




 湿法清洗中去除硅片表面的颗粒
湿法清洗中去除硅片表面的颗粒






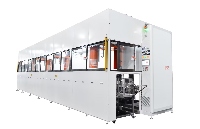








评论