在现代高科技产业如半导体和新能源领域,厚度低于一微米的薄膜被广泛应用,其厚度精确测量是确保器件性能和质量控制的核心挑战。面对超薄、多层、高精度和非破坏性的测量需求,传统的接触式或破坏性方法已难以胜任
2025-12-22 18:04:28 1088
1088 
Structure) 时存在天然物理瓶颈。本白皮书论述了光谱共焦(Chromatic Confocal)位移传感器技术原理,并依据 LTC系列产品的技术规格,为半导体行业的关键测控环节提供量得准、测得快的选型指导与解决方案。
2025-12-21 19:01:03 219
219 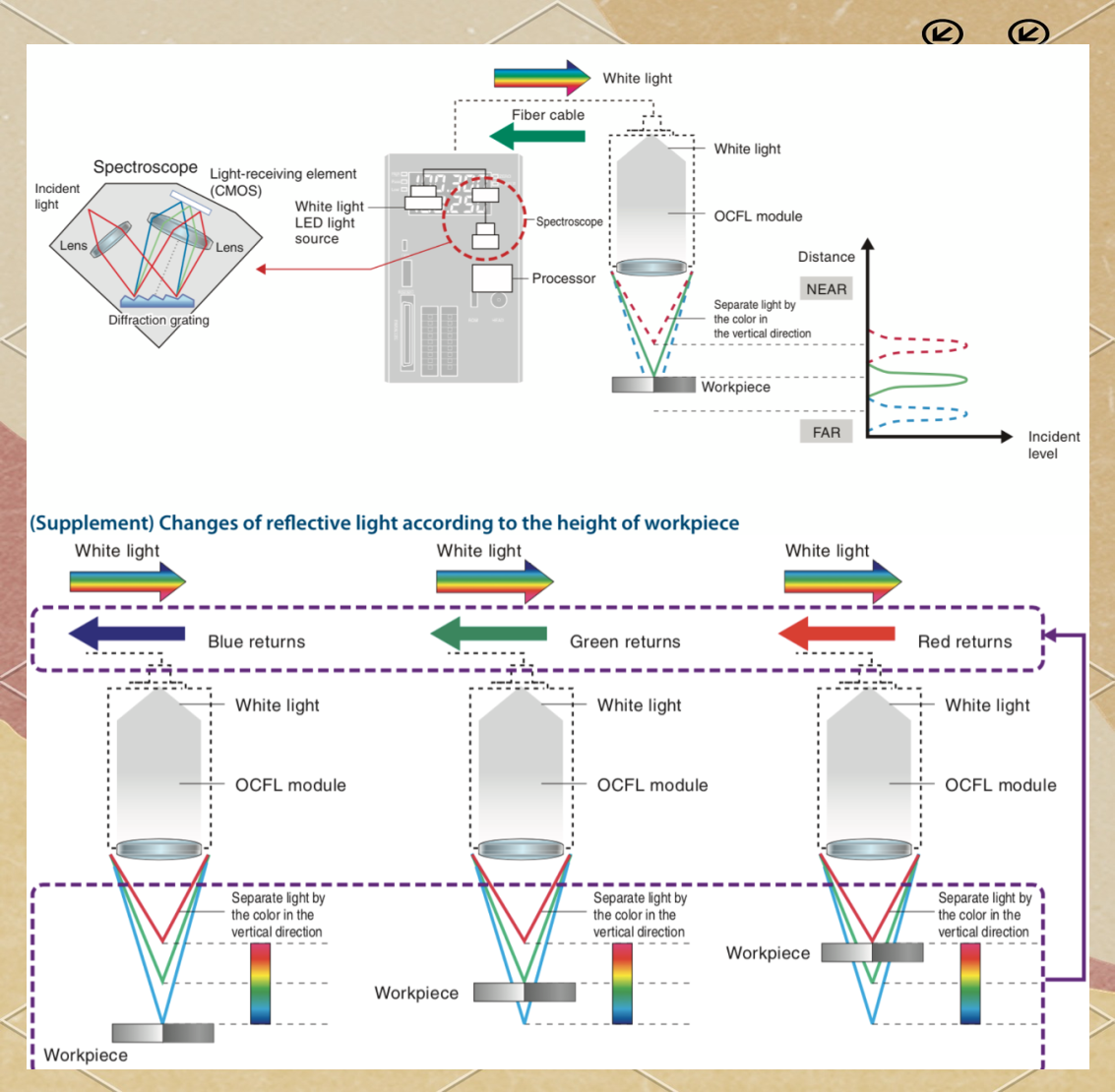
传统椭偏测量在同时确定薄膜光学常数(复折射率n,k)与厚度d时,通常要求薄膜厚度大于10nm,这限制了其在二维材料等超薄膜体系中的应用。Flexfilm全光谱椭偏仪可以非接触对薄膜的厚度与折射率
2025-12-08 18:01:31 237
237 
传统检测方式面临挑战: × 接触损伤风险 :传统接触式测量易划伤光学膜层 × 数据可靠性低 :高反光与透明层叠结构使传统光学测量受干扰 × 多层测量难 :偏振片的多层复合结构使单层厚度测量困难 × 生产效率低 :难以适配高速产
2025-12-04 08:10:33 157
157 
共焦测量技术作为一种非接触式光学测量方法,因其高精度和抗干扰能力强等特点,逐渐成为精密测量领域的研究热点。本文首先从物理光学与信息论角度解释其原理;其次阐述海伯森
2025-11-07 17:22:06 669
669 
随着半导体芯片制造精度进入纳米尺度,薄膜厚度的精确测量已成为保障器件性能与良率的关键环节。光谱椭偏仪虽能实现埃米级精度的非接触测量,但传统设备依赖宽带光源与光谱分光系统,存在测量效率低、系统复杂且易
2025-11-03 18:04:06 220
220 
01啤酒瓶身厚度测量难点啤酒瓶作为典型的高透明曲面容器,其厚度检测长期受限于材料特性与工业环境的双重制约,具体难点包括:表面光学干扰:玻璃的高透明度导致传统光学设备面临"双重困境"
2025-10-27 08:17:30 279
279 
共焦测量技术作为一种非接触式光学测量方法,因其高精度和抗干扰能力强等特点,逐渐成为精密测量领域的研究热点。
2025-10-24 16:49:21 1232
1232 
在电子电气系统中,共模电压是影响系统稳定性、电磁兼容性(EMC)以及设备安全的关键因素之一。 准确测量共模电压对于分析系统故障、优化电路设计以及保障设备可靠运行至关重要。 本文将从共模电压的基本概念
2025-10-14 09:13:28 799
799 
一、引言
玻璃晶圆总厚度偏差(TTV)测量数据的准确性,对半导体器件、微流控芯片等产品的质量把控至关重要 。在实际测量过程中,数据异常情况时有发生,不仅影响生产进度,还可能导致产品质量隐患 。因此
2025-09-29 13:32:12 460
460 
我将从超薄玻璃晶圆 TTV 厚度测量面临的问题出发,结合其自身特性与测量要求,分析材料、设备和环境等方面的技术瓶颈,并针对性提出突破方向和措施。
超薄玻璃晶圆(
2025-09-28 14:33:22 338
338 
一、引言
碳化硅(SiC)作为宽禁带半导体材料的代表,在功率器件、射频器件等领域发挥着关键作用。总厚度偏差(TTV)是衡量碳化硅衬底及外延片质量的重要指标,其精确测量对保障碳化硅器件性能至关重要
2025-09-22 09:53:36 1555
1555 
Wafer厚度、表面粗糙度、三维形貌、单层膜厚、多层膜厚。1、使用光谱共焦对射技术测量晶圆Thickness、TTV、LTV、BOW、WARP、TIR、SORI等参数,同
2025-09-17 16:05:18
一、引言
碳化硅(SiC)凭借优异的物理化学性能,成为功率半导体器件的核心材料。总厚度偏差(TTV)作为衡量 SiC 衬底质量的关键指标,其精确测量对器件性能和可靠性至关重要。然而,碳化硅独特
2025-09-16 13:33:13 1573
1573 
三维形貌膜厚测量系统自动测量Wafer厚度、表面粗糙度、三维形貌、单层膜厚、多层膜厚。1、使用光谱共焦对射技术测量晶圆Thickness、TTV、LTV、BOW、
2025-09-11 16:41:24
一、引言
碳化硅(SiC)作为宽禁带半导体材料,在功率器件、射频器件等领域应用广泛。总厚度偏差(TTV)是衡量碳化硅衬底质量的关键指标,准确测量 TTV 对保障器件性能至关重要。目前,探针式和非接触
2025-09-10 10:26:37 1011
1011 
薄膜厚度的测量在芯片制造和集成电路等领域中发挥着重要作用。椭偏法具备高测量精度的优点,利用宽谱测量方式可得到全光谱的椭偏参数,实现纳米级薄膜的厚度测量。Flexfilm全光谱椭偏仪可以非接触对薄膜
2025-09-08 18:02:42 1463
1463 
水冷板覆膜厚度测量难点环境振动干扰测量稳定性:产线高频振动易致测量数据漂移,重复性差,难以保证覆膜厚度测量的一致性。膜厚差异与结构复杂性:水冷板存在多种厚度规格,且表面常有坡度、凹槽等复杂形貌,对传
2025-09-08 08:17:13 898
898 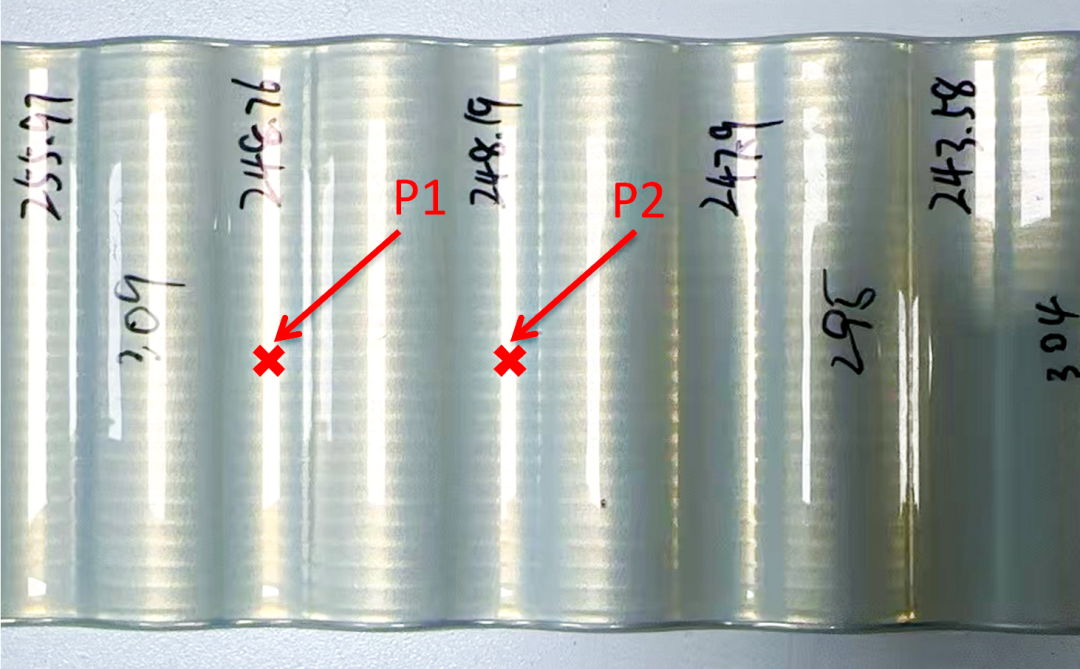
工业测量的终极目标不是追求极致精度,而是实现恰到好处的质量控制。光子精密 CD-5000 与 PDH 系列的技术分化,正体现了这一理念 —— 在高精度与高效率之间,为每个制造场景找到最优解。随着智能
2025-09-05 08:00:00 1007
1007 
摘要
本文围绕便携式碳化硅衬底 TTV 厚度测量设备,深入分析其测量精度、速度、便携性等性能指标,并结合半导体生产车间、科研实验室、现场检测等场景,探讨设备的适用性,旨在为行业选择合适的测量设备提供
2025-08-29 14:43:09 993
993 
摘要
本文聚焦碳化硅衬底 TTV 厚度不均匀性测量需求,分析常规采样策略的局限性,从不均匀性特征分析、采样点布局优化、采样频率确定等方面提出特殊采样策略,旨在提升测量效率与准确性,为碳化硅衬底
2025-08-28 14:03:25 545
545 
摘要
本文聚焦碳化硅衬底 TTV 厚度不均匀性测量需求,分析常规采样策略的局限性,从不均匀性特征分析、采样点布局优化、采样频率确定等方面提出特殊采样策略,旨在提升测量效率与准确性,为碳化硅衬底
2025-08-27 14:28:52 995
995 
摘要
本文针对碳化硅衬底 TTV 厚度测量中存在的边缘效应问题,深入分析其产生原因,从样品处理、测量技术改进及数据处理等多维度研究抑制方法,旨在提高 TTV 测量准确性,为碳化硅半导体制造提供可靠
2025-08-26 16:52:10 1092
1092 
摘要
本文聚焦碳化硅衬底 TTV 厚度测量数据处理环节,针对传统方法的局限性,探讨 AI 算法在数据降噪、误差校正、特征提取等方面的应用,为提升数据处理效率与测量准确性提供新的技术思路。
引言
在
2025-08-25 14:06:16 545
545 
WD4000晶圆厚度翘曲度测量系统兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV
2025-08-25 11:29:30
本文围绕探针式碳化硅衬底 TTV 厚度测量仪,系统阐述其操作规范与实用技巧,通过规范测量流程、分享操作要点,旨在提高测量准确性与效率,为半导体制造过程中碳化硅衬底 TTV 测量提供标准化操作指导
2025-08-23 16:22:40 1082
1082 
摘要
本文围绕探针式碳化硅衬底 TTV 厚度测量仪,系统阐述其操作规范与实用技巧,通过规范测量流程、分享操作要点,旨在提高测量准确性与效率,为半导体制造过程中碳化硅衬底 TTV 测量提供标准化操作
2025-08-20 12:01:02 551
551 
形貌测量系统自动测量Wafer厚度、表面粗糙度、三维形貌、单层膜厚、多层膜厚。1、使用光谱共焦对射技术测量晶圆Thickness、TTV、LTV、BOW、WARP
2025-08-20 11:26:59
摘要
本文聚焦碳化硅衬底 TTV 厚度测量过程,深入探究表面粗糙度对测量结果的影响机制,通过理论分析与实验验证,揭示表面粗糙度与测量误差的关联,为优化碳化硅衬底 TTV 测量方法、提升测量准确性提供
2025-08-18 14:33:59 454
454 
本文通过对比国产与进口碳化硅衬底 TTV 厚度测量仪在性能、价格、维护成本等方面的差异,深入分析两者的性价比,旨在为半导体制造企业及科研机构选购测量设备提供科学依据,助力优化资源配置。
引言
在
2025-08-15 11:55:31 707
707 
摘要
本文针对碳化硅衬底 TTV 厚度测量中出现的数据异常问题,系统分析异常类型与成因,构建科学高效的快速诊断流程,并提出针对性处理方法,旨在提升数据异常处理效率,保障碳化硅衬底 TTV 测量准确性
2025-08-14 13:29:38 1027
1027 
系统自动测量Wafer厚度、表面粗糙度、三维形貌、单层膜厚、多层膜厚。1、使用光谱共焦对射技术测量晶圆Thickness、TTV、LTV、BOW、WARP、TIR
2025-08-12 15:47:19
摘要
本文针对激光干涉法在碳化硅衬底 TTV 厚度测量中存在的精度问题,深入分析影响测量精度的因素,从设备优化、环境控制、数据处理等多个维度提出精度提升策略,旨在为提高碳化硅衬底 TTV 测量准确性
2025-08-12 13:20:16 778
778 
摘要
本文针对碳化硅衬底 TTV 厚度测量设备,详细探讨其日常维护要点与故障排查方法,旨在通过科学的维护管理和高效的故障处理,保障测量设备的稳定性与测量结果的准确性,降低设备故障率,延长设备使用寿命
2025-08-11 11:23:01 555
555 
摘要
本文对碳化硅衬底 TTV 厚度测量的多种方法进行系统性研究,深入对比分析原子力显微镜测量法、光学测量法、X 射线衍射测量法等在测量精度、效率、成本等方面的优势与劣势,为不同应用场景下选择合适
2025-08-09 11:16:56 898
898 
摘要
本文针对碳化硅衬底 TTV 厚度测量中各向异性带来的干扰问题展开研究,深入分析干扰产生的机理,提出多种解决策略,旨在提高碳化硅衬底 TTV 厚度测量的准确性与可靠性,为碳化硅半导体制造工艺提供
2025-08-08 11:38:30 657
657 
WD4000晶圆三维显微形貌测量系统兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它采用白光光谱共焦多传感器和白光干涉显微测量双向扫描技术,完成非接触式扫描并建立表面3D
2025-08-04 13:59:53
精密测量领域再添利器深视智能重磅发布光谱共焦位移传感器SCI系列全新型号SCI04020,这是高要求及严苛环境下精密测量的突破性升级,在影像仪检测等需要大工作距离的场景中表现突出,切实解决碰撞风险痛
2025-07-28 08:17:36 724
724 
WD4000晶圆THK膜厚厚度测量系统兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它采用白光光谱共焦多传感器和白光干涉显微测量双向扫描技术,完成非接触式扫描并建立表面3D
2025-07-25 10:53:07
为多领域提供高标准的模拟解决方案。下文Luminbox将带大家了解光谱匹配度测量的关键技术与标准。光谱匹配度测量的关键技术luminbox光谱测量示意图1.测量前
2025-07-24 10:23:35 587
587 
光子精密推出了QM系列闪测仪 + CD-5000系列光谱共焦位移传感器的组合,以高性价比的解决方案,满足用户的多重测量需求。
这一方案既能助用户精准完成轮廓与高度测量、也满足了便捷式使用需求,同时还能有效降低成本,为企业的生产检测环节提供更经济高效的选择。
2025-07-23 09:23:02 549
549 
在半导体制造中,薄膜的沉积和生长是关键步骤。薄膜的厚度需要精确控制,因为厚度偏差会导致不同的电气特性。传统的厚度测量依赖于模拟预测或后处理设备,无法实时监测沉积过程中的厚度变化,可能导致工艺偏差和良
2025-07-22 09:54:56 1646
1646 
在现代半导体和显示面板制造中,薄膜厚度的精确测量是确保产品质量的关键环节。传统方法如扫描电子显微镜(SEM)虽可靠,但无法用于在线检测;椭圆偏振仪和光谱反射法(SR)虽能无损测量,却受限于计算效率
2025-07-22 09:54:46 1178
1178 
在半导体、光学镀膜及新能源材料等领域,精确测量薄膜厚度和光学常数是材料表征的关键步骤。Flexfilm光谱椭偏仪(SpectroscopicEllipsometry,SE)作为一种非接触、非破坏性
2025-07-22 09:54:27 1747
1747 
在半导体芯片制造中,薄膜厚度的精确测量是确保器件性能的关键环节。随着工艺节点进入纳米级,单颗芯片上可能需要堆叠上百层薄膜,且每层厚度仅几纳米至几十纳米。光谱椭偏仪因其非接触、高精度和快速测量的特性
2025-07-22 09:54:19 881
881 
被广泛采用。Flexfilm全光谱椭偏仪不仅能够满足工业生产中对薄膜厚度和光学性质的高精度测量需求,还能为科研人员提供丰富的光谱信息,助力新材料的研发和应用。1光
2025-07-22 09:54:08 2166
2166 
在半导体和显示器件制造中,薄膜与基底的厚度精度直接影响器件性能。现有的测量技术包括光谱椭偏仪(SE)和光谱反射仪(SR)用于薄膜厚度的测量,以及低相干干涉法(LCI)、彩色共焦显微镜(CCM)和光谱
2025-07-22 09:53:09 1468
1468 
。本文本文基于FlexFilm单点膜厚仪的光学干涉技术框架,提出一种基于共焦光谱成像与薄膜干涉原理的微型化测量系统,结合相位功率谱(PPS)算法,实现了无需校准的高效
2025-07-21 18:17:57 1456
1456 
当 3C 制造迈入 “纳米级精度” 新纪元,消费者对屏幕显示效果与设备轻薄化的极致追求,正倒逼制造环节升级 ——0.1 微米级质量控制已成为行业硬性指标。作为国产光谱共焦技术引领者,立仪光谱共焦
2025-07-15 17:00:10 390
390 深视智能光谱共焦位移传感器定时触发功能操作指南旨在协助用户更加全面地了解我们的传感器设备。操作步骤一:打开SG-Imaging,连接控制器。操作步骤二:在主界面选择【环境设定】,打开【编码器设定
2025-07-14 08:18:37 429
429 
光刻胶生产技术复杂、品种规格多样,在电子工业集成电路制造中,对其有着极为严格的要求,而保证光刻胶产品的厚度便是其中至关重要的一环。 项目需求 本次项目旨在测量光刻胶厚度,光刻胶本身厚度处于 30μm-35μm 范围,测量精度要
2025-07-11 15:53:24 430
430 
一种重要的光学检测工具——光纤光谱仪。 光纤光谱仪以其结构紧凑、响应快速、操作灵活等优势,已广泛应用于薄膜厚度、光学常数、均匀性等参数的测量中,是当前实现非接触、非破坏性测量的重要手段之一。本文将围绕光纤光谱
2025-07-08 10:29:37 407
407 系列正以50纳米重复精度和多材质适应性,成为3C行业质检环节的"终极武器"。本期小明就来分享明治光谱共焦在3C行业中的经典应用案例手机摄像头点胶厚度测量在手机制造过程中,摄像头模组的点
2025-07-08 07:34:52 641
641 
光谱共焦传感器是一种新型高精度非接触式的光电位移传感器。光谱共焦传感技术以其具备高精度、高分辨率、可用于多维数字化成像分析等独特优势,被广泛应用于手机/3C行业、半导体行业、材料科学研究和微观
2025-06-30 15:28:30 975
975 
WD4000全自动晶圆厚度测量设备兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它采用白光光谱共焦多传感器和白光干涉显微测量双向扫描技术,完成非接触式扫描并建立表面3D
2025-06-27 11:43:16
智能点光谱共焦位移传感器,正是为破解这些行业痛点而生。它以光学技术为核心,重新定义了精密测量的标准,成为手机镜头、VR/AR光机等高端光学制造领域的“标尺”。三大
2025-06-23 08:18:14 534
534 
在光学元件制造领域,4-5mm 厚度玻璃镜片的高精度测量面临显著挑战:传统满足 1μm 精度的光谱共焦传感器量程仅 2.6mm,无法直接覆盖测量范围,而单一传感器搭配位移机构又难以兼顾精度与效率
2025-06-19 17:14:25 863
863 
WD4000晶圆厚度测量设备兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV,BOW
2025-06-18 15:40:06
深视智能光谱共焦位移传感器SCI系列透明物体厚度测量操作指南旨在协助用户更加全面地了解我们的传感器设备。为方便后续
2025-06-16 08:19:40 880
880 
光谱共焦位移传感器采用同轴测量原理,克服了传统激光三角测量传感器的角度限制,显著减少了测量盲区。同时拥有多种优势,能够更精确地测量深孔、盲孔等复杂结构。
2025-06-13 09:08:29 849
849 
在碳化硅衬底厚度测量中,探头温漂与材料各向异性均会影响测量精度,且二者相互作用形成耦合效应。深入研究这种耦合影响,有助于揭示测量误差根源,为优化测量探头性能提供理论支撑。
耦合影响机制分析
材料
2025-06-11 09:57:28 669
669 
引言
在碳化硅衬底厚度测量中,探头温漂是影响测量精度的关键因素。传统测量探头受环境温度变化干扰大,导致测量数据偏差。光纤传感技术凭借独特的物理特性,为探头温漂抑制提供了新方向,对提升碳化硅衬底厚度
2025-06-05 09:43:15 465
465 
厚度、表面粗糙度、三维形貌、单层膜厚、多层膜厚。1、使用光谱共焦对射技术测量晶圆Thickness、TTV、LTV、BOW、WARP、TIR、SORI等参数,同时
2025-06-03 15:52:50
引言
碳化硅衬底 TTV(总厚度变化)厚度是衡量其质量的关键指标,直接影响半导体器件性能。合理选择测量仪器对准确获取 TTV 数据至关重要,不同应用场景对测量仪器的要求存在差异,深入分析选型要点
2025-06-03 13:48:50 1453
1453 
WD4000晶圆几何形貌在线测量系统采用高精度光谱共焦传感技术、光干涉双向扫描技术,完成非接触式扫描并建立3D Mapping图,实现晶圆厚度、TTV、LTV、Bow、Warp、TIR、SORI、等
2025-05-30 11:03:11
WD4000系列Wafer晶圆厚度量测系统采用白光光谱共焦多传感器和白光干涉显微测量双向扫描技术,完成非接触式扫描并建立表面3D层析图像,实现Wafer厚度、翘曲度、平面度、线粗糙度、总体厚度变化
2025-05-27 13:54:33
较大。同时,镜头模组的形状也较为复杂,存在曲面、台阶等多种结构,增加测量的难度。深视智能SCI01045光谱共焦位移传感器集成多项核心技术优势,以0.006μm分
2025-05-26 08:18:57 744
744 
概况及原理海伯森HPS-LC系列3D线光谱共焦传感器突破传统检测方式的限制,为工业4.0时代提供更高测量精度、更快测量速度的光学精密检测传感器。针对透明玻璃薄膜的透光特性、锂电产品的复杂曲面结构
2025-05-19 16:57:30 125
125 
概况及原理海伯森HPS-LC系列3D线光谱共焦传感器突破传统检测方式的限制,为工业4.0时代提供更高测量精度、更快测量速度的光学精密检测传感器。针对透明玻璃薄膜的透光特性、锂电产品的复杂曲面结构
2025-05-19 16:40:48 19
19 
概况及原理海伯森HPS-LC系列3D线光谱共焦传感器突破传统检测方式的限制,为工业4.0时代提供更高测量精度、更快测量速度的光学精密检测传感器。针对透明玻璃薄膜的透光特性、锂电产品的复杂曲面结构
2025-05-19 15:55:58 16
16 
VT6000系列国产中图共焦显微镜主要用于对各种精密器件及材料表面进行微纳米级测量。它以转盘共聚焦光学系统为基础,结合高稳定性结构设计和3D重建算法,共同组成测量系统,保证仪器的高测量精度。国产中图
2025-05-15 14:44:11
Wafer厚度、表面粗糙度、三维形貌、单层膜厚、多层膜厚。1、使用光谱共焦对射技术测量晶圆Thickness、TTV、LTV、BOW、WARP、TIR、SORI等参数,
2025-05-13 16:05:20
测量可能损伤镜片、测量精度受人为因素影响大等问题。光谱共焦传感器作为一种非接触式、高精度的测量技术,在镜片厚度测量领域展现出显著优势。本期小明就来分享一下明治光谱共
2025-05-06 07:33:24 822
822 
表磁测量是对磁性材料或磁体表面磁场强度的测量,表磁测量设备中有不同的测试模式适用于不同的样品形状、尺寸和测量目的。该如何选择?以下是对各种测试模式的介绍及适用场景: 测试模式 维度 定义 适用
2025-04-22 09:24:01 594
594 光谱共焦位移传感器通过亚微米级精度、强材质适应性、超高速采样频率及非接触式测量技术,解决晶圆表面平整度检测的行业痛点,为半导体制造企业提供高效、精准的检测手段。检
2025-04-21 08:18:31 783
783 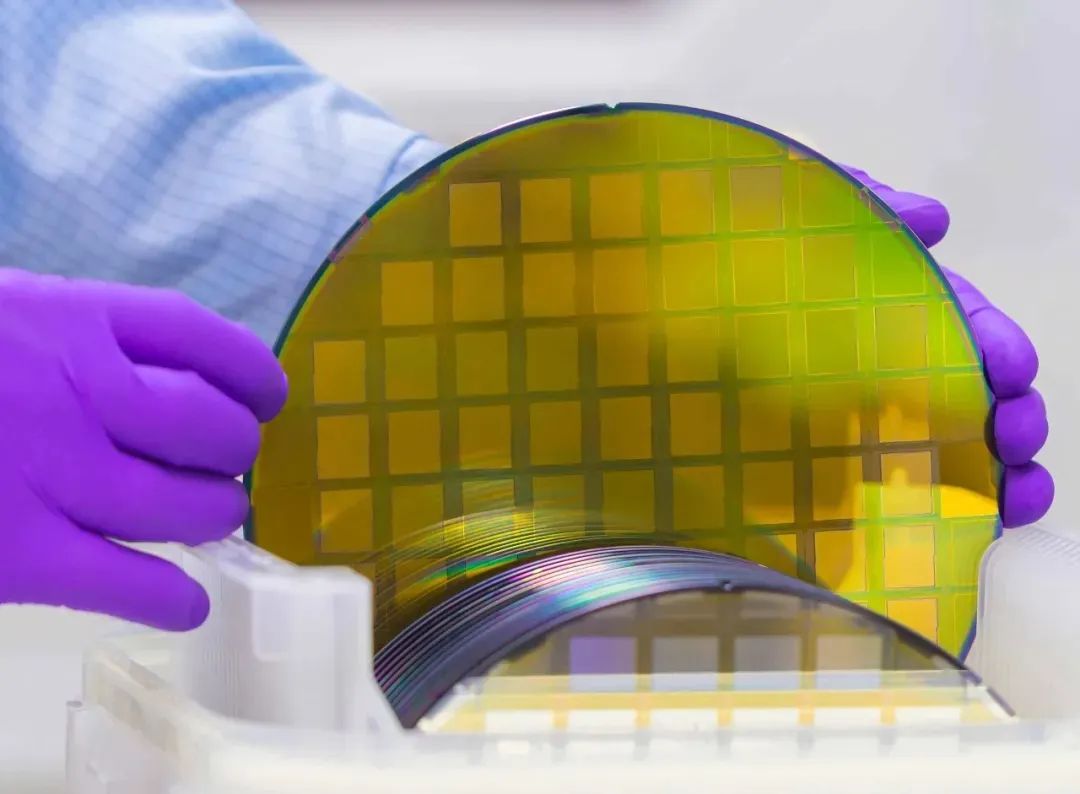
在精密测量领域,明治的ADK系列与ACC系列光谱共焦传感器以各自独特的技术优势广泛应用于工业检测、科研实验等高精度位移测量场景。ADK系列一拖二双探头;最小分辨率0.02um可稳定测量金属、陶瓷
2025-04-15 07:32:57 730
730 
级的厚度测量精度呢?本期小明就来分享一下明治传感的解决办法~场景需求1、非接触式在线测量:要求测量过程中不与极片直接接触,避免对极片造成损伤或污染2、测量速度:需
2025-04-01 07:34:03 783
783 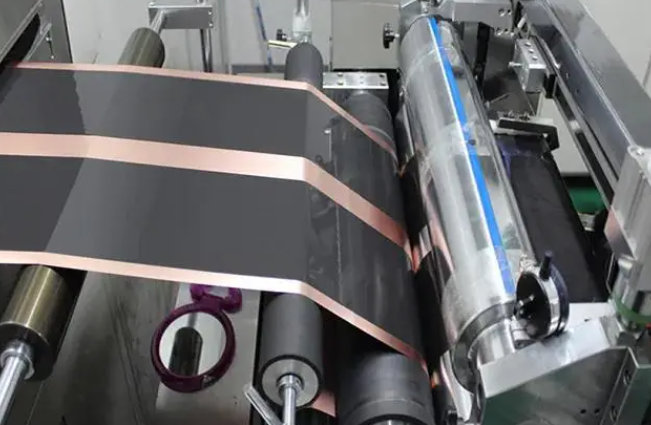
WD4000系列晶圆微观几何轮廓测量系统采用高精度光谱共焦传感技术、光干涉双向扫描技术,完成非接触式扫描并建立3D Mapping图,实现晶圆厚度、TTV、LTV、Bow、Warp、TIR、SORI
2025-03-19 17:36:45
。成像与光谱共焦技术,结合专业测量软件,把测量结果可以上传数字化、数据化。一、产品描述1.产品特性武汉易之测仪器生产的全自动卧式光学投影像测量仪基于光学尺的全闭环
2025-03-07 10:15:17
有人知道怎么通过图案模式软件触发光谱仪吗,光谱仪不能硬件触发,控制光谱仪去单次测量,在特定图片下光谱仪测量。
2025-02-24 08:31:23
进行实测,对于同一样品不同测量位置,在1200-1700nm波段,光谱曲线上下波动波幅较大,重复性也不好。
问题如下:
1.一般的光谱模块,每次使用前都需要使用白板和黑板校准,nanoEVM模块没有附带
2025-02-24 07:07:15
NS系列膜层厚度台阶高度测量仪主要用于台阶高、膜层厚度、表面粗糙度等微观形貌参数的测量。测量时通过使用2μm半径的金刚石针尖在超精密位移台移动样品时扫描其表面,测针的垂直位移距离被转换为与特征尺寸
2025-02-21 14:05:13
一、无锡泓川科技(国产品牌,性价比高) 无锡泓川科技有限公司专注于光学测量与检测领域,其核心产品LTC系列光谱共焦位移传感器以高精度、强适应性为特色。该系列具备亚微米级测量精度(最小静态噪声仅3nm
2025-02-20 08:17:25 4461
4461 
前言非接触式激光厚度测量仪支持多种激光型号,并对应有不同的测量模式,比其他类似软件更合理,更加容易上手。下面我们用 CMS 激光下的厚度模式与平面模式进行操作。一、产品描述1.产品特性非接触式激光
2025-02-13 09:37:19
前言利用光学+激光制造技术新的创新,武汉易之测仪器可以制造各种高质量标准或定制设计的各种石英晶圆玻璃激光厚度测量仪定制,以满足许多客户应用的需求。一、产品描述1.产品特性以下原材料可以用于石英晶圆
2025-02-13 09:32:35
摘要 本研究基于泓川科技LTC型光谱共焦传感器,针对冷轧无取向硅钢(牌号35W300,厚度0.35mm)的在线厚度检测需求,提出基于光-热-力耦合模型的动态补偿方案。通过六传感器阵列协同测量技术
2025-02-11 06:45:55 761
761 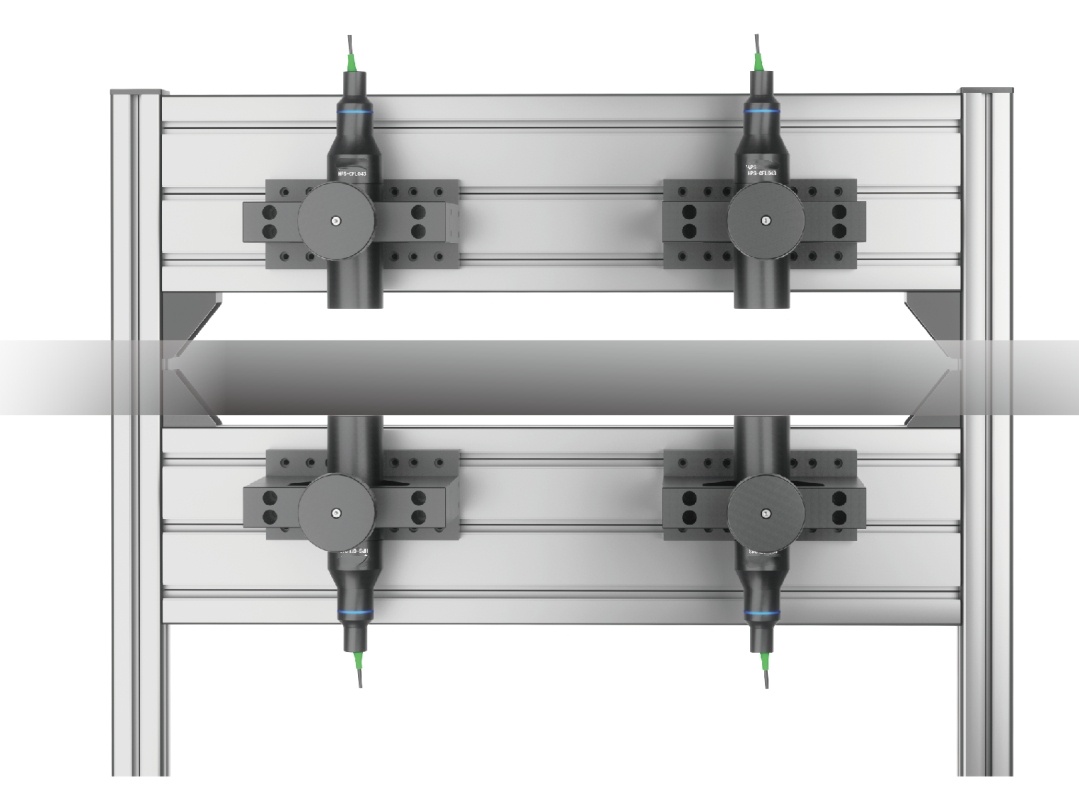
白光干涉仪的膜厚测量模式原理主要基于光的干涉原理,通过测量反射光波的相位差或干涉条纹的变化来精确计算薄膜的厚度。以下是该原理的详细解释:
一、基本原理
当光线照射到薄膜表面时,部分光线会在薄膜表面
2025-02-08 14:24:34 508
508 
白光干涉仪的光谱干涉模式原理主要基于光的干涉和光谱分析。以下是对该原理的详细解释:
一、基本原理
白光干涉仪利用干涉原理测量光程之差,从而测定有关物理量。在光谱干涉模式中,白光作为光源,其发出的光
2025-02-07 15:11:00 563
563 
基本理论和典型应用\",并研究该方法对轻微变化的涂层厚度有多敏感。
任务描述
镀膜样品
椭圆偏振分析仪
总结 - 组件 ...
椭圆偏振系数测量
椭圆偏振分析仪测量反射系数(s-和p-
2025-02-05 09:35:38
,我们以太阳光为例,说明了如何将测量到的光谱导入VirtualLab Fusion中,然后介绍了如何使用所述数据用作光学系统中光源的光谱组成。
建模任务
如何将测量到的太阳光光谱(见下图)导入到
2025-01-23 10:22:34
在半导体产业这片高精尖的领域中,氮化镓(GaN)衬底作为新一代芯片制造的核心支撑材料,正驱动着光电器件、功率器件等诸多领域迈向新的高峰。然而,氮化镓衬底厚度测量的精准度却时刻面临着一个来自暗处的挑战
2025-01-22 09:43:37 449
449 
在半导体制造这一微观且精密的领域里,氮化镓(GaN)衬底作为高端芯片的关键基石,正支撑着光电器件、功率器件等众多前沿应用蓬勃发展。然而,氮化镓衬底厚度测量的准确性却常常受到一个隐匿 “敌手” 的威胁
2025-01-20 09:36:50 404
404 
在半导体制造这一高精尖领域,碳化硅衬底作为支撑新一代芯片性能飞跃的关键基础材料,其厚度测量的准确性如同精密机械运转的核心齿轮,容不得丝毫差错。然而,测量探头的 “温漂” 问题却如隐匿在暗处的 “幽灵
2025-01-15 09:36:13 386
386 
。 而在生产阶段需要将原料进行混合、熔化、压延、退火和切割等工艺才能制成光伏原片半成品。而在压延的过程中,产品的厚度往往关系到产品的合格度。 项目需求 1、已知玻璃的厚度大约为2-3.5mm,需要测量出玻璃的精确厚度,并保证测
2025-01-14 16:43:52 850
850 
在半导体制造的微观世界里,碳化硅衬底作为新一代芯片的关键基石,其厚度测量的精准性如同精密建筑的根基,不容有丝毫偏差。然而,测量探头的 “温漂” 问题却如同一股暗流,悄然冲击着这一精准测量的防线,给
2025-01-14 14:40:26 447
447 
在半导体芯片制造的微观世界里,精度就是生命线,晶圆厚度测量的精准程度直接关联着最终产品的性能优劣。而测量探头的 “温漂” 问题,宛如精密时钟里的一粒微尘,虽小却能搅乱整个测量体系的精准节奏。深入探究
2025-01-13 09:56:22 693
693 
一、“温漂” 现象的本质剖析
测量探头的 “温漂”,指的是由于环境温度变化或探头自身在工作过程中的发热,导致探头的物理特性发生改变,进而使其测量精度出现偏差的现象。从原理上看,多数测量探头基于电学或
2025-01-10 15:12:22 598
598 
 电子发烧友App
电子发烧友App











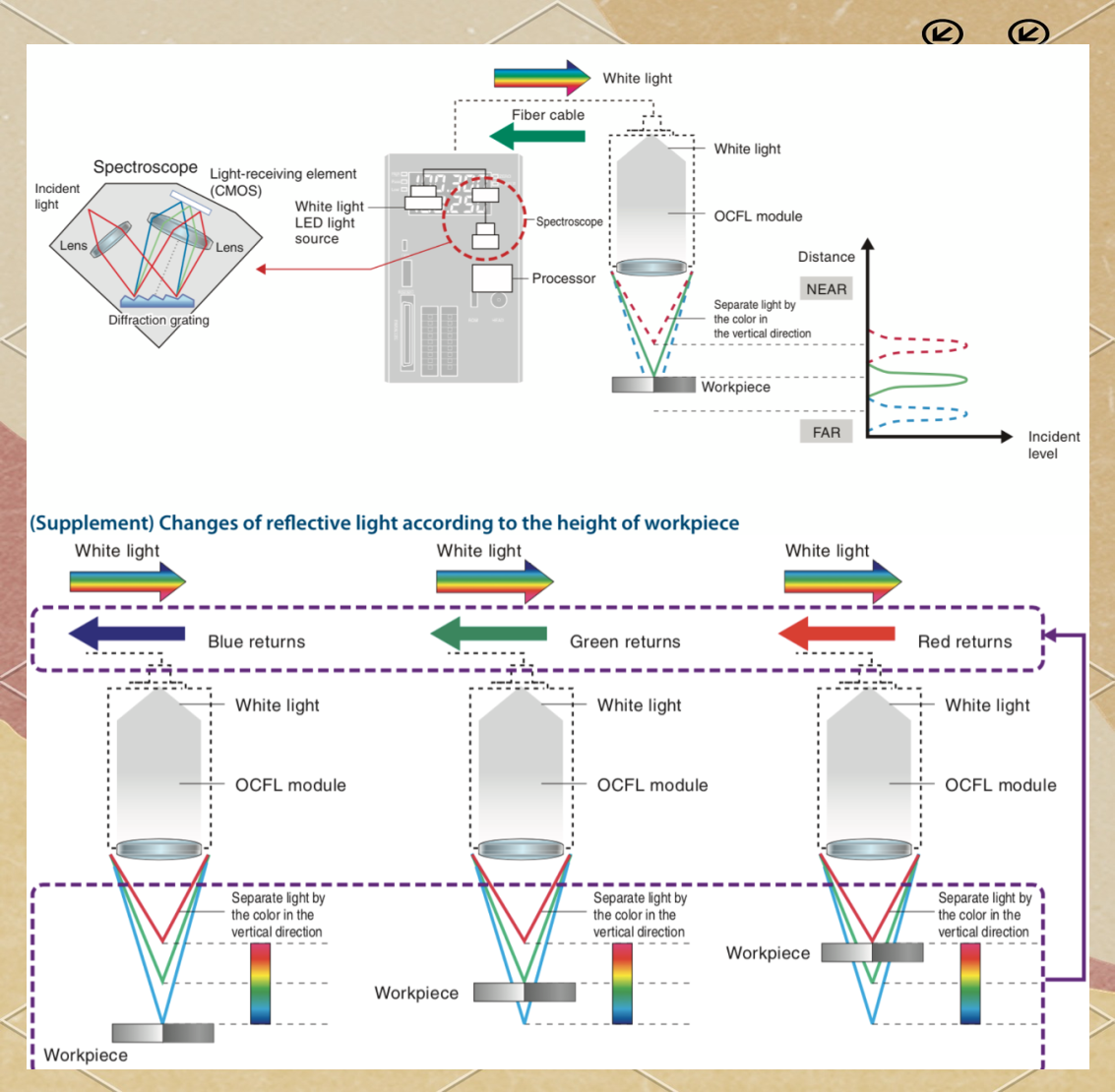








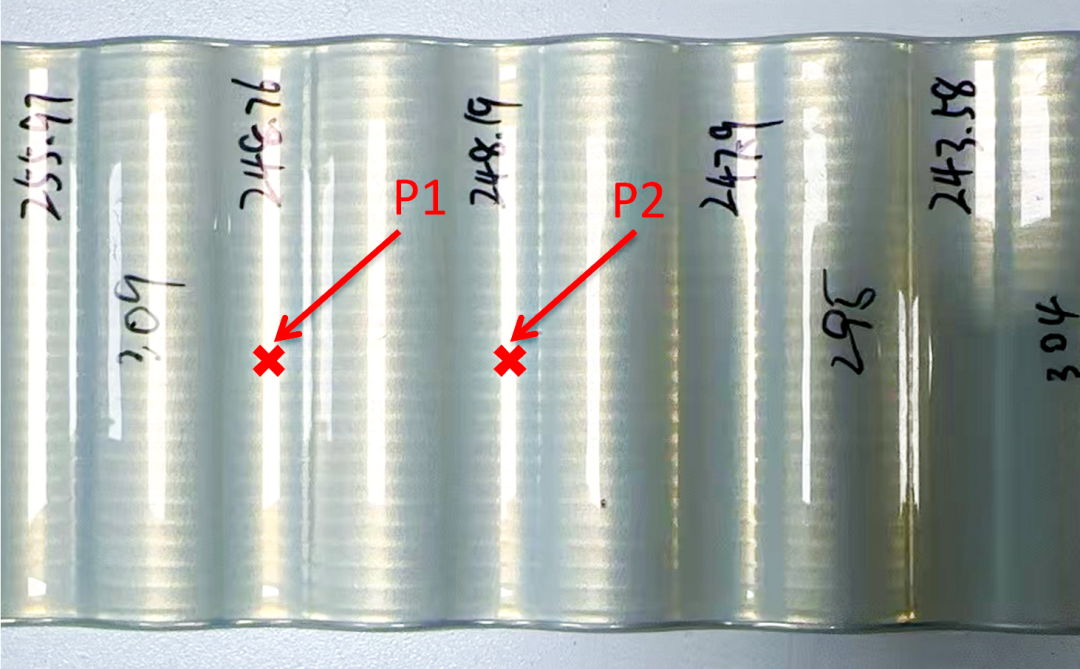


















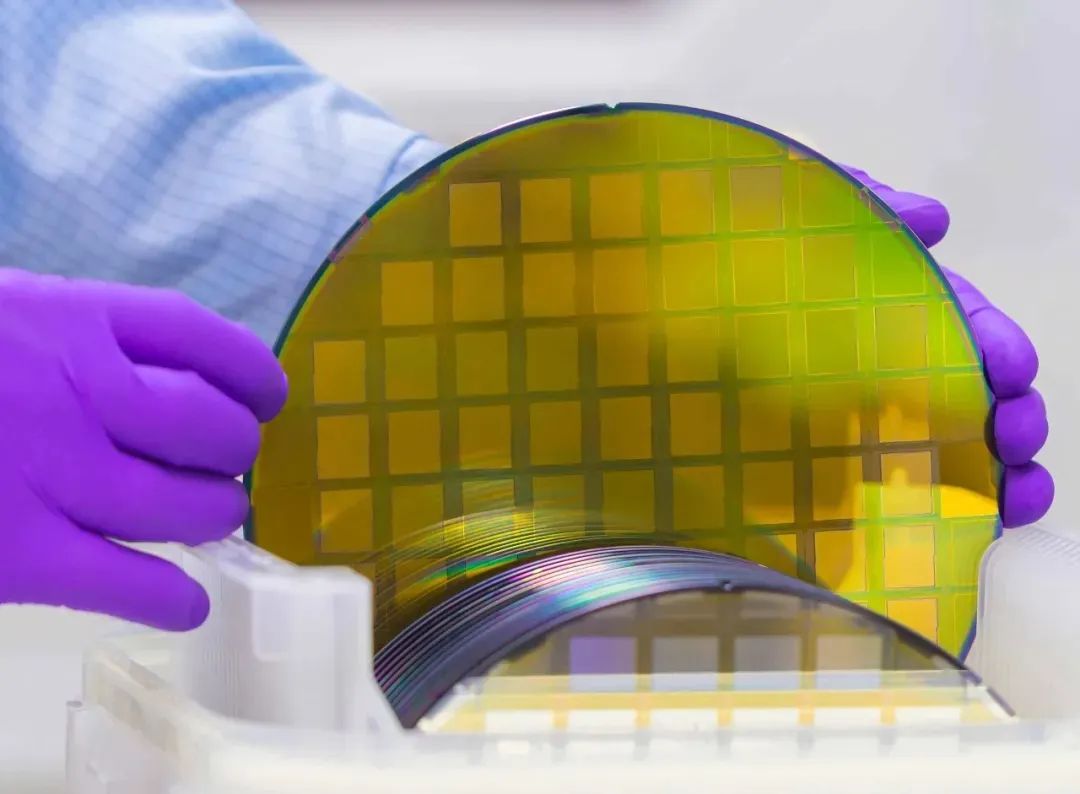


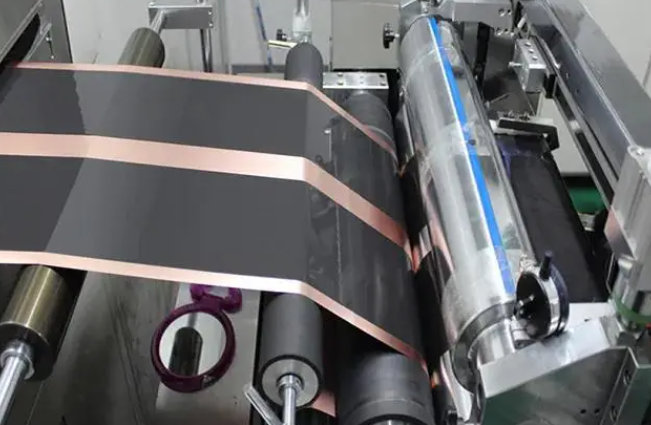

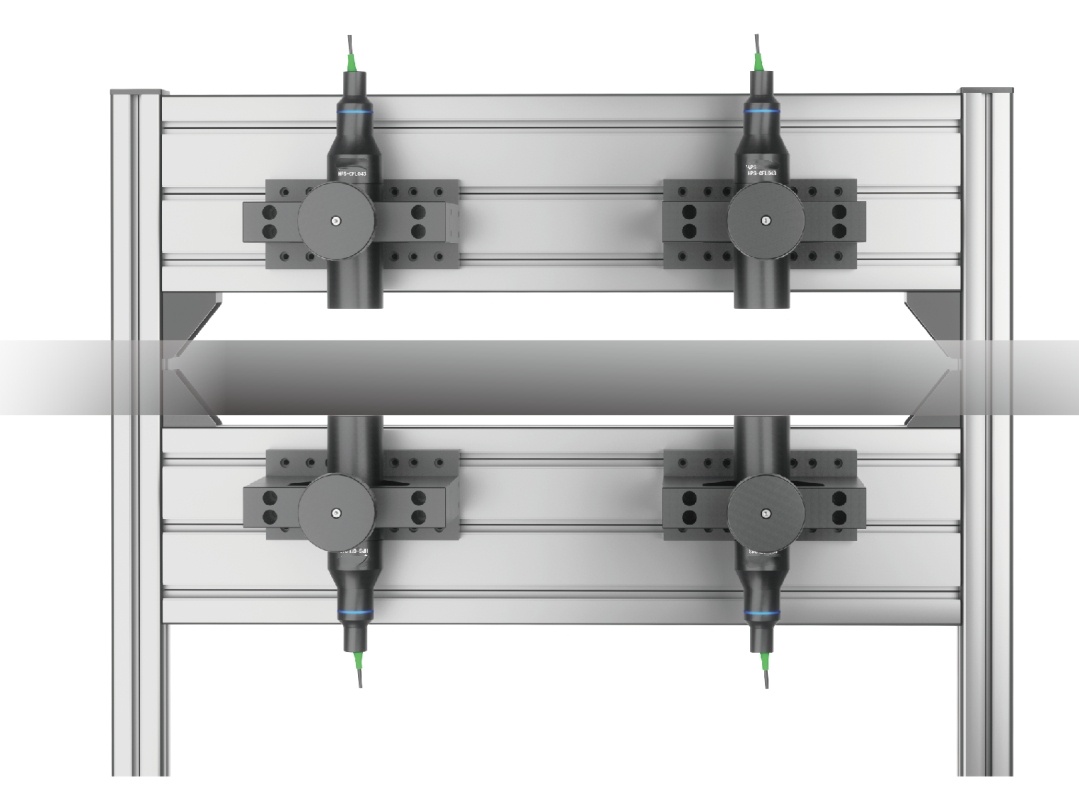






评论