芯片底部填充胶可靠性有哪些检测要求?
芯片底部填充胶(Underfill)在先进封装(如Flip Chip、CSP、2.5D/3D IC等)中起着至关重要的作用,主要用于缓解焊点因热膨胀系数(CTE)失配产生的热机械应力,提高器件的可靠性和使用寿命。为确保其性能满足应用要求,底部填充胶需经过一系列可靠性检测。以下是常见的检测要求和测试项目:
一、基本性能检测
1.粘度与流动性
检测胶体在毛细作用下的流动能力,确保能充分填充芯片与基板之间的间隙。
测试方法:旋转粘度计、毛细流动测试。
2,固化特性
包括固化温度、时间、放热峰、固化收缩率等。
测试方法:DSC(差示扫描量热法)、TGA(热重分析)。
3.玻璃化转变温度(Tg)
决定材料在高温下的刚性保持能力。
测试方法:DMA(动态力学分析)、DSC。
4.热膨胀系数(CTE)
尤其关注低于和高于Tg时的CTE值,需与芯片/基板匹配以减少热应力。
测试方法:TMA(热机械分析)。
5,模量(弹性模量、剪切模量)
影响应力缓冲效果,过高或过低均可能影响可靠性。
测试方法:DMA、拉伸/剪切试验。

二、可靠性环境测试(加速寿命试验)
1.温度循环测试(Thermal Cycling, TC)
模拟实际使用中反复热胀冷缩对焊点和填充胶的影响。
·常见条件:-55°C↔+125°C,500~3000 cycles。
·评估指标:电性能连续性、焊点开裂、胶体开裂或脱层。
2.高温高湿存储(THB / HAST)
THB(Temperature Humidity Bias):85°C/85%RH,加偏压。
HAST(Highly Accelerated Stress Test):130°C/85%RH或更高,不加/加偏压。
评估胶体吸湿性、离子迁移、腐蚀风险及界面附着力。
3.高温存储(HTS)
如150°C或175°C下存储1000小时以上,考察长期热稳定性。
4.回流焊模拟测试
模拟多次无铅回流焊过程(如260°C峰值),验证胶体是否耐受组装工艺。
三、界面与结构完整性检测
1.附着力测试(Adhesion Test)
胶体与芯片钝化层(如SiO₂、SiN)、基板(如FR-4、BT树脂)之间的结合强度。
方法:划痕测试、剥离测试、剪切测试。
2.空洞与填充完整性检查
X-ray、声学扫描显微镜(SAT/C-SAM)检测填充是否完全、是否存在气泡或空洞。
3.裂纹与分层观察
可靠性测试后通过剖面SEM/FIB或SAT检查胶体是否开裂、脱层。
四、电性能相关要求(视应用场景)
·体积电阻率/表面电阻率
·介电常数(Dk)与损耗因子(Df)(高频应用尤其重要)
·离子杂质含量(Na⁺、Cl⁻等,影响电迁移)
五、行业标准参考
·JEDEC标准(如JESD22-A104温度循环、JESD22-A110 HAST)
·IPC标准(如IPC-TM-650系列)
·AEC-Q系列(车规级应用,如AEC-Q100/Q200)
总结
底部填充胶的可靠性检测是一个多维度、系统性的过程,需结合材料性能、工艺兼容性、环境适应性以及最终产品的应用场景(消费电子、汽车电子、航空航天等)综合评估。对于高可靠性领域(如汽车、医疗、军工),测试条件更为严苛,周期更长。
-
芯片
+关注
关注
463文章
54704浏览量
471356 -
检测
+关注
关注
5文章
4981浏览量
94412 -
底部填充剂
+关注
关注
0文章
15浏览量
5555
发布评论请先 登录



 汉思新材料:芯片底部填充胶可靠性有哪些检测要求
汉思新材料:芯片底部填充胶可靠性有哪些检测要求

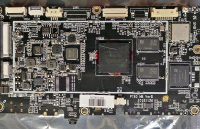



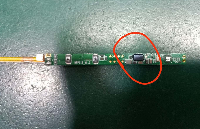













评论