底部填充胶(Underfill)在电子封装(尤其是倒装芯片、BGA、CSP等)中起着至关重要的作用,它通过填充芯片与基板之间的间隙,均匀分布应力,显著提高焊点抵抗热循环和机械冲击的能力。然而,如果底部填充胶出现开裂或脱落,会严重威胁器件的可靠性和寿命。
以下是导致这些失效的主要原因分析及相应的解决方案:

一、 开裂/脱落原因分析
1. 材料本身问题:
CTE(热膨胀系数)不匹配: 这是最主要的原因之一。填充胶的CTE与芯片(硅,~2.6 ppm/°C)、基板(FR4,~12-18 ppm/°C;BT,~14-15 ppm/°C)或焊料(无铅焊料,~21-25 ppm/°C)差异过大。在温度循环过程中,不同材料膨胀收缩程度不同,在填充胶内部或界面处产生巨大的剪切应力,超过其强度极限时就会开裂(通常在芯片边缘或角落应力集中处开始)。
模量(弹性模量)过高: 模量过高的填充胶过于刚硬,在应力作用下不易发生微小形变来释放能量,更容易发生脆性断裂。
韧性不足: 材料本身脆性大,抗冲击和抗开裂扩展能力差。
固化不完全/固化收缩过大:
固化不完全: 固化温度/时间不足、配方问题或受污染导致交联密度不够,内聚强度和粘接强度下降。
固化收缩过大: 固化过程中体积收缩过大,在胶体内或界面处产生内应力,成为潜在的裂纹源。
吸水率高/耐湿性差: 吸湿后材料会膨胀(湿膨胀),在后续干燥或温度变化时产生应力。吸湿还会导致材料塑化、模量下降、Tg降低,并可能引发水解反应破坏粘接或材料本身。在回流焊(尤其是无铅高温回流)时,内部水分急剧汽化产生蒸汽压,可能导致“爆米花”式开裂或界面分层。
Tg(玻璃化转变温度)过低: 如果填充胶的Tg低于器件的工作温度或存储温度上限,在高温下材料会变软(模量急剧下降),失去支撑和保护焊点的作用,且更容易发生蠕变,导致应力释放不良或长期可靠性下降。Tg过低也可能使CTE在高温区变得更大,加剧应力。
2. 工艺控制不当:
点胶/填充不良:
填充不饱满/空洞/气泡: 点胶路径设计不合理、胶量不足、流速/压力不当、温度不合适(粘度太高或太低)、助焊剂残留过多阻碍流动等,导致填充区域存在空洞或未完全填充。空洞处是应力集中点,容易成为裂纹的起始点。未填充区域则完全失去保护。
填充高度不足/过量: 高度不足保护不够;过量可能导致胶体爬上芯片侧面过多,在后续封装或温度变化时因应力不同而开裂。
固化工艺不当: 未严格按照胶水供应商推荐的温度曲线和时间进行固化(温度过低、时间过短、升温/降温速率过快)。过快升温可能导致表面快速固化而内部未固化(“表干里不干”),过快降温则会产生热应力。
基板/芯片表面污染:
助焊剂残留: 这是最常见的污染源,残留的松香、活性剂等会严重削弱填充胶与焊点、阻焊层或芯片钝化层的粘接力。
油脂、指纹、灰尘、颗粒物:操作不当引入的污染物。
氧化物/钝化层特性: 基板焊盘或芯片钝化层(如SiN, PI)的表面能、粗糙度、化学性质不适合粘接。
清洁不彻底: 在点胶前未有效去除助焊剂残留和其他污染物。清洁剂选择不当或清洁工艺(如清洗时间、温度、喷淋压力)不佳也可能留下残留或损伤表面。
应力点: 在组装或测试过程中,器件受到不当的机械应力(如弯曲、扭曲、碰撞),可能导致填充胶在固化前或固化后受损。
3. 设计因素:
芯片尺寸过大/间隙过小: 大尺寸芯片在温度变化时变形更大,应力更大。过小的间隙(Standoff Height)使得填充胶流动困难,易产生填充缺陷。
应力集中设计: 芯片边缘尖锐、基板上的通孔位置靠近焊点等设计会加剧局部应力。
基板材料选择: 基板本身的CTE、模量和Tg也会影响整个系统的热机械应力分布。
4. 使用环境因素:
严苛的温度循环: 范围宽(ΔT大)、速率快的温度循环对填充胶的耐热疲劳性能是巨大考验。
高湿度环境: 长期暴露在高湿环境下会加速吸湿,影响材料性能和界面粘接。
机械冲击/振动: 超出填充胶承受能力的物理冲击。
二、 解决方案
1. 优化底部填充胶材料选择:
匹配CTE: 优先选择CTE介于芯片和基板之间(通常在30-90ppm/°C范围内)并尽可能接近焊料CTE的填充胶。改性环氧树脂常通过添加无机填料(如二氧化硅)来降低CTE。
调整模量: 选择具有适中模量(通常在几GPa到十几GPa范围)的填充胶。过高的模量虽能提供支撑但易裂,过低的模量则支撑不足。可通过添加增韧剂(如橡胶粒子、热塑性树脂)提高韧性。
提高Tg:确保填充胶的Tg显著高于器件的最高工作温度和存储温度(通常要求高于125°C,无铅应用可能需要>150°C)。
降低吸水率/提高耐湿性: 选择疏水性配方或经过耐湿改性的填充胶。
控制固化收缩率: 选择低收缩配方。
确保完全固化特性: 选择固化窗口宽、对工艺波动不敏感的胶水,并确保其能在推荐的条件下完全固化。
选用知名品牌可靠产品: 如汉高乐泰、汉思新材料等,并索要完整可靠的性能数据报告。
2. 严格控制工艺过程:
优化点胶工艺:
精确控制胶量: 通过实验确定最佳胶量(确保充分填充无空洞,且不严重溢出)。
优化点胶路径与参数: 设计合理的点胶轨迹(如L形、U形),控制点胶速度、压力、针头高度、温度(预热基板可降低胶水粘度改善流动性)。
真空辅助填充/毛细流动控制: 对于复杂结构或小间隙,可采用真空辅助或优化胶水流动性的配方来促进填充,减少气泡。
使用自动化点胶设备: 保证一致性和精度。
严格执行固化工艺:
精确遵循推荐曲线: 使用温度曲线测试仪验证炉温曲线是否满足胶水规格书要求(包括升温速率、峰值温度、保温时间、降温速率)。
避免过快升降温: 控制升降温速率以减少热应力。
加强清洁工艺:
彻底去除助焊剂残留: 采用有效的清洗工艺(水基或溶剂清洗)和合适的清洗设备(如浸泡、喷淋、超声波),并进行清洗效果验证(如离子污染度测试、目检、表面能测试)。
控制生产环境: 保持操作环境清洁(无尘车间),防止二次污染。操作员佩戴防静电手套。
表面处理(必要时): 对于难粘接的表面,在点胶前可考虑采用等离子体清洗,能显著提高表面能和活性,去除微观污染物,极大改善粘接强度。
3. 优化设计与操作:
设计考虑: 与封装设计工程师沟通,考虑热机械应力因素(如避免尖锐转角、优化焊盘布局和通孔位置)。在可能的情况下,选择CTE匹配性更好的基板材料。
应力消除:在组装、测试、运输和后续集成过程中,严格遵守操作规范,避免对器件施加不当的机械应力(如弯曲、跌落)。使用合适的工装夹具。
4.加强质量监控与失效分析:
过程监控: 对点胶后的填充效果进行自动光学检查,检查填充饱满度、有无明显空洞和溢出。抽样进行切片分析,检查内部填充质量和界面状况。
可靠性测试: 对生产批次的样品进行加速可靠性测试(如温度循环试验、高温高湿存储、压力锅蒸煮试验)以验证长期可靠性。
失效分析: 一旦发生开裂/脱落,立即进行失效分析:
无损检测: X射线检查内部空洞、裂纹位置。
破坏性分析:切片后用金相显微镜或扫描电镜观察裂纹形态(穿晶/沿晶)、起始位置、界面状况。
成分分析: 检查界面是否有污染物(如EDS分析)。
材料性能复测: 测试失效胶块的Tg、模量、CTE等是否偏离标准值。
明确失效模式与机理: 是热疲劳断裂?界面粘接失效?还是湿气导致的失效?根据分析结果精准定位问题根源,指导后续改进。
总结
解决底部填充胶开裂和脱落问题是一个系统工程,需要从材料选型、点胶工艺控制、设计优化和严格监控四个方面协同发力。最关键的是选择CTE匹配性好、Tg高、韧性足、耐湿性好的填充胶,并辅以彻底有效的清洁工艺、精确可控的点胶和固化工艺。 同时,建立完善的质量监控体系和失效分析能力,是快速定位问题、持续改进工艺、确保产品长期可靠性的根本保障。
建议与底部填充胶供应商的技术支持团队紧密合作如汉思新材料,他们能根据你的具体应用(芯片尺寸、基板类型、工作环境、可靠性要求)提供最匹配的产品推荐和详细的工艺指导。 在工艺变更(尤其是换胶)后,务必进行充分的工艺验证和可靠性测试。
-
材料
+关注
关注
3文章
1593浏览量
28695 -
倒装芯片
+关注
关注
1文章
124浏览量
16872
发布评论请先 登录



 汉思新材料:底部填充胶可靠性不足如开裂脱落原因分析及解决方案
汉思新材料:底部填充胶可靠性不足如开裂脱落原因分析及解决方案

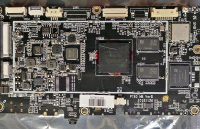

















评论