环氧底部填充胶固化后出现气泡是一个常见的工艺问题,不仅影响美观,更严重的是会降低产品的机械强度、热可靠性、防潮密封性和长期可靠性,尤其在微电子封装等高要求应用中可能导致器件失效。
以下是对气泡产生原因的详细分析以及相应的解决方案:
 汉思新材料:环氧底部填充胶固化后有气泡产生原因分析及解决方案
汉思新材料:环氧底部填充胶固化后有气泡产生原因分析及解决方案一、 气泡产生原因分析
1. 材料本身原因:
预混胶中残留气泡: 胶水在混合或运输储存过程中本身裹入了空气气泡。
脱泡性能差: 胶水本身的粘度、触变性或配方导致其脱泡能力弱,混合后或点胶前静置脱泡效果不佳。
溶剂或低沸点成分挥发: 某些配方含有溶剂或低沸点成分,在固化升温过程中挥发形成气泡。
反应副产物气体: 固化反应过程中可能产生少量低分子量的气体副产物。
2. 点胶/施胶工艺:
点胶速度过快: 高速点胶时,胶体冲击基板或元器件边缘,容易卷入空气。
点胶高度不当:
过高: 胶线“跌落”撞击基板,容易溅射和卷入空气。
过低: 针头可能刮蹭到基板或元器件,干扰胶流,导致裹气。
点胶路径设计不合理: 路径过于复杂、急转弯或点胶起始/结束位置不当,容易在胶流中形成涡流卷入空气。
针头选择不当: 针头内径过大或过小、针头形状(如平口针)不适合,影响胶流平稳性。
胶量不足或不连续: 胶量不足以填充间隙或点胶中断,导致填充不连续,末端或角落容易滞留空气。
点胶压力/速度波动:设备不稳定导致胶流不均匀,易产生气泡。
3. 基板与元器件因素:
表面污染: 焊盘、阻焊层、元器件底部或侧壁存在油脂、指纹、助焊剂残留、水分、脱模剂等污染物,影响胶水的润湿铺展性,导致填充不良和气泡滞留。
表面能低/润湿性差: 某些基板材料或元器件表面(如某些塑封料)本身表面能较低,胶水难以良好浸润,形成气穴。
元器件底部间隙复杂: 底部有凸点、凸块、不平整或狭小缝隙,空气不易被排出。
元器件或基板吸湿: 存储环境湿度高,未充分烘烤除湿,在高温固化时水分汽化形成气泡(常见于BGA、CSP等底部间隙较大的器件)。
4. 填充环境与过程:
环境湿度高: 空气中的水汽可能被吸入未固化的胶体中,固化时形成气泡。
毛细流动受阻: 填充过程中,胶水在芯片底部间隙内的毛细流动前端如果受阻(如污染物、间隙突变),空气被包裹无法排出。
填充后静置时间不足: 点胶后立即进入固化,胶水没有足够时间让已卷入的小气泡上浮逸出(尤其对粘度稍高的胶水更重要)。
5. 固化工艺:
升温速率过快: 这是非常常见的原因。过快的升温速度使得胶水粘度迅速降低,同时溶剂/水分挥发或反应副产物气体产生的速率远大于胶水粘度降低后气泡能逸出的速率,导致气泡被“锁”在固化胶体中。
固化温度过高:超出推荐范围的高温可能加剧低沸点成分挥发或副反应产气。
固化曲线不合适: 没有设置合适的预热平台(预固化阶段)让气泡在胶体粘度较低但尚未凝胶前有足够时间逸出。
6. 设备与工具:
点胶设备不稳定: 压力、流量控制不精确,导致点胶不均。
真空脱泡设备效果不佳: 脱泡时间不足、真空度不够、真空腔体泄漏。
针头或储胶管有污染/堵塞: 影响胶流顺畅性。
二、 解决方案与预防措施
针对以上原因,需要系统性地排查和改进:
1. 优化材料选择与处理:
选择低吸湿、低粘度、高流动性、脱泡性好的胶水: 咨询供应商,选择专门针对低气泡或无气泡应用设计的底部填充胶。
严格进行真空脱泡:
混合后:在点胶前必须进行充分的真空脱泡处理。确保真空度足够高(通常要求能达到<1 Torr/百帕级别)、脱泡时间足够(根据胶量和粘度,通常几分钟到十几分钟)、脱泡罐密封良好无泄漏。
点胶筒/针筒:灌装到点胶筒后,可能也需要进行短时间的二次真空脱泡。
严格控制储存和使用条件:胶水按要求冷藏/冷冻储存,使用前回温至室温并充分搅拌(如需),避免开封后长时间暴露在空气中吸湿或污染。
验证胶水批次稳定性: 新批次胶水上线前进行小批量工艺验证。
2. 改善点胶工艺:
优化点胶参数:
降低点胶速度,尤其是在拐角和靠近元器件边缘时。
调整点胶高度,找到最佳高度(通常离基板表面0.1-0.5mm,根据针头和胶水特性调整),避免刮蹭和飞溅。
优化点胶压力和出胶量,确保胶流稳定连续。
优化点胶路径: 设计简单、顺畅的点胶路径(如“L”型或“U”型),避免急转弯和复杂路径。起始点和结束点通常设计在空旷区域或易于排气的位置。确保胶线首尾相连或重叠。
选择合适的点胶针头:选用内径合适(通常略大于胶点直径)、锥形或斜口针头,减少胶流扰动。定期检查更换磨损针头。
确保胶量充足且连续:精确计算所需胶量(考虑元器件尺寸、间隙、爬升高度),点胶后目检胶线是否连续无中断,能充分填充并形成良好“围栏”。
3、确保基板与元器件清洁干燥:
严格清洗: 在点胶前进行有效的清洗工艺(如等离子清洗、溶剂清洗、水基清洗),彻底去除焊后残留的助焊剂、油脂、颗粒等污染物。等离子清洗还能提高表面能,改善润湿性。
充分烘烤除湿:对于吸湿性强的元器件(如BGA、塑封器件)和基板(如某些PCB材料),在点胶前必须按照规范进行高温烘烤除湿(如125°C,8-24小时),去除吸收的水分。存储环境应控制湿度(通常<10% RH)。
4、控制填充环境与过程:
控制环境湿度: 点胶和填充过程最好在温湿度受控的环境中进行(如20-25°C,<40% RH)。
增加填充后静置时间:点胶完成后,在进入固化炉之前,给予一定的静置时间(几秒到几分钟,根据胶水特性),让已卷入的大气泡有时间上浮破裂。对于复杂结构或高粘度胶水尤为重要。
5、优化固化工艺:
设置阶梯式升温曲线/预固化平台: 这是解决升温过快导致气泡的关键!
第一步(预固化/凝胶化阶段): 在相对较低的温度(例如胶水凝胶化温度附近,如80-100°C)下保温一段时间(如10-30分钟,甚至更长)。此阶段胶水粘度显著降低但尚未完全固化,为气泡提供了最佳逸出窗口期。
第二步(主固化阶段): 再缓慢或快速升温到最终固化温度(如150-165°C),完成完全固化。确保总固化时间满足要求。
严格控制升温速率: 在预固化阶段结束后的升温速率也不宜过快,特别是在胶体接近凝胶点时。
确保炉温均匀性: 定期校验固化炉(回流焊炉或烘箱)各温区的温度均匀性。
6、设备维护与管理:
定期维护点胶设备: 校准压力、流量传感器,检查泵、阀、管路密封性。
确保真空脱泡设备性能: 定期检查真空泵油、密封圈,校验真空度。
保持针头、储胶管清洁: 及时清洗更换,避免堵塞或污染。
7、过程监控与检验:
在线监测: 对关键参数(点胶量、点胶路径、点胶高度、真空度、温湿度、炉温曲线)进行在线监控或SPC控制。
离线检验:对固化后的产品进行抽检或全检(如X-Ray检查、声扫检查、切片分析),及时发现气泡问题并追溯原因。建立可接受的气泡标准(如大小、数量、位置)。
总结
解决环氧底部填充胶固化后的气泡问题是一个需要系统性工程思维的过程。材料选择、真空脱泡、基板/元件清洁干燥、点胶参数优化(特别是速度和高度)、以及固化曲线的设计(关键的预固化平台)是最常出问题也最需要重点关注的环节。必须通过严谨的工艺试验设计、持续的过程监控和严格的物料/设备管理,才能有效控制和消除气泡,确保底部填充的质量和最终产品的可靠性。
文章来源:汉思新材料
-
芯片
+关注
关注
463文章
54686浏览量
471247 -
微电子封装
+关注
关注
1文章
33浏览量
7287
发布评论请先 登录



 汉思新材料:环氧底部填充胶固化后有气泡产生原因分析及解决方案
汉思新材料:环氧底部填充胶固化后有气泡产生原因分析及解决方案

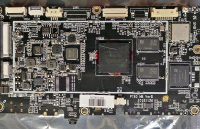

















评论