针对BGA(球栅阵列)底部填充胶(Underfill)固化异常延迟或不固化的问题,需从材料、工艺、设备及环境等多方面进行综合分析。以下为常见原因及解决方案
一、原因分析
1.材料问题
胶水过期或储存不当:未按供应商要求储存(如温度、湿度、避光等),导致胶水性能劣化。
材料受潮:吸湿性胶水因湿气干扰固化反应。
2.固化条件不达标
温度不足或时间过短:未达到胶水固化所需的温度曲线(如未达到推荐的120℃或时间不足)。
温度分布不均:回流焊炉或固化炉温度均匀性差,局部区域未达固化温度。
UV固化胶的光照不足:UV灯强度衰减或照射时间不足。
3.工艺操作问题
点胶不均匀:胶水未充分填充BGA底部间隙,导致局部固化不良。
胶水渗透性差:胶水未完全覆盖焊点,存在气泡或空隙。
-固化前预固化不足:未完成预固化(如低温预固化)直接进入主固化阶段。
4.环境因素
湿度过高:湿气干扰固化反应(尤其对湿气敏感型胶水)。
氧气抑制(自由基固化胶水):氧气阻聚导致表面发粘或不固化。
5.设计兼容性问题
BGA间隙过小:胶水无法充分流动,导致填充不良。
材料与基板不匹配:胶水与PCB基板或焊球材料的热膨胀系数(CTE)差异过大。

二、解决方案
1.材料优化
严格管控材料:检查胶水有效期及储存条件(如低温干燥环境),避免使用过期或劣化材料。
选择低吸湿性胶水:改用对湿气不敏感的材料(如阳离子固化胶)。
2.固化条件调整
验证温度曲线:使用温度曲线测试仪(如KIC测温仪)确认固化炉实际温度与设定值一致,确保达到胶水TDS(技术数据表)要求。
优化固化设备:调整炉内热风循环或增加均温板,改善温度均匀性。
UV固化参数优化:定期检测UV灯强度,必要时更换灯管;延长照射时间或增加照射角度。
3.工艺改进
优化点胶参数:调整点胶速度、压力及路径,确保胶水均匀覆盖BGA底部间隙。
提高胶水流动性:预热基板(如60~80℃)或选择低粘度胶水,改善填充效果。
分阶段固化:按胶水要求进行预固化(如80℃/30min)+主固化(如150℃/60min)。
4.环境控制
湿度管控:生产环境湿度控制在40%~60%(视胶水类型而定),必要时使用除湿机。
隔绝氧气:对自由基固化胶水,可在氮气环境下固化或选用厌氧型胶水。
5.设计与兼容性验证
优化BGA设计:与PCB设计团队协作,确保BGA与基板间隙合理(推荐50~100μm)。
材料兼容性测试:通过热循环试验(-40℃~125℃)验证胶水与基板的CTE匹配性。
三、测试与监控
1.固化过程监控:
使用示踪剂(如DSC分析)检测固化度,确保达到90%以上。
通过红外热成像仪检查固化温度均匀性。
2.固化后检测:
切片分析:观察胶水填充是否完全,是否存在气泡或空洞。
推力测试:验证BGA焊点与胶水的结合强度。
电性能测试:检查电气连接可靠性(如菊花链测试)。
四、总结
固化异常的根本原因通常是材料、工艺、设备或环境的综合作用。建议通过以下步骤系统排查:
1.确认胶水型号与工艺要求匹配;
2.验证固化设备参数与胶水TDS一致性;
3.优化点胶工艺及环境条件;
4.必要时与胶水供应商联合分析,提供失效样品进行FTIR或DSC测试。
通过以上措施,可显著提升BGA底部填充胶的固化可靠性,避免因固化不良导致的焊点开裂或器件失效。
-
BGA
+关注
关注
5文章
586浏览量
51947 -
芯片封装
+关注
关注
14文章
620浏览量
32390
发布评论请先 登录
导热灌封胶固化后表面不均匀的原因
UVLED固化机在光学镜片UV胶固化的应用
手机SIM卡和银行卡芯片封装和bga底部填充胶方案
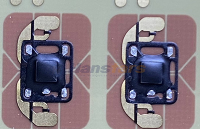
工业计算机电脑主板CPU,BGA芯片底部填充胶应用
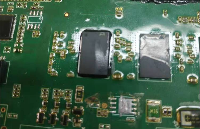



 BGA底部填充胶固化异常延迟或不固化原因分析及解决方案
BGA底部填充胶固化异常延迟或不固化原因分析及解决方案



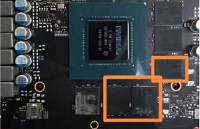

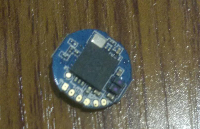







评论