直播回顾
兴森科技携手电巢科技联合推出的《兴森大求真》第6期“FCBGA先进封装基板兴力量”直播活动圆满结束。
本期直播内容让观众过足了“瘾”!多位重量级亲临电巢XR技术直播间,深度剖析了FCBGA基板的行业现状及未来趋势,同时,兴森科技也充分展示了其先进技术和创新解决方案,更引人瞩目的是,兴森科技首次实景展示了兴森半导体FCBGA基板厂的工艺和技术,与大家共同见证了“兴”力量,包括尖端的设备、卓越的人才、领先的技术以及雄厚的资源等。这一切都离不开兴森科技多年来不懈的积累和持续的研发投入。
本期直播活动中,兴森科技不仅仅只是扮演了参与者的角色,更是引领者,为业界及观众带来了关于FCBGA先进封装的前沿知识,并树立了标杆。
FCBGA
先进封装演进趋势
信息时代,我们目睹着数据量不断膨胀,推动着芯片性能的飞速提升,例如处理器的浮点计算能力、网络芯片的带宽、存储器的容量。核心芯片必须不断提升互连速度和密度,IO速率每4~6年翻一番的发展速度已不能满足对芯片性能提升的诉求,因此,提升密度成为不可或缺的途径。
然而,自2010年后,随着摩尔定律放缓,半导体集成速度开始放缓。与此相反,封装技术的集成速度迅速加快,以2.5D/3D晶片堆叠为代表的先进封装不断崭露头角,各种热门词汇如TSV、RDL、SiP、Chiplets 等层出不穷。
从基板角度看,先进封装的物理架构包括一下几种形式:
1)基板类封装,主要包括FCCSP和FCBGA;
2)Panel类封装,PLP;
3)无基板类封装,例如扇出型WLP 。
其中FCBGA基板封装在互连规模方面居于领先地位,已成为CPU、GPU、AI、交换等核心芯片不可缺少的封装形式。
根据Yelo 2023市场监控的报告显示,涉及FCBGA基板的两类封装(Flip-Chip、 2.5D/3D),其2022年的收入达到约317亿美元(占比接近72%), 预计2028年,这一数字将增长至约625亿美元(占比接近80%)。凸显了FCBGA基板封装在半导体行业中的重要性和增长潜力。
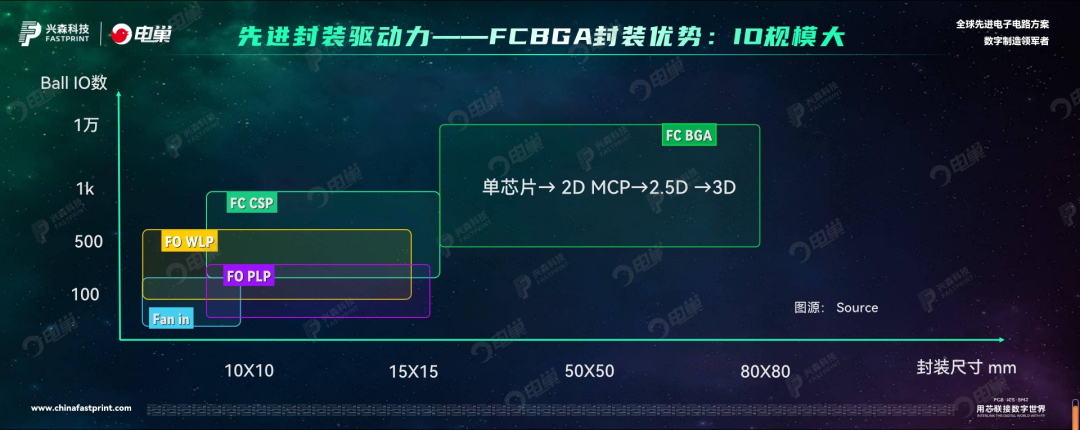
FCBGA封装优势
FCBGA基板
技术趋势
FCBGA基板作为先进封装的重要载体,承载着多重功能,包括信号互连、机械支撑以及底部散热。
受核心芯片高性能的需求驱动,FCBGA基板不断演进,朝向高速、高层数、大尺寸、细线路、小间距的方向发展,以满足更多、更高密度的大带宽IO互连需求。同时,它还承载了集成无源器件、埋晶片、集成光等多种功能。
然而,随着2.5D/3D先进封装的复杂度越来越高,对FCBGA基板的要求也日益提高,这包括对其平整度、导通及绝缘可靠性提出了更大的挑战。
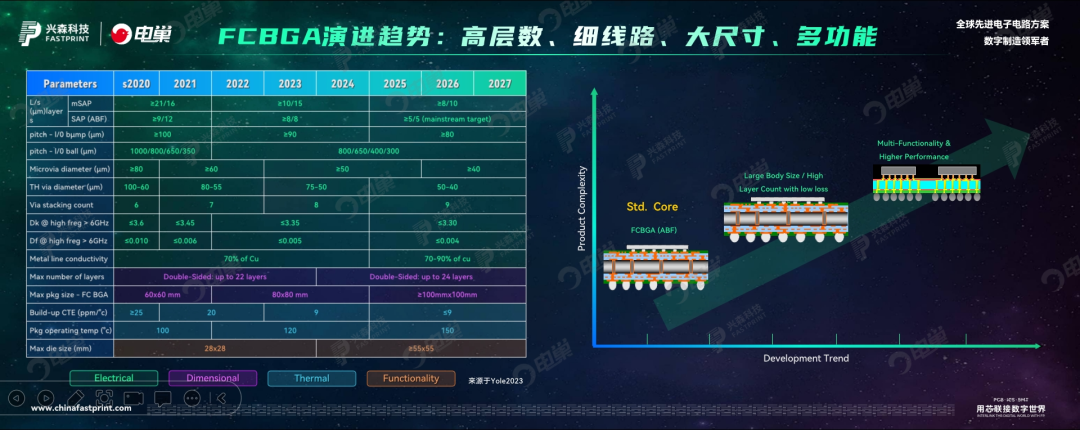
FCBGA基板演进方向(源自Yole)
FCBGA基板厂
首次公开
兴森FCBGA基板布局
应国内外市场及客户需求,兴森半导体对标国际一流,已经构建了两个FCBGA基板厂区。
首先是位于珠海的厂区,其定位为“高阶FCBGA基板样品及小批量基地”,于2021年启动,2022年底投产,该厂不仅可以满足样品和小批量需求,还可协同客户Co Design、Co Research。
其次,广州厂区的定位为“高端FCBGA基板大批量基地”,于2022年启动,预计将在2024年第一季获得认证。
兴森FCBGA基板高工艺能力
在高层数和大尺寸方面,兴森半导体目前的量产能力已经达到了7-2-7 (16 层板)的水平,且尺寸控制在80x80mm以下。同时,兴森还拥有9-2-9和110x110mm 的打样能力。兴森的目标不仅于此,目标在2024年达到行业标杆水准,将层数提升至22层及以上,以满足市场需求。
在高密度方面,包括细线路和小间距,兴森已具备了12/12um线路的量产能力,并且可以支持9/12um的设计需求;到了2024年,计划将进一步缩小线路等级至8/8um。而Bump pitch方面,兴森已具备130um的量产能力,预估在2024年将突破bump pitch 90um的技术难关。

兴森FCBGA基板工艺路标
兴森FCBGA基板高质量高产出与制程
FCBGA基板的制造工艺要求高、涉及复杂的工序,追求高良率、高可靠性的高质量,需要建立严格、严谨的质量体系。
在生产制程中,兴森采用了类晶圆的理念,全厂采用无尘设计,关键工序达到了百级和千级的无尘环境标准。此外,兴森全面采用高自动化的生产线,设备设计以非接触方式为主,以减少了人为的接触。生产物流方面,兴森建立了AGV无人搬运系统和立体仓库系统,进一步提高了生产效率和质量控制。
目前,兴森FCBGA基板的良率已经达到了世界一流水平,不仅保障了高良率的要求,还能够实现高产出。
兴森FCBGA基板厂级实验室
为确保产品的高质量,不仅需要实现高良率,还需要充分验证其高可靠性。因此,兴森半导体专门为 FCBGA基板建立了一座卓越的“万级无尘厂级实验室”,这个实验室包括环境实验室、化学实验室以及物理实验室,其管理符合IATF16949及ISO17025的严格要求。实验室设备齐全,配备了大量高规格仪器设备,同时拥有高度专业的人才团队,在研发阶段,即可与客户共同充分验证和分析产品可靠性。而已经通过认证的产品,将会经过一系列严格的加严测试,以确保其质量和可靠性达到最高标准。
兴森FCBGA绿色工厂
兴森FCBGA基板厂秉承“打造绿色工厂,实现无污染生产”的理念,精心打造了一套全面的环保系统,包括中央供药区、中央废水处理系统和中央监控系统。
“中央供药区”采用现代自动供药系统,确保每个生产步骤都获得正确的材料和化学药剂。这不仅提高了生产效率,还减少过多的化学药剂使用,降低了资源浪费。
“中央废水处理系统”采用高效过滤技术及洁净化工艺手法,实现了约百分之六七十的水可再循环应用,并确保排放水质达到国家标准。
“中央监控系统”实时监控工厂的运行环境,包含空调作动、温湿度、环境异物含量、设施能耗管理等方面。这不仅有助于确保产品质量,还是提高生产可持续性的关键环节。
兴森FCBGA基板绿色工厂
总结
随着先进封装技术的飞速增长,国内外芯片制造和封测厂家对高端FCBGA基板的需求变得越来越紧迫。为了满足市场的迫切需求,兴森半导体积极对标国际一流水平,大力投入建设“高端FCBGA基板厂”,这一举措首次在本期直播中得以亮相。
兴森科技致力于为客户提供“高工艺、高质量、高产出”的高端FCBGA基板产品,并深知客户的需求是多样化和迅速变化的,在满足客户需求的同时,还要与客户携手合作,助力客户在前期研发和创新方面取得成功。未来,兴森将会为客户创造更多解决方案,持续制造更多“兴”能量!
审核编辑:汤梓红
-
芯片
+关注
关注
463文章
54410浏览量
469153 -
半导体
+关注
关注
339文章
31222浏览量
266414 -
先进封装
+关注
关注
2文章
562浏览量
1062
原文标题:直播回顾|解密FCBGA基板,探索先进封装基板"兴"力量
文章出处:【微信号:China_FASTPRINT,微信公众号:兴森科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
Arm解析未来技术市场与设备发展趋势
MPO光纤跳线未来趋势:从800G到硅光集成的技术演进
从被动响应到主动支撑:“四可”技术的演进路径与发展趋势
华宇电子ICCAD-Expo 2025圆满收官
台积电CoWoS平台微通道芯片封装液冷技术的演进路线

Chiplet与异构集成的先进基板技术

从技术突破到量产落地,国产FCBGA攻克翘曲难题、打破国外垄断
未来半导体先进封装PSPI发展技术路线趋势解析

从DBC到AMB:氮化铝基板金属化技术演进与未来趋势

先进Interposer与基板技术解析
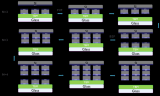
从 2D 到 3.5D 封装演进中焊材的应用与发展




 FCBGA先进封装演进趋势 FCBGA基板技术趋势
FCBGA先进封装演进趋势 FCBGA基板技术趋势








评论