底部填充胶(Underfill)是一种在电子组装中用于增强焊点可靠性的工艺,特别是在倒装芯片封装中。针对底部填充胶(Underfill)进行二次回炉(通常发生在返修、更换元件或后道工序需要焊接时),需要格外谨慎。底部填充胶在首次固化后,其物理和化学性质已经相对稳定,二次加热会带来额外的热应力和潜在的可靠性风险。
以下是关键的注意事项:

1. 确认底部填充胶的耐温性:
这是最核心的前提。必须查阅所使用的底部填充胶的产品规格书。
明确其玻璃化转变温度和热分解温度。
了解供应商对多次回流焊的耐受性建议。有些高性能胶水设计时考虑了返修需求,耐温性较高;而普通胶水可能无法承受二次高温。
绝对确保二次回炉的峰值温度低于底部填充胶的Tg或供应商允许的最高二次回流温度(通常取两者中更低者)。否则胶体会软化、分解甚至燃烧,完全丧失保护作用并可能污染炉膛或焊点。
2. 严格控制回流温度曲线:
峰值温度:必须低于第1点确认的允许温度。通常需要比标准无铅焊料的峰值温度(~245-250°C)显著降低。可能需要专门为返修制定低温曲线。
升温速率:控制升温速率非常重要。过快的升温会导致胶体和元件/基板间因热膨胀系数不同而产生巨大热应力,极易造成胶体开裂、分层或焊点损伤。应使用相对温和的升温斜率。
恒温区时间:在液相线以上时间应足够短,以完成焊接但最小化对胶体的热暴露时间。避免长时间高温浸泡。
冷却速率:同样需要控制,避免过快的冷却导致热冲击和收缩应力,引起裂纹或分层。推荐使用较平缓的冷却斜率。
3. 评估固化度变化:
首次固化后,底部填充胶可能并未达到100%完全固化(取决于初始固化工艺)。二次加热会继续固化反应。
过度的二次固化可能导致胶体变脆,Tg升高,从而降低其吸收应力的能力,增加在后续温度循环中失效的风险。需要评估这种变化对长期可靠性的影响。
4. 热应力管理:
二次加热会重新施加巨大的热应力在已经被填充胶“绑定”的元件、焊球和基板上。
底部填充胶在首次固化后已经与元件和基板紧密结合,热膨胀系数的差异在二次加热时再次被放大,增加了界面分层、胶体本体开裂或焊球疲劳的风险。
优化温度曲线(控制升/降温速率)是管理热应力的关键。
5.与胶水供应商沟通:
在进行二次回炉返修前,强烈建议咨询底部填充胶的供应商。
提供具体的返修场景、拟采用的温度曲线,获取他们对胶水耐受性的确认和建议的最佳实践。
文章来源:汉思新材料
-
电子组装
+关注
关注
0文章
22浏览量
11829 -
倒装芯片
+关注
关注
1文章
124浏览量
16875 -
电子胶水
+关注
关注
4文章
58浏览量
8503
发布评论请先 登录



 汉思新材料:底部填充胶二次回炉的注意事项
汉思新材料:底部填充胶二次回炉的注意事项

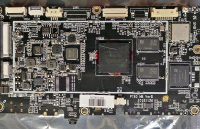




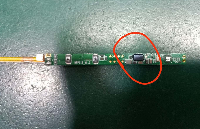



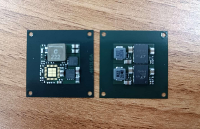








评论