通讯计算卡BGA四角填充加固胶应用案例由汉思新材料提供
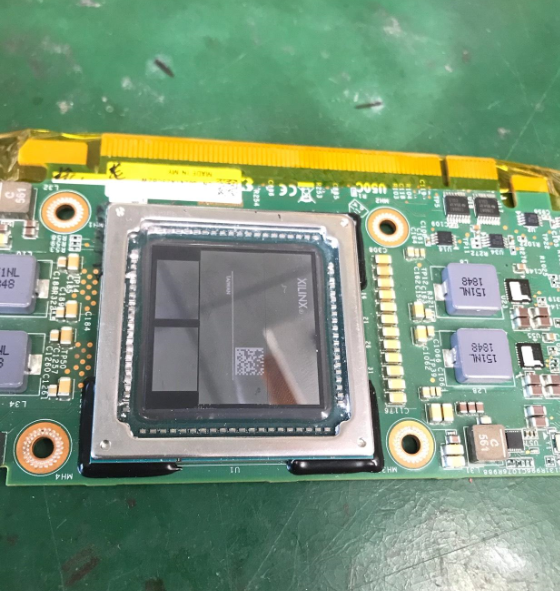
客户产品:通讯计算卡
用胶部位:通讯计算卡BGA四角填充加固
芯片尺寸 :50*50mm 锡球高度:3.71mm 锡球间距:1.00mm 锡球数量:2000颗 锡球大小:0.25mm
用胶目的:粘接、固定,抗震动。
施胶工艺:简易型点胶机
固化方式:接受150度7~8分加热固化
颜色:无要求
换胶原因:新项目研发。
客户用胶要求:
a.主芯片较大与板之间的应力,缓解外应力
b.主芯片持续性工作温度100度,要求缓解热应力,耐高温冲击
c.要求胶水可返修和超强粘接力
汉思新材料推荐用胶:
经过汉思工作人员和客户详细沟通对接,推荐底部填充胶HS710给客户测试。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片
+关注
关注
463文章
54389浏览量
469054 -
BGA
+关注
关注
5文章
586浏览量
51936 -
计算卡
+关注
关注
0文章
16浏览量
4497
发布评论请先 登录
相关推荐
热点推荐
汉思新材料:人形机器人底部填充胶(Underfill)应用指南
人形机器人底部填充胶(Underfill)应用指南人形机器人结构复杂、运动剧烈,其早期故障中超过60%与焊点失效相关,而底部填充胶(Underfill)应用不当是主要原因之一。通过在关

汉思新材料:电路板IC加固环氧胶选择与应用
在电路板制造与运维过程中,IC(集成电路)作为核心部件,其固定可靠性直接决定设备的稳定性与使用寿命。环氧胶因具备优异的粘接强度、耐环境性及电气绝缘性能,成为IC加固的首选材料。一、环氧胶适配IC

在芯片封装保护中,围坝填充胶工艺具体是如何应用的
围坝填充胶(Dam&Fill,也称Dam-and-Fill或围堰填充)工艺是芯片封装中一种常见的底部填充(Underfill)或局部保护技术,主要用于对芯片、焊点或敏感区域提供机械支撑

5G通信模组和gps天线封装加固用什么胶
5G通信模组和gps天线封装加固用什么胶在5G通信模组和GPS天线封装加固中,需根据具体应用场景,工作环境、结构特点及性能要求选择适配的胶粘剂,以下是不同场景下的胶水推荐及分析:5G通信模组和gps

汉思新材料:芯片底部填充胶可靠性有哪些检测要求
芯片底部填充胶可靠性有哪些检测要求?芯片底部填充胶(Underfill)在先进封装(如FlipChip、CSP、2.5D/3DIC等)中起着至关重要的作用,主要用于缓解焊点因热膨胀系数

汉思底部填充胶:提升芯片封装可靠性的理想选择
解决方案,在半导体封装领域占据了重要地位。底部填充胶主要用于BGA(球栅阵列)、CSP(芯片级封装)和FlipChip(倒装芯片)等先进封装工艺中,通过填充芯片与

汉思新材料:底部填充胶可靠性不足如开裂脱落原因分析及解决方案
底部填充胶(Underfill)在电子封装(尤其是倒装芯片、BGA、CSP等)中起着至关重要的作用,它通过填充芯片与基板之间的间隙,均匀分布应力,显著提高焊点抵抗热循环和机械冲击的能力

汉思新材料:PCB器件点胶加固操作指南
点胶加固焊接好的PCB板上的器件是一个常见的工艺,主要用于提高产品在振动、冲击、跌落等恶劣环境下的可靠性。操作时需要谨慎,选择合适的胶水、位置和用量至关重要。以下是详细的步骤和注意事项:汉思新材料
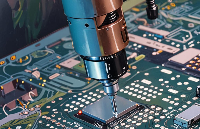
汉思新材料:底部填充胶二次回炉的注意事项
底部填充胶(Underfill)是一种在电子组装中用于增强焊点可靠性的工艺,特别是在倒装芯片封装中。针对底部填充胶(Underfill)进行二次回炉(通常发生在返修、更换元件或后道工序

BGA底部填充胶固化异常延迟或不固化原因分析及解决方案
针对BGA(球栅阵列)底部填充胶(Underfill)固化异常延迟或不固化的问题,需从材料、工艺、设备及环境等多方面进行综合分析。以下为常见原因及解决方案一、原因分析1.材料问题胶水过期或储存不当




 通讯计算卡BGA四角填充加固胶应用案例
通讯计算卡BGA四角填充加固胶应用案例









评论