电子发烧友网报道(文/周凯扬)到了3nm这个工艺节点之后,单靠现有的0.33NA EUV光刻机就很难维系下去了。为了实现2nm乃至未来的埃米级工艺,将晶体管密度推向1000MTr/mm2,全面投入使用高NA EUV光刻机已经势在必行了。据了解,一台高NA EUV的光刻机成本就可能达到3.2亿美元,这样一个天价的光刻系统究竟能带来哪些优势,又存在哪些挑战呢?
规模和密度的平衡,我们为什么需要高NA光刻机?
从今年发布的不少新品来看,即便工艺没有太大的变化,芯片的性能仍在稳步提升,有的是从架构上找到了创新,有的选择了改善带宽之类的性能。但我们也都能看出,其中有一部分产品选择了走大规模的路线,比如苹果的M1 Ultra。这种方式虽然增加了功耗,但对于那些对功耗并不敏感的产品来说,似乎也是可行的一种思路,那么我们真的有必要用到更贵的高NA EUV光刻机进一步提升密度吗?
这个问题的答案其实不言而喻了,英特尔、台积电等晶圆厂提前预订的高NA EUV光刻机订单已经证明了它的重要性。归根结底还是我们的晶体管密度需求仍在不断攀升,但我们需要明白这个需求并不是线性增长的。
新世纪的20年代,很可能成为深度技术发展的黄金十年,比如边缘AI芯片、基于CMOS的NIR/SWIR成像器、光电集成的片上激光雷达等等。你可以说推动工艺发展最大的功臣是智能手机芯片,但其他应用对高密度的需求同样不可小觑,因为这对它们来说也就意味着更高的存储容量和带宽、更高的算力。
如今的深度学习在大规模模型的爆发下,所需算力每几个月就会翻一番,但现在能效比已经成了优先级更高的指标,要想同时满足性能和算力的话,主要方法有四种:一是换一种系统级计算架构,比如DSA架构;二是充分利用3D设计,也就是我们常说的3D封装和堆叠技术;三是从晶体管架构上创新,譬如纳米管、纳米片、CFET和原子沟道等;第四个则是目前看来最快捷的一条路线,通过光刻技术的发展直接提升密度。
高NA光刻机带来的优势
固然高NA EUV光刻机能够让我们挺进下一工艺节点,但它带来的好处并不只是增加晶体管密度。先从技术价值上来说,0.55的大数值孔径与0.33相比,可以实现尺寸减小2/5的特征图形,将密度提升2.9倍。其次,高NA EUV光刻机带来了更高的成像对比度,从而极大改善线宽均匀性,在更少的光刻胶剂量下实现更少的条纹变化。

光刻机晶体管密度的变化趋势 / ASML
对于使用光刻机的晶圆厂来说,以上的优势减少了多重光刻的需要,也减少了光刻胶的剂量使用,从而降低了整体成本。其次,由于工序的简化,曝光后光刻胶图形边缘与设计图形之间的边缘放置误差也一并减少了。这也一并导致了掩膜处理周期的减少,极大提高整个晶圆厂的运转效率。
有突破就有挑战
既然高NA EUV光刻机有这么多好处,ASML为何还不加快进度将其造出来,而是要等到2024年才能出货呢?答案是目前看来,这类光刻机的制造和应用都面临着不小的挑战,以至于在2025年大规模投入都存在一定阻碍。
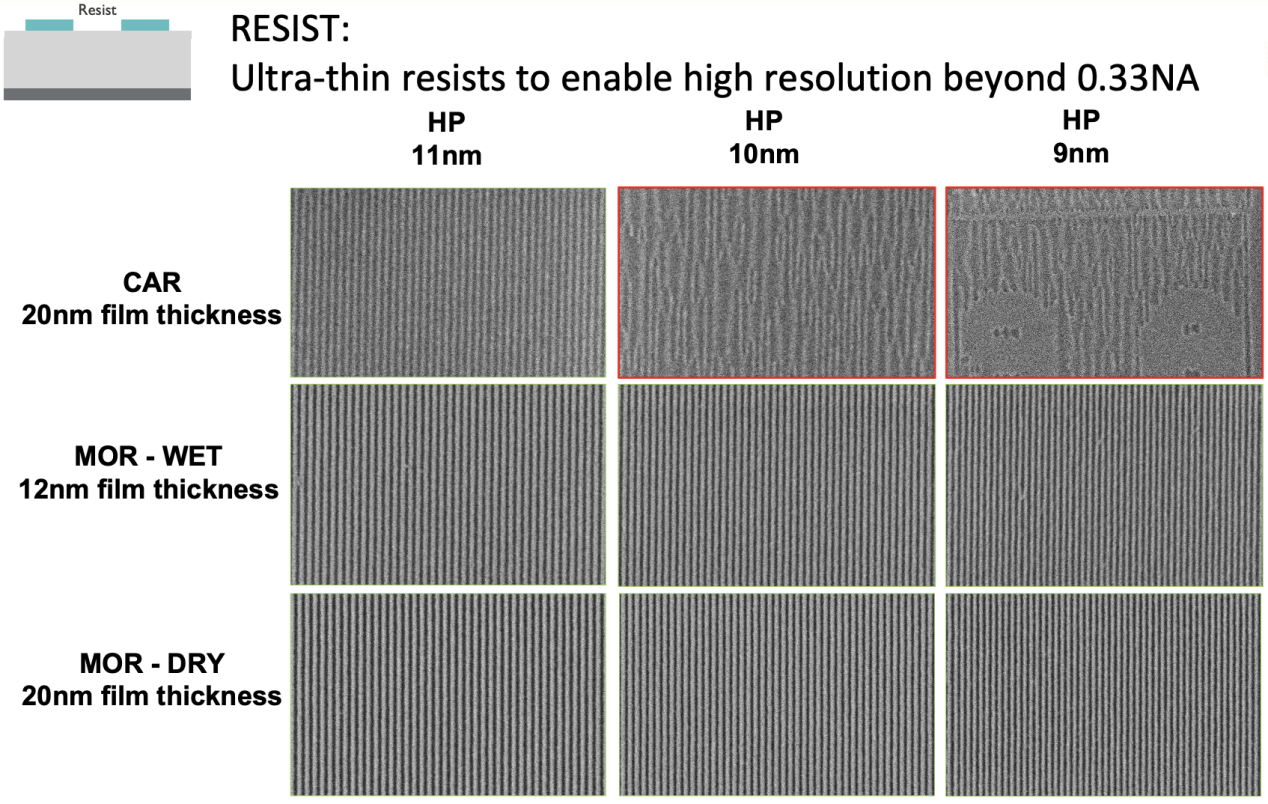
0.33NA之后所需的光刻胶厚度 / IMEC
我们先从光刻胶说起,高NA EUV光刻机需要用到更薄的光刻胶,比如小于20nm,这样才能维持2:1这一理想的线高宽比。否则因为更大的厚度,就会超过这一比例,在曝光阶段容易因为重心变化引发光刻胶塌陷。除了需要超薄、超高分辨率的光刻胶,还要考虑引入的随机效应,这种随机效应会导致不必要的失效和特征图形粗糙度,从而影响到芯片的性能,甚至可能会使整个系统失效。
再者就是高NA EUV光刻机需要用到的新光掩膜,光掩膜对于芯片的制造来说至关重要,因为它的明暗区域内保存着设备成品所需的设计布局信息。随着特征图形尺寸的减小,与理想光掩膜之间的偏差对最终晶圆图案的影响也在增加。
为祸作乱者之一就是光掩膜的3D效应,比如EUV中,光线以6°的入射角击中光掩膜,以此产生的反射可能会产生屏蔽,从而因为光掩膜的缘故在晶圆上产生成像误差。所以必须开发新的变形光掩膜技术及规范,才能减轻3D效应带来的影响。
小结
在更高的芯片性能需求下,转向高NA的EUV光刻机已是必然,这类光刻系统也能彻底释放现代晶体管结构创新的潜力,引领我们走向埃米时代。但我们也不能就此忘记刚引入EUV光刻机时的教训,3年后ASML的高NA EUV实现高密度已经是定数,但良率和产量问题才是这套系统交付后最大的问题。
规模和密度的平衡,我们为什么需要高NA光刻机?
从今年发布的不少新品来看,即便工艺没有太大的变化,芯片的性能仍在稳步提升,有的是从架构上找到了创新,有的选择了改善带宽之类的性能。但我们也都能看出,其中有一部分产品选择了走大规模的路线,比如苹果的M1 Ultra。这种方式虽然增加了功耗,但对于那些对功耗并不敏感的产品来说,似乎也是可行的一种思路,那么我们真的有必要用到更贵的高NA EUV光刻机进一步提升密度吗?
这个问题的答案其实不言而喻了,英特尔、台积电等晶圆厂提前预订的高NA EUV光刻机订单已经证明了它的重要性。归根结底还是我们的晶体管密度需求仍在不断攀升,但我们需要明白这个需求并不是线性增长的。
新世纪的20年代,很可能成为深度技术发展的黄金十年,比如边缘AI芯片、基于CMOS的NIR/SWIR成像器、光电集成的片上激光雷达等等。你可以说推动工艺发展最大的功臣是智能手机芯片,但其他应用对高密度的需求同样不可小觑,因为这对它们来说也就意味着更高的存储容量和带宽、更高的算力。
如今的深度学习在大规模模型的爆发下,所需算力每几个月就会翻一番,但现在能效比已经成了优先级更高的指标,要想同时满足性能和算力的话,主要方法有四种:一是换一种系统级计算架构,比如DSA架构;二是充分利用3D设计,也就是我们常说的3D封装和堆叠技术;三是从晶体管架构上创新,譬如纳米管、纳米片、CFET和原子沟道等;第四个则是目前看来最快捷的一条路线,通过光刻技术的发展直接提升密度。
高NA光刻机带来的优势
固然高NA EUV光刻机能够让我们挺进下一工艺节点,但它带来的好处并不只是增加晶体管密度。先从技术价值上来说,0.55的大数值孔径与0.33相比,可以实现尺寸减小2/5的特征图形,将密度提升2.9倍。其次,高NA EUV光刻机带来了更高的成像对比度,从而极大改善线宽均匀性,在更少的光刻胶剂量下实现更少的条纹变化。

光刻机晶体管密度的变化趋势 / ASML
对于使用光刻机的晶圆厂来说,以上的优势减少了多重光刻的需要,也减少了光刻胶的剂量使用,从而降低了整体成本。其次,由于工序的简化,曝光后光刻胶图形边缘与设计图形之间的边缘放置误差也一并减少了。这也一并导致了掩膜处理周期的减少,极大提高整个晶圆厂的运转效率。
有突破就有挑战
既然高NA EUV光刻机有这么多好处,ASML为何还不加快进度将其造出来,而是要等到2024年才能出货呢?答案是目前看来,这类光刻机的制造和应用都面临着不小的挑战,以至于在2025年大规模投入都存在一定阻碍。
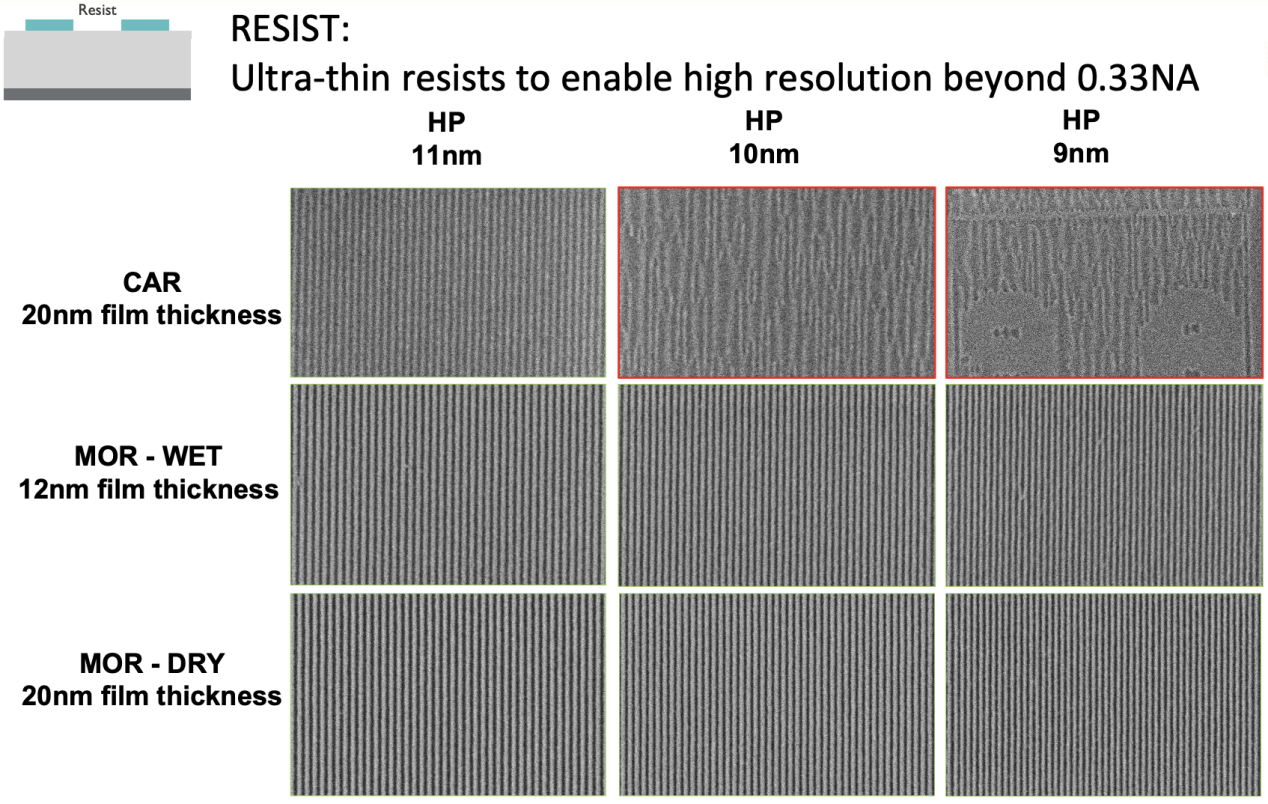
0.33NA之后所需的光刻胶厚度 / IMEC
我们先从光刻胶说起,高NA EUV光刻机需要用到更薄的光刻胶,比如小于20nm,这样才能维持2:1这一理想的线高宽比。否则因为更大的厚度,就会超过这一比例,在曝光阶段容易因为重心变化引发光刻胶塌陷。除了需要超薄、超高分辨率的光刻胶,还要考虑引入的随机效应,这种随机效应会导致不必要的失效和特征图形粗糙度,从而影响到芯片的性能,甚至可能会使整个系统失效。
再者就是高NA EUV光刻机需要用到的新光掩膜,光掩膜对于芯片的制造来说至关重要,因为它的明暗区域内保存着设备成品所需的设计布局信息。随着特征图形尺寸的减小,与理想光掩膜之间的偏差对最终晶圆图案的影响也在增加。
为祸作乱者之一就是光掩膜的3D效应,比如EUV中,光线以6°的入射角击中光掩膜,以此产生的反射可能会产生屏蔽,从而因为光掩膜的缘故在晶圆上产生成像误差。所以必须开发新的变形光掩膜技术及规范,才能减轻3D效应带来的影响。
小结
在更高的芯片性能需求下,转向高NA的EUV光刻机已是必然,这类光刻系统也能彻底释放现代晶体管结构创新的潜力,引领我们走向埃米时代。但我们也不能就此忘记刚引入EUV光刻机时的教训,3年后ASML的高NA EUV实现高密度已经是定数,但良率和产量问题才是这套系统交付后最大的问题。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
光刻机
+关注
关注
31文章
1201浏览量
49033 -
EUV
+关注
关注
8文章
615浏览量
88977
发布评论请先 登录
相关推荐
热点推荐
中国打造自己的EUV光刻胶标准!
其他工艺器件的参与才能保障芯片的高良率。 以光刻胶为例,这是决定芯片 图案能否被精准 刻下来的“感光神经膜”。并且随着芯片步入 7nm及以下先进制程芯片 时代,不仅需要EUV光刻机
俄罗斯亮剑:公布EUV光刻机路线图,挑战ASML霸主地位?
电子发烧友网报道(文/吴子鹏) 在全球半导体产业格局中,光刻机被誉为 “半导体工业皇冠上的明珠”,而极紫外(EUV)光刻技术更是先进制程芯片制造的核心。长期以来,荷兰 ASML 公司几乎垄断

AI需求飙升!ASML新光刻机直击2nm芯片制造,尼康新品获重大突破
*1(L/S*2)高分辨率。扇出型面板级封装(FOPLP)技术为何会获得台积电、三星等代工大厂的青睐?比较传统的光刻机设备,尼康DSP-100的技术原理有何不同?能解决AI芯片生产当中的哪些痛点问题? 针对2nm、3nm芯片制造

看点:台积电展示新一代芯片技术 特斯拉:努力在中国市场推出辅助驾驶
(低成本方案,适配手机/笔记本),并宣布至2029年均无需采用ASML高价High-NA EUV光刻设备。这意味着台积电即便不用阿斯麦昂贵的高数值孔径极紫外
垄断 EUV 光刻机之后,阿斯麦剑指先进封装
电子发烧友网综合报道 当全球半导体产业陷入 “先进制程竞赛” 的白热化阶段,极紫外(EUV)光刻机作为高端芯片制造的 “皇冠上的明珠”,成为决定产业格局的核心力量。荷兰阿斯麦(ASML)作为全球唯一
EUV光源重大突破!ASML:芯片产量将提升50%
紫外光刻(EUV)设备的公司。EUV设备堪称芯片制造商生产先进计算芯片的“神器”,像台积电、英特尔等行业巨头都高度依赖它。EUV光刻机是以1
泽攸科技 | EBL和EUV光刻机有何区别?如何影响半导体行业?
从技术路径上看,电子束光刻和大家熟悉的EUV光刻并不是同一类问题的解法。电子束光刻本质上是一种直接写入技术,利用聚焦电子束在抗蚀剂上逐点曝光,通过电磁控制精确描绘图形。这种方式不依赖掩

光刻机的“精度锚点”:石英压力传感器如何守护纳米级工艺
在7纳米、3纳米等先进芯片制造中,光刻机0.1纳米级的曝光精度离不开高精度石英压力传感器的支撑,其作为“隐形功臣”,是保障工艺稳定、设备安全与产品良率的核心部件。本文聚焦石英压力传感器在光刻机中
国产高精度步进式光刻机顺利出厂
近日,深圳稳顶聚芯技术有限公司(简称“稳顶聚芯”)宣布,其自主研发的首台国产高精度步进式光刻机已成功出厂,标志着我国在半导体核心装备领域取得新进展。 此次稳顶聚芯出厂的步进式光刻机属于WS180i
【「AI芯片:科技探索与AGI愿景」阅读体验】+半导体芯片产业的前沿技术
%。至少将GAA纳米片提升几个工艺节点。
2、晶背供电技术
3、EUV光刻机与其他竞争技术
光刻技术是制造
发表于 09-15 14:50
EUV光刻胶材料取得重要进展
电子发烧友网综合报道 随着集成电路工艺的不断突破, 当制程节点持续向7nm及以下迈进,传统的光刻技术已难以满足高精度、高密度的制造需求,此时,波长13.5nm的极紫外(EUV)光刻技术

中科院微电子所突破 EUV 光刻技术瓶颈
极紫外光刻(EUVL)技术作为实现先进工艺制程的关键路径,在半导体制造领域占据着举足轻重的地位。当前,LPP-EUV 光源是极紫外光刻机所采用的主流光源,其工作原理是利用波长为 10.6um 的红外

ASML官宣:更先进的Hyper NA光刻机开发已经启动
电子发烧友网综合报道,日前,ASML 技术高级副总裁 Jos Benschop 表示,ASML 已携手光学组件独家合作伙伴蔡司,启动了 5nm 分辨率的 Hyper NA 光刻机开发。这一举措标志着
发表于 06-29 06:39
•2162次阅读
电子直写光刻机驻极体圆筒聚焦电极
电子直写光刻机驻极体圆筒聚焦电极
随着科技进步,对电子显微镜的精度要求越来越高。电子直写光刻机的精度与电子波长和电子束聚焦后的焦点直径有关,电子波长可通过增加加速电极电压来减小波长,而电子束聚焦后
发表于 05-07 06:03



 密度提升近3倍,高NA EUV光刻机有何玄机
密度提升近3倍,高NA EUV光刻机有何玄机




评论