热压键合机TC Bonder(Thermal Compression Bonding)是一种用于半导体封装过程中热压键合的专用设备。在高带宽内存(HBM)的制造过程中,TC Bonder通过施加热量和压力将多个DRAM芯片堆叠在一起,实现芯片间的电气连接。
根据填充材料的不同,热压键合又可以分为TC-NCF, TC-NCP, TC-CUF, TC-MUF等等。取决于基板材料的不同,热压键合又可以分为Chip-to-Substrate (C2S) ,Chip-to-Wafer (C2W),Chip-to-Chip (C2C) 和Chip-to-Panel(C2P)。
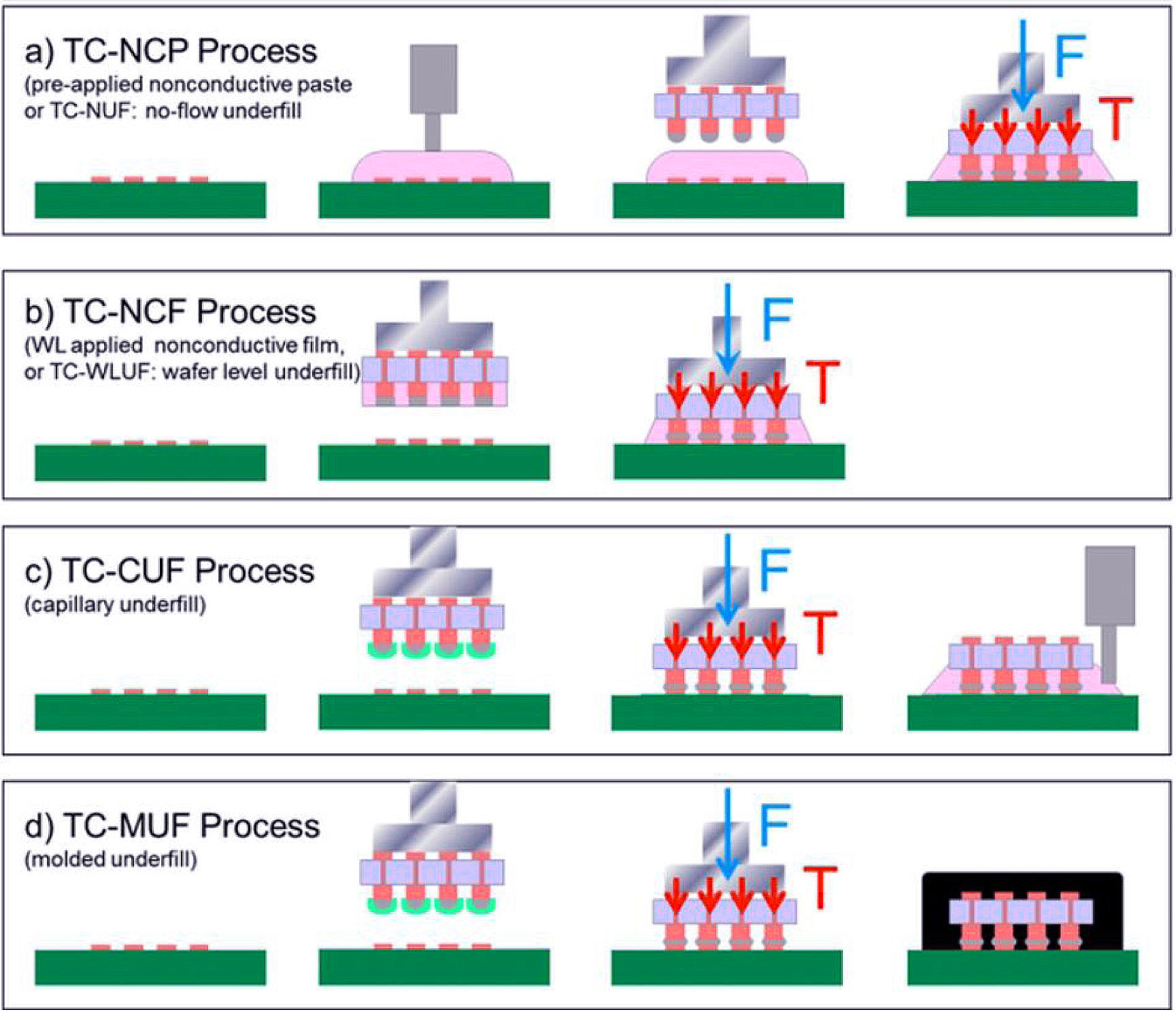
以常见的TC-CUF热压键合为例,整个芯片键合过程通常在1-5秒,热压键合机(TC Bonder)的具体步骤流程如下:
(1)将基板真空吸附到非常平整的pedestal上,并通常加热到150ºC到 200ºC。将基板的温度设定尽可能的高来减少键合时间。
(2)在基板的C4区域喷涂上足量的助焊剂 。
(3)将邦头加热到150ºC到200ºC之间,并用邦头去拾取芯片。
(4)用上视和下视相机来确定芯片和基板的相对位置,通过校准过的算法算出芯片所需的空间位置调整来完全对照基板的凸点,通过设备上精密的机械控制来完成这个步骤。
(5)然后将邦头连带吸附的芯片一起以亚微米的精度靠近基板。此时芯片和基板都处在锡球融化温度以下,所以锡球都是固体。锡球可以是在基板上也可以在芯片上或者两者都有。
(6)在下降过程中邦头一直处在压力敏感控制,既进行着非常灵敏且实时的力测量。
(7)当芯片和基板接触的那瞬间,系统探测到一个压力上的变化,从而判断接触发生同时迅速将邦头从压力敏感控制转为压力和位置共同控制。
(8)此时通过邦头上的加热装置迅速将芯片加热至300ºC以上。值得指出的是热压键合的温度变化率一般都是在100 ºC/s。相比之下,回流焊键合的温度变化率要低很多,通常在2 ºC/s。
(9)当锡球处于熔融状态时,通过邦头对芯片的精确位置控制来确保每对凸点都键合上,且将芯片间隙高度控制在合理的范围内。值得指出的是,在加热的过程中,真个系统都会热膨胀,这部分的膨胀需要邦头位置的精确控制来抵消。
(10)将邦头的温度迅速冷却至锡球熔点以下,使得锡球变为固相。通常冷却温度变化率要比加热温度变化率要低一些,通常在−50 °C/s。
(11)关闭邦头对芯片的真空吸附,芯片跟邦头分离。芯片键合在基板上移出热压键合设备,键合完成。
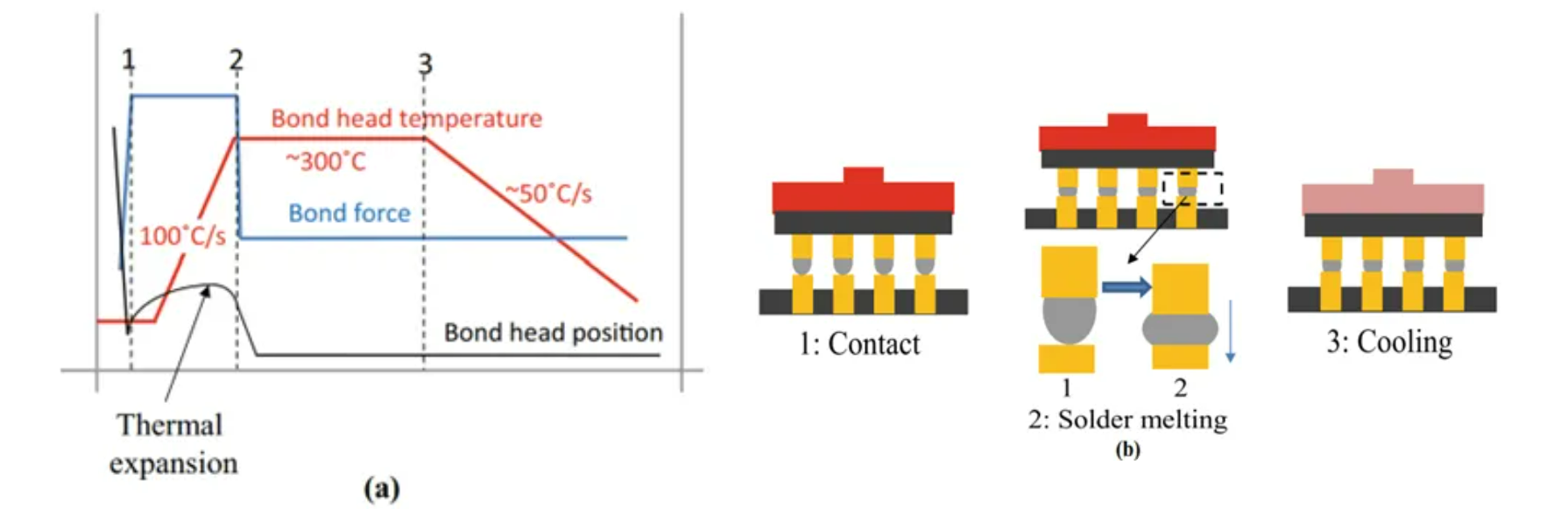
整个热压键合过程中,热压键合机会实时监测邦头的温度(Temperature),邦头的应力( Bond Force)和Z方向的位移 (Bond Head Z Postion)。要求键合设备拥有亚微米甚至纳米级别的位置对准精度,确保待键合芯片在高温压合时能精准对接。需要精准控制键合温度、压力和时间,以确保形成理想的金属间化合物层,同时避免过度扩散导致的键合失效或电性能劣化。
热压键合机(TC Bonder)是HBM制程的核心设备,随着人工智能(AI)和高性能计算(HPC)的需求增长,对HBM的需求供不应求,热压键合机(TC Bonder)的需求也将保持高增长趋势,但,目前热压键合机基本被国外厂商所垄断,国产替代任重而道远。
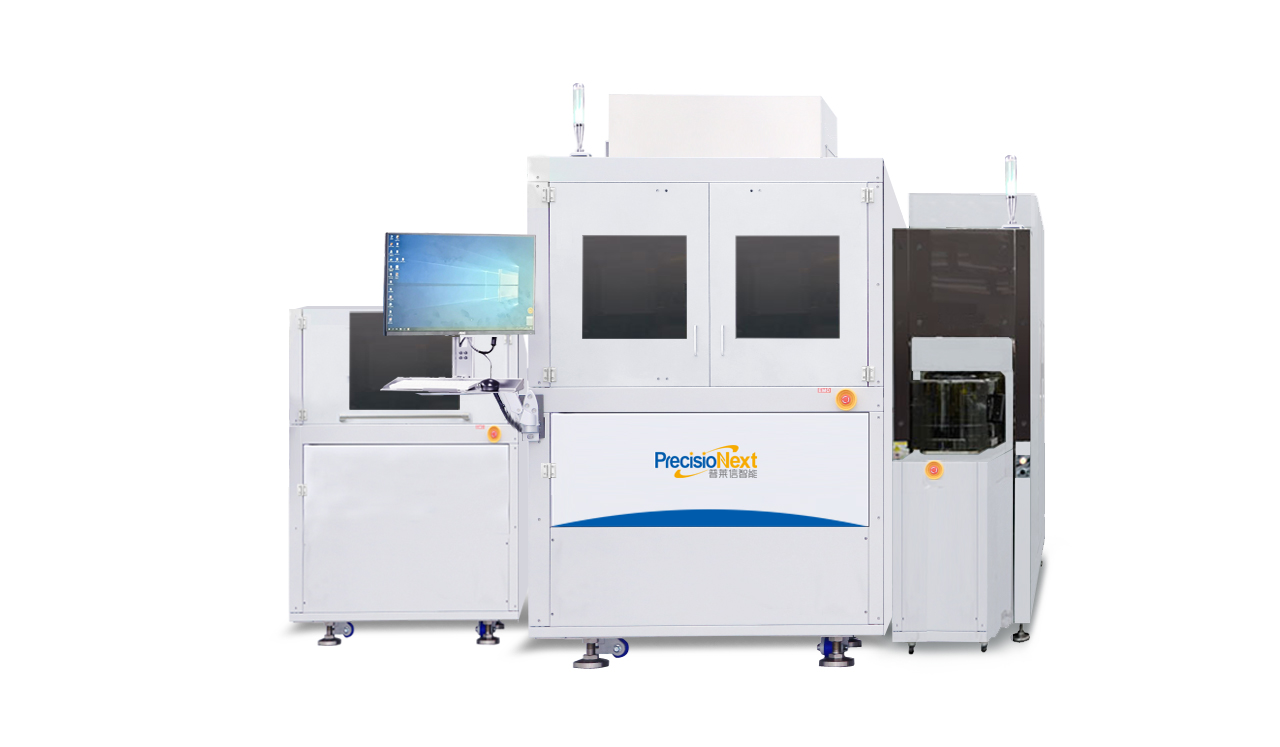
目前国产设备商积极布局该领域,例如普莱信的Loong系列热压键合机,拥有LoongWS和LoongF两种机型,贴装精度达到±1μm@3σ,其中LoongWS可以支持TC-NCF、MR-MUF等HBM堆叠键合工艺,LoongF支持FluxlessTCB无助焊剂热压键合工艺,适用于下一代HBM芯片。随着中国半导体技术的进步和普莱信Loong系列TCB设备的推出和量产,国产厂商在HBM的研发和制造上,将在不远的将来迎来爆发点。
审核编辑 黄宇
-
芯片
+关注
关注
463文章
54432浏览量
469389 -
键合
+关注
关注
0文章
107浏览量
8305 -
HBM
+关注
关注
2文章
434浏览量
15884
发布评论请先 登录
中电科正式发布全自动高真空键合设备及TCB热压键合机两款先进封装核心装备
高频超声键合技术:引线键合工艺优化与质量检测方法

半导体封装引线键合技术:超声键合步骤、优势与推拉力测试标准

NTC热敏芯片键合工艺介绍
热压键合工艺的技术原理和流程详解

氧浓度监控在热压键合(TCB)工艺过程中的重要性

IGBT 芯片平整度差,引发键合线与芯片连接部位应力集中,键合失效

突破堆叠瓶颈:三星电子拟于16层HBM导入混合键合技术




 热压键合机(TC Bonder)在HBM的应用
热压键合机(TC Bonder)在HBM的应用









评论