
今年似乎每个人都在讨论Multi-Die(集成多个异构小芯片)系统。随着计算需求激增和摩尔定律放缓,这种将多个异构晶粒或小芯片集成到同一封装系统中的方式,能够为实现苛刻PPA、控制成本以及满足上市时间的一系列需求提供一个更合理的解决方案。Multi-Die系统让开发者能够以具有成本效益的价格加速扩展系统功能、降低风险、快速打造新的产品型号,从而实现灵活的产品组合管理。
Multi-Die系统现在已经上市了,但这个概念是早在一两年前就被提出的,只不过进展一直十分缓慢。2023年对Multi-Die系统来说也许会是个转折点。
首先,以这些架构为基础的更广泛的生态系统日渐成熟,为实现成本效益以及取得成功提供了更大的机会。其次,设计和验证工具、IP以及制造方面的投资相结合,将会有效克服之前的障碍,为Multi-Die系统的普及铺平道路。Multi-Die正在逐渐被主流半导体世界所接受。
2023年,Multi-Die系统
被大规模采用的开端之年
从疫苗研发到气候变化,从智能手机到先进机器人,设备和系统的智能水平在不断提升,但对芯片的要求却是在尺寸不变或者更小的情况下,提供更高的带宽、更好的性能和更低的功耗。芯片尺寸正在接近极限,在单个SoC中,处理能力、内存、带宽也都遇到了瓶颈。
解决上述困境正是Multi-Die系统的价值所在,它为激发持续创新提供了新的途径。
Multi-Die系统可以拥有数万亿个晶体管,开发者可以根据特定功能的独特要求以及整体系统性能和成本目标,灵活地指定特定功能的晶粒采用特定的工艺技术。
我们预计从2023年开始,未来几年将是Multi-Die系统设计显著增长的几年。
-
高性能计算(HPC)和超大规模数据中心领域因为存在大量计算密集型工作负载,预计将成为Multi-Die架构的最大采用者。
-
移动设备领域的芯片开发者需要在设备尺寸和内存都受限的情况下实现更好的PPA,因此也会采用Multi-Die设计。考虑到Multi-Die的多种形式,一些移动设备制造商正在利用先进的封装来提高芯片密度。
-
汽车芯片开发者也在采用Multi-Die架构,例如用于人工智能模型训练的Tesla D1。业内越来越多的芯片制造商对此愈加重视。通过针对不同的专业功能使用不同的晶粒,汽车子系统可以更好地满足整体PPA和成本要求。
凭借在成本、功能集成和扩展方面的优势,Multi-Die系统正迅速渗透到各个应用领域。所有迹象都表明,2023年将成为Multi-Die系统被大规模采用的开端之年。
Multi-Die生态系统越来越成熟
目前不仅AMD、苹果、亚马逊和英特尔等芯片制造商推出了Multi-Die设计,业内其他主要厂商也在这方面取得了重大进展。Multi-Die架构的生态系统正在迅速走向成熟,这将加速Multi-Die系统在市场上的大规模采用。
工具支持是Multi-Die系统走向成熟的重要推动因素。
之前开发者们大多使用需要手动分析的专有工具和脚本,但现在有了更多统一而成熟的整体性工具,这些工具可以简化设计、验证、测试、签核和芯片生命周期管理等功能,让开发者不再被深层的设计复杂性所困扰。此外,标准化IP可以提供安全稳定的die-to-die连接,降低集成风险并加速chiplet市场发展。
联盟、流程和先进封装技术是推动Multi-Die生态系统走向成熟的另一个标志。
新思科技是主要行业联盟的一员,新思科技的3DIC Compiler协同设计和分析平台经过认证,可用于关键流程,并且针对先进的封装技术获得了生产验证。外包半导体封装和测试(OSAT)供应商则提供了Multi-Die封装所需的技术。此外,硅中介层、重分布层(RDL)和3D堆叠等先进封装技术取得了重大突破,能够实现高集成密度、更低功耗和更高性能。
在标准方面, 通用芯粒互连技术(UCIe)规范是关键的推动因素之一,并且成为目前die-to-die连接的首选标准:
-
该规范目前支持2D、2.5D和桥接封装,预计将支持3D封装。
-
唯一一种具有完整的die-to-die接口堆栈的标准。
-
它支持每个引脚高达32 Gbps的带宽,足以满足当前和未来的应用。
Multi-Die系统,从拐点到腾飞
如果2022年末是Multi-Die系统发展的转折点,那么2023年将是这类架构真正腾飞的一年。凭借包括EDA工具和IP在内的全面Multi-Die解决方案,新思科技实现了早期架构探索、快速软件开发和系统验证、高效设计实施、稳定的晶粒间连接以及改进的制造和可靠性。
新思科技的Multi-Die系统解决方案包括晶粒/封装协同设计、验证、IP、测试和修复、签核分析和芯片生命周期管理等技术。
与采用新的工艺节点相比,开发者们应该已经发现采用Multi-Die系统更具成本效益。另一些设计团队采用此系统是希望利用其实现PPA、成本和上市时间等方面的优势。无论如何,Multi-Die系统有望与单个晶粒一样成为主流芯片,推动应用实现更高性能,让人们的生活更快向数智低碳迈进。

原文标题:2023是否会成为Multi-Die的腾飞之年?
文章出处:【微信公众号:新思科技】欢迎添加关注!文章转载请注明出处。
-
新思科技
+关注
关注
5文章
989浏览量
53022
原文标题:2023是否会成为Multi-Die的腾飞之年?
文章出处:【微信号:Synopsys_CN,微信公众号:新思科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
AI与Multi-Die时代的快速仿真:EDA快仿工具选型指南与验证效率优化方法
新思科技携手Socionext实现3DIC芯片成功流片

新思科技发布全新软件定义硬件辅助验证解决方案
嵌入式开发是否会成为下一个被看好的领域?

软件定义的硬件辅助验证如何助力AI芯片开发

新思科技Multi-Die方案助力车企迈向汽车电子新时代
新思科技助力UCIe 3.0快速落地
新思科技以AI驱动EDA加速Multi-Die创新
面向芯粒设计的最佳实践
DAF胶膜(Die Attach Film)详解
新思科技UCIe IP解决方案实现片上网络互连
新思科技网页端虚拟原型工具的工作流程
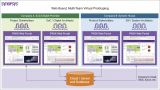
新思科技与三星深化合作加速AI和Multi-Die设计
手机芯片:从SoC到Multi Die




 2023是否会成为Multi-Die的腾飞之年?
2023是否会成为Multi-Die的腾飞之年?




评论