Multi-Die设计将多个异构或同构裸片无缝集成在同一封装中,大幅提升了芯片的性能和能效,因而在高性能计算(HPC)、人工智能(AI)、数据分析、先进图形处理和其他要求严苛的应用领域中至关重要。
Multi-Die设计虽然代表了一项突破性的飞跃,但也带来了诸多工程开发方面的挑战。在2025年芯粒峰会上,来自Ansys、英特尔、新思科技和台积公司的行业专家汇聚一堂,围绕日益复杂的技术挑战展开深入探讨,并分享了宝贵的见解与建议。
应对多物理场挑战
Multi-Die设计带来的变革性优势毋庸置疑,但随之而来的挑战同样令人生畏。与会专家指出,如何有效管理影响功耗和热完整性的多物理场相互作用,是其中尤为棘手的难题。
Ansys电子、半导体与光学事业部的研究员兼首席技术专家Norman Chang表示:“电气、机械、流体和热之间的相互作用非常复杂。”
面对这些相互关联的领域,设计团队必须理解和分析其中涉及的所有相互作用和影响。Chang强调:“必须综合考虑所有因素。”
英特尔架构、设计与技术解决方案及技术开发副总裁Lalitha Immaneni也表示,日益增长的处理需求使Multi-Die设计中的功耗和热管理进一步复杂化。
她谈到:“以AI领域为例,带宽持续提升,容量面临瓶颈,功耗也在不断上升。未来五到十年内,设计的功耗可能高达五千瓦。我们该如何应对这样的局面?”
缩放和优化问题
随着Multi-Die设计日益复杂,各个维度上的微缩/扩展和优化已成为关键考量。工程师必须致力于器件微型化(微缩)、增强性能和容量(纵向扩展),并拓展多器件或系统间的连接与集成(横向扩展)。
每个维度都伴随着特有的挑战,包括功耗控制、散热、信号完整性和整体系统可靠性的保障。
Immaneni表示,英特尔正在推进系统技术协同优化(STCO),即同步优化系统架构、技术节点和设计方法,以期在半导体制造过程中实现性能、功耗和成本效益的全面改善。
她强调:“如果忽视协同优化,一旦执行过程中出现问题,就要付出代价,损失将无法弥补。”
新思科技产品线管理执行总监Shekhar Kapoor补充说:“这是一个多尺度问题。我们需要同时进行微缩、纵向扩展和横向扩展,必须在所有这些不同尺度上进行优化,而每个尺度在性能、时序、电气、散热甚至成本方面都有不同的KPI。”
AI赋能Multi-Die设计
与会专家表示,电子设计自动化(EDA)工具和方法学的进步,为应对Multi-Die挑战提供了有力支持。特别是AI驱动的工具,正被用来优化性能、功耗和成本。
在谈到AI辅助设计优化时,Kapoor表示:“它可以解决布局、布线、架构搭建等问题,还能探索庞大的多目标解空间,显著加快设计进程。”
台积公司的IP和3DFabric高级总监Lluis Paris也表示:“AI正助力我们更快找出哪些材料组合可以实现更好的性能表现。我们还利用AI处理大量复杂的DRC(设计规则检查),判断它们是否完整。”
推动Multi-Die封装技术发展和行业标准制定
与会专家一致认为,Multi-Die封装是当前面临的重大挑战之一,还有多个障碍需要攻克。
Paris强调:“我们需要共同努力,解决混合键合和3D封装方法问题。相关技术指日可待。”
Immaneni补充道:“在开发一些复杂的3DIC解耦技术时,我认为材料方面需要大量创新。例如,分层问题、热管理问题、高速I/O的可靠性问题,都是亟需解决的技术挑战。只有大力推动材料创新,才能真正解决这些技术难题。”
与会专家还指出了行业标准的重要性,但也坦言在实际推进中面临不小的阻力。
Immaneni表示:“我们面临的最大挑战之一是UCIe的各种变体,也就是外部内存问题。它们必须针对现有封装技术进行认证。”
Paris认为:“我完全认可UCIe标准本身的价值。但遗憾的是,市场上的实际情况并不理想。”他指出,客户青睐UCIe PHY的高能效表现,但往往忽视了对标准协议的采用。
整合研究方向与专业技能
与会专家认为,为了应对复杂的Multi-Die设计挑战并加速创新,必须依靠全行业的协作和工程技能的持续演进。
Chang预言:“由1,000个芯粒组成的芯片并不遥远,或许就在未来两三年。我们还有大量研究工作需要开展,必须与大学和新思科技等伙伴携手,共同实现这一愿景。”
工作流程和工程技能也必须融合。
Immaneni强调:“观察当下那些正在不断成长和创新的工程师,你会发现他们的技能已不再局限于某个特定领域。不再有单一的芯片架构师、封装架构师或平台架构师,现在需要的是跨领域的综合能力。”
Paris补充道:“你需要成为一个通才。真正的价值体现在跨领域知识的融会贯通。如果你只是深入钻研一个极窄的领域,未必能解决一些边界模糊的新问题。”
Kapoor总结说:“不要像工程师那样看问题,而要像创新者那样去思考。技术能力固然重要,但创造力同样不可或缺。这就是为什么我们需要构建一个合作共赢的生态系统。它是成就一切的基础。没有生态系统,我们将寸步难行。”
注明:本文包含2025年1月21至23日在美国加利福尼亚州圣克拉拉举行的芯粒峰会上,相关人士在专家座谈会上发表的观点。
-
半导体
+关注
关注
339文章
31560浏览量
267985 -
eda
+关注
关注
72文章
3172浏览量
184218 -
新思科技
+关注
关注
5文章
994浏览量
53028 -
芯粒
+关注
关注
1文章
89浏览量
467
原文标题:迈向“千芯粒”时代:新思科技以AI驱动EDA加速Multi-Die创新
文章出处:【微信号:Synopsys_CN,微信公众号:新思科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
AI与Multi-Die时代的快速仿真:EDA快仿工具选型指南与验证效率优化方法
新思科技携手台积公司全面加速EDA、IP及系统协同创新
新思科技以AI赋能EDA全流程升级
新思科技携手Socionext实现3DIC芯片成功流片

新思科技发布全新软件定义硬件辅助验证解决方案
新思科技Multi-Die方案助力车企迈向汽车电子新时代
新思科技助力UCIe 3.0快速落地
伴芯科技重磅发布DVcrew与PDcrew两大创新产品,以AI智能体重构EDA

新思科技斩获2025年台积公司开放创新平台年度合作伙伴大奖
新思科技UCIe IP解决方案实现片上网络互连
新思科技网页端虚拟原型工具的工作流程
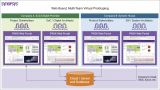



 新思科技以AI驱动EDA加速Multi-Die创新
新思科技以AI驱动EDA加速Multi-Die创新





评论