空位工程(Vacancy engineering)被认为是一种调节电催化剂催化活性的有效方法。
基于此,苏州大学陈子亮副教授和康振辉教授、德国柏林工业大学Prashanth W. Menezes(共同通讯作者)等报道了通过顺序的相位转换策略,在NiSe2结构中产生了带有电荷极化的Se空位(NiSe2-Vse)。
所制备的NiSe2-Vse在碱性介质中对H2O2的选择性最高达96%,在0.25-0.55 V宽电位范围内的选择性超过90%,在已报道的过渡金属基电催化剂中处于领先地位。
此外,在5000次加速降解试验(ADT)后,仅有轻微的选择性衰减。
本文通过DFT计算,以检测Se空位如何增强本征2e− ORR活性和对NiSe2的选择性。在标准条件(U=0 V)和2e− ORR平衡电位(U=0.70 V)下,绘制了NiSe2和NiSe2-Vse在2e− ORR过程中的自由能图。
值得注意的是,对比原始的NiSe2(U=0和0.70 V时分别为4.548和3.848 eV),NiSe2-Vse的∆G*OOH值(U=0和0.70 V时分别为4.28和3.58 eV)更接近理想的∆G*OOH值(U=0和0.70 V时分别为4.22和3.52 eV)。
此外,还模拟了吸附*OOH与基底(NiSe2和NiSe2-Vse)之间的电荷密度差分布。负电荷极化的Se空位使吸附的*OOH与催化剂间产生了更明显的电荷定位,从而加强了活性Ni位点与*OOH的结合。
该结果证明,引入电荷极化Se空位后,有利于提高活性Ni位点与中间体的结合,从而优化∆G*OOH。
在U=0.70 V下,NiSe2-Vse-N-OOH体系的∆G*OOH值为3.61 eV,与NiSe2-Vse-OOH系统的理想值3.52 eV非常接近,但比NiSe2-V-OOH体系的理想值更远,再次证明了Se空位中负电荷极化对提高本征2e− ORR活性的积极作用。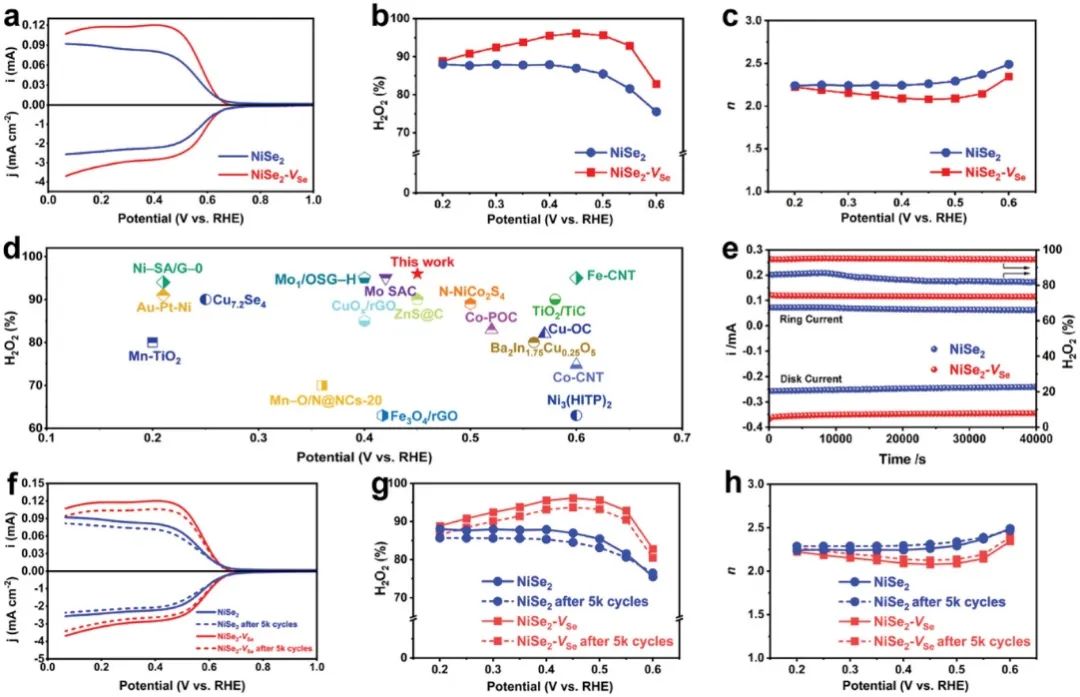
审核编辑:刘清
-
DFT
+关注
关注
2文章
237浏览量
24103 -
ADT
+关注
关注
0文章
12浏览量
9720 -
orr
+关注
关注
0文章
18浏览量
2463
原文标题:苏大&柏林工大Adv. Sci.:NiSe2-Vse电催化氧气转化为过氧化氢
文章出处:【微信号:清新电源,微信公众号:清新电源】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
SPM 溶液清洗:半导体制造的关键清洁工艺

SPM在工业清洗中的应用有哪些

精准氧气供应控制:MF4700系列气体质量流量计在啤酒酿造中的应用
半导体清洗中SPM的最佳使用温度是多少
如何选择合适的SC1溶液来清洗硅片

sc-1和sc-2可以一起用吗

半导体rca清洗都有什么药液

瞬态吸收助力理解AQ(蒽醌)在H•−ORR光催化过程中的作用机制

半导体芯片清洗用哪种硫酸好
氮氧化镓材料的基本性质和制备方法




 NiSe2-Vse电催化氧气转化为过氧化氢
NiSe2-Vse电催化氧气转化为过氧化氢







评论