据媒体报道,作为全球一号代工厂,台积电已经开始大规模量产第六代CoWoS晶圆级芯片封装技术,集成度大大提高。
我们知道,如今的高端半导体芯片越来越复杂,传统的封装技术已经无法满足,Intel、台积电、三星等纷纷研发了各种2.5D、3D封装技术,将不同IP模块以不同方式,整合封装在一颗芯片内,从而减低制造难度和成本。
CoWoS的全称为Chip-on-Wafer-on-Substrate,是一种将芯片、基底都封装在一起的技术,并且是在晶圆层级上进行,目前只有台积电掌握,技术细节属于商业机密。
它属于2.5D封装技术,常用于HBM高带宽内存的整合封装,比如AMD Radeon VII游戏卡、NVIDIA V100计算卡都属于此类。
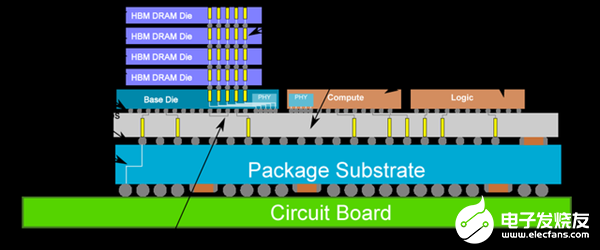
CoWoS封装结构简图
台积电当然也不会披露第六代CoWoS的细节,只是说可以在单个封装内,集成多达12颗HBM内存。
最新的HBM2E已经可以做到单颗容量16GB,12颗封装在一起那就是海量的192GB!
责任编辑:gt
-
芯片
+关注
关注
462文章
53539浏览量
459195 -
台积电
+关注
关注
44文章
5787浏览量
174785 -
晶圆
+关注
关注
53文章
5345浏览量
131701 -
封装
+关注
关注
128文章
9142浏览量
147900
发布评论请先 登录





 台积电第六代CoWoS晶圆级芯片封装量产,单封装内集成多达12颗HBM内存
台积电第六代CoWoS晶圆级芯片封装量产,单封装内集成多达12颗HBM内存


















评论