在半导体制造中有两种基本的刻蚀工艺:干法刻蚀和湿法腐蚀。干法刻蚀是把硅片表面曝露于气态中产生的等离子体,等离子体通过光刻胶中开出的窗口,与硅片发生物理或化学反应(或这两种反应),从而去掉曝露的表面材料。干法刻蚀是亚微米尺寸下刻蚀器件的最重要方法。而在湿法腐蚀中,液体化学试剂(如酸、碱和溶剂等)以化学方式去除硅片表面的材料。湿法腐蚀一般只是用在尺寸较大的情况下(大于3微米)。湿法腐蚀仍然用来腐蚀硅片上某些层或用来去除干法刻蚀后的残留物。
干法刻蚀也可以根据被刻蚀的材料类型来分类。按材料来分,刻蚀主要分成三种:金属刻蚀、介质刻蚀、和硅刻蚀。介质刻蚀是用于介质材料的刻蚀,如二氧化硅。接触孔和通孔结构的制作需要刻蚀介质,从而在ILD中刻蚀出窗口,而具有高深宽比(窗口的深与宽的比值)的窗口刻蚀具有一定的挑战性。硅刻蚀(包括多晶硅)应用于需要去除硅的场合,如刻蚀多晶硅晶体管栅和硅槽电容。金属刻蚀主要是在金属层上去掉铝合金复合层,制作出互连线。
刻蚀也可以分成有图形刻蚀和无图形刻蚀。有图形刻蚀采用掩蔽层(有图形的光刻胶)来定义要刻蚀掉的表面材料区域,只有硅片上被选择的这一部分在刻蚀过程中刻掉。有图形刻蚀可用来在硅片上制作多种不同的特征图形,包括栅、金属互连线、通孔、接触孔和沟槽。无图形刻蚀、反刻或剥离是在整个硅片没有掩模的情况下进行的,这种刻蚀工艺用于剥离掩模层(如STI氮化硅剥离和用于制备晶体管注入侧墙的硅化物工艺后钛的剥离)。
反刻是在想要把某一层膜的总的厚度减小时采用的(如当平坦化硅片表面时需要减小形貌特征)。光刻胶是另一个剥离的例子。总的来说,有图形刻蚀和无图形刻蚀工艺条件能够采用干法刻蚀或湿法腐蚀技术来实现。为了复制硅片表面材料上的掩膜图形,刻蚀必须满足一些特殊的要求。
包括几方面刻蚀参数:刻蚀速率、刻蚀剖面、刻蚀偏差、选择比、均匀性、残留物、聚合物、等离子体诱导损伤、颗粒玷污和缺陷等。刻蚀是用化学或物理方法有选择的从硅片表面去除不需要的材料的过程。刻蚀的基本目标是在涂胶的硅片上正确的复制掩模图形。有图形的光刻胶层在刻蚀中不受腐蚀源显著的侵蚀。这层掩蔽膜用来在刻蚀中保护硅片上特殊区域而选择性的刻蚀掉未被光刻胶保护的区域如图一。
在通常的CMOS工艺流程中刻蚀都是在光刻工艺之后进行的如图二。从这一点来说,刻蚀可以看成在硅片上复制所想要的图形的最后主要图形转移工艺步骤[1]。
图一:刻蚀在CMOS技术中的应用
图二:通常的CMOS工艺流程
-
半导体
+关注
关注
339文章
31203浏览量
266368 -
刻蚀
+关注
关注
2文章
223浏览量
13827
原文标题:刻蚀工艺中的干法刻蚀和湿法腐蚀
文章出处:【微信号:iawbs2016,微信公众号:宽禁带半导体技术创新联盟】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
释放MEMS机械结构的干法刻蚀技术
释放MEMS机械结构的干法刻蚀技术
GaN材料干法刻蚀工艺在器件工艺中有着广泛的应用

干法刻蚀之铝刻蚀的介绍,它的原理是怎样的




 两种基本的刻蚀工艺:干法刻蚀和湿法腐蚀
两种基本的刻蚀工艺:干法刻蚀和湿法腐蚀




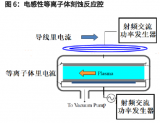





评论