文章来源:芯云知
原文作者:Crane
本文介绍了干法刻蚀用到的设备的原理及结构。
干法刻蚀技术是一种在大气或真空条件下进行的刻蚀过程,通常使用气体中的离子或化学物质来去除材料表面的部分,通过掩膜和刻蚀参数的调控,可以实现各向异性及各向同性刻蚀的任意切换,从而形成所需的图案或结构。常见的干法刻蚀设备有反应离子刻蚀机(RIE)、电感耦合等离子体刻蚀机(ICP)、磁性中性线等离子体刻蚀机(NLD)、离子束刻蚀机(IBE),本文目的对各刻蚀设备的结构进行剖析,以及分析技术的优缺点。
RIE
RIE设备的结构通常比较简单,一般由射频电源、阳极、阴极、气源和真空泵组成,其中,晶圆位于阴极上,射频电源与阴极相连接,在刻蚀开始时,射频电源施加电场到气体上,气体被电离为离子、电子、原子和分子,其中由于电子的运动速度远大于其他离子,在刻蚀腔中会形成明显的鞘区,在晶圆上方会形成自偏压的电场,RIE利用该效应吸引并加速等离子体中的离子与被刻蚀材料产生物理化学作用,最终产生的副产物气体挥发被排出。然而,这种由自偏压效应引起的刻蚀过程中各物质的运动速度不同,造成了RIE刻蚀离子与反应自由基的不匹配,在RIE刻蚀过程中,经常产生的“黑硅”现象就是该原理造成的。

图1 RIE刻蚀结构示意图
ICP
随着工艺要求的不断提高,研发人员开发了电感耦合等离子体刻蚀机(ICP),该设备克服了自由基、离子不匹配的问题,常用的ICP刻蚀机结构如图2所示,一般由顶部通入刻蚀气体,经过刻蚀腔侧壁的RF线圈,被RF线圈施加的电场激发为等离子体,在腔体中形成明显的辉光层;然后,通过在位于下电极上施加Bias的功率吸收等离子体中的刻蚀离子。相比RIE刻蚀技术,ICP刻蚀腔体一般具有较低的气压,更高密度的等离子体,可以通过射频线圈功率、气体流量、Bias功率的调控,实现更高速率,更高精度以及更大深宽比的刻蚀。
图2右给出了ICP用C4F8刻蚀石英的过程,其中射频放电C4F8产生的氟碳自由基会自发的形成钝化层沉积在表面,然后在施加在晶圆表面的Bias作用下,正离子具有较高的速率延垂直于晶圆表面轰击钝化层以及刻蚀石英,实现石英的高深宽比刻蚀。
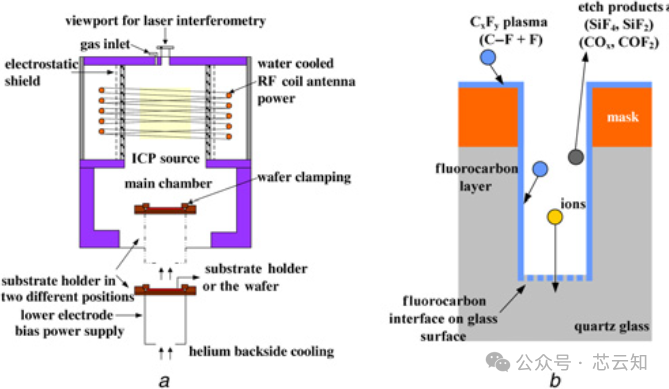
图2 ICP刻蚀机构成和刻蚀示例
NLD
传统ICP刻蚀射频线圈会对刻蚀腔中的磁场产生影响,使得径向的等离子体密度不一致,并干扰刻蚀离子的运动,从而影响刻蚀均匀性。研发人员进一步开发了磁中性环路放电,该设备的结构如图3所示,其在ICP刻蚀线圈的外围施加了三个控制磁场的线圈,通过控制三个线圈磁场的大小从而可以在刻蚀腔中形成磁中环强度为0的环境,从而产生更高密度以及分布均匀的等离子体。加以Bias的控制,NLD技术具有更好的刻蚀均匀性,更高的刻蚀速率。除常用的介质层外,也经常用于刻蚀碳化硅等耐刻蚀材料。
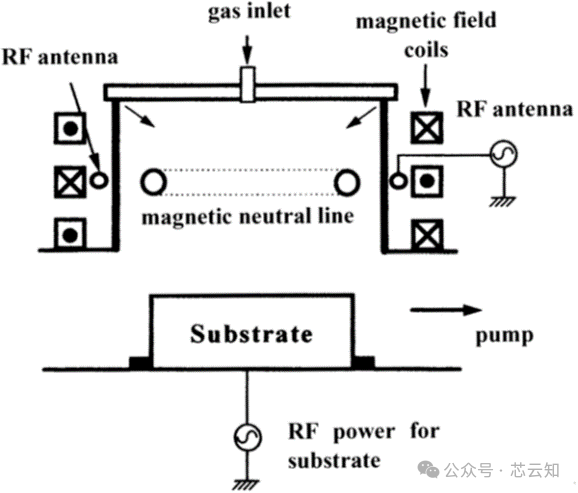
图3 NLD刻蚀机结构
IBE
IBE刻蚀为纯物理轰击刻蚀,常用于氟基或者氯基等离子体无法刻蚀的材料,例如,金、铜、铂等。常规IBE刻蚀机的结构如图4所示,氩气通过灯丝提供的电子将其离子化形成等离子体并离子源,然后通过电子引出加速系使离子均匀射向晶圆工件台,最后通过轰击固体表面原子,使材料原子发生溅射,达到刻蚀目的。
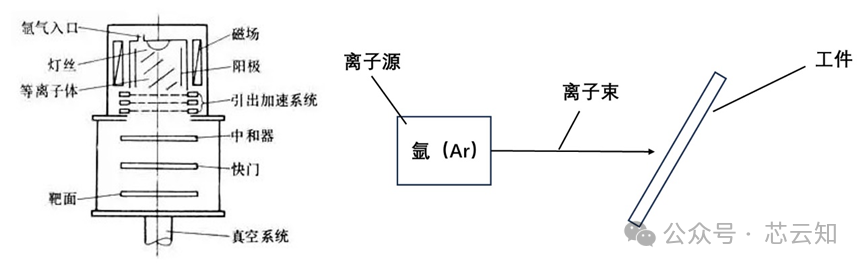
图4 IBE刻蚀结构和离子束路径
IBE的特点主要有:1)高方向性的中性离子束能够控制侧壁轮廓,优化刻蚀过程中的径向均匀性和结构形貌。2)通过调整工件台的角度可以通过倾斜晶圆从而改变离子束的撞击方向实现侧壁角度的控制。
审核编辑:汤梓红
-
等离子体
+关注
关注
0文章
148浏览量
15322 -
晶圆
+关注
关注
53文章
5490浏览量
132955 -
刻蚀机
+关注
关注
0文章
60浏览量
4969
原文标题:MEMS常用干法刻蚀设备结构及原理
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
释放MEMS机械结构的干法刻蚀技术
【转帖】干法刻蚀的优点和过程
释放MEMS机械结构的干法刻蚀技术
两种基本的刻蚀工艺:干法刻蚀和湿法腐蚀
干法刻蚀工艺介绍
干法刻蚀解决RIE中无法得到高深宽比结构或陡直壁问题
干法刻蚀和清洗(Dry Etch and Cleaning)
干法刻蚀工艺的不同参数
晶圆表面温度对干法刻蚀的影响

干法刻蚀侧壁弯曲的原因及解决方法




 干法刻蚀常用设备的原理及结构
干法刻蚀常用设备的原理及结构








评论