半导体底部填充(Underfill)技术:原理、材料、工艺与可靠性
1. 引言:底部填充在先进封装中的作用
现代半导体封装涉及多个互连层级,以连接集成电路(IC)芯片与最终系统。这些层级从L0(芯片内部互连,如门电路)到L4(系统级连接)不等。其中,第一级(Level 1)封装涉及将一个或多个芯片连接到基板并进行封闭保护,而第二级(Level 2)封装则是将封装后的器件连接到印刷电路板(PCB)。
随着器件复杂性和集成度的提高,球栅阵列(BGA)、倒装芯片(Flip-Chip)等封装技术日益普及。这些技术依赖焊点(焊球或焊凸点)实现电气和机械连接。然而,一个主要挑战来自于硅芯片(低CTE,约2.5 ppm/°C)与有机基板(如FR-4,高CTE,约16 ppm/°C)或陶瓷基板(如氧化铝,约6.9 ppm/°C)之间显著的热膨胀系数(Coefficient of Thermal Expansion, CTE)失配。在器件工作经历温度循环时,这种失配会在焊点上引发巨大的热机械应力,最终导致疲劳失效。
底部填充胶(Underfill)正是在这种背景下应运而生。它是一种胶粘剂材料,通常是填充了无机填料的环氧树脂基复合材料。在大多数工艺中,它在焊点形成后被填充到芯片和基板之间的间隙中。其核心功能是机械地耦合芯片与基板,将两者紧密连接在一起,从而显著提高封装组件的可靠性。
2. 底部填充的作用机理与优势
2.1 缓解CTE失配:
当一个带有底部填充的倒装芯片或BGA组件经历温度变化时,填充于间隙中的Underfill材料会固化并牢固粘接芯片与基板。这形成了一个整体的复合结构。虽然Underfill自身也会热胀冷缩,但它在X-Y平面(水平方向)的膨胀受到刚性相对较强的芯片和基板的限制。这种约束使得大部分由CTE失配引起的变形转变为Z轴(垂直方向)的变形以及Underfill内部的应力,而不是集中作用于脆弱焊点的剪切应力。
2.2 “锁”定效应:
固化后的Underfill就像一把“锁”,将芯片和基板牢牢地固定在一起。它将原本集中在单个焊球/焊凸点上的应力,重新分布到整个被Underfill覆盖的界面区域,并传递到更为坚固的基板和芯片结构上。如图1.3所示,热应力作用下的变形得以有效管理。这极大地减小了温度循环过程中焊点所承受的应变,防止了剪切疲劳开裂,延长了器件的工作寿命。
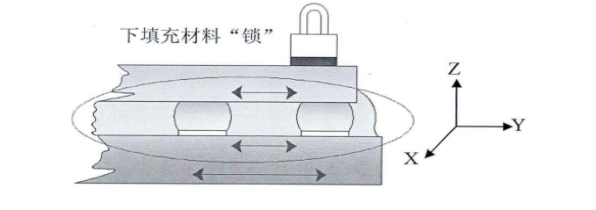
2.3 底部填充的主要功能:
基于以上原理,Underfill提供以下关键优势:
· 增强可靠性:显著提高焊点在热循环和机械冲击下的疲劳寿命。
· 应力重新分布:减轻芯片与基板间CTE失配带来的不利影响,避免焊球破裂。
· 环境保护:密封芯片底部和焊点,防止湿气、离子污染、辐射等有害环境因素的侵入。
· 提高机械强度:增强组件抵抗冲击、振动和物理损伤的能力。
· 辅助散热:Underfill(特别是使用导热填料时)可以作为芯片到基板的一个散热途径。
3. 底部填充材料的组成
Underfill是一种复杂的复合材料体系,通常包含以下组分:
· 树脂体系:通常基于环氧树脂(Epoxy Resin),提供粘接力和结构强度。
· 固化剂(Hardener):与树脂反应形成坚固的交联网络聚合物。常见类型包括酚醛型、胺型和酸酐型,它们赋予Underfill不同的特性(如玻璃化转变温度Tg、固化速度、韧性等)。
o 酚醛型:Tg较低,对凸点保护性较差,翘曲小。
o 胺型:Tg中等,对Low-K层和凸点保护性中等,翘曲中等。
o 酸酐型:Tg高,对Low-K层保护性好,对凸点保护性好,但翘曲大。
· 填料(Filler):加入的无机颗粒,用于改性材料性能。主要作用包括:
o 降低Underfill的整体CTE,使其更接近焊料(约18-22 ppm/°C),减小应力。
o 降低固化过程中的收缩率。
o 提高导热性。
o 提高机械强度和模量。
o 吸收固化反应放出的热量。
o 常见填料有二氧化硅(SiO2)、氮化硼(BN)、氧化铝(Al2O3),各自具有不同的特性(见下表,改编自原文表2.3)。
· 促进剂(Accelerator):控制固化反应的速度。
· 偶联剂(Coupling Agent):改善无机填料与有机树脂基体之间的界面结合力。
· 增韧剂(Toughening Agent):提高材料的断裂韧性,抵抗开裂。
· 其他添加剂:流动改性剂、润湿剂、颜料等。
表1:常见Underfill填料的关键特性
| 填料类型 | 密度 (g/cc) | 导热系数 (W/mK) | CTE (ppm/°C) | 模量 (GPa) | 泊松比 | 颗粒形状 | 平均尺寸 (µm) |
| 二氧化硅 (SiO2) | 2.2 | 1.5 | 0.5 | 74 | 0.19 | 球状 | 3 |
| 氮化硼 (BN) | 2.25 | 300 | <0.5 | 43 | 0.25 | 不规则 | 1 |
| 氧化铝 (Al2O3) | 3.98 | 36 | 6.6 | 385 | 0.21 | 多边形 | 0.3 |
4. 底部填充工艺
目前主要有三种底部填充工艺(如图1-2所示):
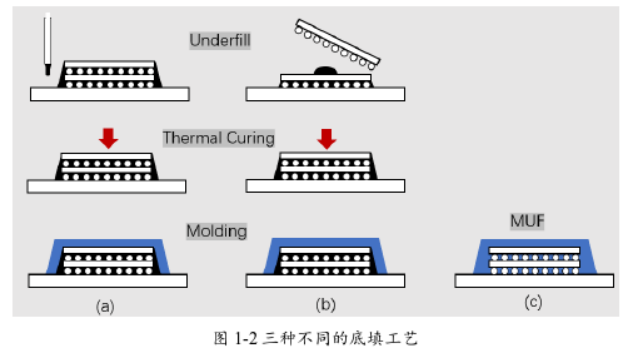
· 毛细作用底部填充(Capillary Underfill, CUF):这是最传统和广泛使用的方法。
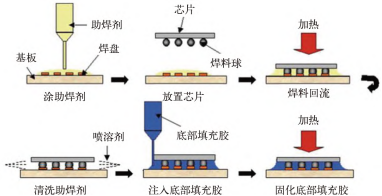
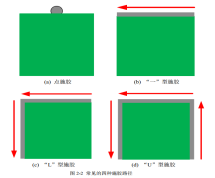
1. 芯片首先通过焊料回流焊接到基板上。
2. 通常对组件进行预热,以降低Underfill粘度,促进流动。
3. 将液态Underfill点胶在芯片的一个或多个边缘。
4. 利用芯片与基板之间形成的微小间隙(通常为30-100µm,毛细现象发生的最小间隙约10µm)产生的毛细管力,驱动Underfill流入并填满整个间隙。常见的点胶路径有单边“一”字型、L型、U型或针对小芯片的点状(见图2-2)。
5. 加热组件使Underfill固化。
o 挑战:流动时间影响生产效率;若流动受阻或点胶不当,可能导致填充不完全或产生空洞。需要洁净的表面以保证良好的润湿和流动。
· 免流动底部填充(No-Flow Underfill, NFU):

6. 在芯片贴装之前,将Underfill材料点涂在基板的目标区域上。
7. 将芯片贴装到涂有Underfill的基板焊盘上。
8. 将组件送入回流焊炉。高温同时熔化焊料形成连接,并使Underfill材料固化。
o 挑战:对助焊剂的兼容性要求高,Underfill不能干扰焊接,反之亦然。在贴片或固化过程中易产生气穴(空洞)。
· 模塑底部填充(Molded Underfill, MUF):(与芯片整体塑封同时完成)
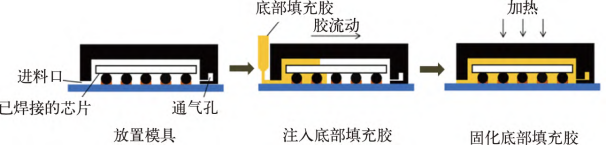
9. 芯片先通过回流焊接到基板。
10. 将整个组件放入模具型腔中。
11. 注入一种特殊配方的模塑料(Molding Compound),这种材料在高压下流动,同时完成对芯片顶部/侧面的包封以及底部间隙的填充。
o 挑战:模塑料粘度通常较高,使底部填充变得困难;需要真空辅助和优化的模具设计(如增加排气口)来防止空洞、确保完全填充,尤其对复杂结构或窄间隙。具有高生产效率的潜力。
5. 可靠性挑战与失效模式
尽管Underfill能带来显著好处,但其应用过程十分敏感,不当的工艺可能导致缺陷和失效:
· 空洞(Voids):在Underfill流动或固化过程中产生的气泡或未填充区域。原因包括胶水流动性差、基板/芯片表面污染或吸潮、固化过程放气、点胶策略不当等。空洞会破坏机械结构的完整性,影响应力分布。
· 填充不完全(Incomplete Fill):Underfill未能完全填满芯片下方的间隙。
· 胶坝(Fillet)问题:芯片边缘形成的Underfill胶边的形状或尺寸不当。边角裂纹可能在此处萌生。
· 分层(Delamination):Underfill与芯片钝化层、基板阻焊层或焊盘之间失去附着力。
· 填料沉降(Filler Settling):较重的填料颗粒在流动或固化过程中沉降,导致材料性能不均匀。
· 开裂(Cracking):Underfill材料自身发生开裂,或由Underfill引入的应力导致芯片开裂(Die Cracking)或边角开裂(Corner Crack)。
· 焊点断裂(Bump Fracture):尽管Underfill能极大缓解,但在极端条件下或存在缺陷时仍可能发生。
· 助焊剂残留(Flux Residue):未清理干净的助焊剂可能影响Underfill性能。
6. 助焊剂兼容性
在需要使用助焊剂进行焊接的工艺中(特别是CUF和MUF,焊接在填充之前),残留在基板或芯片表面的助焊剂可能对后续的Underfill产生干扰。助焊剂的成分(如松香树脂、有机酸活化剂、溶剂等)可能与Underfill的组分(环氧树脂、固化剂、引发剂等)发生化学反应,导致:
· 抑制或延缓Underfill的固化反应。
· 造成固化不完全,使得Underfill强度不足或发粘。
· 降低Underfill在界面处的附着力。
因此,选择与所用助焊剂兼容的Underfill材料至关重要(或者在CUF工艺中,确保回流焊后、点胶前进行彻底清洗)。兼容性可以通过以下方法判断:
· 切片分析:对固化后的样品进行切片观察,检查界面处是否存在异常。
· 混合测试:将Underfill胶水与焊锡膏(含助焊剂)混合,按照Underfill的固化条件进行固化,然后检查是否完全固化,有无气泡或未固化区域。若混合后能正常固化,则表明兼容性较好。
7. 结论
半导体底部填充(Underfill)是实现高密度封装(如倒装芯片和BGA)高可靠性的关键技术。通过机械耦合芯片与基板,它有效缓解了CTE失配带来的破坏性影响,将应力从脆弱的焊点重新分布,并提供环境保护。深入理解Underfill的作用原理、材料组成、应用工艺(CUF, NFU, MUF)以及潜在的失效模式(包括助焊剂兼容性问题),对于设计和制造稳定可靠的电子器件至关重要。精确的材料选择和严格的工艺控制是充分发挥Underfill技术可靠性优势的根本保障。
审核编辑 黄宇
-
芯片
+关注
关注
463文章
54463浏览量
469749 -
半导体
+关注
关注
339文章
31284浏览量
266826 -
封装
+关注
关注
128文章
9339浏览量
149089
发布评论请先 登录
什么是高可靠性?
汉思新材料:底部填充胶可靠性不足如开裂脱落原因分析及解决方案

提升功率半导体可靠性:推拉力测试机在封装工艺优化中的应用

半导体测试可靠性测试设备




 半导体底部填充(Underfill)技术:原理、材料、工艺与可靠性
半导体底部填充(Underfill)技术:原理、材料、工艺与可靠性














评论