本文介绍了FinFet Process Flow-源漏极是怎样形成的。
在FinFET制造工艺中,当完成伪栅极结构后,接下来的关键步骤是形成源漏极(Source/Drain)。这一阶段对于确保器件性能和可靠性至关重要。以下是详细的工艺流程描述,特别关注PMOS和NMOS源漏极形成的每一步及其作用。
FinFet Process Flow-Fin的形成,FinFet Process Flow-哑栅极的形成。
一、为栅极侧壁沉积
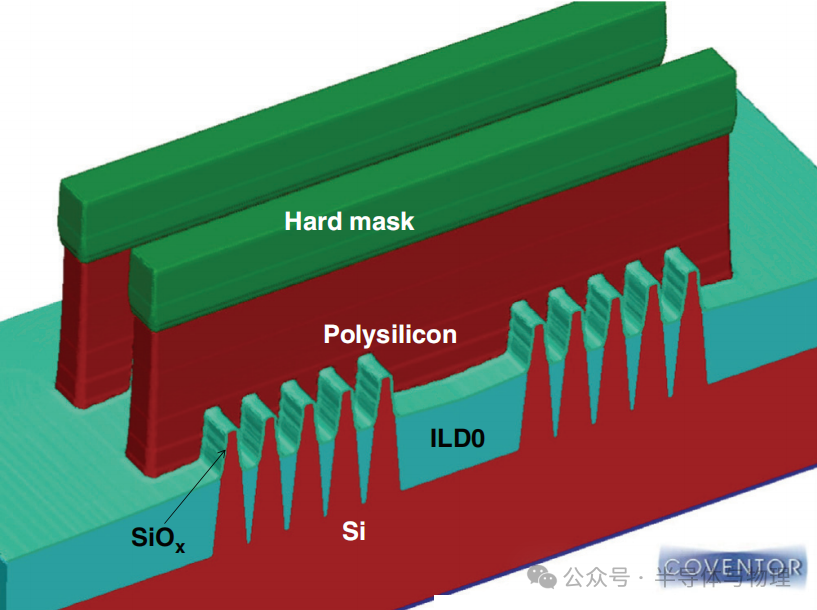
晶圆清洁与侧壁沉积
首先,在完成伪栅极结构后的晶圆上进行彻底清洁,以去除任何可能影响后续步骤的污染物。接着,沉积一层薄的侧壁(通常为氧化硅SiOx)芯片制造:薄膜工艺,这层材料作为后续侧壁间隔物的基础,并有助于保护鳍片免受直接损伤。
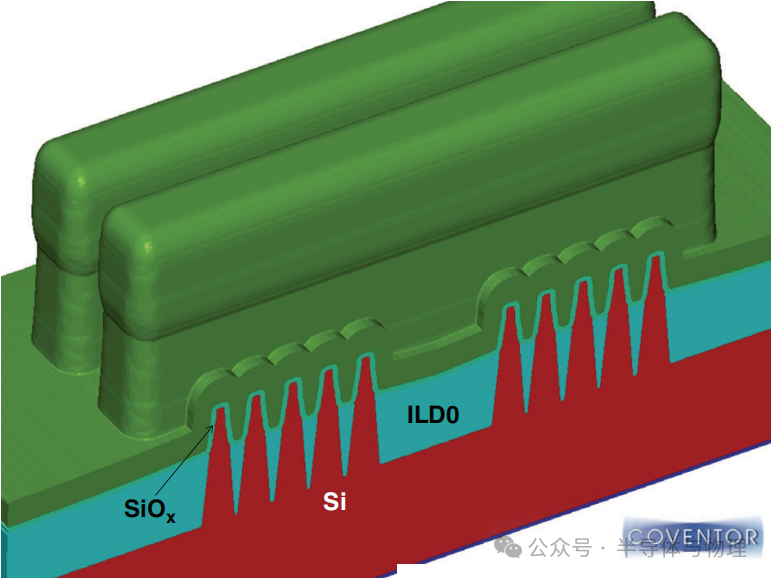
二、PMOS源漏极形成
PMOS光刻芯片制造:光刻工艺原理与流程
为了允许PMOS源漏极的形成,应用一个PMOS掩模,使得NMOS区域被光刻胶(PR)覆盖。
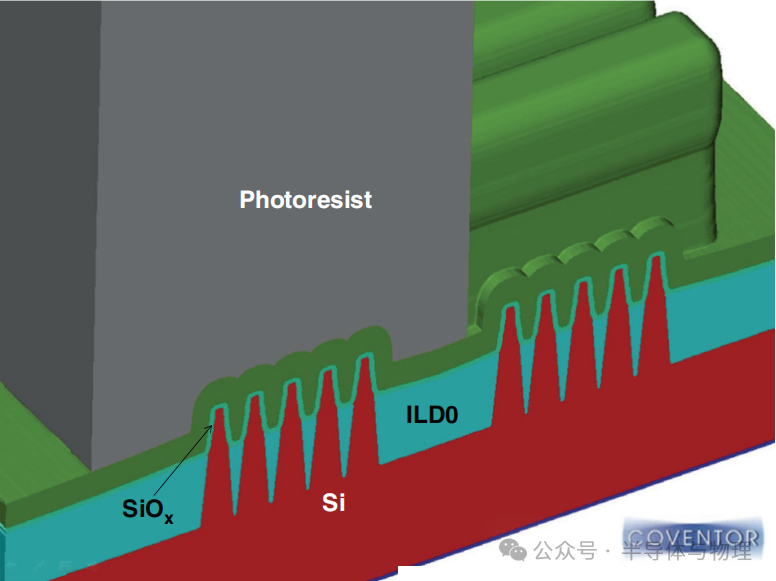
PMOS侧壁间隔物蚀刻与鳍片间隔物移除
在PMOS区域,通过蚀刻去除侧壁间隔物并移除鳍片上的SiO2间隔物。此步骤为后续的选择性外延生长(Selective Epitaxial Growth,芯片制造中的SiGe)做好了准备。
光刻胶剥离与晶圆清洗
完成上述蚀刻后,剥离光刻胶并清洗晶圆,以清除任何残留物质,保证接下来的生长过程不受污染。
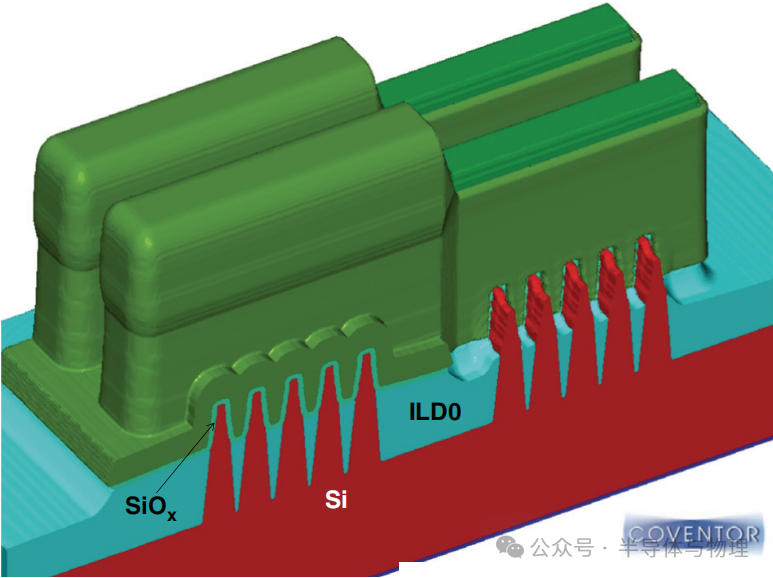
硅凹陷与SiGe选择性外延生长
接下来,通过蚀刻使硅表面略微凹陷,然后在这些凹陷处生长重掺杂的p型SiGe。选择性外延生长技术用于在此处形成高质量的SiGe晶体芯片制造中的SiGe,它不仅增加了PMOS器件的载流子迁移率,还提高了其性能。至此,PMOS器件的源漏极形成完毕。
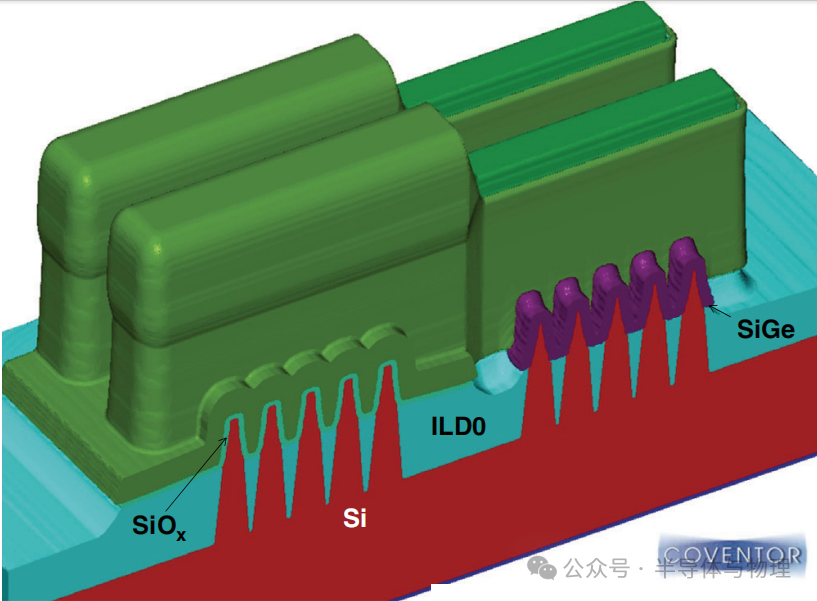
三、NMOS源漏极形成
NMOS光刻
接下来,切换到NMOS区域,应用相应的光刻胶掩模,这次是PMOS区域被覆盖,NMOS区域暴露出来。目的是为接下来的NMOS源漏极形成做准备。
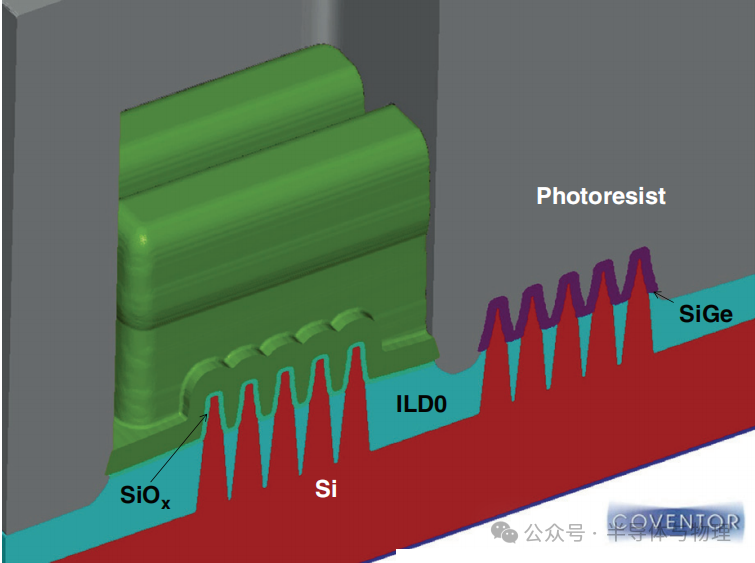
NMOS侧壁间隔物蚀刻与鳍片间隔物移除
类似于PMOS的处理,蚀刻NMOS侧壁间隔物并移除NMOS鳍片上的间隔物。
这是为了确保接下来的n型离子注入可以准确地定位到目标位置。
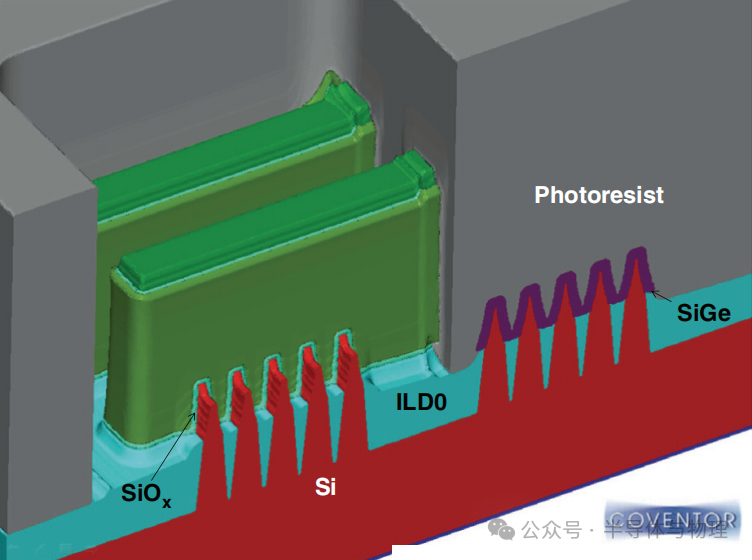
n型离子注入芯片制造:离子注入工艺
执行n型离子注入以重掺杂NMOS源漏极。该步骤旨在将大量的n型杂质引入到硅中,以创建低电阻的源漏区。
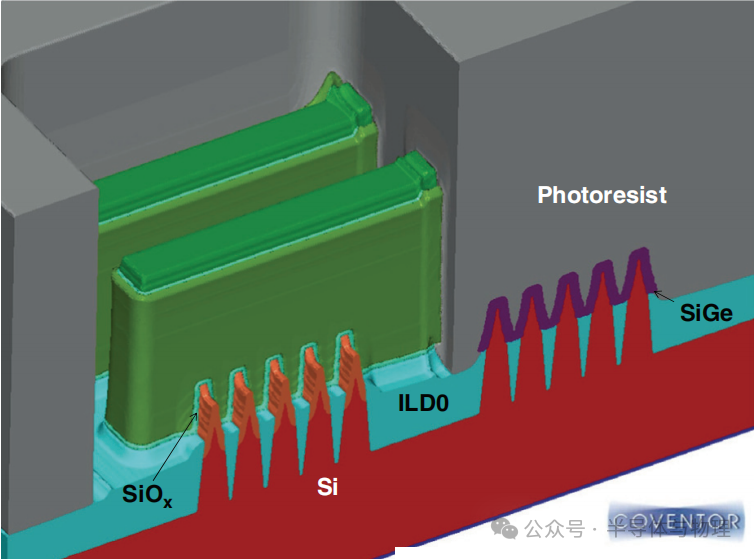
光刻胶剥离与晶圆清洗
再次剥离光刻胶并清洗晶圆,确保没有残留物质干扰接下来的退火过程。
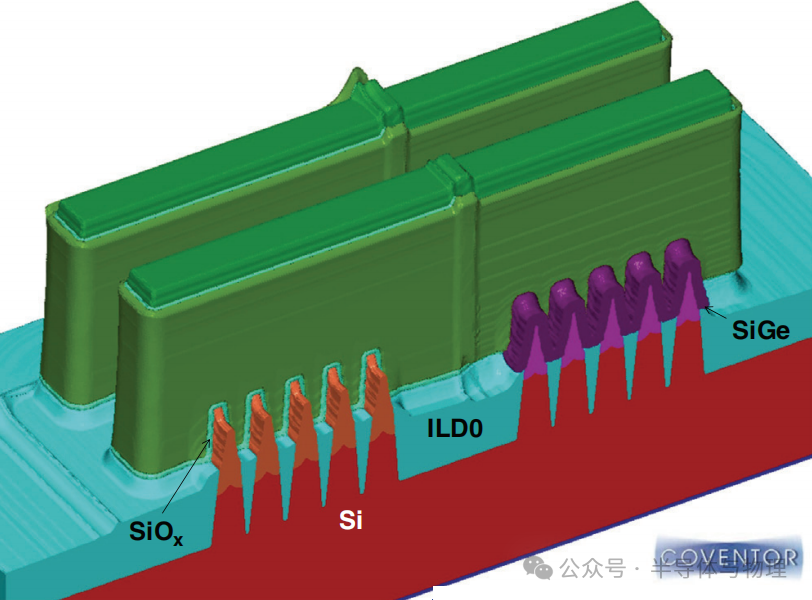
退火芯片制造:退火工艺
最后,通过退火激活掺杂剂。退火过程可以使掺杂原子进入硅晶格的适当位置,从而优化电学特性。
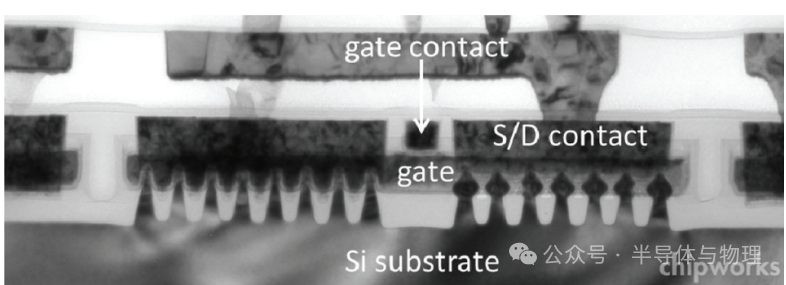
-
漏极
+关注
关注
0文章
35浏览量
11030 -
FinFET
+关注
关注
12文章
262浏览量
92371 -
Process
+关注
关注
0文章
17浏览量
12492
原文标题:FinFet Process Flow-源漏极形成
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
使用 Neutron 运行eiq_genai_flow时输出错误怎么解决?
抬升源漏技术如何拯救纳米尺度晶体管

选型手册:VS6808DH 共漏极双通道 N 沟道增强型功率 MOSFET 晶体管

NVTFWS002N04XM功率MOSFET技术解析与应用指南
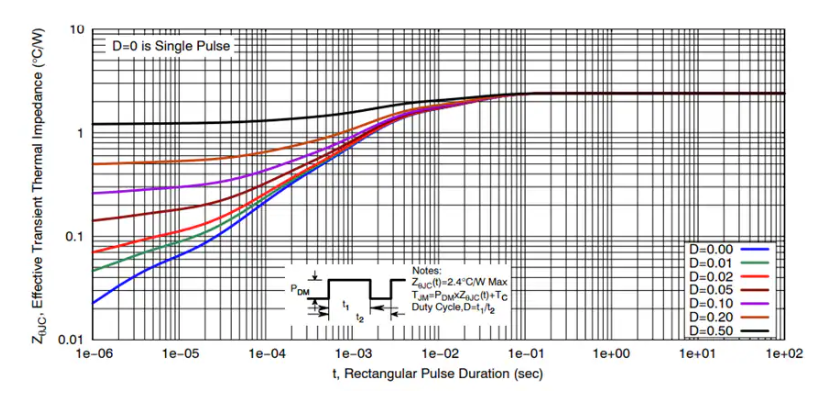
芯片漏印工装
RDS(on)低至8.6mΩ,扬杰推出200V MOSFET Gen2.0系列
CYW20704 的 UART 4 针(TX/RX/CTS/RTS)是什么形式(推拉或漏极开路)吗?
体硅FinFET和SOI FinFET的差异
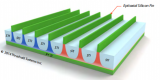
源漏扩展结构概述

MAX7321 I²C端口扩展器,具有8路漏极开路I/O技术手册
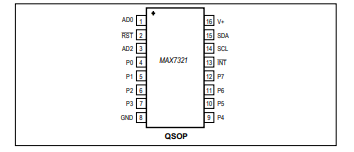



 FinFet Process Flow-源漏极是怎样形成的
FinFet Process Flow-源漏极是怎样形成的


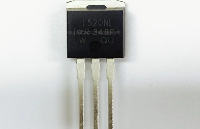
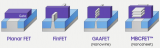



评论