本文介绍了SiO2薄膜的刻蚀机理。
干法刻蚀SiO2的化学方程式怎么写?刻蚀的过程是怎么样的?干法刻氧化硅的化学方程式?
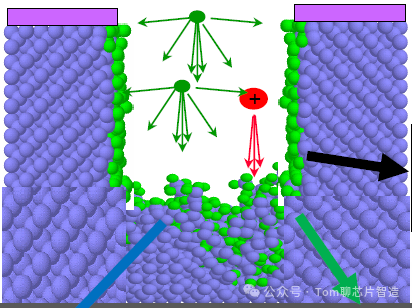
如上图,以F系气体刻蚀为例,反应的方程式为: SiO2(s)+ CxFy +Ar(+)>SiF4 (g)+ CO(g) CxFy是来自刻蚀气体(如CF₄、CHF₃)解离产生的氟自由基,用于氧化硅的化学刻蚀。 Ar(+)是被加速的高能离子,起到物理轰击的作用。 SiF4 :四氟化硅,气相形式的挥发性产物。 CO:一氧化碳,副产物。 红色箭头代表离子轰击,高能离子轰击表面,破坏SiO₂分子的键,为自由基提供更多反应位点,同时起到“方向性”作用,使刻蚀更具各向异性。 绿色箭头代表氟自由基,即CxFy。Ar离子轰击与化学刻蚀的结合,才能显著提高刻蚀速率。单一的物理或化学机制均不足以实现高效刻蚀。 离子与中性粒子比值对反应速率的影响

如上图: 中性粒子(自由基)浓度:Ar(+)浓度:当比值较低时,刻蚀速率主要受自由基的浓度限制。在高比值时,Ar离子轰击成为限制因素,刻蚀速率趋于饱和。
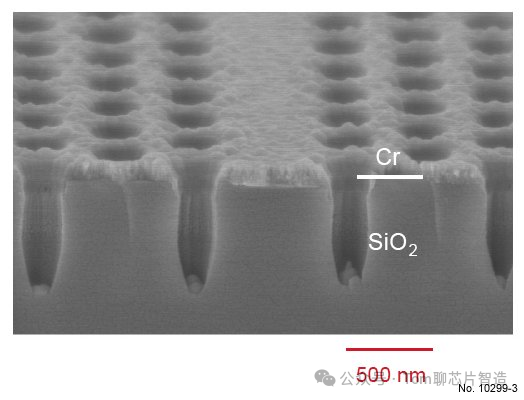
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
薄膜
+关注
关注
1文章
374浏览量
46258 -
SiO2
+关注
关注
0文章
24浏览量
8880 -
刻蚀
+关注
关注
2文章
223浏览量
13827
原文标题:SiO2薄膜的刻蚀机理
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
热点推荐
磁控溅射SiO₂薄膜工艺优化:台阶仪在膜厚与粗糙度表征中的应用
氧化硅(SiO₂)薄膜作为典型的功能薄膜材料,具有优良的光学、电学及机械性能,在液晶显示、太阳能电池、建筑玻璃及汽车玻璃等领域得到广泛应用。其低折射率和高透光特性,使其在光学减反射膜和表面保护层中

基于椭圆偏振法的光学薄膜测量
。
椭圆偏振分析器
本用例展示了椭圆偏振法的基本原理,并说明了VirtualLab Fusion中内置的椭圆仪分析器的使用。
SiO2涂层的可变角度光谱椭圆偏振(VASE)分析
本用例说明了在
发表于 04-09 08:11
[VirtualLab] SiO2膜层的可变角椭圆偏振光谱(VASE)分析
VirtualLab Fusion中的椭圆偏振分析器在二氧化硅(SiO2)涂层上的使用。对于系统的参数,我们参考Woollam等人的工作 \"可变角度椭圆偏振光谱仪(VASE)概述。I.
发表于 04-09 08:10
基于椭偏光谱法研究不同基底对TiO₂/SiO₂薄膜光学常数的影响
椭偏仪作为表征光学薄膜性能的核心工具,在光学薄膜领域具有不可替代的作用。本研究聚焦基底类型(K9玻璃、石英玻璃、单晶硅)对溶胶-凝胶法制备的TiO₂和SiO₂薄膜光学性能的调控机制。F

椭偏仪表征薄膜非晶相 | 精准分析不同衬底温度下氢化非晶氧化硅(i-a-SiOₓ:H)薄膜的光学性质与结构
本征氢化非晶氧化硅(i-a-SiOₓ:H)是a-Si:H/c-Si异质结太阳电池的重要钝化材料,兼具PECVD低温沉积、带隙宽等优势,但i-a-SiOₓ:H钝化性能与制备工艺、仪器密切相关;目前室温

台阶仪表征MEMS压力传感器硅槽刻蚀:TMAH80℃下薄膜良率达到92.67%
当前MEMS压力传感器在汽车、医疗等领域的应用广泛,其中应力敏感薄膜的厚度是影响传感器性能的关键一,因此刻蚀深度合格且均匀性良好的薄膜至关重要。费曼仪器作为薄膜测量技术革新者,致力于为

湿法刻蚀sc2工艺应用是什么
湿法刻蚀SC2工艺在半导体制造及相关领域中具有广泛的应用,以下是其主要应用场景和优势:材料选择性去除与表面平整化功能描述:通过精确控制化学溶液的组成,能够实现对特定材料的选择性去除。例如,它能

湿法刻蚀的主要影响因素一览
湿法刻蚀是半导体制造中的关键工艺,其效果受多种因素影响。以下是主要影响因素及详细分析:1.化学试剂性质与浓度•种类选择根据被刻蚀材料的化学活性匹配特定溶液(如HF用于SiO₂、KOH用于硅衬底
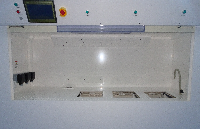
椭偏仪原理和应用 | 精准测量不同基底光学薄膜TiO₂/SiO₂的光学常数
椭偏仪作为表征光学薄膜性能的核心工具,在光学薄膜领域具有不可替代的作用。本研究聚焦基底类型(K9玻璃、石英玻璃、单晶硅)对溶胶-凝胶法制备的TiO₂和SiO₂薄膜光学性能的调控机制。F

VirtualLab Fusion应用:氧化硅膜层的可变角椭圆偏振光谱(VASE)分析
VirtualLab Fusion中的椭圆偏振分析器在二氧化硅(SiO2)涂层上的使用。对于系统的参数,我们参考Woollam等人的工作 \"可变角度椭圆偏振光谱仪(VASE)概述。I.
发表于 06-05 08:46
芯片刻蚀原理是什么
芯片刻蚀是半导体制造中的关键步骤,用于将设计图案从掩膜转移到硅片或其他材料上,形成电路结构。其原理是通过化学或物理方法去除特定材料(如硅、金属或介质层),以下是芯片刻蚀的基本原理和分类: 1. 刻蚀
半导体boe刻蚀技术介绍
泛应用。以下是其技术原理、组成、工艺特点及发展趋势的详细介绍: 一、技术原理 BOE刻蚀液是一种以氢氟酸(HF)和氟化铵(NH₄F)为基础的缓冲溶液,通过化学腐蚀作用去除半导体表面的氧化层(如SiO₂、SiNₓ)。其核心反应机制包括: 氟化物离子攻击: 氟化铵(NH₄



 SiO2薄膜的刻蚀机理
SiO2薄膜的刻蚀机理







评论