本征氢化非晶氧化硅(i-a-SiOₓ:H)是 a-Si:H/c-Si 异质结太阳电池的重要钝化材料,兼具PECVD低温沉积、带隙宽等优势,但 i-a-SiOₓ:H钝化性能与制备工艺、仪器密切相关;目前室温(25℃)下在n型直拉单晶硅(n-Cz-Si)表面沉积 i-a-SiOₓ:H 时,硅片少子寿命极低,钝化效果差,且衬底温度对其钝化性能的影响尚不明确;Flexfilm全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
本研究采用等离子体增强化学气相沉积法(PECVD)制备i-a-SiOₓ:H薄膜,通过微波光电导(MW-PCD)、射频光电导(RF-PCD)测少子寿命,光谱型椭偏仪验晶型,探究不同衬底温度的影响,结果显示薄膜均为非晶相,200℃~220℃时少子寿命最高、钝化效果最优。
1
实验材料与设备
flexfilm
衬底材料:选用n型直拉单晶硅片(n-Cz-Si),晶向为(100),厚度约 180μm,尺寸为 40mm×40mm;硅片经激光切割后,采用RCA清洗法去除表面杂质与氧化层,确保衬底洁净。
实验工艺参数:实验中,仅将衬底温度作为变量,其余工艺参数保持固定:沉积功率 12W、沉积气压 22Pa、反应气体流量比(SiH₄CO₂)为 30.6 mL/min、沉积时间 10min。衬底温度共设置 6 个梯度:25℃(室温)、100℃、180℃、200℃、220℃、250℃,以系统分析温度对钝化性能的影响规律。
2
室温沉积 i-a-SiOₓ:H 的性能表征
flexfilm
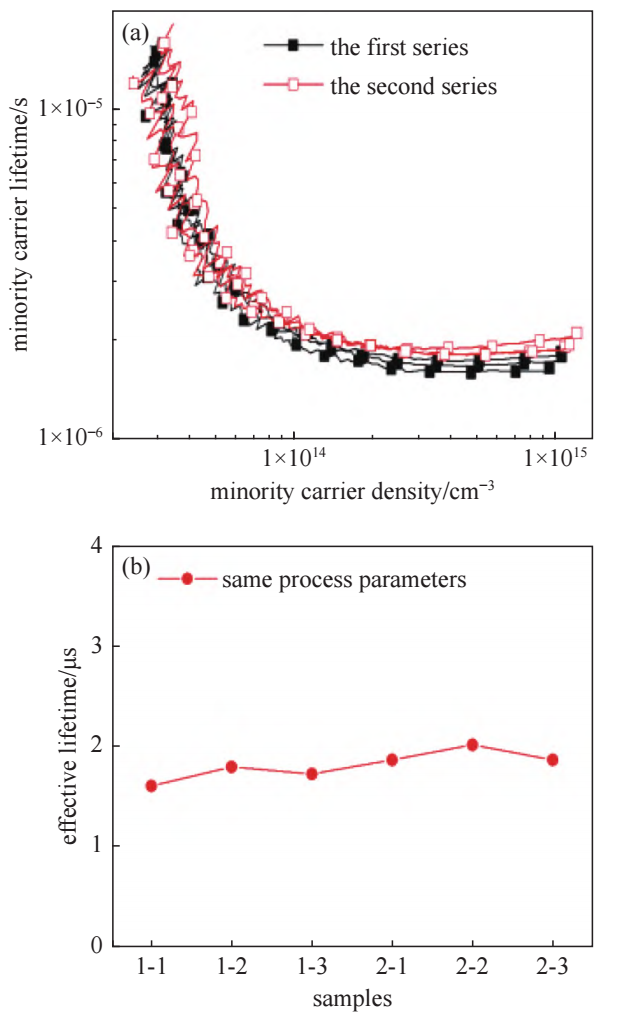
(a) 少子寿命随注入浓度变化,(b) 注入浓度1×10¹⁵cm⁻³硅片少子寿命
少子寿命:钝化效果不理想。结果显示室温下该薄膜对 n-Cz-Si 的钝化效果较差。从少子寿命与注入浓度的关系曲线可见,少子寿命随注入浓度增加显著下降,说明沉积后硅片表面仍存在较多空位与缺陷;当注入浓度为 1×10¹⁵cm⁻³ 时,少子寿命仅为 1~2 μs。这一现象与室温沉积 i-a-Si:H 的钝化性能不佳原因相似—低温无法有效钝化硅片表面的悬挂键。

(a) 实部,(b) 虚部
椭偏仪检测:确认为非晶相。采用椭偏仪测试室温沉积薄膜的介电常数(包括实部 ε₁与虚部 ε₂),结果显示:该薄膜的介电常数特征峰与非晶硅的特征峰高度吻合,证明室温下沉积的 i-a-SiOₓ:H 薄膜为非晶相,完全符合实验对钝化层晶型的预期要求。
3
不同衬底温度对薄膜钝化性能的影响
少子寿命:先增后减,200℃~220℃最优

(a) 不同注入浓度硅片少子寿命,(b) 注入浓度为1×10¹⁵cm⁻³时少子寿命

不同衬底温度i-a-SiOx:H 膜钝化后硅片少子寿命
以 1 号位置硅片为研究对象,测试不同温度下的少子寿命发现:i-a-SiOₓ:H 的钝化性能与衬底温度高度相关。
当温度低于 100℃时,硅片少子寿命不足 10μs,钝化效果差。原因是低温不利于 SiH₄热分解—而 SiH₄分解产生的硅原子、氢原子(及 H₂中的氢原子),是补偿硅片悬挂键、实现钝化的关键,低温会导致这一过程难以充分进行。
随温度升高,少子寿命呈“先增后减”趋势:220℃时,注入浓度 1×10¹⁵cm⁻³ 条件下,少子寿命达到最大值 747μs。
为验证结果可靠性,对 3 个硅片(均取注入浓度 1×10¹⁵cm⁻³)重复测试,发现 3 个样品的少子寿命随温度变化趋势完全一致,最优钝化温度集中在200℃~220℃(不同位置略有差异)。结合本实验的设备与工艺参数,建议 PECVD 法沉积 i-a-SiOₓ:H 时,衬底温度可设为 210℃,该结论与相关文献研究结果基本一致。
钝化均匀性:温度越高,均匀性越差

i-a-SiOx:H 膜钝化后硅片少子寿命
通过 MW-PCD 对 1 号位置硅片进行少子寿命扫描(扫描图中,深黑色代表少子寿命高,红色代表少子寿命低),结果显示:整块硅片的少子寿命存在不均匀性,且温度越高,不均匀性越明显。这是因为硅片表面各处气流存在差异,导致辉光放电状态不同,进而使薄膜厚度与成分在不同区域出现差异。
两种 PCD 测试方法对比:原理不同,RF-PCD 更可靠

MW-PCD 法测试硅片少子寿命主要特征值(单位:μs)
两种方法均验证了“少子寿命随温度先增后减、220℃达最大”的规律,证明温度对钝化性能的影响具有可靠性。
但两种方法的测试数据存在差异,核心原因是测试原理不同:MW-PCD 为瞬态方法,通过 200ns 波长 904nm 的脉冲激光注入产生非平衡载流子,记录硅片反射微波功率的时间变化;RF-PCD 为非接触式方法,可选择瞬态或准瞬态测试模式。
由于薄膜均匀性较差,少子寿命分布不均,综合来看,RF-PCD 的测试结果更具可靠性。
椭偏仪表征:所有温度下均为非晶相

不同衬底温度沉积i-a-SiOx:H 膜硅片介电常数谱:(a)实部,(b)虚部
对不同温度下沉积的 i-a-SiOₓ:H 薄膜进行椭偏仪测试,结果显示:无论衬底温度如何变化,薄膜的介电常数实部与虚部均符合非晶硅的特征峰,证明所有温度条件下沉积的 i-a-SiOₓ:H 薄膜均为非晶相,完全满足实验设计要求。
本研究明确了衬底温度对i-a-SiOₓ:H薄膜钝化性能的重要影响,确定了200-220℃为PECVD工艺的最佳温度窗口。该研究结果为优化a-Si:H/c-Si异质结太阳电池的界面钝化工艺提供了重要实验依据,对提升太阳电池转换效率具有实际指导意义。
Flexfilm全光谱椭偏仪
flexfilm

全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)
- 先进的旋转补偿器测量技术:无测量死角问题。
- 粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
- 秒级的全光谱测量速度:全光谱测量典型5-10秒。
- 原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《衬底温度对氢化非晶氧化硅(i-a-SiOx:H)钝化性能的影响研究》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
太阳能电池
+关注
关注
22文章
1267浏览量
73006 -
光学
+关注
关注
4文章
833浏览量
37890
发布评论请先 登录
VirtualLab Fusion应用:氧化硅膜层的可变角椭圆偏振光谱(VASE)分析
VirtualLab Fusion应用:氧化硅膜层的可变角椭圆偏振光谱(VASE)分析
NIP型非晶硅薄膜太阳能电池的研究
椭偏仪原理和应用 | 精准测量不同基底光学薄膜TiO₂/SiO₂的光学常数

基于光谱椭偏术的多层结构介质衍射光栅表征研究






 椭偏仪表征薄膜非晶相 | 精准分析不同衬底温度下氢化非晶氧化硅(i-a-SiOₓ:H)薄膜的光学性质与结构
椭偏仪表征薄膜非晶相 | 精准分析不同衬底温度下氢化非晶氧化硅(i-a-SiOₓ:H)薄膜的光学性质与结构

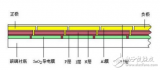











评论