全球四大云计算巨头(CSP)——微软、谷歌、亚马逊AWS及Meta正在加大对人工智能(AI)领域的投入,预计全年总投资额将达到惊人的1700亿美元。据台湾业界分析,鉴于对高性能AI芯片的需求增长,硅中介层面积加大,导致12英寸晶圆切割出的数量减少,从而加剧了台积电CoWoS先进封装产能的紧张局面。
英伟达占据全球AI GPU市场约80%的份额,根据集邦咨询预测,到2024年,台积电CoWoS月产能有望增至4万片,并在明年底实现翻番。然而,随着英伟达B100和B200芯片的问世,单片硅中介层面积增大,CoWoS产能依然吃紧。
半导体业内人士指出,自2011年起,CoWoS技术不断发展,每一代硅中介层面积都在增加,导致可从12英寸硅晶圆上切取的中介层硅片数量减少。同时,芯片搭载的HBM存储数量呈指数级增长,且HBM标准也在不断提高,GPU周围需要放置多个HBM,这无疑给生产带来了挑战。
业界观察家表示,HBM芯片产能同样面临巨大压力,需采用EUV光刻机制造的芯片层数逐步增多。以HBM市场占有率领先的SK海力士为例,该公司已在1α制程引入EUV光刻机,并计划在今年转向1β制程,有望将EUV光刻机使用率提升3~4倍。除此以外,随着HBM的多次升级换代,其容量也在稳步提升,HBM4中的堆叠层数将高达16层。
综合来看,在CoWoS与HBM双重瓶颈制约下,短期内产能问题恐难得到有效缓解。尽管台积电的竞争对手英特尔提出了玻璃基板替代硅中介层的解决方案,但这一技术尚待进一步突破。
-
台积电
+关注
关注
44文章
5810浏览量
177055 -
英伟达
+关注
关注
23文章
4115浏览量
99631 -
CoWoS
+关注
关注
0文章
170浏览量
11536
发布评论请先 登录
CoWoS(Chip-on-Wafer-on-Substrate)先进封装工艺的材料全景图及国产替代进展

GPU不是AI的唯一解:英伟达用Groq LPU证明,推理赛道需要“另一条腿”

英伟达Rubin GPU采用钻石铜散热,解决芯片散热难题


AI芯片发展关键痛点就是:CoWoS封装散热

CoWoS产能狂飙下的隐忧:当封装“量变”遭遇检测“质控”瓶颈
先进封装市场迎来EMIB与CoWoS的格局之争
CoWoS产能狂飙的背后:异质集成芯片的“最终测试”新范式
AVX TAJ系列钽电容产地、产能与交期分析(2025.12.8)
英伟达,怎么也用上碳化硅了
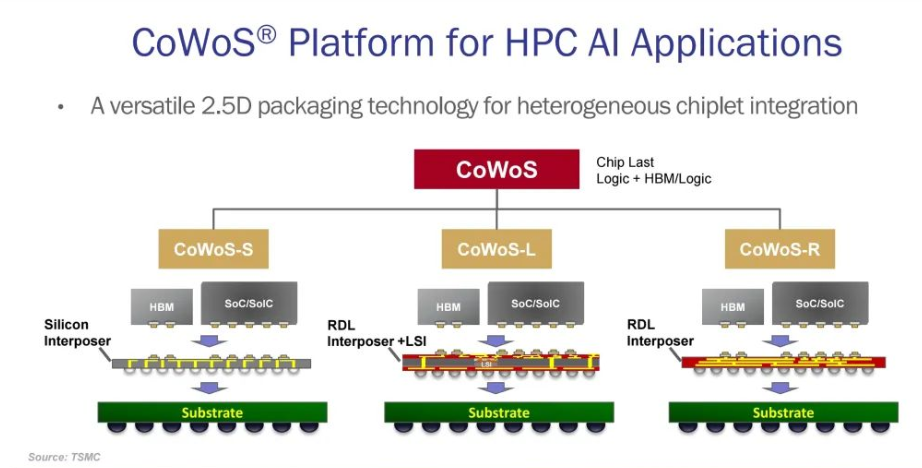
传英伟达自研HBM基础裸片
aicube的n卡gpu索引该如何添加?
英伟达拟再推中国特供GPU,今年6月量产!
GPU 维修干货 | 英伟达 GPU H100 常见故障有哪些?




 CoWoS先进封装产能吃紧,英伟达GPU供应依旧受限
CoWoS先进封装产能吃紧,英伟达GPU供应依旧受限





评论