电子发烧友网报道(文/梁浩斌)在多种先进封装技术中,硅中介层都起到重要的作用。在台积电CoWoS封装中,硅中介层是高密度互连的核心,是实现多芯片集成和高性能的关键。
不过最近有消息称,英伟达决定在下一代Rubin GPU中,为了进一步提高散热效率,将用碳化硅中介层替代第一代Rubin GPU上采用的硅中介层,并最晚在2027年广泛应用。而Rubin GPU正是采用了台积电CoWoS封装,因此,台积电目前正在与主要合作伙伴联合开发SiC中介层制造技术。如果未来SiC中介层能够被广泛应用,那么将打开SiC衬底在功率芯片、光波导等场景之外的新动能。
CoWoS和中介层
CoWoS(Chip on Wafer on Substrate)的核心是通过中介层(Interposer)将多个芯片集成在同一封装内,实现超高带宽,低延迟的芯片间通信。从名字就能看出,CoWoS是由三层结构组成的,分别是芯片层、硅中介层和基板。
芯片层是包括GPU、CPU、HBM在内的芯片,这些芯片通过中介层上的微凸块,即直径约 20μm 的锡铜焊点,将芯片与中介层焊接,机械固定的同时实现电气连接。
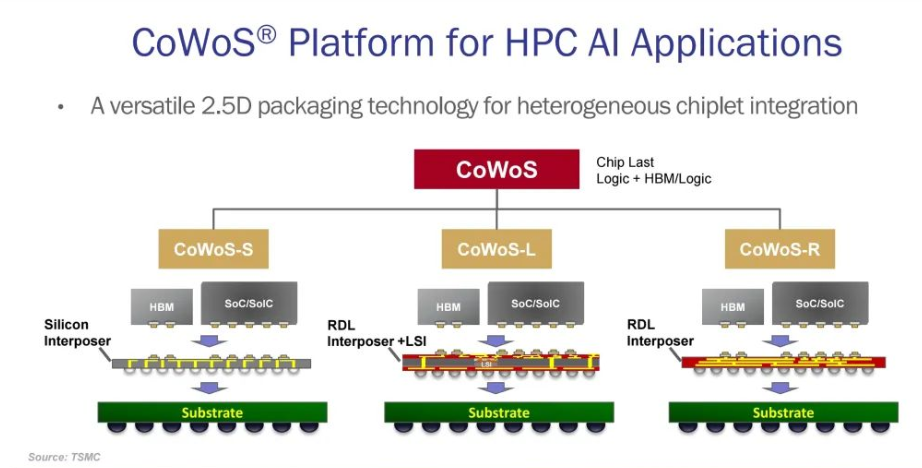
中介层此前是采用硅材料制造,在硅片上利用垂直贯穿硅片的铜填充孔,即所谓的硅通孔来连接上下层芯片的信号和电源,缩短传输路径以降低延迟。再通过由多层铜和低介电材料组成的高密度布线层,利用低至1μm的线宽和线距,实现超高密度的互连,以及TB/s级别的传输速率。
实际上,在CoWoS封装发展的过程中,由于硅中介层的工艺复杂,成本高,所以后续也延展出RDL中介层和混合中介层等不同形式,主要目的是降低成本以及量产难度。比如RDL中介层用聚合物和铜布线替代硅,成本降低30%,带宽稍低,可以应用于边缘计算和网络设备。
基板层则是传统常见的有机封装基板,是承载中介层的基础,为中介层提供机械支撑和电气接口,通过悍球阵列与PCB主板连接,提供I/O接口和电源分配、信号传输的功能。
碳化硅中介层,一把双刃剑
将中介层的硅材料,换成碳化硅,从材料的角度来看,最显著的提升是热管理能力上带来了质的飞跃,碳化硅的热导率是硅的3倍以上。目前AI芯片中,中介层的散热能力成为了瓶颈,尤其是Rubin系列芯片中,集成HBM4的多芯片产品功率已经接近2000W,传统硅中介层的散热能力已接近物理极限。
碳化硅的高热导率特性,可以令整体的封装热密度相比采用硅中介层的芯片大幅提高,以满足未来AI芯片的高功率需求。
除了散热,碳化硅材料由于硬度更高,高温稳定性更好,在集成密度和互连性能上相比硅中介层更有优势。去年4月,杨百翰大学研究团队开发出通孔深宽比达到109:1的碳化硅通孔方案,相比之下硅中介层通孔深宽比一般小于17:1。这意味着互连密度提升超过5倍,能大幅提高带宽,为AI芯片带来更高的数据吞吐性能。
不过,碳化硅中介层在制造加工过程中也面临着很多问题。首先是碳化硅材料硬度极高,在切割和表面平整阶段就面临加工时间长,切割平整度差的问题。在硅通孔制造的过程中往往会用到干法刻蚀设备,但对于碳化硅而言,同样干法刻蚀所需的时间是硅的20倍。
另外,碳化硅与铜的界面结合能仅为硅的 1/3,需引入钛、镍过渡层,但会使接触电阻增加 2-3 倍。石墨烯过渡层虽可将肖特基势垒降低 0.3-0.5 eV,但需在 1200℃以上的高温下原位生长,与 CoWoS 的低温封装工艺(<250℃)不兼容。
还有一个比较关键的点是,目前先进制程采用的大硅片都是12英寸,而碳化硅衬底目前主要还是6英寸或8英寸。今年以来,越来越多的衬底厂商研发出12英寸碳化硅衬底,包括天岳先进、天科合达、晶盛机电、烁科晶体、南砂晶圆等厂商都已经展出了相关产品,产业链上,12英寸碳化硅的激光剥离、多线切割等设备也已经就绪。
最大的问题在于,12英寸碳化硅衬底的量产节点目前仍未有一个较为明确的指引,所以如果英伟达和台积电希望在2027年实现碳化硅中介层的量产,就需要积极去推动上游衬底、设备等厂商的量产进展。
小结:
随着AI芯片的功率和性能需求不断提高,封装技术的迭代已经不仅限于结构上的三维堆叠,高集成、高速互连等的瓶颈,需要利用材料去突破性能的限制。对于碳化硅中介层来说,短期内,工艺上还存在非常多难点,但随着碳化硅材料价格的不断下降,12英寸衬底未来量产后,将会为产业带来更多新的可能。
不过最近有消息称,英伟达决定在下一代Rubin GPU中,为了进一步提高散热效率,将用碳化硅中介层替代第一代Rubin GPU上采用的硅中介层,并最晚在2027年广泛应用。而Rubin GPU正是采用了台积电CoWoS封装,因此,台积电目前正在与主要合作伙伴联合开发SiC中介层制造技术。如果未来SiC中介层能够被广泛应用,那么将打开SiC衬底在功率芯片、光波导等场景之外的新动能。
CoWoS和中介层
CoWoS(Chip on Wafer on Substrate)的核心是通过中介层(Interposer)将多个芯片集成在同一封装内,实现超高带宽,低延迟的芯片间通信。从名字就能看出,CoWoS是由三层结构组成的,分别是芯片层、硅中介层和基板。
芯片层是包括GPU、CPU、HBM在内的芯片,这些芯片通过中介层上的微凸块,即直径约 20μm 的锡铜焊点,将芯片与中介层焊接,机械固定的同时实现电气连接。
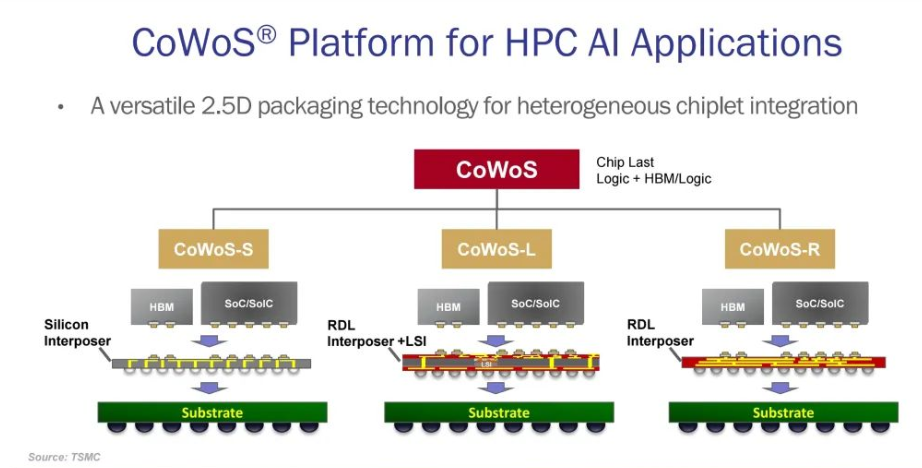
中介层此前是采用硅材料制造,在硅片上利用垂直贯穿硅片的铜填充孔,即所谓的硅通孔来连接上下层芯片的信号和电源,缩短传输路径以降低延迟。再通过由多层铜和低介电材料组成的高密度布线层,利用低至1μm的线宽和线距,实现超高密度的互连,以及TB/s级别的传输速率。
实际上,在CoWoS封装发展的过程中,由于硅中介层的工艺复杂,成本高,所以后续也延展出RDL中介层和混合中介层等不同形式,主要目的是降低成本以及量产难度。比如RDL中介层用聚合物和铜布线替代硅,成本降低30%,带宽稍低,可以应用于边缘计算和网络设备。
基板层则是传统常见的有机封装基板,是承载中介层的基础,为中介层提供机械支撑和电气接口,通过悍球阵列与PCB主板连接,提供I/O接口和电源分配、信号传输的功能。
碳化硅中介层,一把双刃剑
将中介层的硅材料,换成碳化硅,从材料的角度来看,最显著的提升是热管理能力上带来了质的飞跃,碳化硅的热导率是硅的3倍以上。目前AI芯片中,中介层的散热能力成为了瓶颈,尤其是Rubin系列芯片中,集成HBM4的多芯片产品功率已经接近2000W,传统硅中介层的散热能力已接近物理极限。
碳化硅的高热导率特性,可以令整体的封装热密度相比采用硅中介层的芯片大幅提高,以满足未来AI芯片的高功率需求。
除了散热,碳化硅材料由于硬度更高,高温稳定性更好,在集成密度和互连性能上相比硅中介层更有优势。去年4月,杨百翰大学研究团队开发出通孔深宽比达到109:1的碳化硅通孔方案,相比之下硅中介层通孔深宽比一般小于17:1。这意味着互连密度提升超过5倍,能大幅提高带宽,为AI芯片带来更高的数据吞吐性能。
不过,碳化硅中介层在制造加工过程中也面临着很多问题。首先是碳化硅材料硬度极高,在切割和表面平整阶段就面临加工时间长,切割平整度差的问题。在硅通孔制造的过程中往往会用到干法刻蚀设备,但对于碳化硅而言,同样干法刻蚀所需的时间是硅的20倍。
另外,碳化硅与铜的界面结合能仅为硅的 1/3,需引入钛、镍过渡层,但会使接触电阻增加 2-3 倍。石墨烯过渡层虽可将肖特基势垒降低 0.3-0.5 eV,但需在 1200℃以上的高温下原位生长,与 CoWoS 的低温封装工艺(<250℃)不兼容。
还有一个比较关键的点是,目前先进制程采用的大硅片都是12英寸,而碳化硅衬底目前主要还是6英寸或8英寸。今年以来,越来越多的衬底厂商研发出12英寸碳化硅衬底,包括天岳先进、天科合达、晶盛机电、烁科晶体、南砂晶圆等厂商都已经展出了相关产品,产业链上,12英寸碳化硅的激光剥离、多线切割等设备也已经就绪。
最大的问题在于,12英寸碳化硅衬底的量产节点目前仍未有一个较为明确的指引,所以如果英伟达和台积电希望在2027年实现碳化硅中介层的量产,就需要积极去推动上游衬底、设备等厂商的量产进展。
小结:
随着AI芯片的功率和性能需求不断提高,封装技术的迭代已经不仅限于结构上的三维堆叠,高集成、高速互连等的瓶颈,需要利用材料去突破性能的限制。对于碳化硅中介层来说,短期内,工艺上还存在非常多难点,但随着碳化硅材料价格的不断下降,12英寸衬底未来量产后,将会为产业带来更多新的可能。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
发布评论请先 登录
相关推荐
热点推荐
技术突围与市场破局:碳化硅焚烧炉内胆的氮化硅陶瓷升级路径
耐火材料与纯碳化硅材料面临极限挑战时,氮化硅陶瓷的技术指标为这一领域提供了更具针对性的升级方案。
一、产品细节:氮化硅陶瓷的技术优势
针对焚烧炉内胆的实际工况,氮
发表于 03-20 11:23
200mm碳化硅衬底厚度与外延厚度的多维度影响
我们能将碳化硅 (SiC) 衬底厚度推进到多薄而不影响性能?这是我们几十年来一直在追问的问题,同时我们也在不断突破碳化硅 (SiC) 材料性能的极限——因为我们知道下一代碳化硅 (Si

简单认识博世碳化硅功率半导体产品
博世为智能出行领域提供全面的碳化硅功率半导体产品组合,包括用于逆变器、车载充电器和直流/直流转换器的碳化硅功率MOSFET和碳化硅功率模块。这些解决方案已面向全球整车厂、一级供应商以及分销商,产品
高功率密度碳化硅MOSFET软开关三相逆变器损耗分析
MOSFET 逆变器的功率密度,探讨了采用软开关技术的碳化硅 MOSFET 逆变器。 比较了不同开关频率下的零电压开关三相逆变器及硬开关三相逆变器的损耗分布和关键无源元件的体积, 讨论了逆变器效率和关键无源元件体积与开关频率之
发表于 10-11 15:32
•38次下载
探索碳化硅如何改变能源系统
作者:Michael Williams, Shawn Luke 碳化硅 (SiC) 已成为各行各业提高效率和推动脱碳的基石。碳化硅是高级电力系统的推动剂,可满足全球对可再生能源、电动汽车 (EV
AR光波导+先进封装双驱动,12英寸碳化硅静待爆发
电子发烧友网综合报道 12英寸碳化硅在近期产业内迎来两大新需求:AI眼镜市场爆发,推动碳化硅AR光波导镜片量产节奏;为了进一步提高散热效率,英伟达决定在下一代Rubin GPU中,将用
[新启航]碳化硅 TTV 厚度测量技术的未来发展趋势与创新方向
一、引言
碳化硅(SiC)作为宽禁带半导体材料的代表,在功率器件、射频器件等领域发挥着关键作用。总厚度偏差(TTV)是衡量碳化硅衬底及外延片质量的重要指标,其精确测量对保障碳化硅器件性能至关重要
![[新启航]<b class='flag-5'>碳化硅</b> TTV 厚度测量技术的未来发展趋势与创新方向](https://file1.elecfans.com/web3/M00/20/D6/wKgZPGhd-raAI0RYAACIgEePWXY565.png)
Wolfspeed碳化硅技术实现大规模商用
碳化硅 (SiC) 技术并非凭空而来,它是建立在数十年的创新基础之上。近四十年来,Wolfspeed 始终致力于碳化硅 (SiC) 技术和产品的创新并不断强化基础专利。仅在过去的五年中,我们
碳化硅器件的应用优势
碳化硅是第三代半导体典型材料,相比之前的硅材料,碳化硅有着高击穿场强和高热导率的优势,在高压、高频、大功率的场景下更适用。碳化硅的晶体结构稳定,哪怕是在超过300℃的高温环境下,打破了传统材料下器件的参数瓶颈,直接促进了新能源等

碳化硅晶圆特性及切割要点
01衬底碳化硅衬底是第三代半导体材料中氮化镓、碳化硅应用的基石。碳化硅衬底以碳化硅粉末为主要原材料,经过晶体生长、晶锭加工、切割、研磨、抛光、清洗等制造过程后形成的单片材料。按照电学性

博世碳化硅技术在新能源汽车领域的应用
惊闻谣传头部碳化硅Tier 1玩家博世“被”退出碳化硅赛道,小编表示地铁、老人、手机.jpg,火速去内部打探消息——结果只想说一句:别慌,博世还在,且蓄势待发!这样精彩的舞台,怎会少了博世这位心动嘉宾。

EAB450M12XM3全碳化硅半桥功率模块CREE
EAB450M12XM3全碳化硅半桥功率模块CREEEAB450M12XM3是Wolfspeed(原CREE科锐)生产的1200V、450A全碳化硅半桥功率模块,致力于高功率、高效化技术应用打造
发表于 06-25 09:13
碳化硅在多种应用场景中的影响
对碳化硅技术进行商业化应用时,需要持续关注材料缺陷、器件可靠性和相关封装技术。本文还将向研究人员和专业人士介绍一些实用知识,帮助了解碳化硅如何为功率半导体行业实现高效且可靠的解决方案。

国产SiC碳化硅功率半导体企业引领全球市场格局重构
到IDM模式的战略转型 国产SiC碳化硅功率半导体企业发展历程诠释了中国半导体产业的转型升级路径。国产SiC碳化硅功率半导体企业创立初期采用Fabless模式,专注于 芯片设计与市场开拓 ,但很快意识到IDM(集成设计制造)模式



 英伟达,怎么也用上碳化硅了
英伟达,怎么也用上碳化硅了





评论