 这张图是CoWoS(Chip-on-Wafer-on-Substrate)先进封装工艺的材料全景图,清晰展示了从底层基板到顶层芯片的全链条材料体系,以及各环节的全球核心供应商。下面我们分层拆解:
这张图是CoWoS(Chip-on-Wafer-on-Substrate)先进封装工艺的材料全景图,清晰展示了从底层基板到顶层芯片的全链条材料体系,以及各环节的全球核心供应商。下面我们分层拆解:
一、中间结构:CoWoS 的分层逻辑
从下到上,CoWoS 的核心结构分为三大层:
1. 底层:基板承载层(Substrate Layer)
Substrate Core(基板核心):核心是低介电常数玻璃纤维(Glass Fiber, Low Dk),提供绝缘与支撑,供应商包括 RESONAC、DOOSAN、Panasonic 等。
Build-up film(积层膜):即 IC 载板的关键绝缘层(如 ABF 膜),用于构建高密度布线,核心供应商是日本味之素(AJINOMOTO,ABF 膜垄断者),还有 SEKISUI、Nittobo、万华化学等。
Solder Ball(焊球):实现基板与 PCB 的电气连接,供应商包括中芯国际(SMIC)、Accurus、MacDermid Alpha 等。
Solder Mask(阻焊层):保护基板线路,防止短路和氧化,供应商有 RESONAC、TAMURA、TAIYO HOLDINGS 等。
2. 中层:芯片互联层(Chip Interconnection Layer)
这是实现芯片与基板高密度互联的核心:
C4 Bump(C4 凸点):即控制塌陷芯片凸点,是 SoC/HBM 与基板的核心电气连接结构,供应商包括中芯国际(SMIC)、NIPPON STEEL 等。
RDL Material (PSPI)(重布线层材料,光敏聚酰亚胺):用于构建芯片间的重布线层,实现超高带宽信号传输,供应商包括 tok、TORAY、JSR、Dupont,以及国内的强力新材(TRONLY)。
Underfill(底填材料):填充凸点与基板的间隙,缓冲热应力、保护焊点,供应商有 NAMICS、NAGASE、Henkel、MacDermid Alpha 等。
3. 顶层:芯片与热管理层(Chip & Thermal Management Layer)
这一层保障高算力芯片的稳定运行:
核心芯片:包括 SoC(计算芯片)和 HBM(高带宽内存),通过硅中介层(Silicon Wafer)实现 3D 堆叠,硅片供应商有信越(ShinEtsu)、SUMCO、SK Siltron 等。
TIM(热界面材料):填充在芯片与散热结构之间,降低热阻、提升散热效率,供应商包括陶氏(Dow)、杜邦(DuPont)、3M、Henkel、Indium 等国际巨头。
NCF(非导电膜):用于芯片键合的绝缘与粘接,供应商有 Henkel、TORAY、RESONAC 等。
LMC(低模量化合物):用于封装保护和应力缓冲,供应商包括 Panasonic、NAMICS、NAGASE、RESONAC、Henkel 等。
二、行业解读:供应链格局与国产机遇
从这张图可以清晰看到:
高端材料仍被国际巨头主导:ABF 积层膜、高端 TIM、PSPI 等核心材料,话语权仍在日本、美国企业手中。
国产厂商已在部分环节实现突破:在焊球、阻焊层、部分 RDL 材料(如强力新材)等领域,国内企业已进入供应链。
供应链高度全球化:CoWoS 作为台积电主导的先进封装工艺,其材料体系依赖全球协作,同时也凸显了自主可控的战略紧迫性。
这张图不仅是材料清单,更是先进封装领域 “卡脖子” 环节和国产替代机会的直观映射。
三、CoWoS 关键材料国产替代进展清单
1、底层基板与承载材料
| 材料环节 | 核心功能 | 代表国产厂商 | 技术进展与市场地位 |
|---|---|---|---|
基板核心 (Substrate Core) | 提供机械支撑与电气绝缘 | 深南电路、沪电股份、生益科技 | 已实现中高端 IC 载板量产,在消费电子、汽车电子领域广泛应用,部分产品进入国际供应链。 |
积层膜 (Build-up film) | 高密度布线绝缘层(ABF 膜) | 序轮、华正新材、南亚新材 | ABF 膜仍处技术突破期,序轮等企业完成实验室验证,量产稳定性待提升;普通积层膜已实现国产替代。 |
阻焊层 (Solder Mask) | 保护线路、防止短路 | 容大感光、广信材料、三孚新材 | 技术成熟,产品覆盖中高端封装,国内市场占有率超 50%,部分产品出口海外。 |
焊球 (Solder Ball) | 基板与 PCB 电气连接 | 中芯国际、Accurus、有研亿金 | 已实现规模化量产,在消费电子、通信领域广泛应用,技术指标接近国际先进水平。 |
2、芯片互联与重布线材料
| 材料环节 | 核心功能 | 代表国产厂商 | 技术进展与市场地位 |
|---|---|---|---|
C4 凸点 (C4 Bump) | 芯片与基板的核心互联 | 中芯国际、长电科技、通富微电 | 国内封测龙头已掌握成熟工艺,在中高端封装中广泛应用,技术与国际差距较小。 |
RDL 材料 (PSPI) | 重布线层绝缘与保护 | 强力新材、明士、华海诚科 | 强力新材等企业实现 PSPI 量产,进入部分先进封装供应链;高端高分辨率 PSPI 仍依赖进口。 |
底填材料 (Underfill) | 保护凸点、缓冲热应力 | 华海诚科、德邦科技、安集科技 | 中低端产品已实现国产替代,高端高流动性、高可靠性底填仍需进口,技术攻关中。 |
3、热管理与封装保护材料
| 材料环节 | 核心功能 | 代表国产厂商 | 技术进展与市场地位 |
|---|---|---|---|
热界面材料 (TIM) | 降低界面热阻、提升散热 | 德邦科技、天孚通信、碳元科技 | 导热凝胶、垫片等产品满足中高端需求,在 5G、AI 服务器领域应用广泛,部分产品性能对标国际巨头。 |
非导电膜 (NCF) | 芯片键合绝缘与粘接 | 回天新材、德邦科技 | 处于技术追赶阶段,实验室样品性能接近国际水平,量产应用待验证。 |
低模量化合物 (LMC) | 封装保护与应力缓冲 | 华海诚科、回天新材 | 中低端产品已实现替代,高端低模量、高可靠性产品仍依赖进口。 |
4、硅片与辅助材料
| 材料环节 | 核心功能 | 代表国产厂商 | 技术进展与市场地位 |
|---|---|---|---|
硅片 (Silicon Wafer) | 硅中介层与芯片基底 | 沪硅产业、立昂微、中环股份 | 12 英寸大硅片实现量产,在成熟制程应用广泛;高端 12nm 以下硅片仍处技术突破期。 |
玻璃纤维 (Low Dk) | 低介电基板增强材料 | 中国巨石、泰山玻纤 | 低介电玻璃纤维实现量产,在高端 PCB 和 IC 载板中逐步应用,技术指标接近国际先进水平。 |
总结:国产替代的关键突破点
- 已规模化替代:阻焊层、焊球、中低端 TIM、普通积层膜等材料,国产厂商已占据主导地位。
- 技术追赶中:ABF 膜、高端 PSPI、高流动性底填等高端材料,国内企业完成实验室突破,正推进量产验证。
- 核心瓶颈:高端 TIM、NCF、LMC 等材料,仍面临分子设计、工艺稳定性等技术壁垒,是未来攻关重点。
-
封装
+关注
关注
128文章
9317浏览量
149021 -
材料
+关注
关注
3文章
1582浏览量
28689 -
CoWoS
+关注
关注
0文章
170浏览量
11534
发布评论请先 登录
DW-181水溶性助焊剂:面向先进封装工艺的高性能解决方案

先进封装市场迎来EMIB与CoWoS的格局之争
HBM技术在CowoS封装中的应用
CoWoP能否挑战CoWoS的霸主地位




 CoWoS(Chip-on-Wafer-on-Substrate)先进封装工艺的材料全景图及国产替代进展
CoWoS(Chip-on-Wafer-on-Substrate)先进封装工艺的材料全景图及国产替代进展




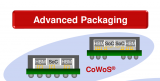





评论