在半导体芯片和光学元件加工等应用中,精确测量薄膜的厚度和折射率至关重要。光谱椭偏仪是一种被广泛应用于测量薄膜厚度和折射率的仪器。大多数传统椭偏仪(图1a)利用机械旋转偏振器和基于光栅的光谱仪进行光谱偏振检测,从而导致系统相对复杂、体积庞大,并且单次测量耗时较长。
据麦姆斯咨询报道,为了解决以上难题,清华大学精密仪器系杨原牧副教授研究团队提出了一种基于超构表面(metasurface)阵列的紧凑型光谱椭圆偏振测量系统,该系统可实现单次曝光(single-shot)光谱偏振检测和精确测定薄膜特性,而无需任何机械运动。具有高度各向异性和多样化光谱响应的硅基超构表面阵列与迭代优化相结合,可高保真地重建薄膜反射光的全斯托克斯(Stokes)偏振光谱。随后,薄膜厚度和折射率可通过将测量结果与适当的材料模型进行高精度拟合来确定。研究团队所提出的方法为开发高通量测量薄膜特性的紧凑型、鲁棒的光谱椭圆偏振系统开辟了一条新途径。相关成果近日以“Metasurface array for single-shot spectroscopic ellipsometry”为题发表于Light: Science & Applications期刊上。
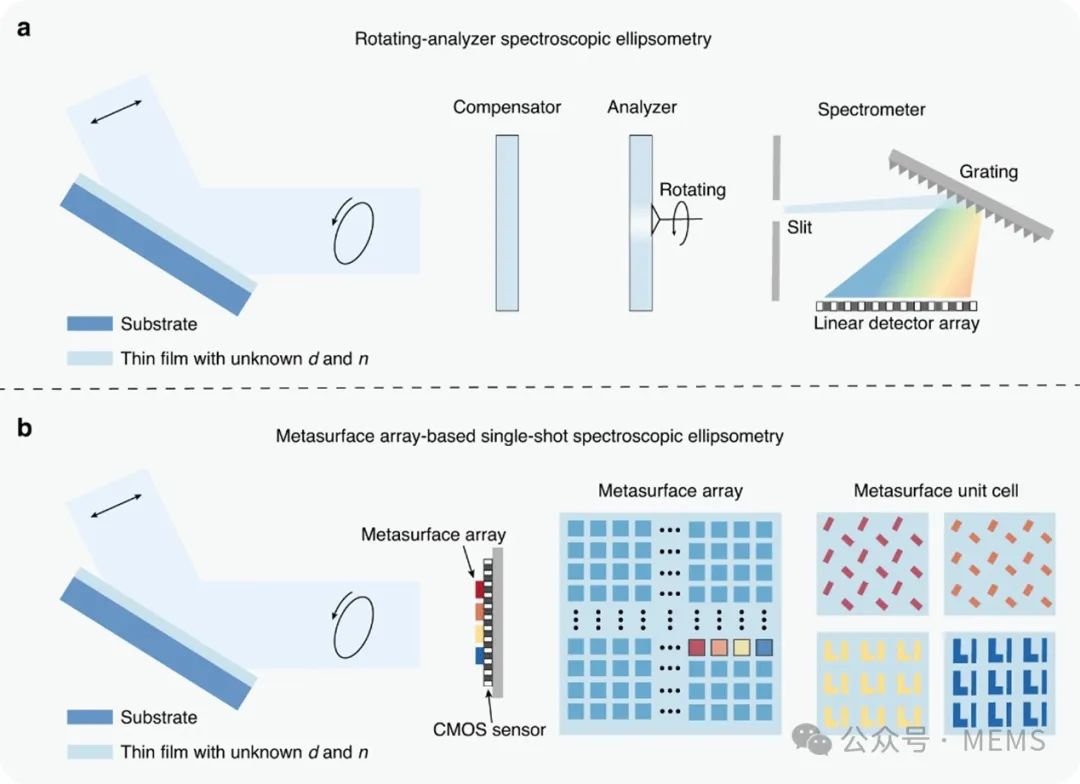
图1 传统椭偏仪与基于超构表面阵列的光谱椭偏仪的比较
基于超构表面阵列的光谱椭偏仪的详细工作原理如图2所示。该原型由集成在CMOS图像传感器顶部的单层超构表面阵列构成。超构表面阵列的Mueller矩阵(M0)是预先校准的。与图像传感器上测量的光强度(Iout)一起,入射光的全斯托克斯偏振光谱可以通过具有l2正则化的凸优化(convex optimizer)重建。接下来,通过利用多光束干涉模型拟合测量结果,可将重建的全斯托克斯偏振光谱转换为椭圆偏振参数,用于确定薄膜厚度d和折射率n。
在上述架构中,精确重建椭圆偏振参数和薄膜特性的关键是设计具有高度各向异性和多样化光谱特征的超构表面阵列,以使Mueller矩阵每行的相关系数最小化。在这项研究中,20 × 20超构表面阵列的每个单元均由蓝宝石衬底上的300 nm厚的硅纳米柱构成。每个单元的几何形状通过最小化不同单元之间的M0相关系数来优化。

图2 基于超构表面阵列的单次曝光光谱椭偏仪的工作原理
为了通过实验演示基于超构表面阵列的光谱偏振检测系统,研究人员组装了一个原型,如图3a所示。超构表面阵列由20 × 20个单元构成,总尺寸为1.5 mm × 1.5 mm。超构表面阵列是通过标准电子束光刻(EBL)和反应离子蚀刻(RIE)工艺在蓝宝石衬底上制造的。研究人员使用5 μm厚的光学透明胶带将超构表面阵列集成到CMOS图像传感器(Sony IMX-183)上。超构表面阵列的照片和超构表面单元的4幅代表性扫描电子显微镜(SEM)图像分别如图3b和3c所示。接下来,研究人员分别评估了系统的光谱偏振重构性能和分辨精细光谱特征的能力,结果如图3d和3e所示。
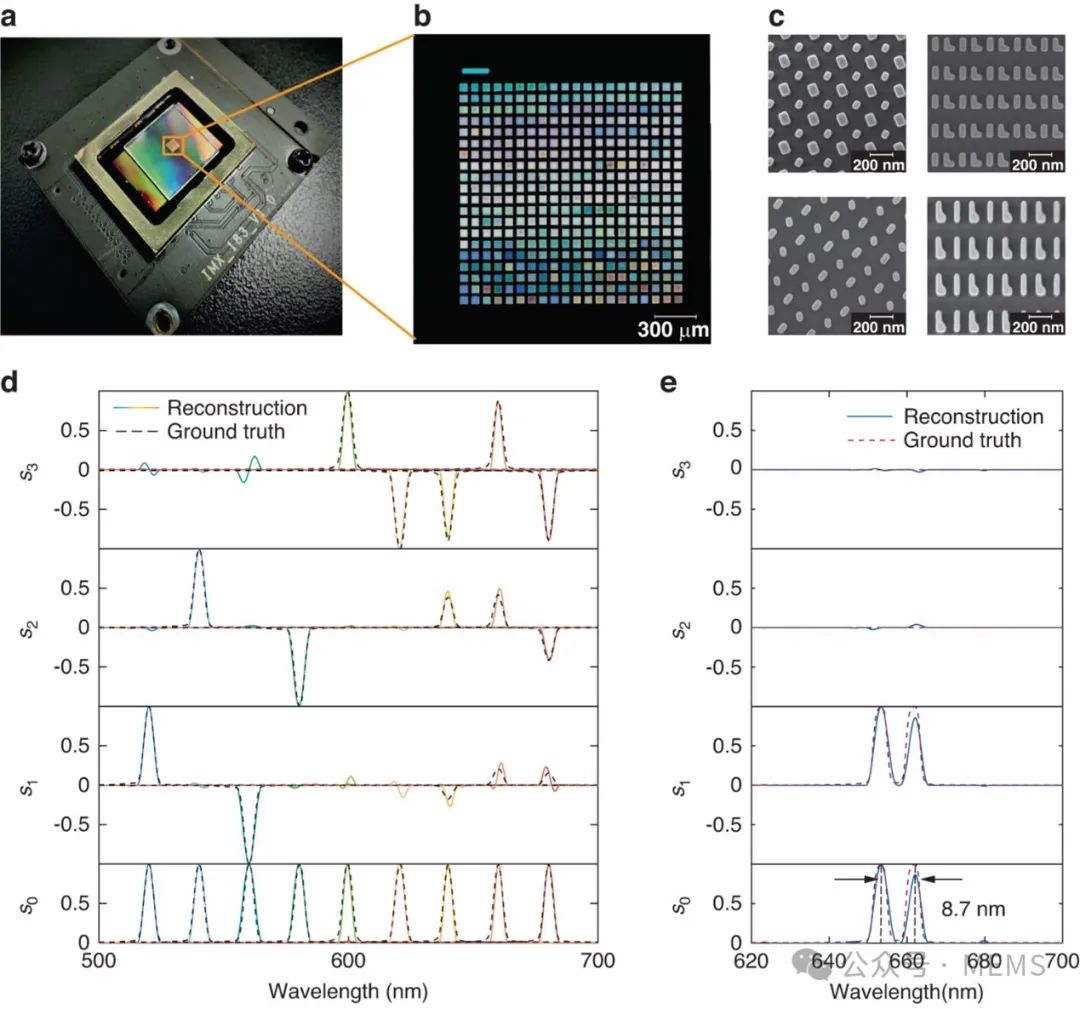
图3 光谱偏振检测性能的表征
最后,为了通过实验演示光谱椭偏仪测量,研究人员选择了沉积在硅衬底上的5个厚度范围在100 nm到1000 nm之间的SiO2薄膜作为测试样品。卤素灯发出的白光通过45°线性偏振器后,以60°入射角(接近布儒斯特角)照射到薄膜样品上,以确保显著的偏振转换效果。来自薄膜的反射光以垂直入射角照射到超构表面阵列上。厚度为100 nm和1000 nm的两种代表性SiO2薄膜的重建全斯托克斯偏振光谱分别如图4a和4b所示,并将其与使用四分之一波片、旋转偏振器和传统的基于光栅的光谱仪的测量结果进行了比较,显示出极佳的一致性。
全斯托克斯偏振光谱可以转换为椭圆偏振参数,厚度分别为100 nm和1000 nm的SiO2薄膜的转换后的结果分别如图4c和4d所示,并将其与基准真实值和理论估计结果作了比较。原型系统重建的薄膜厚度与商用光谱椭偏仪(JA Woollam,V-VASE)测量值之间的比较如图4e所示。使用商用光谱椭偏仪测量的厚度作为基准真实值,对于五种SiO2薄膜,重建薄膜厚度与基准真实值之间的相对误差平均仅为2.16%,标准差(10分钟内10次测量)平均仅为1.28 nm。

图4 SiO2薄膜的厚度和折射率测量
综上所述,这项研究提出并通过实验演示了一种新型的基于超构表面阵列的光谱椭圆偏振系统,用于薄膜特性的单次曝光测量。与传统的光谱椭偏仪相比,本文提出的基于超构表面的系统无需机械移动部件或相位调制元件,因此,它可以实现半导体加工中薄膜特性的高通量在线测量,例如在薄膜蚀刻或沉积系统中。对于原型系统,椭圆偏振测量的光谱范围主要受限于商用CMOS图像传感器在700 nm波长以上的低量子效率和在500 nm波长以下硅的高材料损耗。为了进一步扩展该范围,可以选择在近红外范围内具有更高量子效率的CMOS图像传感器,或者使用在更宽的光谱范围内具有更低损耗的替代材料(例如SiN)来设计和制造超构表面。将其应用扩展至紫外(UV)、红外(IR)或太赫兹(THz)范围没有根本限制。超构表面阵列还有望用于光谱偏振成像,这可以进一步实现空间不均匀薄膜的非破坏性表征。
论文链接:
https://doi.org/10.1038/s41377-024-01396-3
审核编辑:刘清
-
CMOS
+关注
关注
58文章
6247浏览量
243684 -
图像传感器
+关注
关注
68文章
2100浏览量
132594 -
光谱仪
+关注
关注
2文章
1317浏览量
32851 -
半导体芯片
+关注
关注
61文章
950浏览量
72872
原文标题:基于超构表面阵列的微型单次曝光光谱椭偏仪
文章出处:【微信号:MEMSensor,微信公众号:MEMS】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
光谱椭偏仪在二维材料光学表征中的应用综述

椭偏仪在半导体的应用|不同厚度c-AlN外延薄膜的结构和光学性质

椭偏术精准测量超薄膜n,k值及厚度:利用光学各向异性衬底

光谱椭偏仪入门指南:原理、方法与基础应用

椭偏仪在精密薄膜中的应用:基于单驱动变角结构的高重复性精度控制系统

椭偏仪在半导体薄膜厚度测量中的应用:基于光谱干涉椭偏法研究

椭偏仪的原理和应用 | 薄膜材料或块体材料光学参数和厚度的测量

椭偏仪薄膜测量原理和方法:光学模型建立和仿真

椭偏仪测量薄膜厚度的原理与应用

聚焦位置对光谱椭偏仪膜厚测量精度的影响




 基于超构表面阵列的微型单次曝光光谱椭偏仪研究
基于超构表面阵列的微型单次曝光光谱椭偏仪研究




评论