椭偏仪是一种基于椭圆偏振分析的光学测量仪器,通过探测偏振光与样品相互作用后偏振态的变化,获取材料的光学常数和结构信息。Flexfilm全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
1
光谱椭偏法如何测定折射率?
flexfilm

Ψ的振荡具有特定的振幅
除了厚度信息,数据振荡的形状取决于薄膜的折射率。Ψ的振荡曲线,其振幅具有特定值:通过振荡振幅可确定薄膜的准确折射率。图中展示了不同折射率对应的振荡振幅差异,可直观体现这一关系。
2
光谱椭偏法可测量哪些类型的涂层?
椭偏仪可测量多种类型的薄膜,对材料类型无严格限制,只需满足“光可从其表面反射”这一条件。若涂层表面过于粗糙,会导致探测光束散射、无法被探测器接收,此时无法进行光谱椭偏测量。
光谱椭偏法的典型应用场景包括:测量电介质、有机物、半导体甚至金属层;测量各向同性或各向异性、均匀或具有折射率梯度的涂层;甚至可测量多层结构(由不同材料的薄膜组成)。需注意的是,若需测定厚度,光需能够穿透薄膜到达下方基底并反射回探测器。
3
光谱椭偏法能否测量吸收性薄膜?
光谱椭偏法已成功应用于多种吸收性薄膜的测量。若需测定吸收性薄膜的厚度,薄膜需足够薄(通常< 50nm),以避免测量光束在穿透薄膜前被完全吸收。此外,还需考虑吸收性薄膜的未知参数数量。
4
变入射角(VASE)光谱椭偏测量有哪些优势?
椭偏测量通常在接近布儒斯特角的斜入射角下进行。早期椭偏仪强调布儒斯特角的重要性,因其在该角度下测量效果最佳;但对于采用补偿器的现代椭偏仪,布儒斯特角的重要性已大幅降低,不过斜入射角下仍能观察到最显著的偏振态变化。光谱椭偏测量的典型入射角范围为50°-75°。
常规的厚度与折射率测量仅需单入射角即可完成;但随着样品复杂度提高,对多入射角的需求会增加。对于厚度 > 1 微米(μm)的厚膜、折射率梯度薄膜、各向异性材料及复杂多层结构,建议采用2-3 个入射角测量。即便样品无需多入射角测量,额外的入射角数据也可增强模型解的可信度。
5
什么是原位光谱椭偏法?
flexfilm
in situ(原位)源自拉丁语,意为“在原位”。对于椭偏法而言,原位测量指“样品置于专用腔室或池体中时进行的测量”。原位椭偏测量需满足以下条件:将椭偏仪与工艺腔室 / 池体连接(薄膜在 ALD 腔室内沉积,可实时监测薄膜的逐层生长过程)或将工艺腔室 / 池体安装在椭偏仪底座上(实现薄膜动态变化过程中的原位测量)。
6
光谱椭偏法与分光光度测量相比有何不同?
光谱椭偏法(SE)与分光光度法(R/T,即反射 / 透射测量)均为光学测量技术:光谱椭偏法测量偏振态变化,而分光光度法测量反射或透射光的强度。两种技术常互补使用,结合后可获取更多吸收性薄膜的信息。
光谱椭偏法具有以下显著优势:
对超薄薄膜的高灵敏度:光谱椭偏法可获取相位(∆)信息,这对非常薄的表面膜(<10nm)高度敏感;

左:反射仪数据;右:椭偏法对同类薄膜厚度变化的灵敏度
常规反射仪系统对光强的测量精度通常无法优于0.1%,因此无法通过反射率测量捕捉超薄薄膜厚度的微小变化(反射率精度可能高于0.1%,但厚度测量精度需依赖数据准确性);而典型椭偏仪对Ψ和∆的测量精度分别可达0.02°和0.1°以上,甚至可轻松捕捉亚埃级(sub-Angstrom)的薄膜厚度变化。
测量稳定性:椭偏法通过测量参数比值确定光的偏振态,而非测量绝对光强,因此在光强较低或波动时仍能保持较高的测量准确性。
无需校准标准:分光光度法(反射测量)需测量绝对光强,因此需使用 “经过校准的标准样品” 才能实现定量测量,且需长期维护标准样品以确保测量准确性;而椭偏法无需此类校准标准。
7
为何光谱椭偏仪系统在光学设计中采用补偿器?
UVPLUS SE椭偏仪系统均集成补偿器,用于调控光的偏振态。在椭偏仪设计中采用补偿器具有多重优势,包括:对任意样品均能实现高精度测量;可测量全范围的Ψ(0-90°)和∆(0°-360°);可测定退偏振;可测量穆勒矩阵的更多元素。
旋转补偿器:通过旋转样品前方或后方的补偿器,持续调整延迟量,从而可同时采集多种偏振态下的光谱椭偏数据。该技术的核心优势是兼容电荷耦合器件(CCD)探测:可在极短时间(如几分之一秒)内并行读取全光谱数据。目前尚无其他技术能在 1 秒内完成数百个波长的高精度光谱椭偏测量。
8
什么是退偏振?
flexfilm
光谱椭偏测量的核心是确定光从样品表面反射或透射后的偏振态变化。在理想的测量系统与样品条件下,入射光与探测光均为完全偏振光;但实际测量中,系统或样品会导致部分光变为非偏振光,这种现象称为退偏振,退偏振程度用“变为非偏振光的比例”表示。
仅配备补偿器的椭偏仪系统可测定退偏振:Flexfilm全光谱椭偏仪可以测量关于样品或测量系统的退偏振信息。测量系统引入的退偏振主要源于“角度展宽”“带宽效应”或两者共同作用;样品引入的退偏振则通常与“样品不均匀”或“基底背面反射”相关。
退偏振测量具有重要应用价值:可量化非理想样品(如不均匀薄膜、图案化层)的影响;可表征透明基底上的薄膜:若光从基底背面反射并返回探测器,会与薄膜表面反射光产生非相干叠加,导致测量光束退偏振,通过退偏振数据可量化这种背面反射的影响。
9
什么是穆勒矩阵?
flexfilm
穆勒矩阵可完整描述镜面反射样品与光的相互作用。与仅能描述偏振光的琼斯矩阵(Jones matrix)不同,穆勒矩阵可同时描述偏振光、部分偏振光甚至非偏振光。穆勒矩阵为4×4矩阵,用于表征光的反射或透射过程:入射光与出射光的偏振态均通过 4 元素斯托克斯矢量(Stokes vectors)描述。
配备补偿器的椭偏仪可测量穆勒矩阵 16 个元素中的 12 个;若在样品前后均安装补偿器,则可测量全部 16 个元素。不过,穆勒矩阵存在大量冗余信息,无需测量全部元素即可完成常见样品的完整表征。
若测量光为完全偏振光,仅需测量 Ψ 和∆两个参数;即便样品存在退偏振,也仅需测量穆勒矩阵的 3 个元素;对于“各向异性 + 退偏振”样品,独立参数数量增至 7 个。对于更复杂的样品,可通过穆勒矩阵元素观察样品引起的交叉偏振与散射效应。
10
选择光谱椭偏仪时应考虑哪些因素?
选择符合需求的椭偏仪,最佳方式是咨询专业人士,公司的应用工程师已接触过几乎所有类型的椭偏应用场景,结合丰富的产品线,可针对任意应用为客户提供优质技术支持
在比较不同的椭偏仪时,建议重点考虑以下因素:
波长范围:可测量的波长数量与范围,是椭偏仪能否解决薄膜测量问题的关键因素。
入射角范围:多数样品可通过单入射角测量;若样品为多层结构、各向异性材料或复杂结构,可能需要多入射角,具体可咨询工程师。
测量速度:若需进行原位测量或样品多点均匀性扫描,测量速度至关重要。
精度:多数椭偏仪的测量精度与准确度远超用户常规需求。例如,栅氧化层厚度的测量精度通常可达0.003nm以上。
技术类型:椭偏仪的核心技术本身并非直接关注点,但技术类型决定了其波长范围、速度、精度等关键特性。
功能扩展性:需结合应用需求,考虑椭偏仪是否支持后续升级以满足未来需求。典型配件包括:用于均匀性扫描的样品平移台、液体池、温度台、聚焦光斑附件,以及波长范围扩展模块。
价格:椭偏仪系统的价格跨度较大,从简易配置到高端配置均有可选,可满足不同预算需求。
Flexfilm全光谱椭偏仪
flexfilm

全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)
- 先进的旋转补偿器测量技术:无测量死角问题。
- 粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
- 秒级的全光谱测量速度:全光谱测量典型5-10秒。
- 原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《Ellipsometry FAQ》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
仪器
+关注
关注
1文章
4333浏览量
53769 -
光学测量
+关注
关注
0文章
92浏览量
11365
发布评论请先 登录
英飞凌IGBT应用常见问题解答
新手-iPhone/touch常见问题解答
Maxim时分复用(TDMoP)技术问题解答
隔离、iCoupler技术和iCoupler产品常见问题解答




 椭偏仪常见技术问题解答(二)
椭偏仪常见技术问题解答(二)

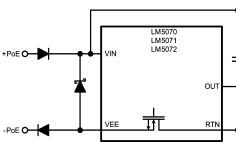
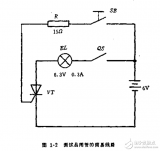





评论