USB端口蓝牙信号发射器BGA芯片底部填充胶方案由汉思新材料提供


涉及部件:蓝牙信号发射器BGA射频芯片
工艺难点:整个发射器板卡装配的时候,塑胶外壳要用超声波进行进行焊接,由于超声波焊接35K高频振动对焊球的应力损伤相当大,造成装配好的发射器无法和蓝牙耳机信号交互配对,不良率高达80%,客户已经采用其它多种方式方法对芯片进行机械加固,但是仍然无法解决问题。后经我司工程师分析原因并结合该芯片的规格参数,可靠性测试条件,再推荐适配的BGA底部填充胶,问题得以解决。
应用产品:HS710底部填充胶
方案亮点:适配极小间隙和孔隙填充,毛细流动速度快,对焊球完全包裹,有效抵御高频机械应力的损伤
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片
+关注
关注
463文章
54441浏览量
469421 -
usb
+关注
关注
60文章
8476浏览量
285878 -
蓝牙
+关注
关注
119文章
6393浏览量
179331 -
芯片封装
+关注
关注
14文章
623浏览量
32397
发布评论请先 登录
相关推荐
热点推荐
电子工程师必看:TPD12S521 HDMI 发射器端口保护与接口芯片解析
电子工程师必看:TPD12S521 HDMI 发射器端口保护与接口芯片解析 大家好,作为一名资深电子工程师,今天要给大家详细介绍一款在 HDMI 接口保护领域表现出色的芯片——TPD1
汉思新材料|芯片级底部填充胶守护你的智能清洁机器人
汉思新材料|芯片级底部填充胶守护你的智能清洁机器人智能清洁机器人的广泛应用随着现代科技的飞速发展,智能清洁机器人已覆盖家庭、商用两大场景:家庭中实现扫拖消全自动,商用领域应用于酒店(客

BGA底部填充胶固化异常延迟或不固化原因分析及解决方案
针对BGA(球栅阵列)底部填充胶(Underfill)固化异常延迟或不固化的问题,需从材料、工艺、设备及环境等多方面进行综合分析。以下为常见原因及解决方案一、原因分析1.材料问题胶水过

汉思新材料取得一种封装芯片高可靠底部填充胶及其制备方法的专利
汉思新材料取得一种封装芯片高可靠底部填充胶及其制备方法的专利2025年4月30日消息,国家知识产权局信息显示,深圳市汉思新材料科技有限公司取得一项名为“封装




 USB端口蓝牙信号发射器·BGA芯片底部填充胶应用
USB端口蓝牙信号发射器·BGA芯片底部填充胶应用








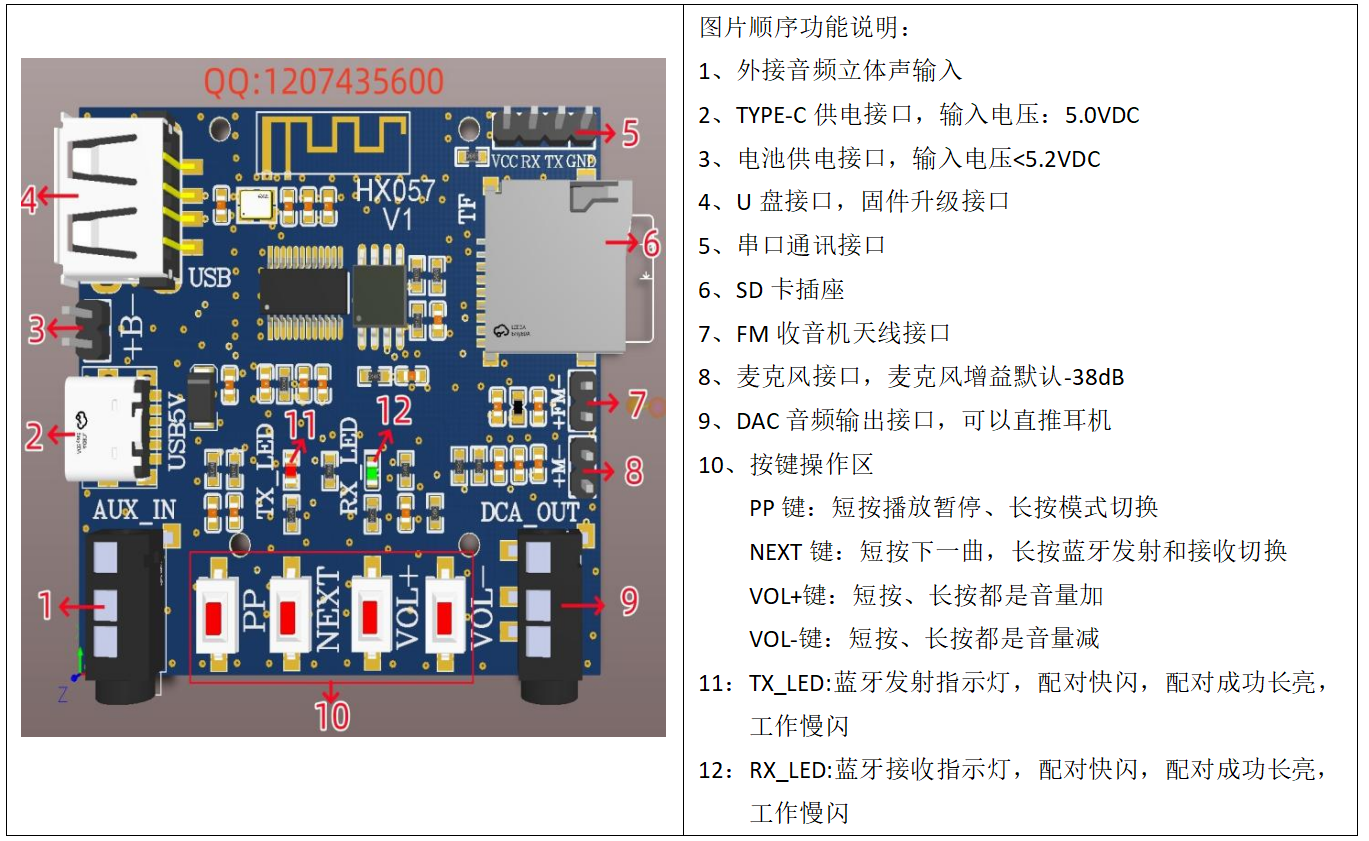






评论