关键词:电子封装,底部填充胶水,胶粘剂,环氧树脂
引言:作为电子封装领域的关键辅助材料,底部填充胶有其特定的使用要求和性能特点。本文分析了底部填充胶在使用中存在的关键问题,介绍了底部填充胶用环氧树脂的研究进展,对底部填充胶的未来发展提出了展望。
00前言
当前,我国消费电子行业发展迅速,已成为全球生产和消费的主要地区。随着电子产品小型化和多功能化的发展,人们对电子芯片也提出越来越高的要求。电子芯片制造起源和发展都在国外,自电子芯片生产引进国内后,国内芯片生产相关材料也引起了极大重视。在电子芯片制造工艺流程中,底部填充胶起着至关重要的作用。虽然用量较少,在芯片制造成本中所占的比例较低,但目前其市场基本依赖进口,国内目前存在较大缺口。
01底部填充胶的作用
在电子封装过程中,电子元器件是由不同线膨胀系数的材料组成。在热循环下,由于膨胀尺度不同会产生热应力差,进而产生相对位移,导致整个元件失效,而底部填充是避免此现象产生的有效方式。
底部填充胶,又称为底填胶、底部填充剂、底填剂和底充胶等,即在封装时渗入到芯片、焊柱和基板之间形成可靠粘接,分散芯片在受到机械作用和热循环作用时其焊点处所受的应力,避免开焊和不良焊点的产生。此外,底部填充胶还可以起到保护焊点免受湿气、离子污染物等周围环境影响的作用。底部填充胶极大地提高了封装稳定性和产品的使用寿命,目前主要用于笔记本电脑、USB、手机等手提电子产品的线路板组装。一般将底部填充胶分为芯片级底部填充(CLU)和 PCB 板级底部填充(BLU),其中芯片级底部填充对封装胶要求更加严格。
02底部填充胶的性能要求
电子芯片高集成化和高性能化的发展,对底部填充胶的性能提出了更高要求。根据工艺和使用性能,底部填充胶需要具备易操作、快速流动、快速固化、长使用寿命、高粘接强度和低模量的基本特点,同时还要满足填充性、兼容性和返修性等。
(1)可靠性:经过温湿、冷热冲击和机械冲击后,电性能和粘接性能稳定。底部填充胶的热膨胀系数(CTE)、玻璃化转变温度(Tg)以及模量系数(Modulus)等,要与 PCB 基材、器件的芯片和焊料合金等因素进行匹配,胶粘剂的Tg对 CTE 有着重要的影响。当温度低于Tg时,CTE 较小,反之则 CTE 急剧增加。模量系数为物质的应力与应变之比,模量是胶粘剂固化性能的重要参数,模量较高则表示胶粘剂的粘接强度与硬度较好,但也代表着胶粘剂固化后残留的应力较大。
(2)操作性:胶粘剂的流动性与锡球间距、锡球尺寸有关。不同间隙高度和流动路径,导致流动时间也不同,如需保证快速完全填充,则要求胶粘剂黏度低、流动快;但黏度也不能过低,否则生产过程中容易滴胶。一方面填充胶的表面张力、接触角、黏度和硬化反应可对填充胶在芯片和电路底板之间流动产生影响,其中黏度为最主要因素,温度则是影响填充胶黏度的重要因素;另一方面焊球点的布置密度和边缘效应对芯片和电路底板之间流动也有一定影响,焊球点之间缝隙的宽度、焊球点的直径、芯片与电路底板之间的缝隙高度决定了焊球点产生的影响。
(3)效率性:底部填充胶的固化温度应适当,以保护主板上的其他电气器件及焊点。同时,固化速度要快,过长的固化时间会影响流水线作业的效率。此外,固化方式需要满足大批量生产需求。
(4)耐热性:胶粘剂的线胀系数(CTE)与基材线胀系数要相匹配。且仅有材料的 CTE 较小时,Tg对热循环疲劳寿命才有一定影响,因为当材料温度高于Tg和低于Tg时,其 CTE 变化差异很大。同时相关试验表明,当 CTE 较低时,Tg越高热循环疲劳寿命就越长。电子元器件在工作时会发热,需要固化物有良好的耐热性。
(5)耐腐蚀性:低氯离子含量和金属离子含量均可减缓微线路腐蚀。
(6)兼容性:焊点周围存在锡膏残留的助焊剂,如果底部填充胶与残留的助焊剂不兼容,会导致底部填充胶无法有效固化。
(7)可检验性:固化前后颜色明显变化,或通过紫外照射出现颜色变化,方便检验固化或填充情况。
(8)返修性:底部填充胶通常要求具有可返修性,因为在线路板组装完成后,如在整板测试中发现芯片不良等情况,需对芯片进行返修。为降低成本、避免废品的产生导致整个电路板的报废,对底部填充胶的可返修性要求与日俱增。
(9)功能性:要求低应力、低 CTE、与锡膏兼容性、绝缘电阻及良好填充效果(无气泡、空洞)等。
03底部填充胶关键问题分析
电子级封装涉及的粘接基材均为精密器件,具有尺寸小(达微米级)、功能化(介电性能、力学性能、耐腐蚀性能、导热等)和所处环境非常规(如高温高湿、温度变化、应力冲击等)等特点。
3.1胶粘剂在固化中收缩产生的应力问题
胶粘剂在固化中由于键长改变会产生收缩问题(一般为 3.5~1.4 Å),胶粘剂从液体到凝胶状态、到达到Tg、再到完全固化,期间受凝胶、固化温度和Tg的影响,不同阶段的状态都不相同,影响因素较多且缺乏过程的表征手段。由于整个过程中会产生不同程度、不同原因的收缩,产生较大的内应力,所以容易导致粘接失效,包括胶层失效(裂纹)、粘接失效(脱附)和器件失效(器件受力变形或破坏)。
目前减小材料的固化收缩率主要是通过添加填料的方式,但其调节能力有限,若大量使用,会导致黏度、模量等大幅度变化,反而不利于底部填充。因此,底部填充胶的应力收缩问题是目前该类材料应用的主要问题之一。
3.2胶粘剂的线胀系数与基材的线胀系数匹配问题
由于电子器件应用温度随着使用环境的变化而变化,导致同类器件可能在低温下应用,也有可能在高温下应用。另外由于电子器件发热等情况带来的局部高温环境不同,甚至固化过程也会发生温度的改变。胶粘剂的 CTE 一般比所粘接器件的CTE 要高,当温度改变时,会在粘接界面产生应力,温度变化量大时甚至会导致局部产生应力开裂。
目前常用的方法是通过添加低膨胀填料进行改进,对填料的要求也比较高,如小粒径会导致黏度上升,填充时粒径不超过缝隙的 1/4,一般光栅阵列间相距 25 μm,因此需要胶粘剂的黏度较低且容易流动填充。这就带来了因填料引起的黏度不匹配与CTE 矛盾的难题。胶粘剂的导热系数不高,导热系数达到 2.8 W/(m·K)很困难,可通过加入填料,改变其数目比和尺寸比进行提升,但提高程度也会影响胶粘剂的其他工艺特性。因此集多种矛盾为一身的体系如何寻求突破是一大难点,目前国外的原料制造水平较高,有专注于通过研究特种结构的环氧树脂来解决此问题。
3.3胶粘剂纯度控制和质量稳定性问题
底部填充胶主要成分为环氧树脂,由于大部分环氧树脂合成是通过环氧氯丙烷开环闭环的工艺路线,会产生含氯副产物。而氯离子在电子器件的应用过程中会腐蚀基材,导致粘接失效,氯离子迁移也会影响电子器件的光电性能。由于在合成阶段难以控制环氧树脂中氯的源头问题,要获得低氯离子含量环氧树脂就需要进行纯化,即使用将已合成树脂进行再反应的方法进行提纯,从而达到电子级的使用要求(氯离子含量 <50 g/kg)。目前,以日本为代表的国外企业在电子级环氧树脂方面发展迅速但对外垄断,而国内高纯低氯环氧树脂发展水平较低,存在产品纯度不高和质量稳定性差等问题,极大地限制了环氧树脂在电子领域的应用。
04底部填充胶研究进展
随着电子封装的要求越来越高,环氧树脂的研究方向主要集中在高纯度、低黏度化以及耐湿热等高性能化方面。
4.1高纯低氯环氧树脂
常见的环氧树脂是由二元(或多元)酚与环氧氯丙烷在碱作用下缩聚而得。在聚合过程中,反应体系黏度大,导致中间相的产生,使反应不完全;同时其他副反应的存在也可能使环氧形成异质末端基,不仅影响树脂自身的性能和固化反应性,也对固化物的性能产生影响。
为了使电子元件不受腐蚀,对残留的钠离子和可水解氯离子的要求相对较高。因此,降低树脂中的杂质含量,特别是控制总氯含量(可水解氯和结合氯之和)尤为重要。但从制造工艺上讲,完全消除不纯物是十分困难的。目前,国内外高纯度环氧树脂主要有双酚A型和邻甲酚醛环氧树脂。
环氧树脂的主要杂质是以有机氯为端基的不纯物,环氧树脂纯度的主要指标是可水解氯含量。氯离子含量控制是较为关键性的因素之一,目前主要方法有连续法、相转移法、非卤掺杂物转化法、溶剂加酸碱洗涤法和分子蒸馏法。随着真空分子蒸馏技术的快速发展,其成为氯离子含量控制的主流工艺,从而使商业化的产品快速面世。目前国外主要的环氧树脂生产厂家为 Dow Chemical、Bakelite、Huntsman 等。国内研究单位为上海市合成树脂研究所、中国科学院化学研究所、蓝星化工新材料股份有限公司和中国石油化工股份有限公司巴陵分公司等,产品质量与国外还存在一定差距。
4.2萘型环氧树脂
萘基环氧树脂一般是由萘酚、萘二酚直接与环氧氯丙烷反应制备,也可先将萘酚、萘二酚和联萘酚原料经甲醛、甲基取代苯酚、羟甲基取代苯及其衍生物、脂环烯烃类等缩合得到多羟基化合物,然后经环氧氯丙烷环氧化制备而得。引入不同的萘基基团或其衍生物可以制备出不同结构的萘型环氧树脂。不同萘基结构的环氧树脂合成工艺和路线差别较大,同时选择不同结构的萘异构体,对成功合成萘型环氧树脂以及关键性能的保证,都起到了决定性的作用。目前在萘型环氧树脂研究方面,国内研究机构的技术水平与企业的工业化生产差甚远,且与国外(特别是日本)的制造技术水平相差甚远。
张奎等通过将刚性大、疏水性强的萘酚结构单元引入环氧单体分子中,合成出2,2’-二缩水甘油醚基-1,1’-联萘(DGEBN)和邻,邻二缩水甘油醚基-二萘基-亚甲基(DGEFN)两种环氧化合物,使得环氧固化物的Tg显著提高,体系的热稳定性和吸湿稳定性得到了改善。同时由于该环氧单体具有较低的黏度、较好的溶解性和加工性,可满足微电子工业的发展要求。由于该类树脂体系含有庞大、疏水性高、刚性的萘环,因此与目前微电子行业常用的苯基环氧树脂相比,该类树脂可以使环氧固化体系的玻璃化转变温度提升较多,使其具有较好的耐热性、较低的吸水率。因此将萘环等多芳环结构引入环氧树脂体系,能够提升环氧树脂的耐热性、耐湿性、力学性能。DGEBN和 DGEFN的结构式如图 2 所示。
 图2DGEBN和DGEFN环氧树脂结构
图2DGEBN和DGEFN环氧树脂结构
宣宜宁等为了改善树脂固化物的耐热性和耐湿性,同时改进该类树脂溶解性差、软化点高问题,选择使用 2-萘酚首先合成出 2,2’-二羟基-1,1’-联萘,进一步制备出新型结构的萘基环氧树脂。该类环氧树脂分子中含有刚性高、体积较大的联萘基团,且树脂的分子质量相对较小。
郑寅等以大体积刚性联萘环为中心,以酯键连接两端的烯酸柔性链,设计合成了对称的刚柔并济萘环环氧树脂,并从柔性链长短因素讨论了环氧树脂的结构和性能之间的关系。刚柔一体含萘环氧树脂的结构如图3所示。
 图3刚柔一体含萘环氧树脂结构4.3联苯型环氧树脂
图3刚柔一体含萘环氧树脂结构4.3联苯型环氧树脂
联苯型环氧树脂熔融黏度小,即使添加大量的二氧化硅,仍然可保持成型时的流动性。同时由于二氧化硅无吸水性,可大大降低材料的吸湿性和透湿性,增加材料的低膨胀性。但联苯型固化物的玻璃化温度要低于酚醛型固化物。
杨明山等将一定质量的环氧氯丙烷、相转移催化剂、无水乙醇混合,采用两步法制备了大规模集成电路封装用联苯型环氧树脂,其结构式如图 4所示。
 图4联苯环氧树脂结构
图4联苯环氧树脂结构
谭怀山等采用 4,4-二甲氧甲基联苯和苯酚制得联苯酚醛,与环氧氯丙烷、季铵盐、NaOH 反应后制得联苯酚醛环氧树脂,其结构式如图5所示。
 图5联苯酚醛环氧树脂结构4.4邻甲酚醛环氧树脂
图5联苯酚醛环氧树脂结构4.4邻甲酚醛环氧树脂
邻甲酚醛环氧树脂(EOCN)是由邻甲酚醛树脂(OCN)和环氧氯丙烷(ECH)反应而得的一种线型酚醛耐热性多官能团的环氧树脂。EOCN 的玻璃化转变温度较高、机械强度高、收缩小、耐湿热、耐腐蚀,具有优良的热稳定性、耐水性、抗开裂性、耐化学药品性、电气绝缘性且可靠性较好。与通用环氧树脂相比,EOCN 的环氧值更高,在固化时可提供更多的交联点,极易形成高交联密度的三维结构。
在潮湿、高温或苛刻环境中,高纯度的 EOCN 封装的电子元器件也能保持其良好的电气绝缘性能。EOCN分子结构式如图6所示。
 图6邻甲酚醛环氧树脂结构
图6邻甲酚醛环氧树脂结构
近年来,大部分国内外企业均可生产无色或透明的 EOCN,而超高纯度和降皂化氯 EOCN 是目前研究发展的方向。高纯 EOCN 后又开发了超高纯(可水解氯含量小于 300×106)EOCN。通过使用合适的溶剂和合适的脱氯化氢剂,如银盐(乙酸银)、离子交换树脂、金属钠,采用电泳、超滤、渗透膜分离等方法来脱除易皂化氯和结合氯,可使树脂中易皂化氯含量降至 100 μg/g以下。
邻甲酚醛树脂的环氧化分为一步法和两步法。其中一步法系采用邻甲酚醛树脂与过量的环氧氯丙烷在负压下加碱闭环,经过一系列的后处理和纯化,可得到低氯高纯度的邻甲酚醛环氧树脂(下称成品树脂);二步法采用环氧氯丙烷和邻甲酚醛树脂,在相转移催化剂作用下生成氯醇醚,然后,在碱性条件下进行闭环氧化,经过一系列后处理和纯化可得到成品树脂。利用先缩合后环氧化工艺法进行生产的优点是控制简便、工艺成熟、产品质量稳定,易于实现工业化大生产。
4.5双环戊二烯苯酚环氧树脂
双环戊二烯苯酚型环氧树脂熔融黏度低、吸水率低、耐热性能好,克服了邻甲酚醛环氧树脂熔融黏度较大的问题。目前使用较多的为 BF3·Et2O 类催化剂,此类催化剂对反应条件要求十分苛刻,易潮解,且会产生大量废液,为后处理增加了很多困难,而且生成的产品颜色较深,使树脂的进一步应用受到了阻碍。
侯彩英等使用三氟化硼乙醚作为催化剂,用对叔丁基苯酚对双环戊二烯改性,合成软化点高、油溶性好的双环戊二烯酚型树脂,但产品颜色较深。李政中等以二环戊二烯-酚和 2,6-二甲基苯酚为原料合成了 2,6-二甲基苯酚-二环戊二烯苯酚树脂,并将其环氧化为 2,6-二甲基苯酚-二环戊二烯环氧树脂,其结构如图7所示。
 图72,6-二甲基苯酚-二环戊二烯苯酚树脂的结构
图72,6-二甲基苯酚-二环戊二烯苯酚树脂的结构
05展望
最早底部填充胶的开发是为了适应球栅阵列封装(BGA)和芯片级封装(CSP)这类封装方式,随着应用领域的逐渐扩大,人们对其产生了差异化的性能需求。实际应用中,企业会根据自己的生产工艺和使用场景进行选择。
(1)目前底部填充胶用环氧树脂的研究方向主要集中在高纯度、低黏度化以及耐湿热等高性能化方面,不同种类树脂功能差异较大。未来,随着电子封装工艺的进步和发展,会对底部填充胶的性能提出更多要求,如可返修性等。
(2)底部填充胶的应力收缩是该类材料应用的主要问题之一,同时氯离子含量控制也是关键性的因素。目前主要是通过萘型环氧树脂、联苯型环氧树脂、邻甲酚醛环氧树脂和环戊二烯型环氧树脂等不同树脂的结构设计上进行改进。本土企业如何从树脂和配方领域创新,提高产品质量是迫在眉睫要解决的问题。
来源:中国胶黏剂
作者:甘禄铜1,刘鑫2,李勇11中国胶粘剂和胶粘带工业协会;2中国化工信息中心有限公司原文:DOI:10.13416/j.ca.2022.01.010
胶水(胶粘剂)技术原理の简介

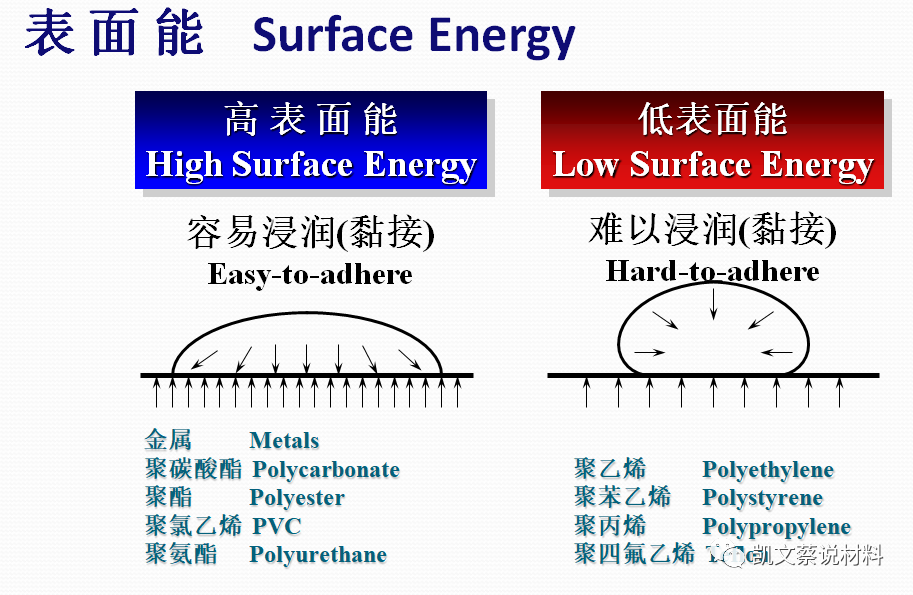


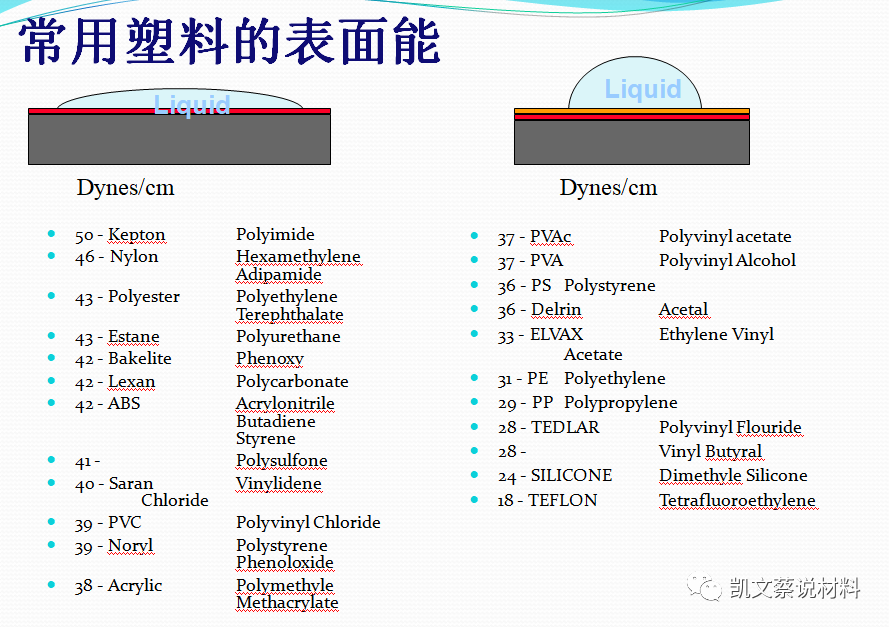
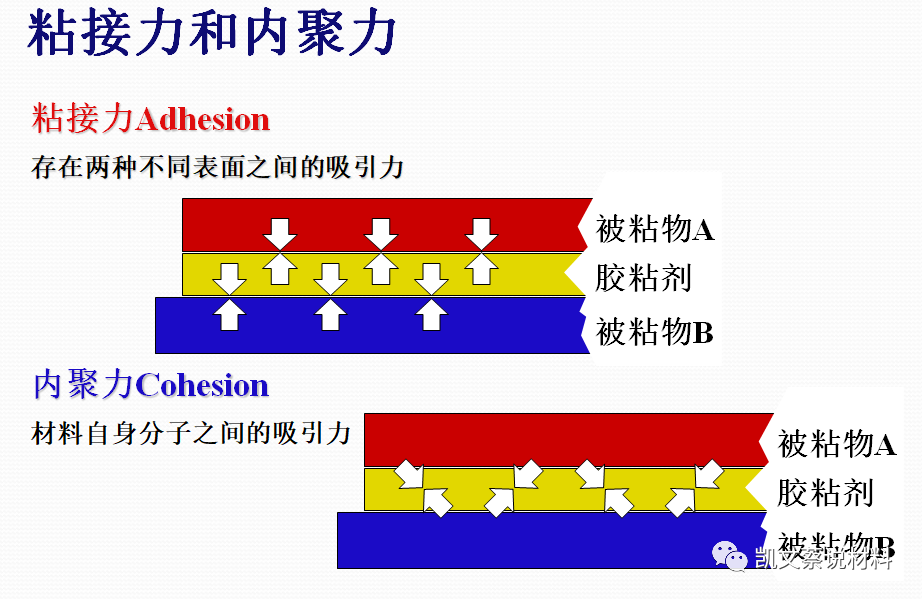
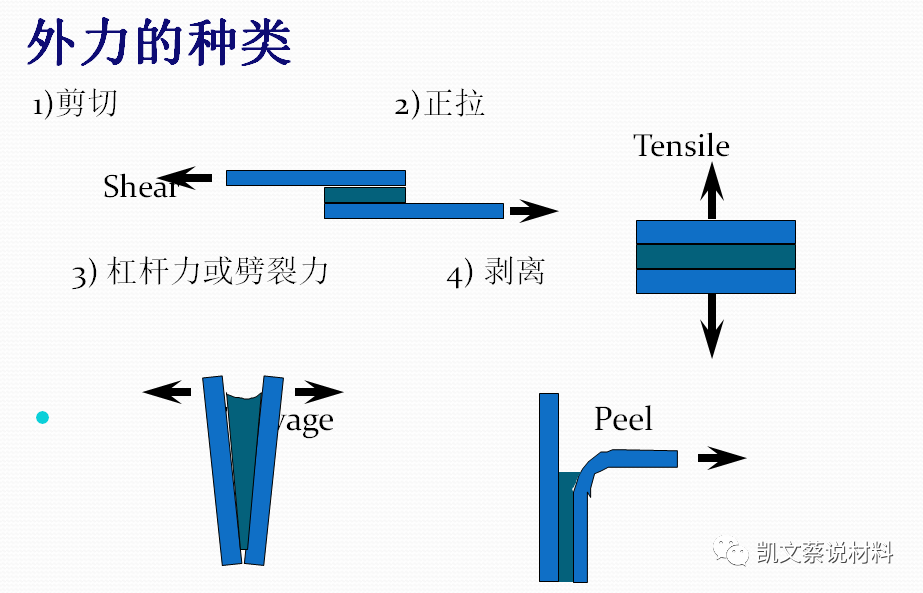
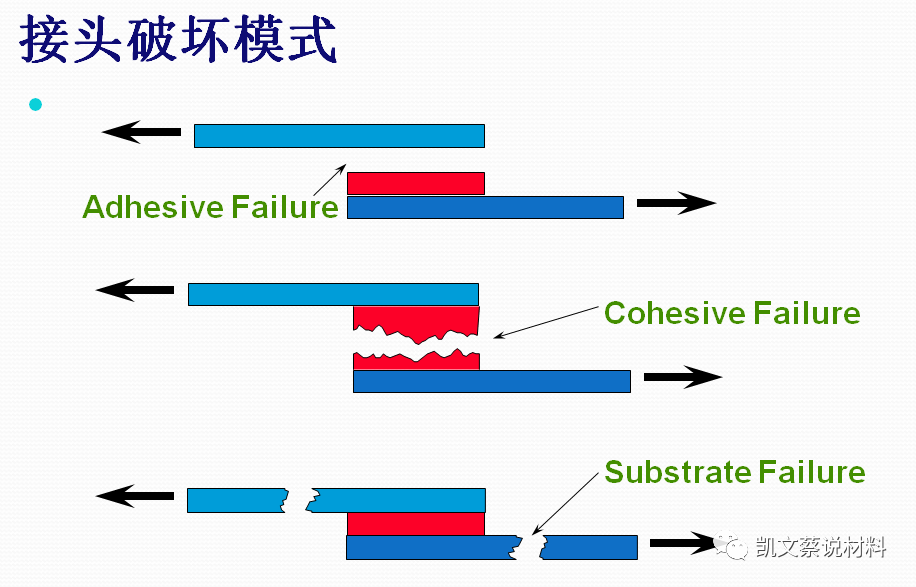
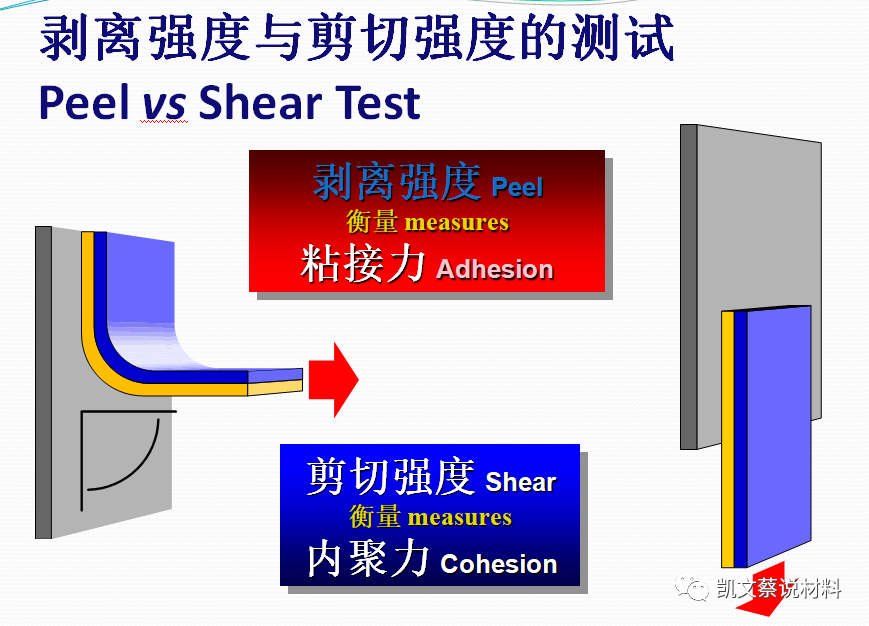












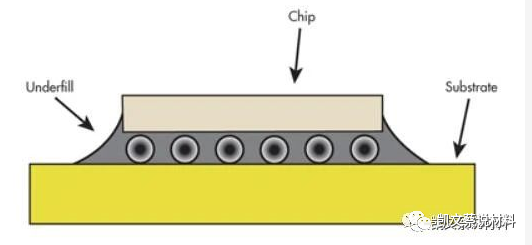
-
封装
+关注
关注
128文章
9398浏览量
149257 -
材料
+关注
关注
3文章
1635浏览量
28726
发布评论请先 登录
汉思新材料:人形机器人底部填充胶(Underfill)应用指南

导电银浆:基于固化过程电阻演变的环氧树脂体系在封装与柔性电子中的应用

环氧树脂在各领域的应用

汉思新材料:底部填充胶可靠性不足如开裂脱落原因分析及解决方案

汉思新材料:环氧底部填充胶固化后有气泡产生原因分析及解决方案




 环氧树脂基底部填充电子封装材料研究进展
环氧树脂基底部填充电子封装材料研究进展














评论