主题:
解决封装材料热失配难题
正文:
在芯片封装、LED封装及功率器件模封中,环氧树脂等有机封装材料与芯片、陶瓷基板之间存在的热膨胀系数(CTE)失配,是导致界面开裂、可靠性下降的主要原因。添加常规填充剂虽能一定程度降低CTE,但往往难以达到理想状态。ULTEA®负热膨胀填充剂为此提供了完美答案。当将其添加到环氧树脂中时,ULTEA®在受热过程中的收缩行为,能主动抵消树脂基体的膨胀,从而将复合材料的整体CTE调整至接近芯片或陶瓷的水平,极大减少热应力。
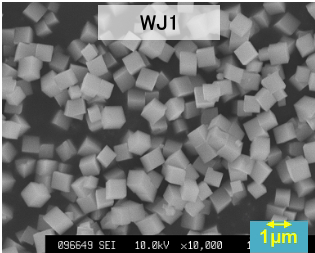
特别是开发品WJ1型号,其平均粒径更细(0.5-1μm),负热膨胀系数更强(-6 x10⁻⁶/K),且密度低(0.2 g/cm³),更容易在树脂中实现高填充量和均匀分散,是树脂应用的理想选择。
深圳市智美行科技有限公司
作为东亚合成的战略伙伴,不仅提供高质量的ULTEA®产品,更能为您的特定封装应用提供技术支持和选型建议。
立即申请免费样品,测试ULTEA®在您配方中的卓越表现!
-
功率器件
+关注
关注
43文章
2055浏览量
94611 -
芯片封装
+关注
关注
13文章
604浏览量
32086
发布评论请先 登录
眺望未来:负热膨胀材料ULTEA®在下一代电子技术中的前瞻性应用探索

实战指南:如何将负热膨胀材料ULTEA®集成到您的电子设计与工艺中

从实验室到产线:负热膨胀材料ULTEA®的产业化之路与可靠性验证体系

破解热致失效困局:深入解析负热膨胀材料ULTEA®在高端电子封装中的应用

提升可靠性!ULTEA®如何通过抑制热膨胀解决电子设备长期老化难题

环氧树脂在各领域的应用

热重分析仪环氧树脂的稳定性测试

一种低翘曲扇出重构方案

热膨胀系数测试






 工程师必备!ULTEA®负热膨胀填充剂在环氧树脂封装中的应用方案
工程师必备!ULTEA®负热膨胀填充剂在环氧树脂封装中的应用方案



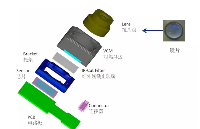










评论