点击蓝字关注我们
电源应用中的 MOSFET 大多是表面贴装器件 (SMD),包括 SO8FL、u8FL 和 LFPAK 等封装。通常选择这些 SMD 的原因是它们具有良好的功率能力,同时尺寸较小,从而有助于实现更紧凑的解决方案。尽管这些器件具有良好的功率能力,但有时散热效果并不理想。
由于器件的引线框架(包括裸露漏极焊盘)直接焊接到覆铜区,这导致热量主要通过PCB进行传播。而器件的其余部分均封闭在塑封料中,仅能通过空气对流来散热。因此,热传递效率在很大程度上取决于电路板的特性:覆铜的面积大小、层数、厚度和布局。无论电路板是否安装到散热器上,都会导致这种情况的发生。通常器件的最大功率能力无法达到最优情形,是因为 PCB 一般不具有高的热导率和热质量。为解决这个问题并进一步缩小应用尺寸,业界开发了一种新的 MOSFET 封装,即让 MOSFET 的引线框架(漏极)在封装的顶部暴露出来(例如图 1 所示)。
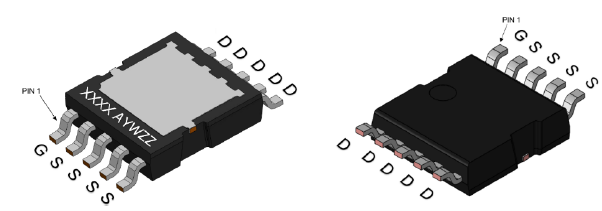
图 1. 顶部散热封装
顶部散热的布局优势
虽然传统功率 SMD 有利于实现小型化解决方案,但出于散热考虑,它们要求在电路板背面其下方的位置不能放置其他元器件。电路板的一些空间无法使用,导致最终的电路板整体尺寸较大。而顶部散热器件可以绕过此问题:其散热是通过器件顶部进行的。这样,MOSFET 下方的板面位置就可以放置元器件了。
该空间可用于布置如下元器件(但不限于此):
反过来,还能缩小电路板尺寸,减少栅极驱动信号的路径,实现更理想的解决方案。
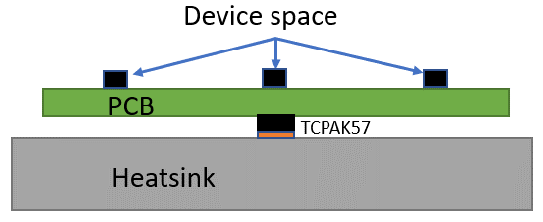
图 2. PCB 器件空间
与标准 SMD 器件相比,顶部散热器件除了可以提供更多的布局空间外,还能减少热量交叠。顶部散热封装的大部分热传播都直接进入散热器,因此 PCB 承受的热量较小。有助于降低周围器件的工作温度。
顶部散热的热性能优势
与传统的表面贴装 MOSFET 不同,顶部散热封装允许将散热器直接连接到器件的引线框架。由于金属具有高热导率,因此散热器材料通常是金属。例如大多数散热器是铝制的,其热导率在 100-210 W/mk 之间。与通过 PCB 散热的常规方式相比,这种通过高热导率材料散热的方式大大降低了热阻。热导率和材料尺寸是决定热阻的关键因素。热阻越低,热响应越好。
Rθ = 绝对热阻
Δx = 与热流平行的材料的厚度
A = 垂直于热流的横截面积
k = 热导率
除了提高热导率外,散热器还提供更大的热质量——这有助于避免饱和,或提供更大的热时间常数。这是因为顶部安装的散热器的尺寸可以改变。对于一定量的热能输入,热质量或热容与给定温度变化成正比。
Cth = 热容,J/K
Q = 热能,J
ΔT = 温度变化,K
PCB 往往具有不同的布局,并且铜皮厚度较低的话,导致热质量(热容)较低和热传播不良。所有这些因素使得标准的表面贴装 MOSFET 在使用时无法实现最佳热响应。从理论上讲,顶部散热封装拥有直接通过高热质量、高导热性源散热的优势,因此其热响应 (Zth (C°/W)) 会更好。在结温升幅一定的情况下,更好的热响应将支持更高的功率输入。这样,对于相同的 MOSFET 芯片,采用顶部散热封装的芯片比采用标准 SMD 封装的芯片将拥有更高的电流和功率能力。
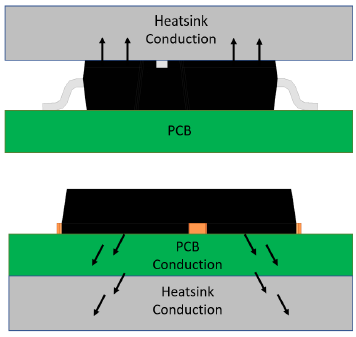
图 3. 顶部散热封装(上)和 SO8FL 封装(下)的散热路径
热性能比较的测试设置
为了演示和验证顶部散热的热性能优势,我们进行了测试,比较了相同热边界条件下 TCPAK57 和 SO8FL 器件的芯片温升和热响应。为使比较有效,两个器件在相同的电气条件和热边界下进行测试。区别在于,TCPAK57 的散热器安装在器件上方,而 SO8FL 器件的散热器安装在 PCB 的底部,位于 MOSFET 区域正下方(图 3)。这是对器件在现场应用中使用方式的复现。测试期间还使用了不同厚度的热界面材料 (TIM),以验证使用不同的热边界能够优化哪种器件封装。整体测试按如下方式进行:对这两个器件施加固定电流(因此是固定功率),然后监视结温的变化,从而得知哪个器件性能更好。

图 4. 每个器件的应用设置
器件选择和PCB布局
在器件选择方面,每种封装中的 MOSFET 具有相同的芯片尺寸并使用相同的技术。这是为了确保每个器件在给定电流下具有相同的功耗,并使封装级热响应一致。这样,我们就能确信所测得的热响应差异是由于封装差异导致的。出于这些原因,我们选择使用 TCPAK57 和 SO8FL。它们采用略有不同的线夹和引线框架设计,一个有引线 (TCPAK57),一个无引线 (SO8FL)。应当注意的是,这些差异很小,不会对稳态热响应产生很大影响,故可忽略。给定参数后,选定的器件如下:
-
NVMFS5C410N SO8FL
-
NVMJST0D9N04CTXG TCPAK57
为了进一步确保所有其他热边界保持等效,我们设计了两个相同的 PCB 以搭载 SO8FL 封装或 TCPAK57 封装。PCB 设计为 4 层板,每层含 1 盎司铜。尺寸为 122 mm x 87 mm。SO8FL 板没有将漏极焊盘连接到电路板其他导电层的热过孔(这对散热并不是最好的);在此比较设置中,可以将其用作最糟散热情况。
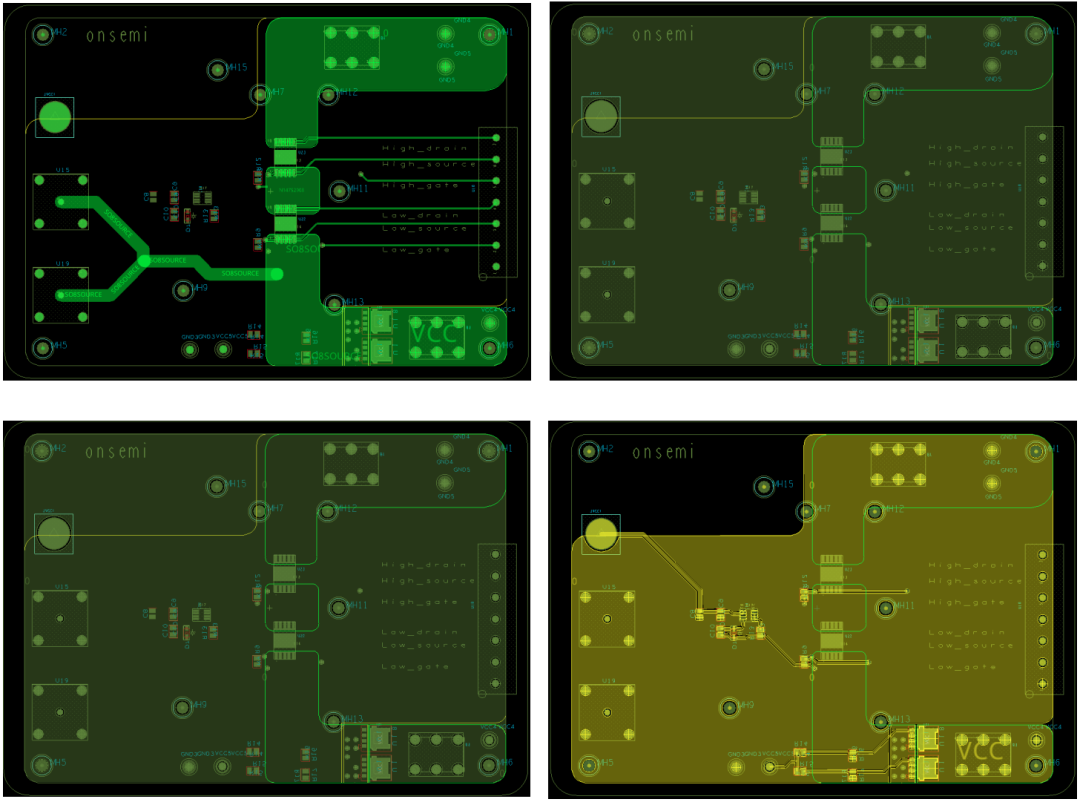
图 5. PCB 的每一层
(第 1 层显示在左上方,第 2 层显示在右上方,
第 3 层显示在左下方,第 4 层显示在右下方)
散热器和热界面材料 (TIM)
测试过程中使用的散热器为铝制,专门设计用于安装到 PCB 上。107 mm x 144 mm 散热器为液冷式,其中 35 mm x 38 mm 散热面积位于 MOSFET 位置正下方。通过散热器的液体是水。水是现场应用中常用的冷却液。对于所有测试场景,其流速都设置为 0.5 gpm 的固定值。水可以提供额外的热容,将热量从散热器转移到供水系统中,有助于降低器件温度。
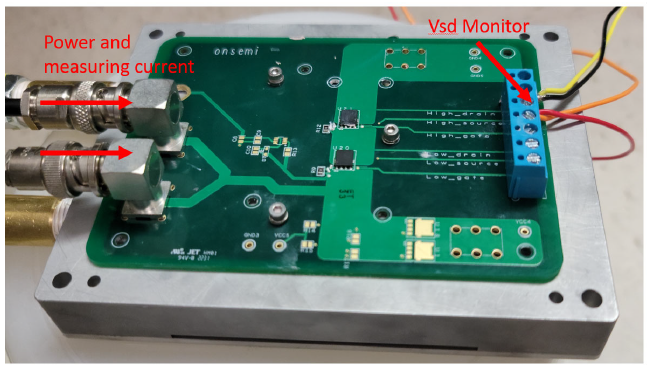
图 6. 应用设置
为了更好地促进 MOSFET 界面散热,应使用热间隙填充物。这有助于填补界面表面可能存在的缺陷。空气作为不良热导体,任何气隙都会增加热阻。测试使用的 TIM 是 Bergquist 4500CVO 填缝剂,其热导率为 4.5 W/mK。使用几种不同厚度的此这种TIM 来展示热响应优化的可能性。固定的厚度通过在电路板和散热器之间使用的精密垫片来实现。使用的目标厚度为:
-
~200 µm
-
~700 µm
测试电路和加热/测量方法
选择的板载电路配置是半桥设置,因为它代表了一种通用型现场应用。两个器件彼此靠近,这也准确反映了现场布局,因为较短的走线有助于减少寄生效应。由于器件之间有热量交叠,这对热响应会发挥一定的作用。
为了能够以较低电流值进行相关加热,电流将通过 MOSFET 的体二极管。为确保始终如此,将栅极到源极引脚短路。给定器件的热响应通过如下方式获得:先加热半桥 FET,直到稳态结温(温度不再升高),然后随着结温回到冷却状态温度,通过一个 10 mA 小信号源监测源漏电压 (Vsd)。加热过程中达到热稳态所需的时间与返回到无电状态的时间相等。体二极管的 Vsd 与结温呈线性关系,因此可以使用一个常数 (mV/ C°) 比率(通过每个器件的表征来确定)将其与 ΔTj 相关联。然后将整个冷却期间的 ΔTj 除以加热阶段结束时的功耗,就得到给定系统的热响应 (Zth)。



2 A 电源、10 mA 电源和 Vsd 的测量均由 T3ster 处理。T3ster 是一款商用测试设备,专门用于监测热响应。它利用前面提到的方法计算热响应。
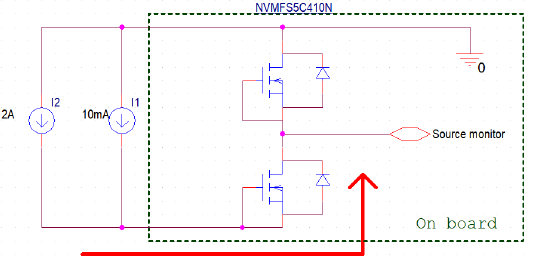
图 7. 电路图
热比较结果
在两种条件下测量每个器件的热响应结果:
-
200 μm TIM
-
700 μm TIM
这两次测量的目的是确定给定受控系统中哪种封装具有更好的热响应,以及哪种器件的热响应可以通过外部散热方法来优化。务必注意,这些结果并非适用于所有应用,而是特定于所提到的热边界。
使用200 μm TIM安装到散热器的封装比较
对于第一个测试操作,每个器件使用 200 μm TIM 安装到水冷散热器上。每个器件都接受 2 A 脉冲,直至稳态。T3ster 监测散热期间的 Vsd,并将其反向关联到该系统的热响应曲线。顶部散热的稳态热响应值为 ~4.13 C°/W ,而 SO8FL 的值为 ~25.27 C°/W。这一巨大差异与预期结果一致,因为顶部散热封装直接安装到高导热性、大热容的散热器上,实现了良好的热传播。对于SO8FL 则由于 PCB 的热导率差,导热效果差。
为了帮助理解如何在应用中利用这些优势,可以将热响应值与每个器件可以承受的功率量联系起来。将 Tj 从 23 C° 的冷却液温度提高到 175 C° 的最大工作温度所需的功率计算如下:


注意:此功率差异在这个特定的热系统中是意料之中的。
在该热系统中,顶部散热单元可应对的功率量是 SO8FL 的 6 倍。在现场应用中,这可以通过几种不同的方式加以利用。下面是它的一些优势:
-
当需要的电流一定时,由于功率能力提高,相比SO8FL 可以使用更小的散热器。从而可能节省成本。
-
对于开关模式电源应用,在保持相近的热裕量的同时可以提高开关频率。
-
可用于原本不适合 SO8FL 的更高功率应用。
-
芯片尺寸一定时,顶部散热器件相比 SO8FL 将有更高的安全裕量,在给定电流需求下运行温度更低。
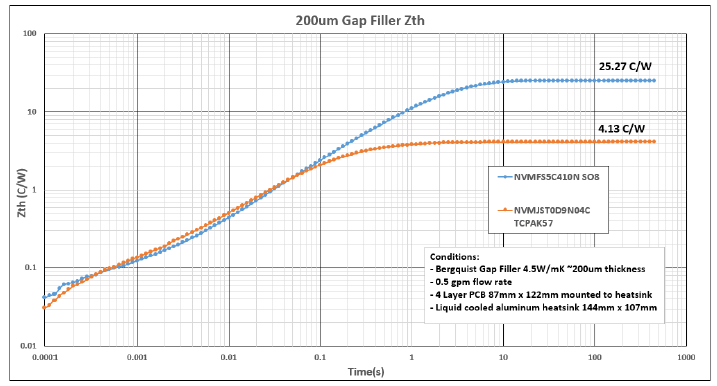
图 8. 使用 200 μm TIM 的热响应曲线

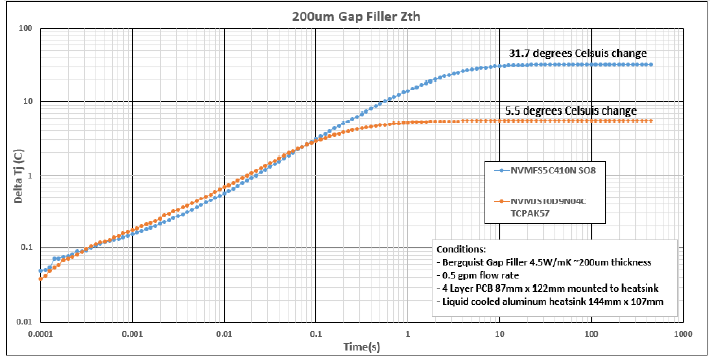
图 9. 使用 200 μm TIM 的温度变化曲线
使用700 μm TIM安装到散热器的封装比较
使用 700 μm 的 TIM 厚度进行了另一次测试操作。这是为了与 200 μm TIM 测试进行热响应变化的比较,以验证外部散热方法对每种封装的影响。该测试操作得到如下热响应结果:顶部散热器件为 6.51 C°/W,SO8FL 为 25.57 C°/W。对于顶部散热,两次 TIM 操作的差异为 2.38 C°/W,而 SO8FL 的差异为 0.3 C°/W。这意味着该外部散热方法对顶部散热器件影响很大,而对 SO8FL 影响很小。这也是意料之中的,因为顶部散热器件的热响应以 TIM 层热阻为主。与散热器相比,TIM 的热导率较低。因此,当厚度增加时,热阻会增加,导致 Rth 更高。
SO8FL TIM 变化发生在电路板和散热器之间。其器件热量必须通过电路板传播才能到达 TIM 和散热器,因此厚度变化对主要热量路径的热阻影响很小。所以,热响应的变化很小。
TIM 厚度变化引起的这些热响应变化,证明了顶部散热封装具有整体优势。TCPAK57 在封装顶部有一个裸露的引线框架,因而可以更好地控制热量路径的热阻。对于特定应用和散热方法,可以利用这个特点来优化热响应。这反过来又会提供更可控和有益的功率能力。SO8FL 和类似的 SMD 器件难以通过其所在的电路板散热,具体情况取决于 PCB 特性。这是非易控因素,因为除了散热之外,PCB 设计还有许多其他变量需要考虑。

图 10. 使用 700 μm TIM 的温度变化曲线
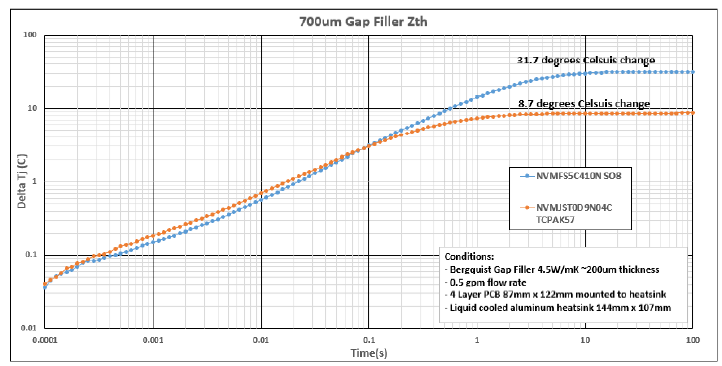
 图 11. 使用 700 μm TIM 的温度变化曲线
图 11. 使用 700 μm TIM 的温度变化曲线
要点总结
顶部散热封装可避免通过 PCB 进行散热,缩短了从芯片到散热装置的热量路径,从而降低了器件的热阻。热阻与散热器和热界面材料特性直接相关。低热阻可以带来许多应用优势,例如:
-
需要的电流量一定时,由于功率能力提高,相比标准 SMD 可以使用更小的顶部散热器件。反过来,这还可能带来成本节省。
-
对于开关模式电源应用,在保持相近的热裕量的同时可以提高开关频率。
-
可用于原本标准 SMD 不适合的更高功率应用。
-
芯片尺寸一定时,顶部散热器件相比等效 SMD 器件将有更高的安全裕量,在给定电流需求下运行温度更低。
更强的热响应优化能力。这通过改变热界面材料和/或厚度来实现。TIM 越薄和/或热导率越好,热响应就越低。热响应也可以通过改变散热器特性来改变。
顶部散热封装可减少通过 PCB 的热量传播,进而减少器件之间的热量交叠。
顶部散热使得 PCB 的背面不需要连接散热器,因此 PCB 上的元器件可以布置得更紧凑。
点个星标,茫茫人海也能一眼看到我


原文标题:详解高效散热的MOSFET顶部散热封装
文章出处:【微信公众号:安森美】欢迎添加关注!文章转载请注明出处。
-
安森美
+关注
关注
33文章
2473浏览量
95940
原文标题:详解高效散热的MOSFET顶部散热封装
文章出处:【微信号:onsemi-china,微信公众号:安森美】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
基本半导体推出第三代碳化硅MOSFET顶部散热封装系列产品

onsemi FDMC86520DC MOSFET:高效性能与卓越散热的完美结合
揭秘高效散热的秘密:散热器性能测试全解析

新品 | 采用顶部散热Q-DPAK封装CoolSiC™ G2 1200V MOSFET 产品扩展

Wolfspeed发布新一代TOLT顶部散热封装产品组合
顶部散热封装QDPAK安装指南

安森美推出采用T2PAK顶部冷却封装的EliteSiC MOSFET
铲齿散热片CNC加工:精密制造赋能高效散热解决方案
Wolfspeed推出新型顶部散热(TSC)碳化硅MOSFET和肖特基二极管,优化热管理并节约能耗

Wolfspeed推SiC MOSFET/SBD新品:顶部散热封装
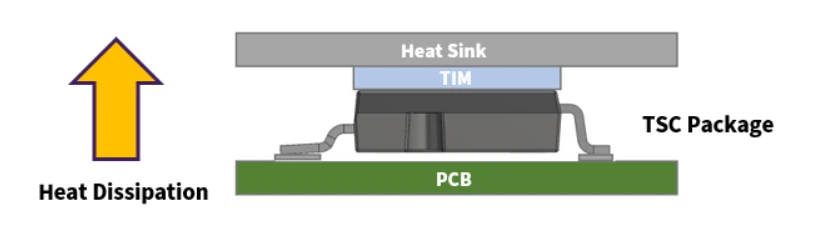
新品 | 采用顶部散热 Q-DPAK封装的 CoolSiC™ 1200V G2 SiC MOSFET




 详解高效散热的MOSFET顶部散热封装
详解高效散热的MOSFET顶部散热封装







评论