银制品易变色、硬度低,传统表面防护方法存在覆膜不均、缺陷多、结合力弱等问题。原子层沉积(ALD)技术可实现均匀、可控的氧化铝(Al₂O₃)薄膜,但膜厚过薄缺陷多、过厚影响外观(色差)。Flexfilm费曼仪器全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
本文采用ALD在抛光925银表面制备不同厚度Al₂O₃薄膜,利用椭圆偏振光谱仪(椭偏仪)精确测厚,研究膜厚与色差的关系,并评估薄膜的疏水、耐腐蚀及机械性能。
1
实验与方法
flexfilm

抛光夹具及氧化铝膜层表面形貌
样品制备:在T150型ALD设备上,基底温度150 ℃,前驱体为三甲基铝(TMA)和水(H₂O),工艺参数:TMA脉冲25 ms/吹扫20 s,H₂O脉冲30 ms/吹扫20 s。925银基底经逐级研磨、抛光(金刚石抛光剂粒度0.25 μm)后超声清洗、氮气吹干。同时在N(100)硅片上同步沉积Al₂O₃薄膜,用于厚度与形貌表征。
表征方法:原子力显微镜测得表面轮廓算术平均偏差Ra=0.28 nm;膜厚由Flexfilm费曼仪器全光谱椭偏仪测量;采用TFCalc软件模拟膜厚-色差关系;通过接触角、摩擦磨损、纳米压痕/划痕、显微硬度及0.1 mol/L Na₂S溶液加速腐蚀实验分别评价疏水性、耐磨性、力学性能和耐腐蚀性。
2
膜厚与色差
flexfilm
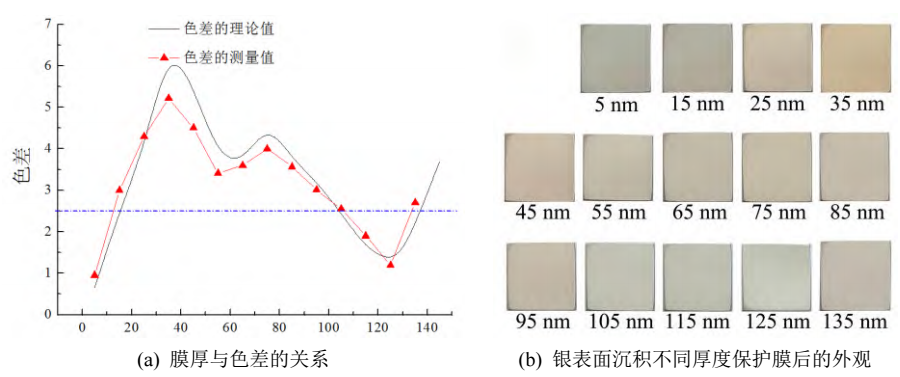
保护膜厚度与色差的关系
TFCalc模拟表明,色差(ΔE)与膜厚呈非线性关系。膜厚104~137 nm时ΔE小于人眼临界值2.5,且在125 nm附近出现极小值。椭偏仪实测厚度与色差变化趋势与模拟一致,因此选定125 nm为最佳膜厚。
3
接触角
flexfilm

镀膜前后的接触角
抛光925银接触角77.7°,沉积125nm Al₂O₃后降至58.1°(亲水),归因于Al₂O₃高表面能及表面羟基化。暴露空气30d后增至72.8°,原因是有机污染物吸附及–OH基团脱水形成Al–O–Al键。表明Al₂O₃膜未能有效提升银表面疏水性。
4
耐磨性
flexfilm
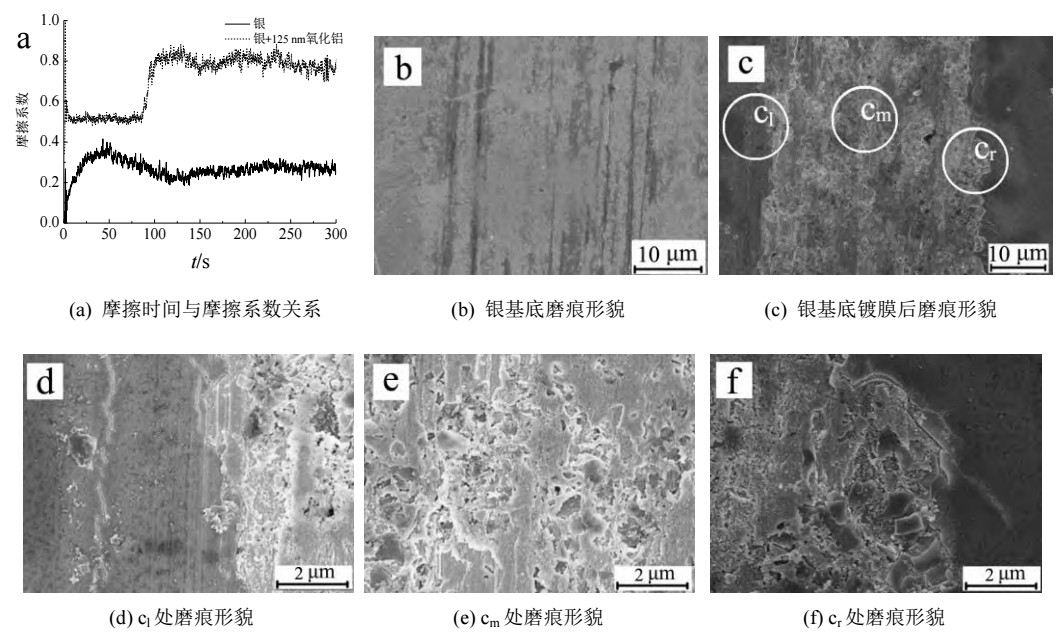
镀膜前后的摩擦系数及磨痕形貌
摩擦磨损测试(60mN,Al₂O₃球对磨)显示:未镀膜银磨痕宽≈34 μm,镀膜后≈45 μm(理论最大深度84.4 nm<125 nm)。磨痕中心呈蜂窝状,边缘有裂纹。未镀膜银摩擦系数先升后降,130 s后趋稳;镀膜后摩擦系数整体升高,86 s时突变加剧,保护膜失效。失效机制为应力集中、热应力、软基底塑性变形诱发微裂纹扩展,最终剥落。
5
纳米压痕及划痕
flexfilm
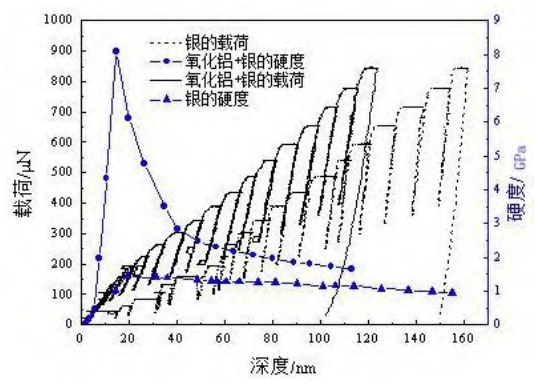
载荷位移曲线
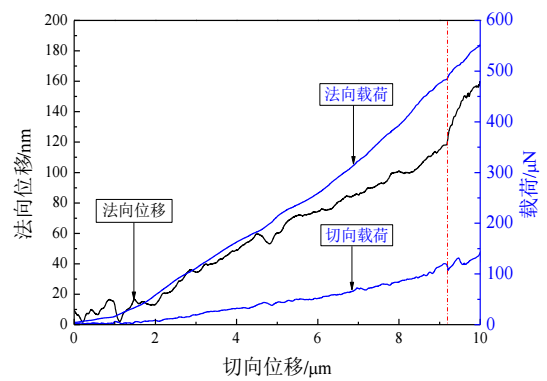
划痕测试图
纳米压痕测试:压入深度<14 nm时硬度随深度增加,14 nm处达最大值8 GPa(接近Al₂O₃真实硬度);超过14 nm后基底效应增强,硬度下降。20~80 nm出现“突跳”,可能因膜开裂。银基底最大硬度1.45 GPa。镀膜后复合硬度为基底的5.5倍。最大载荷845 μN时,镀膜与未镀膜样品的最大压入深度分别为123 nm和161 nm,残余位移比0.8和0.9,表明Al₂O₃膜支撑银基底但限制其弹性恢复。
纳米划痕测试:法向载荷增至488μN、划痕深度122nm时,切向载荷骤降后回升,表明保护膜完全剥落。
6
显微硬度
flexfilm

镀膜前后压痕形貌
显微硬度测试(2.94N,10s)显示,镀膜前后压痕对角线长度相同,硬度均为87 HV₀.₃,即125nm Al₂O₃膜未能提高高载荷下的显微硬度。镀膜样品压痕处产生裂纹(对角线处最宽)及巴氏裂纹,而未镀膜银表面光滑。

压痕不同位置处的EDS测试
EDS分析表明裂纹处Al、O含量随裂纹宽度增加而升高,并检出S元素,说明膜破裂后银被腐蚀生成硫化物。
7
耐腐蚀性能
flexfilm

腐蚀时间与色差、膜厚去除量的关系及局部腐蚀区域
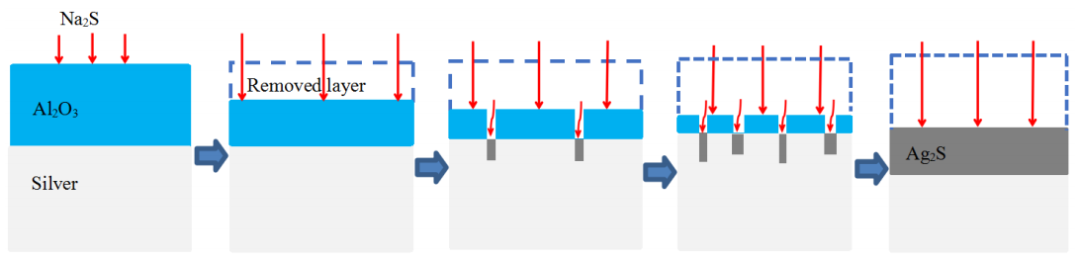
沉积 Al2O3保护膜的 925 银在硫化钠溶液中腐蚀机理
0.1mol/L Na₂S溶液加速腐蚀实验:40min内ΔE变化趋势与膜厚-色差关系一致,且椭偏仪测得硅片上Al₂O₃膜累计去除厚度随腐蚀时间增加,表明ΔE变化主要源于膜层减薄而非银基底腐蚀,保护膜耐蚀优异。超过45min后,ΔE未按预期下降反而持续增大,表面出现岛状腐蚀区域。机理为:膜层减薄导致缺陷暴露,硫离子扩散至Al₂O₃ / Ag界面,与银反应生成灰黑色Ag₂S,形成局部腐蚀区,最终保护膜完全去除后发生全面腐蚀。
本研究利用椭偏仪精确测量了原子层沉积氧化铝(Al₂O₃)薄膜的厚度,成功解决了银制品保护中外观与性能的平衡问题。椭偏仪数据表明,当膜厚为125 nm时,色差(ΔE)出现极小值,既不影响外观,又为基底提供了有效保护。此外,通过椭偏仪对腐蚀过程中膜厚变化的动态监测,揭示了保护膜的失效机理:前期为均匀减薄,后期因膜层变薄、缺陷暴露而引发局部腐蚀。综上,椭偏仪在光学薄膜领域,为优化ALD工艺参数、评估防护性能及阐明失效机制提供了关键的数据支撑。
Flexfilm费曼仪器全光谱椭偏仪
flexfilm

Flexfilm费曼仪器全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)
- 先进的旋转补偿器测量技术:无测量死角问题。
- 粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
- 秒级的全光谱测量速度:全光谱测量典型5-10秒。
- 原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm费曼仪器全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《银制品表面氧化铝保护膜的机械与耐腐蚀性能》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
光学薄膜
+关注
关注
1文章
35浏览量
10761 -
光谱仪
+关注
关注
2文章
1285浏览量
32759 -
仪器
+关注
关注
1文章
4293浏览量
53707
发布评论请先 登录
厚膜电阻和贴片电阻的区别是什么
全钒氧化还原液流电池导电塑料电极耐腐蚀性的研究
镀镍的应用领域 镀镍材料的耐腐蚀性能
椭偏仪在半导体薄膜工艺中的应用:膜厚与折射率的测量原理和校准方法




 椭偏仪在光学薄膜中的应用 | Al₂O₃膜厚、色差与耐腐蚀性解析
椭偏仪在光学薄膜中的应用 | Al₂O₃膜厚、色差与耐腐蚀性解析





评论