声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
封装
+关注
关注
128文章
9380浏览量
149210
发布评论请先 登录
相关推荐
热点推荐

北方华创发布12英寸芯片对晶圆混合键合设备Qomola HPD30
北方华创近日发布12英寸芯片对晶圆(Die to wafer,D2W)混合键合设备——Qomola HPD30。
热压键合工艺的技术原理和流程详解
热压键合(Thermal Compression Bonding,TCB)是一种先进的半导体封装工艺技术,通过同时施加热量和压力,将芯片与基板或其他材料紧密连接在一起。这种技术能够在微

氧浓度监控在热压键合(TCB)工艺过程中的重要性
随着半导体产品高性能、轻薄化发展,封装技术作为连接芯片与外界环境的桥梁,其重要性日益凸显。在众多封装技术中,热压键合(Thermal Compression Bonding)

wafer晶圆厚度(THK)翘曲度(Warp)弯曲度(Bow)等数据测量的设备
通过退火优化和应力平衡技术控制。
3、弯曲度(Bow) 源于材料与工艺的对称性缺陷,对多层堆叠和封装尤为敏感,需在晶体生长和镀膜工艺中严格调控。
在先进制程中,三者共同决定了晶
发表于 05-28 16:12



 晶圆键合工艺技术详解(69页PPT)
晶圆键合工艺技术详解(69页PPT)

















































































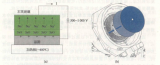








评论