南京屹立芯创半导体科技有限公司
在半导体先进封装向更高密度、更薄厚度、异质集成演进的浪潮中,Die Attach Film (DAF胶膜) 凭借其优异的工艺精度、超薄特性(可低至<10μm)和简化流程的优势,已成为芯片贴装不可或缺的核心材料。然而,其精密结构也带来了一个核心痛点——微米级气泡(Void)问题。尤其在追求极致集成的3D堆叠、超薄芯片(<50μm)、2.5D/3D封装等前沿领域,任何微小气泡都可能成为封装可靠性失效的“导火索”。
面对这一行业共性难题,屹立芯创凭借对先进封装工艺的深刻理解,聚焦于真空环境下的热流精准控制与智能气压调节核心技术,推出了一系列创新解决方案,直击气泡痛点,为高可靠性封装保驾护航。
一、气泡:高密度封装的隐形杀手
DAF胶膜在贴装过程中,受热软化后被压合于芯片与基板的微米级界面中。界面微观不平整、残留气体或排气不畅等因素,都极易将气体“锁”在胶体内,形成致命空洞。
机械完整性崩塌:气泡直接侵蚀有效粘接面积,显著削弱结合强度,大幅提升界面分层(Delamination)风险。
热管理失效:气泡是热的绝佳绝缘体。它会阻塞芯片向基板的导热路径,形成局部热点(Hot Spot),加速器件性能衰减。
长期可靠性隐患:在后续回流焊或温度循环中,气泡内气体受热膨胀会产生巨大应力,极易诱发芯片微裂纹或界面剥离。
超薄芯片与高密度堆叠更放大了这一风险:
芯片与DAF膜同步减薄,使得气体逃逸路径被极度压缩,除泡难度呈指数级上升。多层芯片堆叠中,下层的一个微小气泡都可能成为引发整个结构力学失稳的“多米诺骨牌”。
二、破局之道:真空除泡技术的精妙协同
传统方法难以应对微米级间隙中的气泡挑战。屹立芯创通过真空、热流与压力的精妙协同,实现了对气泡的“精准歼灭”。
1. 真空压力除泡系统:深入“敌后”,动态剿灭气泡
核心技术:真空-压力循环“呼吸法”
针对贴装后已存在的界面气泡,该系统通过精心设计的多段式真空-压力循环程序,实现动态、深度除泡。
在高真空环境下,强力抽吸并扩大溶解及游离的微米气泡,使其脱离界面束缚。
随后施加均匀的静高压,促进胶体二次流动与渗透,强力挤压并溶解微小气泡,同时确保界面紧密接触。
通过多次循环,彻底清除包括边缘气阱(Air Trap)在内的各类气泡,实现完美界面填充。
应用场景:
贴膜除泡:攻克贴合界面气泡难题,为芯片堆叠/micro LED/OCA提供无缺陷贴合保障。
底填除泡:守护微米互连可靠性,确保倒装芯片封装长期稳定运行。
灌封除泡:实现模块级结构保护,提升车规与功率器件在恶劣环境下的耐久性。
铟TIM除泡:突破散热界面导热瓶颈,为CPU/GPU/AI芯片释放极致性能潜能。
 真空压力除泡系统
真空压力除泡系统 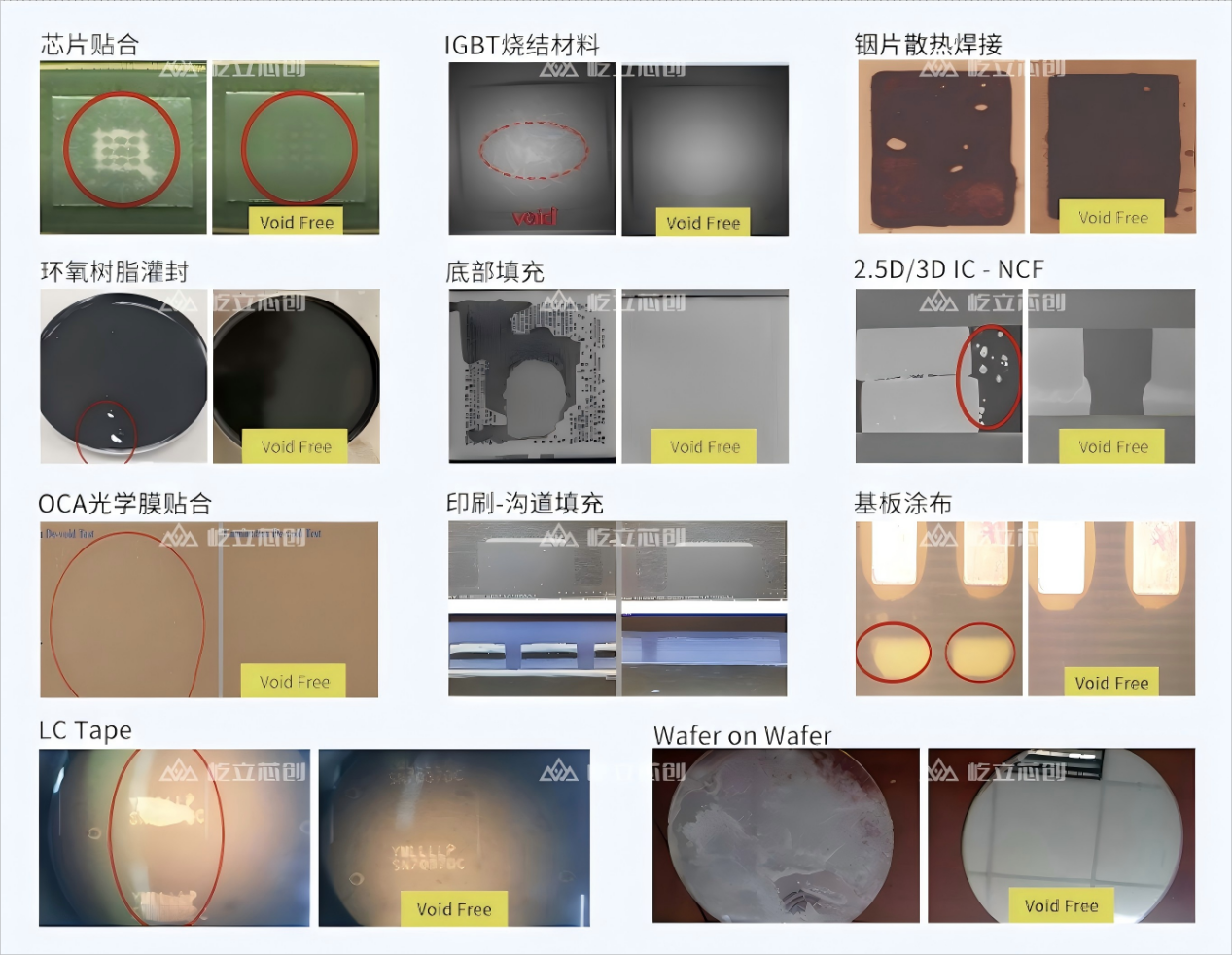
三、微米世界的胜负手,为先进封装提供“零气泡”基底
当DBG/SDBG工艺将芯片带入“超薄时代”,当异质集成成为提升算力的核心路径,界面气泡已成为制约其可靠性的最大瓶颈之一。
屹立芯创依托热流与气压两大核心技术,打造以真空除泡系统和晶圆级真空贴压膜系统为核心的先进封装气泡整体解决方案,致力于为全球客户提供从材料、工艺到设备的全链条“零气泡”保障,正跻身成为全球热流与气压技术的领导者与除泡品类专家,为半导体封装的下一次革新奠定坚实的可靠性基石。
审核编辑 黄宇
-
半导体
+关注
关注
339文章
31494浏览量
267685 -
先进封装
+关注
关注
2文章
572浏览量
1079
发布评论请先 登录
微型皮拉尼真空传感器PVC1000用在热导式真空表测真空度

真空计如何守护动力电池安全?从除泡到烘烤,两道关键工序的“真空闭环”

屏幕模组电磁干扰与接地失效难题的高可靠导电泡棉连接方案

Onsemi ES2DAF超快整流器:特性与设计应用解析
车规级SMT导电泡棉:-40℃不黑屏、125℃不断连的接地方案

SMT镀锡导电泡棉:微型化电子的高可靠EMI屏蔽方案

导电泡棉:连接触摸膜与PCB的可靠EMI解决方案

彻底告别真空泵:免脱泡自排泡灌封胶如何提升精密电子生产效率? |铬锐特实业

灌封胶气泡消除技巧:搅拌+抽真空+固化全流程排气消泡方法 | 铬锐特实业

康丽达导电泡棉全系列解析:从SMT工艺到AIR LOOP的结构创新与选型指南

真空造粒机PLC数据采集解决方案

芯片印刷除钨浆料的改进
DAF胶膜(Die Attach Film)详解
里程碑!屹立芯创除泡系统落地马来槟城,深耕 IoT 与先进封装

虹科分享 功夫机器人来了!CMG擂台之上的技术决胜点是什么?




 决胜微米之间:DAF胶膜真空除泡方案
决胜微米之间:DAF胶膜真空除泡方案




评论