Hello,大家好,我们来分享下先进封装中TSV需要的相关设备。
TSV 生产流程涉及到深孔刻蚀、PVD、CVD、铜填充、微凸点及电镀、清洗、减薄、键合等二十余种设备,其中深孔刻蚀、气相沉积、铜填充、清洗、CMP去除多余的金属、晶圆减薄、晶圆键合等工序涉及的设备最为关键。
1)深孔刻蚀设备
深孔刻蚀是TSV的关键工艺,目前首选技术是基于Bosch工艺的干法刻蚀。深反应等离子刻蚀设备是感应耦合高密度等离子体干法刻蚀机(InductivelyCoupled Plasma Etcher),采用半导体刻蚀机的成熟技术,独特设计的双等离子体源实现了对腔室内等离子体密度的均匀控制,满足硅高深宽比刻蚀工艺的要求。具有稳定可靠的工艺性能、宽阔的工艺窗口和良好的工艺兼容性,用于晶片的高深宽比刻蚀。
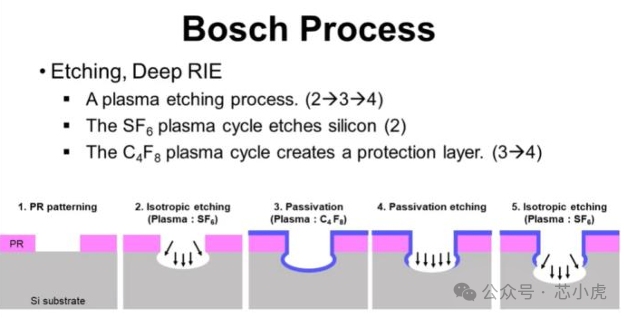
2)气相沉积设备
气相沉积设备主要用于薄膜电路表面的高低频低应力氧化硅等薄膜淀积。设备具有低温TEOS工艺沉积氧化硅薄膜,应力易调控,适用于薄膜电路制造中保护膜层的沉积。设备应具有预真空室、基片传送模块以及工艺模块等,传片及工艺过程自动化。绝缘层做好后,通过物理气相沉积法(PVD)沉积金属扩散阻挡层和种子层,为后续的铜填充做好准备。后续的电镀铜填充要求TSV侧壁和底部具有连续的阻挡层和种子层。种子层的连续性和均匀性被认为是 TSV 铜填充最重要的影响因素。根据硅通孔的形状、深宽比及沉积方法不同,种子层的特点也各有不同,种子层沉积的厚度、均匀性和粘合强度是极为重要的指标。
3)铜填充设备
深孔金属化电镀设备用于新一代高频组件高深宽比通孔填孔电镀铜工艺,解决高深宽比微孔内的金属化问题,提高互联孔的可靠性。TSV填孔镀铜工序是整个TSV工艺里最核心、难度最大的工艺,对设备的要求比较高,成熟的用于TSV填孔镀铜的设备价格昂贵。
4)减薄抛光设备
一旦完成了铜填充,则需要对晶圆进行减薄抛光。TSV要求晶圆减薄至50μm甚至更薄,要使硅孔底部的铜暴露出来,为下一步的互连做准备。目前晶圆减薄可以通过机械研磨、化学机械抛光、湿法及干法化学处理等不同的加工工序来实现,但晶圆很难容忍减薄过程中的磨削对晶圆的损伤及内在应力,其刚性也难以使晶圆保持原有的平整状态,同时后续工艺的晶圆传递、搬送也遇到了很大的问题。目前业界的多采用一体机的思路,将晶圆的磨削、抛光、贴片等工序集合在一台设备内。
5)清洗设备
TSV 的湿法清洗不同于晶圆级封装等先进封装,其中有几个关键工序需用到清洗:
①TSV刻蚀后清洗:有比较重的硅的残留、侧壁的polymer比较重,清洗的时候不能破坏底部的二氧化硅;
②TSV长完liner后要把底部的二氧化硅打开后清洗,清洗底部的同时不能破坏侧壁长好的liner的二氧化硅;
③大马士革正面制程刻蚀后的清洗包括Via刻蚀后和Trench刻蚀后;
④露铜过程前后的清洗。
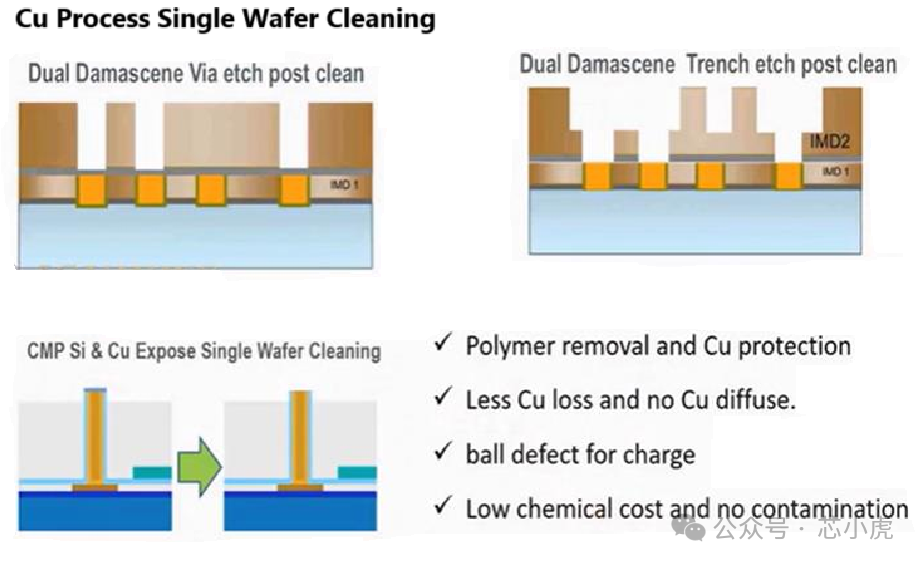
6)检测量测设备
在后段封装工艺中,芯片倒装(Flip-chip)、圆片级封装(Wafer-level Packaging)和硅通孔(Through-silicon Via,TSV)等先进工艺要求对凸点(Bump)、通孔(TSV)、铜柱(Copper pillar)等的缺损/异物残留及其形状、间距、高度的一致性,以及重布线层(Re-distribution layer,RDL)进行无接触定量检查和测量,以保证集成电路芯片生产线快速进入量产阶段并获取稳定的高成品率和高经济效益。
-
工艺
+关注
关注
4文章
729浏览量
30431 -
TSV
+关注
关注
4文章
139浏览量
82833 -
先进封装
+关注
关注
2文章
573浏览量
1081
原文标题:半导体先进封装中TSV工艺需要的设备有哪些?
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
先进封装之TSV及TGV技术初探

什么是TSV封装?TSV封装有哪些应用领域?
TSV关键工艺设备及特点
TSV的工艺流程和关键技术综述
TSV以及博世工艺介绍




 先进封装中TSV工艺需要的相关设备
先进封装中TSV工艺需要的相关设备














评论