
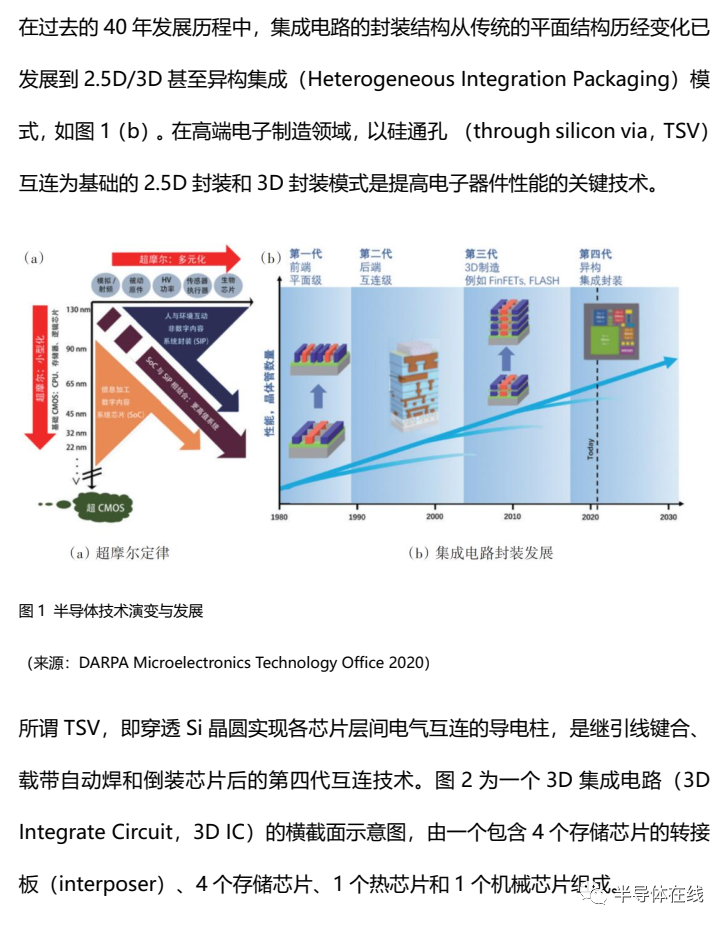
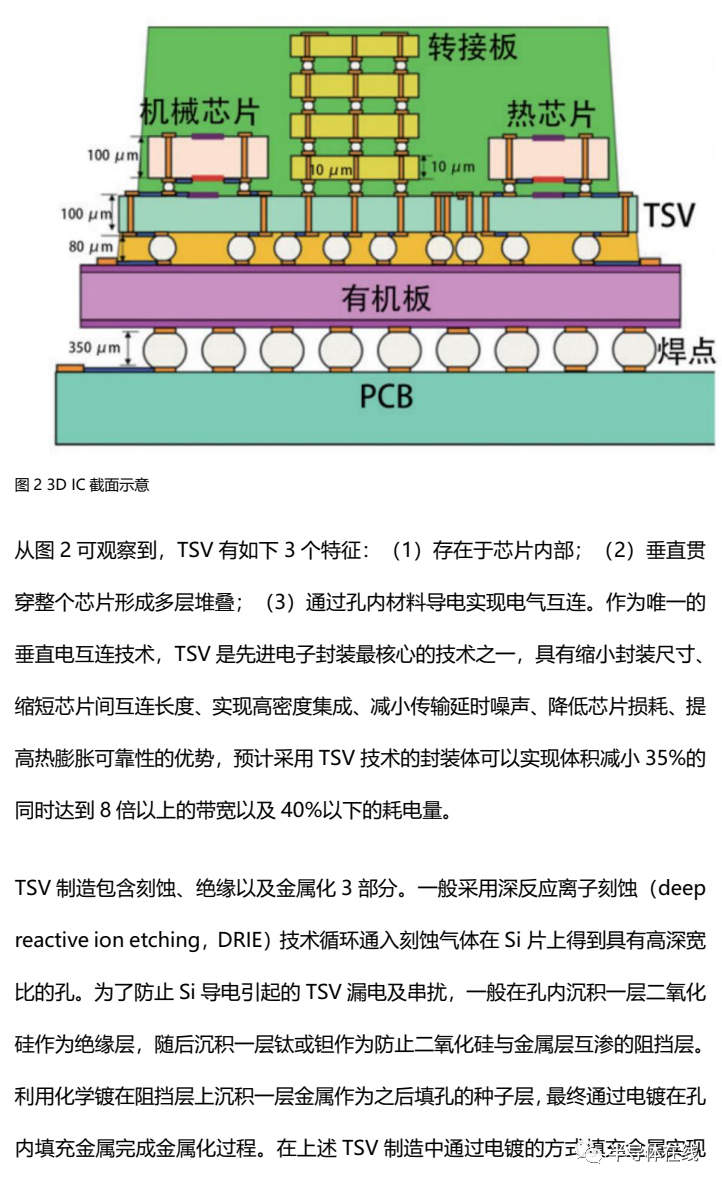


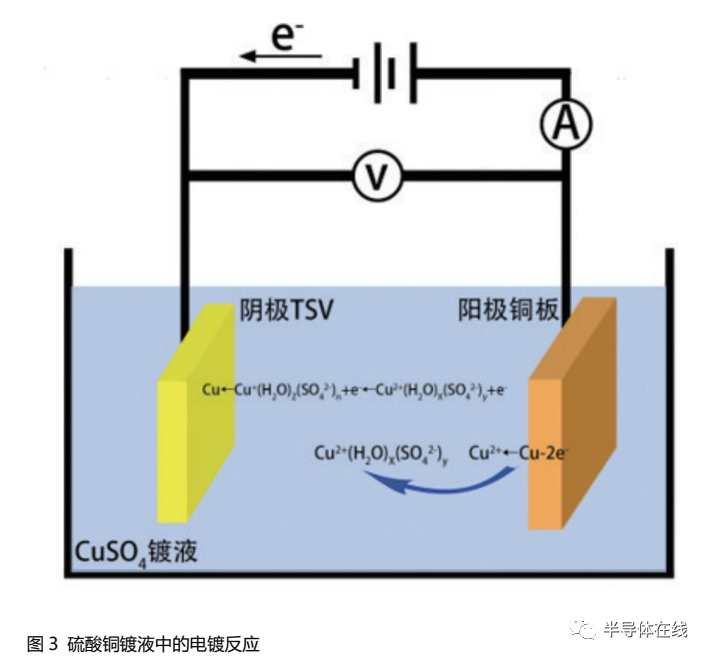














来源:《科技导报》2023年第5期
作者:谌可馨 1,3,高丽茵 1,2*,许增光 2,李哲 1,刘志权 1,2
审核编辑:汤梓红
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
封装
+关注
关注
128文章
9332浏览量
149047 -
电镀
+关注
关注
16文章
478浏览量
25896 -
TSV
+关注
关注
4文章
139浏览量
82774 -
硅通孔
+关注
关注
2文章
31浏览量
12150 -
先进封装
+关注
关注
2文章
563浏览量
1062
原文标题:先进封装中硅通孔(TSV)铜互连电镀研究进展
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
热点推荐
新型铜互连方法—电化学机械抛光技术研究进展
新型铜互连方法—电化学机械抛光技术研究进展多孔低介电常数的介质引入硅半导体器件给传统的化学机械抛光(CMP)技术带来了巨大的挑战,低k 介质的脆弱性难以承受传统CMP 技术所施加的机械
发表于 10-06 10:08
铜电车线材料的研究进展
对目前铜电车线材料的研究进展做了述评,并阐述了用定向凝固方法制备高度强度高导电率铜车线的可行性,同时报道了记者近期在这方面的一些研究结果。
发表于 07-06 13:37
•22次下载
3D IC集成与硅通孔TSV互连
重点讨论了垂直互连的硅通孔(TSV)互连工艺的关键技术及其加工设备面临的挑战.提出了工艺和设备开发商的应对措施并探讨了3DTSV
发表于 12-07 10:59
•89次下载

详解TSV(硅通孔技术)封装技术
硅通孔技术(Through Silicon Via, TSV)技术是一项高密度封装技术,正在逐渐取代目前工艺比较成熟的引线键合技术,被认为是第四代封
发表于 10-12 18:30
•1.8w次阅读

什么是TSV封装?TSV封装有哪些应用领域?
硅通孔技术(Through Silicon Via, TSV)技术是一项高密度封装技术,正在逐渐取代目前工艺比较成熟的引线键合技术,被认为是第四代封
发表于 08-14 15:39
•9.3w次阅读
先进封装中铜-铜低温键合技术研究进展
用于先进封装领域的 Cu-Cu 低温键合技术进行了综述,首先从工艺流程、连接机理、性能表征等方面较系统地总结了热压工艺、混合键合工艺实现 Cu-Cu 低温键合的研究进展与存在问题,进一步地阐述了新型纳米材料烧结工艺在实现低温连接




 先进封装中硅通孔(TSV)铜互连电镀研究进展
先进封装中硅通孔(TSV)铜互连电镀研究进展











评论