工艺原理
CSP(Chip Scale Package,芯片级封装)技术是一种先进的封装技术,其焊端通常设计为直径0.25mm的焊球。这种设计不仅减小了封装尺寸,还提高了集成度。在焊接过程中,焊膏首先融化,随后焊球融化,这种顺序融化机制有助于避免焊球间的桥连问题,但可能因印刷过程中的少印而导致球窝、开焊等缺陷。因此,对于0.4mm间距的CSP,确保印刷过程中获得足够的焊膏量是关键。
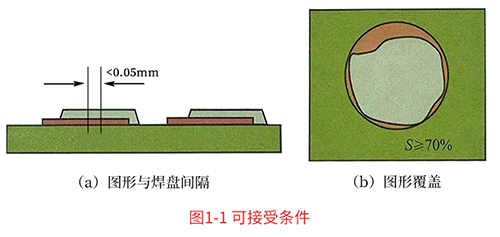
基准工艺
为了优化CSP的焊接效果,基准工艺设定如下:
模板厚度:0.08mm。这一厚度选择旨在平衡焊膏的填充性和溢出控制,确保焊膏能够均匀且适量地覆盖焊盘。
模板开口直径:ф0.25mm,与焊球直径相匹配,以确保焊膏能够准确、完整地填充到焊球下方的区域。
模板类型:推荐使用FG模板。FG模板(Fine Grain模板)以其精细的网孔结构和优异的脱模性能,有助于实现高精度的焊膏印刷。
接受条件
可接受条件:
焊膏图形中心位置:焊膏图形中心偏离焊盘中心应小于0.05mm,以确保焊膏的准确位置,避免焊接不良。
焊膏量:焊膏量覆盖率超出焊盘75%~125%的范围(通过SPI检测)。这一范围确保了焊膏的充足性,同时避免了过量焊膏可能导致的短路问题。
焊膏覆盖面积:焊膏覆盖面积应大于或等于模板开口面积的70%,以确保焊膏能够充分覆盖焊盘,提高焊接的可靠性和稳定性。
印刷质量:
无漏印现象,且挤印引发的焊膏与焊盘最小间隔应大于或等于0.5mm²,以避免短路风险。
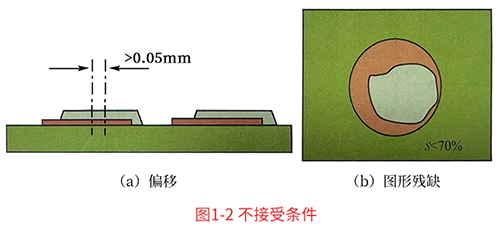
不接受条件
焊膏图形中心位置偏移:图形中心偏离焊盘中心大于0.05mm,这可能导致焊接不良,产生锡珠,影响封装质量。
焊膏量异常:焊膏量覆盖率超出焊盘75%~125%的范围,无论是过多还是过少,都可能对焊接质量产生不利影响。
焊膏覆盖面积不足:图形覆盖面积小于模板开口面积的70%,这可能导致焊盘部分区域无焊膏覆盖,进而影响焊接的可靠性。
印刷缺陷:出现焊膏漏印、严重挤印与拉尖等缺陷,这些都会直接影响焊接的质量和稳定性,因此不被接受。
总的来说,CSP封装工艺的成功实施需要严格控制焊膏的印刷过程,确保焊膏的准确位置、适量填充和良好覆盖,以满足严格的焊接质量要求。
审核编辑 黄宇
-
封装
+关注
关注
128文章
9330浏览量
149047 -
CSP
+关注
关注
0文章
129浏览量
29544 -
焊盘
+关注
关注
6文章
605浏览量
39892
发布评论请先 登录
LED晶膜屏的FPC基材选型与COB封装工艺研究(源头厂家技术白皮书)
CoWoS(Chip-on-Wafer-on-Substrate)先进封装工艺的材料全景图及国产替代进展

热压键合工艺的技术原理和流程详解

SK海力士HBS存储技术,基于垂直导线扇出VFO封装工艺

半导体“封装过程”工艺技术的详解;

详解芯片封装的工艺步骤

半导体封装工艺流程的主要步骤




 CSP(Chip Scale Package)封装工艺详解
CSP(Chip Scale Package)封装工艺详解 












评论