挑战传统,打破限制,勇攀高峰,打破常规者们在寻求开创性解决方案的过程中重塑规则。继SK海力士品牌短片《谁是打破常规者》播出后,将推出一系列文章,展示公司在重塑技术、重新定义行业标准方面采取的各种“打破常规”的创新举措。作为本系列首篇文章,将详述HBM领域中MR-MUF技术的发展。
体积更小、速度更快、带宽更高、性能更佳。如今,领先的存储器产品正迅速发展,以满足人工智能时代下的高需求。然而,这些进步也带来了一项可能阻碍下一代产品发展的挑战——热量过高。
为解决这一问题,SK海力士取得了前所未有的突破,开发出了一种名为批量回流模制底部填充(MR-MUF, Mass Reflow-Molded Underfill)1 的新型创新封装技术,可以有效改善芯片的散热性能。自2019年以来,MR-MUF技术被应用于SK海力士开创性产品HBM2中,使公司在市场竞争中脱颖而出。作为唯一一家采用MR-MUF技术的公司,应用该技术的HBM产品的散热性能获得客户一致好评,SK海力士毫无疑问地成为HBM市场的领导者。
1批量回流模制底部填充(MR-MUF, Mass Reflow-Molded Underfill): 批量回流焊是一种通过熔化堆叠芯片间的凸点以连接芯片的技术。通过模制底部填充技术,将保护材料填充至堆叠芯片间隙中,以提高耐用性和散热性。结合回流和模制工艺,MR-MUF技术将半导体芯片连接到电路上,并用环氧树脂模塑料(EMC)填充芯片间及凸点间的空隙。
2高带宽存储器(HBM, High Bandwidth Memory): 一种高附加值、高性能存储器产品,通过硅通孔技术(TSV)将多个DRAM芯片垂直互联。与现有的DRAM产品相比,数据处理速度显著提高。
本文将探讨MR-MUF技术的开创性发展,并重点关注高导热性新材料如何解决下一代HBM产品热量过高的问题。
全力攻克散热难题
随着存储器产品的发展,散热问题愈发严峻,导致这一问题的原因有多个:例如,由于表面积减少和功率密度增加,半导体微型化会直接影响产品的散热性能;对于HBM这样的DRAM堆叠产品,热传导路径较长会导致热阻增加,热导性也会因芯片之间的填充材料而受限;此外,速度和容量的不断提升,也会导致热量增加。
若无法充分控制半导体芯片产生的热量,可能会对产品性能、生命周期和功能产生负面影响。这是客户重点关注的问题,因为此类问题会严重影响其生产力、能源成本和竞争力。所以,除容量和带宽外,包括散热在内均已成为先进存储器产品开发过程中的关键考虑因素。
因此,人们开始将注意力转向半导体封装技术,因其主要功能之一是热控制。在第二代HBM产品HBM2之前,SK海力士的HBM产品一直采用行业标准性热压非导电膜(TC-NCF,Thermal Compression Non-Conductive Film)3技术。然而,随着HBM产品的进步,需要更薄的芯片来容纳更多的芯片层,因此相应的封装技术需要控制更多的热量和压力。SK海力士在开发下一代产品时,还需要解决密集堆叠产品中因压力和厚度而造成芯片翘曲等问题。基于此,公司需要跳出固有思维,为未来产品开发一项全新封装技术。
3热压非导电薄膜(TC-NCF,Thermal Compression Non-Conductive Film):一种通过在芯片间涂抹薄膜状物质来堆叠芯片的技术。通过加热和加压融化这种物质,从而将芯片粘在一起。
MR-MUF技术及其新材料,
填补散热控制拼图中缺失的一环
SK海力士在开发第三代HBM产品——HBM2E时,将传热控制作为改进的主要焦点。即便TC-NCF技术被公认为是适用于密集堆叠产品的封装解决方案,SK海力士仍旧坚持不断挑战现状,努力开发一种可优化散热性能的新型封装技术。经过无数次的测试和试验,公司于2019年推出了新型封装技术MR-MUF,继而彻底改变了HBM市场的未来。
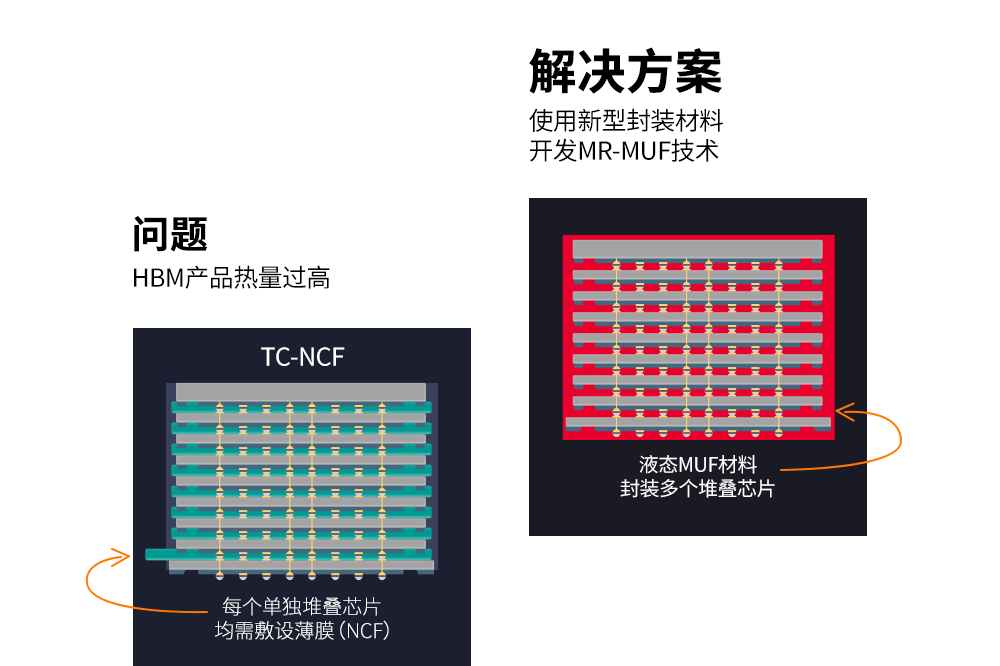
TC-NCF技术与MR-MUF技术散热性能的结构差异
MR-MUF技术由SK海力士多个团队共同开发,该技术能够同时对HBM产品中所有的垂直堆叠芯片进行加热和互联,比堆叠芯片后填充薄膜材料的TC-NCF技术更高效。此外,与TC-NCF技术相比,MR-MUF技术可将有效散热的热虚设凸块数量增加四倍。
MR-MUF技术另一个重要特性是采用了一种名为环氧树脂模塑料(EMC, Epoxy Molding Compound)4的保护材料,用于填充芯片间的空隙。EMC是一种热固性聚合物,具有卓越的机械性、电气绝缘性及耐热性,能够满足对高环境可靠性和芯片翘曲控制的需求。由于应用了MR-MUF技术,HBM2E的散热性能比上一代HBM2提高了36%。
4环氧树脂模塑料(EMC, Epoxy Molding Compound): 一种基于热固性聚合物环氧树脂的散热材料。这种材料可用于密封半导体芯片,以避免芯片受到外部环境因素影响,如高温、潮湿、震动等。
虽然MR-MUF技术也被用于HBM2E的下一代产品——8层HBM3,但在2023年开发12层HBM3时,SK海力士还是将MR-MUF技术提升到了一个新高度。为了保持产品的整体厚度,DRAM芯片必须比8层HBM3所用的芯片薄40%,因此解决芯片翘曲成为了一个关键问题。SK海力士积极应对挑战,开发了先进的MR-MUF技术,并引入了业界首创的芯片控制技术(Chip Control Technology)5和改善散热效果的新型保护材料。在此过程中,因其在先进MR-MUF技术中应用的新型EMC与原始MR-MUF技术中的EMC相比,使散热性能提高了1.6倍,SK海力士再次实现材料创新。
5芯片控制技术(Chip Control Technology):在堆叠芯片时,对每个芯片施加瞬间高热,使顶层芯片下的凸点与底层芯片上的薄垫熔合。薄垫将芯片固定在一起,以防止翘曲。
凭借热量控制技术,
SK海力士成功实现了最高级别HBM的量产

HBM产品发展及散热性能优化时间线
从开发HBM2E开始,MR-MUF技术及随后推出的先进MR-MUF技术的应用,使SK海力士能够生产出业界最高标准的HBM产品。时至2024年,SK海力士已成为首家量产HBM3E的公司,这是最新一代、拥有全球最高标准性能的HBM产品。在应用先进的MR-MUF技术后,与上一代8层HBM3相比,HBM3E在散热性能方面提高了10%,成为人工智能时代炙手可热的存储器产品。展望未来,公司将继续保持其在HBM领域的市场主导地位,并宣布计划将下一代HBM4产品的量产提前至2025年。
打破常规者专访:
HBM产品封装部门,河京武TL
为了更深入地了解MR-MUF技术开发和HBM发展的渊源,本文采访了HBM产品封装部门的 河京武TL。通过对新材料的探索、测试和验证,河京武积极推动着MR-MUF技术的发展,并就这一创新工艺所带来的影响进行了深入探讨。
Q
SK海力士采用MR-MUF技术成功开发出的HBM产品具有怎样的意义?MR-MUF技术和先进MR-MUF技术在材料创新方面有哪些重大突破?
A
“MR-MUF技术的引入让我们站在了HBM市场的顶峰,确保了我们在HBM市场的领先地位。自从我们决定在HBM2E产品上采用MR-MUF技术,而非像其他半导体公司一样使用TC-NCF技术以来,SK海力士一直在超越竞争对手。MR-MUF技术的应用使公司成功量产层数越来越多的、前所未有的HBM产品,充分证明了公司对创新不懈追求的精神。”
“在材料创新方面,MR-MUF技术采用了比NCF技术散热性能更好的EMC材料。与TC-NCF技术相比,这一举措对提高MR-MUF技术的热控性和产品的环境可靠性起到了关键作用。此外,关于先进MUF材料, 是SK海力士在EMC材料基础上更进一步,推出的散热性能更强的新版本。”
Q
在MR-MUF技术的开发过程中,有哪些幕后工作值得分享?
A
“在这些先进技术的背后,是持续不断的测试和评估,以验证和提高用于封装工艺的新材料的质量。”
“在开发先进MR-MUF技术时,将新EMC材料持续用于通用测试载具(UTV, Universal Test Vehicle)6进行可靠性测试至关重要。具有与HBM产品相同规格UTV在经过晶圆级封装(WLP, Wafter-Level Package)7后成为样品,然后进行预见可靠性(LAR, Look Ahead Reliability)8测试,以识别产品缺陷。只有通过测试并进行了必要升级的材料,才可用于HBM最终产品。”
6通用测试载具(UTV, Universal Test Vehicle):在产品开发初期阶段,用于测试和确定产品规格及标准的样品。
7晶圆级封装(WLP, Wafer-Level Package):在切割晶圆前,一次性进行封装和测试晶圆并产出最终产品的技术,在晶圆加工和芯片切割方面,与传统封装工艺不同。
8预见可靠性(LAR, Look Ahead Reliability):在质量评估前进行的初步测试,旨在针对测试过程中发现的产品缺陷制定对策,并于质量评估期间采取相应对策,以修复产品缺陷。
Q
在MR-MUF技术开发过程中,SK海力士的“打破常规者精神”是如何激励员工突破传统的?
A
“我们公司倡导一种‘打破常规’的企业文化,鼓励每个人设定具有挑战性的目标,而非安于现状。此外,无论来自哪个部门,成员们都致力于“一个团队”协作精神,并努力成为团队中最好的一员。”
“这一点在MR-MUF技术开发过程中尤为明显,当时来自各部门的成员通力合作,确保了项目成功。这是全公司成员们共同努力的成果,正是因为大家齐心协力,才使这项创新成为可能。在这个过程中每个成员都各司其职,例如我的职责就是为工程师开发流程提供支持,此外,我的主要职责还包括对材料进行初步风险评估、制定技术验证计划、竞争对手监测以及提前确定客户需求。”
“在SK海力士,我们都是打破常规者。因为我们深信,只要通过共同的努力,就能不断勇攀高峰,创造出令人惊叹的成就。”
-
DRAM
+关注
关注
41文章
2407浏览量
189756 -
存储器
+关注
关注
39文章
7769浏览量
172443 -
SK海力士
+关注
关注
0文章
1017浏览量
42022 -
HBM
+关注
关注
2文章
437浏览量
15910
原文标题:[Rulebreakers’ Revolutions ] MR-MUF热控技术取得突破,HBM迈向新高度
文章出处:【微信号:SKhynixchina,微信公众号:SK海力士】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
192GB,SK海力士开始为英伟达Vera Rubin量产SOCAMM2
SK海力士荣获2026年IEEE企业创新奖
AI浪潮下的业绩狂飙:SK海力士2026年一季度财报深度解析
SK海力士投资19万亿韩元在韩国建设先进封装厂
SK海力士携AI存储器产品亮相NVIDIA GTC 2026




 SK海力士在HBM领域中MR-MUF技术的发展
SK海力士在HBM领域中MR-MUF技术的发展

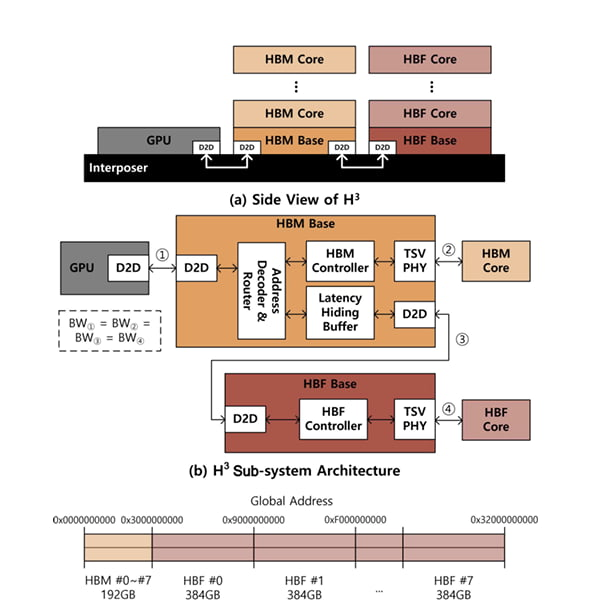




评论